Курсовая Кувалдин 8 вариант. Иркутский национальный исследовательский технический университет институт высоких технологий Кафедра радиоэлектроники и телекоммуникационных систем
 Скачать 0.69 Mb. Скачать 0.69 Mb.
|
|
Министерство науки и высшего образования РФ Федеральное государственное бюджетное образовательное учреждение высшего образования ИРКУТСКИЙ НАЦИОНАЛЬНЫЙ ИССЛЕДОВАТЕЛЬСКИЙ ТЕХНИЧЕСКИЙ УНИВЕРСИТЕТ Институт высоких технологий Кафедра радиоэлектроники и телекоммуникационных систем Допускаю к защитеРуководитель работы М.М.Фискина подпись И.О.Фамилия « » 2020 г. РАСЧЕТ РАСПРЕДЕЛЕНИЯ ПРИМЕСИ В КРЕМНИИПОЯСНИТЕЛЬНАЯ ЗАПИСКАк курсовой работе по дисциплине ОСНОВЫ МИКРОЭЛЕКТРОНИКИ 1.08.00.00 ПЗ обозначение документа Выполнил студент группы РДбз-18-1 В.Ю. Кувалдин подпись И.О. Фамилия Нормоконтролёр М.М.Фискина подпись И.О. Фамилия Курсовая работа защищена с оценкой Иркутск, 2020 г. Министерство науки и высшего образования РФ Федеральное государственное бюджетное образовательное учреждение высшего образования ИРКУТСКИЙ НАЦИОНАЛЬНЫЙ ИССЛЕДОВАТЕЛЬСКИЙ ТЕХНИЧЕСКИЙ УНИВЕРСИТЕТ ЗАДАНИЕ НА КУРСОВУЮ РАБОТУ По курсу: ОСНОВЫ МИКРОЭЛЕКТРОНИКИ Студенту: Кувалдину Владимиру Юрьевичу Тема курсовой работы: «Расчет распределения примеси в кремнии». Исходные данные и вариант расчета Вариант задания на курсовую работу - №8: В работе необходимо рассчитать распределение примеси после диффузионного легирования при создании кремниевого биполярного n-p-n-транзистора. Определить глубины залегания коллекторного, эмиттерного переходов, ширину базы транзистора. Проводят: 1. Расчет базового слоя. 2. Расчет эмиттерного слоя. 3.Построение графика, определение толщины базы биполярного транзистора Исходные данные: Акцепторная примесь – Al (алюминий); Температура процесса диффузии для акцепторной примеси – Т = 1380 К; Время диффузии для акцепторной примеси – t = 1 ч = 3600 сек.; Донорная примесь – As (мышьяк); Температура процесса диффузии для донорной примеси – Т = 1420 К; Время диффузии для донорной примеси – t = 1,5 ч = 5400 сек.: Дата предоставления работы руководителю « » 2020 г. Руководитель курсовой работы:______________________ Фискина М.М.
D1=7*10-13 D2=8*10-14 Содержание
Введение Современный мир сложно представить без устройств, с помощью которых мы храним, обрабатываем и передаем информацию. Их изобретение стало возможным в результате изучения свойств электричества и способов его практического использования — именно этим занимается электроника, одна из наиболее широких и динамично развивающихся областей научного знания. Электронные разработки определяют будущее самых разных направлений современной науки — от экспериментальной физики до вычислительных технологий. Научное изучение электричества стало возможным после изобретения стабильных источников питания. Почву для этого подготовили опыты итальянского врача и физика Луиджи Гальвани. Он предполагал, что мышечные сокращения, которые наблюдаются при разрезании лягушек, связаны с «животным электричеством» — внутренней силой живых организмов. Тем временем физик Алессандро Вольта обратил внимание на то, что в таких опытах используются инструменты из металла, которые контактируют между собой. Как мы сейчас знаем, металлы противоположной полярности создают внешний ток из-за разности своих потенциалов, то есть степеней электризации. Открыв этот эффект, уже в 1800 году Вольта сделал из металлических элементов первую батарею химический источник электрического тока Далее ученые начали изучать применение электричества еще активнее, экспериментировать с количеством разнородных металлов в батарее. Эти опыты позволили не просто наблюдать электрические эффекты, а постепенно продвигаться к более полному пониманию природы электричества на инженерном уровне и накапливать базу для создания устройств. Современный этап развития электроники характеризуется широким применением интегральных микросхем (ИМС). Это связано со значительным усложнением требований и задач, решаемых электронной аппаратурой. Разрабатываемые сейчас сложные системы содержат десятки миллионов элементов. В этих условиях исключительно важное значение приобретают проблемы повышения надежности аппаратуры и ее элементов, микроминиатюризация электронных компонентов и комплексной миниатюризации аппаратуры. Все эти проблемы успешно решает микроэлектроника. Развитие микроэлектроники как самостоятельной науки стало возможным благодаря использованию богатого опыта и базы промышленности, выпускающей дискретные полупроводниковые приборы. Поэтому микроэлектроника продолжает продвигаться быстрыми темпами во всех направлениях. В современной жизни любая техника, которой мы пользуемся, ежедневно наполнена микроэлектроникой. В настоящее время микроэлектроника перешла в стадию наноэлектроники. Прогресс современных средств вычислительной техники, робототехники, аппаратуры цифровых коммуникаций основано на использовании достижений микроэлектроники в разработке и выпуске интегральных микросхем (ИМС), а также на широком применении микропроцессоров и микрокомпьютеров, создаваемых на базе больших и сверхбольших интегральных схем (БМС и СБИС). Непосредственно под электроникой понимают область науки, техники и производства, связанную с исследованием, разработкой и производством электронных приборов и принципов их использования. Поскольку «микро» (от гр.micros-малый) в сложных словах означает отношение к малым предметам, то термин «микроэлектроника» этимологически можно рассматривать как электронику малых размеров. В действительности смысл термина гораздо глубже. Микроэлектроника - это раздел электроники, производством и исследованием интегральных микросхем и принципов их применения. 1. Интегральные биполярные транзисторы. Биполярный транзистор представляет собой полупроводниковый прибор, имеющий два р-n-перехода, образованных в одном монокристалле полупроводника. Эти переходы образуют в полупроводнике три области с различными типами электропроводности. Одна крайняя область называется эмиттером (Э), другая — коллектором (К), средняя — базой (Б). К каждой области припаивают металлические выводы для включения транзистора в электрическую цепь. Электропроводность эмиттера и коллектора противоположна электропроводности базы. В зависимости от порядка чередования р- и n-областей различают транзисторы со структурой р-n-р (рис. 1, а) и n-р-n (рис. 1, б) (иногда их еще называют прямой и обратный). Условные графические обозначения транзисторов p-n-р и n-p-n отличаются лишь направлением стрелки у электрода, обозначающего эмиттер. Принцип работы транзисторов p-n-р и n-p-n одинаков Электронно-дырочный переход, образованный эмиттером и базой, называется эмиттерным, а коллектором и базой — коллекторным. Расстояние между переходами очень мало; у высокочастотных транзисторов оно менее 10 микрометров, а у низкочастотных не превышает 50 мкм (1 мкм=0,001 мм). Основная функция транзистора - это усиление сигнала. Если на базу транзистора подать напряжение, то транзистор начнет открываться. В транзисторе переход коллектор-эмитер открывается плавно: от полностью закрытого состояния (Uб= 0 В) до полностью открытого (этот момент называют напряжение насыщения). Между коллектором и эмиттером течет сильный ток, он называется коллекторный ток (Iк), между базой и эмиттером - слабый управляющий ток базы (Iб). Величина коллекторного тока зависит от величины тока базы. Причем, коллекторый ток всегда больше тока базы в определенное количество раз. Эта величина называется коэффициент усиления по току, обозначается h21э. У различных типов транзисторов это значение колеблется от единиц до сотен раз. Коэффициент усиления по току - это отношение коллекторного тока к току базы: h21э = Iк/Iб Для того, чтобы вычислить коллекторный ток, нужно умножить ток базы на коэффициент усиления: Iк = Iб · h21э  Рис. 1 Изготовление полупроводниковых ИМС осуществляют, используя два основных технологических процесса: диффузию примесей, создающих в полупроводнике область с типом проводимости, противоположным исходному, и эпитаксиальное наращивание слоя кремния на кремниевую подложку, имеющую противоположный тип проводимости. Все элементы схемы формируются в так называемых островках, образованных в кристалле и изолированных между собой. Металлические полоски, необходимые для соединения элементов в электрическую схему, напыляют на поверхность пластины-кристалла. Для этого электроды всех элементов выводятся на поверхность пластины и размещаются в одной плоскости, в одном плане. Поэтому технология изготовления схем с помощью диффузии называется планарно-диффузионной, а с помощью эпитаксиального наращивания – эпитаксиально-планарной. Исходным материалом для изготовления ИМС по планарно-диффузионной технологии является слабо легированная пластина кремния p-типа, на которую методом фотолитографии наносят защитный слой SiО2 (рис. 1.2). Через окна в защитном слое производится диффузия примеси p-типа, в результате чего образуются островки, границы которых упираются снизу в защитный слой, что резко снижает возможность протекания токов утечки по поверхности. Между островками и подложкой образуется р-п-переход, к которому подключают напряжение таким образом, чтобы этот переход был заперт (т.е. минусом на р-подложке). В результате островки становятся изолированными друг от друга. 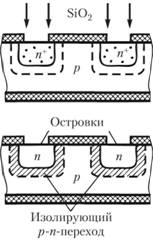 Рис. 1.2. Изготовление островков по планарнодиффузионной технологии Исходным материалом при эпитаксиально-планарной технологии служит пластина кремния n-типа со слоем SiO2 (рис. 1.3, а), в которой вытравливают продольные и поперечные канавки (рис. 1.2, б). Полученную фигурную поверхность (в виде шахматной доски) снова окисляют, создавая изоляционный слой диоксида кремния (рис. 1.3, в). На этот слой эпитаксиально наращивают слой кремния собственной проводимости (рис. 1.3, г), а верхний слой кремния n-типа сошлифовывают. Полученные таким образом островки (рис. 1.3, д) надежно изолированы друг от друга фигурным слоем диэлектрика и емкость между ними существенно меньше, чем в предыдущем случае. Однако такая технология ИМС сложнее и стоимость их изготовления выше.  Рис. 1.3. Изготовление островков по эпитаксиальнопланарной технологии В полученных тем или иным способом островках формируют как активные, так и пассивные элементы методом диффузионной технологии или эпитаксиальным наращиванием Транзисторы ИМС получают последовательной диффузией донорных и акцепторных примесей в островки, созданные тем или иным способом (рис. 1.4, а). Характерным для них является расположение выводов в одной плоскости. Для осуществления логических операций созданы многоэмиттерные транзисторы (рис. 1.4, б, в), применение которых основано на их свойстве оставаться открытыми, если хотя бы к одному из эмиттеров приложено относительно базы прямое напряжение. Запирание транзисторов происходит тогда, когда на все эмиттеры поданы обратные напряжения  Рис. 1.4. Транзисторы интегральных схем а – биполярный транзистор; б – многоэмиттерный транзистор; в – условное обозначение многоэмиттерного транзистора. Наряду с биполярными в ИМС широко применяют нолевые МДП-транзисторы, особенно МОП-транзисторы с индуцированным каналом. В основе их изготовления, так же как и биполярных, лежит планарная технология. Так, при изготовлении островков по планарно-диффузионной технологии получается практически готовая заготовка для МОП-транзистора. Каждый из двух соседних островков (см. рис. 1.20) может быть стоком или истоком этого транзистора. Поэтому для их изготовления требуется меньшее по сравнению с эпитаксиально-планарной технологией количество операций. Диоды ИМС специально не изготавливают, а в качестве их используют транзисторы, включаемые по одной из схем (рис. 1.5) в зависимости от требований, предъявляемых к диоду. Так, на рис. 1.5, а, б в качестве диода используется p-n-переход база–эмиттер. Диод открыт при указанной на рисунке полярности приложенного напряжения и закрывается при противоположной полярности. Диоды, выполненные в соответствии с рис. 1.5, а, б, обеспечивают высокое быстродействие, но малый ток. Диоды, выполненные в соответствии с рис. 1.5, в, используют два параллельных р-n-перехода и, соответственно, больший ток, но меньшее быстродействие. Диоды, в соответствии с рис. 1.5, г, д, имеют наибольшее допустимое обратное напряжение, подобно тому, как в биполярных транзисторах наибольшее напряжение может быть приложено к переходу база–коллектор.  Рис. 1.5. Варианты выполнения диодов на основе транзистора Резисторы ИМС получают диффузией примесей в отведенные для них островки одновременно с созданием эмиттерных и базовых областей транзисторов. В процессе эмиттерной диффузии создаются резисторы с относительно низким сопротивлением (так как в эмиттерной области концентрация носителей велика), а в процессе базовой диффузии – с относительно высоким сопротивлением, потому что в базовой области концентрация носителей значительно меньше. Значения диффузионных резисторов от 10 Ом до 50 кОм. На рис. 1.6 изображен резистор, сформированный в процессе базовой диффузии. 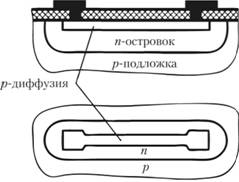 Рис. 1.6. Резистор ИМС Конденсаторы ИМС, так же как и диоды, специально не изготавливают. Для их формирования, так же как и в варикапах, используется барьерная емкость р-п-переходов, которые формируются в островках одновременно с формированием транзисторов. Возможны три варианта формирования конденсаторов. Наибольшую удельную емкость конденсатора обеспечивает использование перехода эмиттер–база (порядка 1500 пФ/мм2), однако этот p-n-переход обладает наименьшим среди всех пробивным напряжением (единицы вольт). Использование перехода коллектор–база позволяет получить конденсатор, удельная емкость которого в 5–6 раз меньше, чем у конденсатора на основе перехода база–эмиттер, а пробивное напряжение примерно во столько же раз больше. Последний вариант выполнения конденсатора заключается в использовании барьерной емкости, образуемой между подложкой кристалла и коллектором транзистора. Поскольку барьерная емкость образуется только у запертого р-n-перехода, напряжение, приложенное к обкладкам конденсатора, должно быть запирающим, т.е. обратным для p-n-перехода, емкостью которого он образован. Для защиты от воздействия внешних факторов и механических повреждений все микросхемы помещают в защитный корпус. ИМС размещаются, как правило, в монолитных корпусах с 14 или 16 выводами. Простейший и самый дешевый корпус – пластмассовый. Однако ввиду недостаточного теплоотвода в нем можно размещать лишь схемы невысокой степени интеграции с рассеиваемой мощностью до 200 мВт. Микросхемы со средней и высокой степенью интеграции из-за большого числа активных элементов рассеивают большую мощность. Для их размещения необходимы корпуса, обеспечивающие хороший теплоотвод и защищающие их от перегрева. Поэтому для микросхем средней и высокой степени интеграции используют керамический и металлокерамический корпуса. Если необходимо более интенсивное охлаждение, могут использоваться радиаторы. Плата с размещенными на ней корпусами микросхем может также обдуваться вентилятором, расположенным внутри корпуса электронного устройства. Поскольку БИС/СБИС значительно сложнее МИС и СИС, для их работы требуются гораздо большее число выводов и более сложные корпуса. Так, 16-разрядный микропроцессор Intel 8086 размещался в 40-контактном корпусе, а число контактов у микропроцессора Pentium 4 составляло уже 480. Для вывода электрических сигналов в корпусах современных СБИС используют специальные шариковые выводы, расположенные по периметру корпуса в несколько рядов. Количество контактов в таких корпусах находится в пределах от нескольких сот до двух тысяч. Причем новые модификации процессоров разрабатываются под серийно выпускаемые корпуса. Для подключения процессорных СБИС применяются специальные соединители – сокеты, к которым осуществляется механический прижим корпуса процессора. Для процессоров Sandy Bridge используется корпус и соответствующий сокет с 2011 контактами. Современные СБИС рассеивают настолько большую мощность, что для их охлаждения используются специальные охлаждающие системы – кулеры, содержащие вентилятор, радиатор с теплоносителем и систему регулирования. 2.1 Расчет распределения примеси при формировании базового слоя. Исходные данные: Акцепторная примесь – Al (алюминий); Температура процесса диффузии для акцепторной примеси – Т = 1380 К; Время диффузии для акцепторной примеси – t = 1 ч = 3600 сек; Донорная примесь – As (мышьяк); Температура процесса диффузии для донорной примеси – Т = 1420 К; Время диффузии для донорной примеси – t = 1,5 ч = 5400 сек: Формирование базового слоя проводят диффузией из ограниченного источника акцепторной примеси в соответствии с вариантом задания. На поверхность пластины наносят атомы акцепторной примеси при концентрации  , которая в процессе нагревания распределяется на определенную глубину. Поверхностная концентрация примеси, близкая к значениям предельной твердой растворимости примеси в данном полупроводниковом материале – , которая в процессе нагревания распределяется на определенную глубину. Поверхностная концентрация примеси, близкая к значениям предельной твердой растворимости примеси в данном полупроводниковом материале –  . .Эпитаксиальный слой n-типа, в который проводят диффузию, имеет концентрацию примеси –  Расчёт базового слоя Согласно графику коэффициент диффузии равен: D1=7*   Распределение примеси подчиняется закону Гаусса:  Заполним расчётную таблицу значениями глубины залегания примеси  и соответствующими им значениями экспоненциального множителя и соответствующими им значениями экспоненциального множителя  и значения функции и значения функции  . Множитель . Множитель  - остаётся неизменным и равен: - остаётся неизменным и равен: 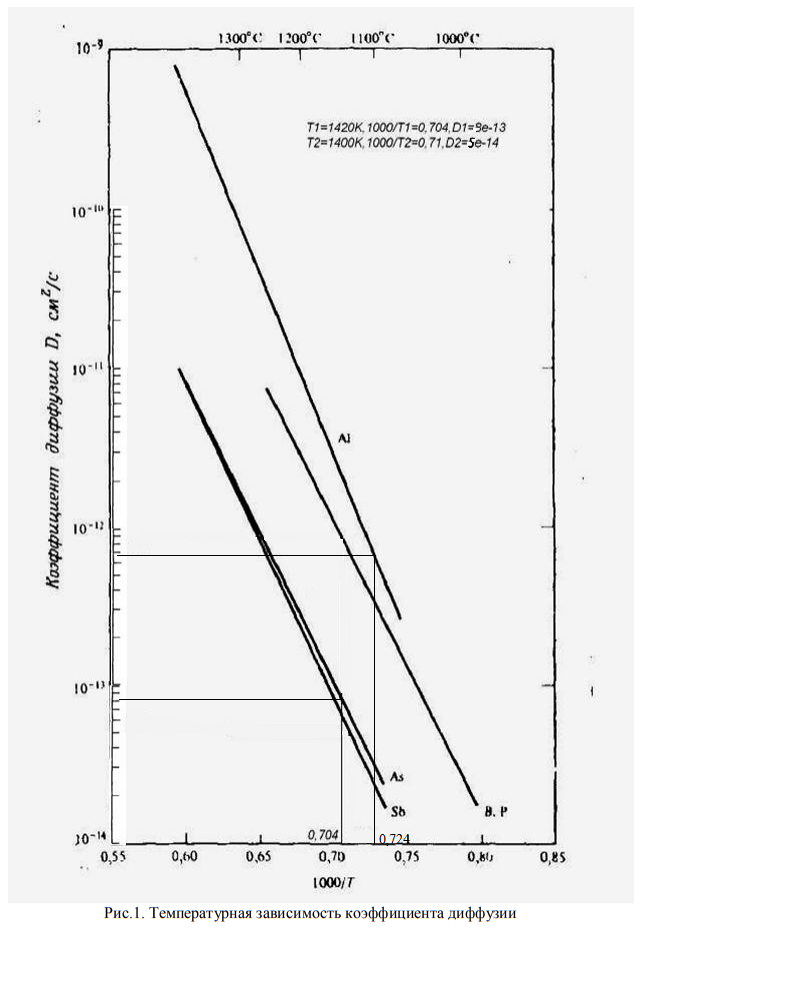 Расчёт значений концентрации акцепторной примеси 2.2 Расчёт эмиттерного слоя Согласно графику коэффициент диффузии равен: D=8*  Условия проведения диффузии донорной примеси соответствуют уравнению:  где   ; ; – дополнительная функция ошибок. – дополнительная функция ошибок.Введём расчётную таблицу значения глубины залегания примеси  , соответствующие им значения функции , соответствующие им значения функции  и значения функции и значения функции  - предварительно рассчитанные в программе Mathcad. - предварительно рассчитанные в программе Mathcad.Расчёт значений концентрации донорной примеси 2.3 Построение графиков распределения примеси в биполярном транзисторе n-p-n типа Глубина коллекторного перехода определяется расстоянием, на котором концентрация акцепторной примеси равна концентрации донорной примеси эпитаксиального слоя (  ). Глубина эмиттерного перехода определяется расстоянием, на котором концентрация донорной примеси эмиттерного слоя равна концентрации акцепторной примеси базового слоя. ). Глубина эмиттерного перехода определяется расстоянием, на котором концентрация донорной примеси эмиттерного слоя равна концентрации акцепторной примеси базового слоя.Необходимо построить совмещённый график распределения примеси  эмиттерной, базовой и коллекторной областей. эмиттерной, базовой и коллекторной областей.Совмещённый график распределения примеси в транзисторе Для определения глубины залегания эмиттерной области необходимо вычислить  –координату точки пересечения графиков распределения донорной примеси эмиттерной области и акцепторной примеси базовой области. Так же, для определения глубины залегания базовой области, следует вычислить –координату точки пересечения графиков распределения донорной примеси эмиттерной области и акцепторной примеси базовой области. Так же, для определения глубины залегания базовой области, следует вычислить  –координату точки пересечения графика распределения акцепторной примеси базовой области с уровнем концентрации донорной примеси эпитаксиального слоя (коллекторной области). –координату точки пересечения графика распределения акцепторной примеси базовой области с уровнем концентрации донорной примеси эпитаксиального слоя (коллекторной области).Найдем ширину базового слоя:  мкм мкмПостроим итоговый график концентраций примесей в каждой области транзистора. ЗАКЛЮЧЕНИЕ В ходе выполнения курсовой работы я научился выполнять расчеты распределения примесей в кремнии при диффузионном легировании. Понял основные принципы диффузионного легирования в технологии полупроводниковых интегральных микросхем (ИМС) и что это используется как основная операция получения слоев р- и n-типов электропроводности в объеме полупроводниковой пластины. Понял почему получило широкое применение диффузионного легирования это обусловлено возможностью создания легированных областей различной толщины с хорошо контролируемыми электрофизическими параметрами и малыми искажениями (дефектами) кристаллической решетки. Так же узнал что такое диффузия. Диффузией называют перенос вещества, обусловленный хаотическим тепловым движением атомов, возникающий вследствие наличия градиента концентрации данного вещества и направленный в сторону убывания этой концентрации в той среде, где происходит диффузия. Выполнил расчет базового и эмиттерного слоя, определил глубину залегания и ширину базы. Построил необходимые графики. Список используемой литературы Марголин, В. И. Физические основы микроэлектроники : учеб. для вузов по специальности "Проектирование и технология радиоэлектрон. средств" направления "Проектирование и технология электрон. средств" / В. И. Марголин, В. А. Жабрев, В. А. Тупик . - М.: Академия, 2008. - 398 с. Математическое моделирование технологических процессов. В.А. Никоненко. Практикум. –М: МИСиС, 2001. – 48с. Основы микроэлектроники: Учебное пособие для вузов / Н.А.Аваев, Ю.Е. Наумов, В.Т. Фролкин.- М.:Радио и связь, 1991. Степаненко И.П. Основы микроэлектроники : [Учеб. пособие для вузов] / Игорь Павлович Степаненко. - 2-е изд. . - М.: Лаб. базовых знаний, 2005. - 488 с. : a-ил. - (Технический университет) Технология материалов микро- и наноэлектроники / Л.В. Кожитов [и др.] . - М.: МИСИС, 2007. - 542 с. |
