Реферат1. Реферат з курсу Методи дослідження органічних наноструктур на тему
 Скачать 0.62 Mb. Скачать 0.62 Mb.
|
1-3 МеВ, розсіяних в зворотньому напрямку по відношенню до досліджуваного зразка.Міністерство освіти та науки України Національний університет «Львівська політехніка» ІТРЕ Кафедра ЕП  Реферат З курсу „Методи дослідження органічних наноструктур” на тему: „Методи та засоби дослідження оптичних властивостей тонких плівок ” Виконав: Ст.гр. ЕЛ – 41 Прийма М.С. Перевірив: Костів Н.В. Львів 2016 Зміст Вступ……………………………………………………......………......................3 1.Етапи розвитку досліджень структури і властивостей поверхонь плівок.……………………………………………………………………………..4 2. Метод дослідження тонких плівок методом еліпсометрії………………….5 3. Метод дослідження спектрофотометрієй………………………….……..….8 4. Скануюча електронна мікроскопія……………………………………………9 5. Спектроскопія Резерфордовского зворотного розсіювання………………..10 Список використаної літератури………………………………………..…...…12 Вступ Тонка плівка являє собою шар матеріалу в діапазоні від часток нанометра (моношар) до декількох мікрометрів товщиною. Керований синтез матеріалів у вигляді тонких плівок (процес, званий відкладення) є важливим кроком у багатьох додатках. Відомим прикладом є побутової дзеркало, яке, як правило, має тонке металеве покриття на зворотному боці скла для формування відображає ізобаженія. Процес сріблення був колись звичайним для виробництва дзеркал, в той час як останнім часом металевий шар осідає з використанням методів, таких як напилювання. Прогрес в області тонких методів осадження плівок в 20 - му столітті відкрили широкий спектр технологічних проривів в таких областях, як магнітні носії запису, електронні напівпровідникові прилади світлодіоди, оптичних покриттів (просвітлення оптики), твердих покрить на різальний інструмент, і виробництво енергії (наприклад, тонкоплівкових сонячних елементів), зберігання (тонкоплівкові батареї). Воно також застосовується до лікарських засобів, за допомогою тонкоплівкової доставки ліків.[1] На додаток до їх прикладного інтересу, тонкі плівки грають важливу роль в розвитку і вивченні матеріалів з новими і унікальними властивостями. Приклади включають мультіферроікі і сверхрешітки, які дозволяють вивчати квантове утримання шляхом створення двовимірних електронних станів.
Поверхневі шари реального твердого тіла мають складну будову і в найпростішому випадку можуть бути надані наступною схемою (рис.1.1)  Рис.1.Будова поверхневого шару твердого тіла Таким чином, поверхня реального тіла слід розглядати як багатошарову систему. Міжфазні шари в композиційних матеріалах мають більш складну будову і, як правило, визначають їх фізико-хімічні властивості. В історії вивчення властивостей поверхні умовно виділяють три основних етапи: Перший етап - вивчення поверхні реальних тіл; Основний висновок етапу - властивості поверхні визначається адсорбованими шарами, структурою і складом знаходиться на ній оксидного покриття. Другий етап - дослідження атомарному чистих поверхонь, отримання яких стало можливим, головним чином, завдяки розвитку вакуумній техніці. На практиці атомарно чисті поверхні отримують за допомогою таких основних методів: 1) розкол кристалів у вакуумі; 2) нанесення в високому вакуумі тонкого шару на підкладку. У ряді випадків використовують спеціальні методи очищення, наприклад: 1) іонну або електронно-променеве травлення в вакуумі або захисній середовищі; 2) нагрівання до високих температур в захисному середовищі або високому вакуумі. Однак травлення або нагрів можуть викликати зміну кристалічної структури поверхневих шарів, і при цьому нагрів навіть до досить високих температур не дозволяє повністю видалити хемосорбування шару. Основні результати другого етапу: - Встановлено, що атомарному чисті поверхні - особливі об'єкти, що мають специфічну будову і властивості; - Визначені фундаментальні характеристики структури, поверхневих електронних і фононних станів; На поверхні утворюються поверхневі фонони і поверхневі екситон, що отримали назву сурфонов. - Закінчено формування уявлень про поверхневих шарах чистих матеріалів, як шарах з особливими фізичними властивостями. Екситони - квазічастинки, які можна розглядати як самоузгоджені переміщаються електрони і дірки. Третій етап - (початок - 50-60-ті роки) характеризується інтенсифікацією досліджень міжфазних шарів багатошарових систем в композитах, їх змін при різних зовнішніх впливах. В даний час завдяки появі та розвитку великого числа методів фізико-хімічного аналізу особливо активно вивчаються поверхні розділу в композиційних матеріалах. Наприклад, досить докладно вивчена структура систем Si-SiO2.В зокрема, встановлено утворення проміжних шарів змінного складу SiOx. Успіхи сучасного матеріалознавства в значній мірі визначені результатами досліджень цих міжфазних шарів.
Еліпсометрія - високочутливий і точний поляризаційно-оптичний метод дослідження поверхонь і кордонів розділу різних середовищ (твердих, рідких, газоподібних), заснований на вивченні зміни стану поляризації світла після взаємодії його з поверхнею кордонів розділу цих середовищ. Термін «еліпсометрія» запропонував в 1944 р. Ротен, оскільки мова йде про вивчення еліптичної поляризації, що виникає в загальному випадку при накладенні взаємно перпендикулярних коливань, на які завжди можна розкласти поле світлової хвилі відносно площини її падіння. Хоча зазначені зміни можна спостерігати як у відбитому, так і в світлі, що проходить, в даний час в переважній кількості робіт вивчається поляризація відбитого світла.[2]  Рис. 2. Эллипсометр Horiba Uvisel в лаборатории университета LAAS в Тулузе. Еліпсометрія - сукупність методів вивчення поверхонь рідких і твердих тіл станом поляризації світлового пучка, відбитого цією поверхнею і переломленого на ній. Падаючий на поверхню монохроматичний плоскополярізованний луч набуває при відображенні і ламанні еліптичну поляризацію внаслідок наявності тонкого перехідного шару на межі розділу середовищ. Залежність між оптичними постійними шару і параметрами еліптично поляризованого світла встановлюється на підставі формул Френеля. На принципах еліпсометрії побудовані методи чутливих безконтактних досліджень поверхні рідини або твердих речовин, процесів абсорбції, корозії та ін. 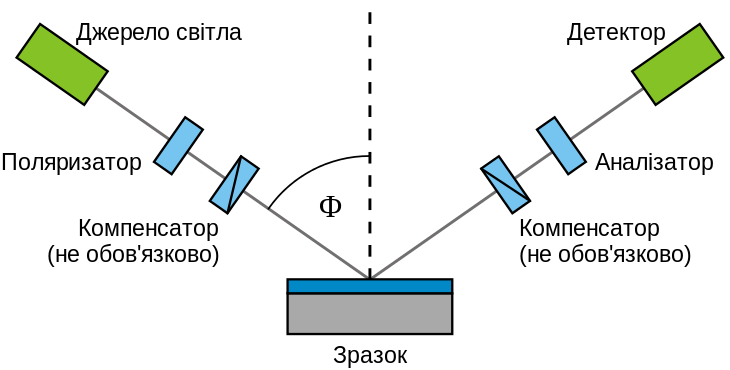 Рис. 3. Принцип дії еліпсометра Прилади, засновані на методі еліпсометрії, - спектральні еліпсометри (або спектроелліпсометри). Як джерело світла в них використовуються лампи різних типів (для дослідження в різних ділянках спектра), світлодіоди, а також лазери. Крім того існує прилад на світлодіодах - світлодіодна спектральна еліпсометрія, який також, як лазерний, дає можливість досліджувати не тільки мікро-, а й нанорозмірні неоднорідності на поверхні досліджуваного об'єкта. Світлодіодні джерела світла мають ряд переваг перед традиційними ламповими, це: - Високе відношення сигнал / шум сигналу на виході; - Висока надійність і економічність; - Відсутність необхідності використання світлофільтрів для виділення частини спектра; - Малі габарити і низька собівартість; До переваг спектральних еліпсометрія з класичними ламповим джерелом світла можна віднести: - Висока яскравість джерела (типова потужність до 150 Вт, в окремих випадках до 1 квт); - Широкий робочий спектральний діапазон - від далекого УФ до середнього ІК; Дані особливості дозволяють проводити аналіз багатошарових покриттів з товщиною плівок від декількох ангстрем до десятків мікрометрів.
Спектрофотометрія – сукупність методів визначення кількісних характеристик монохроматичного випромінювання. Спектральна фотометрія дає методи отримання спектрів випромінювання, відбивання, пропускання, поглинання і розсіювання. Вони виражаються графічними залежностями розподілення відповідних величин за довжинами хвиль або частотами випромінювання. Спектрофотометрія (абсорбційна) — фізико-хімічний метод досліджень розчинів і твердих речовин, оснований на вивченні спектрів поглинання в ультрафіолетовій (200—400 нм), видимій (400—760 нм) та інфрачервоній (>760 нм) областях спектра. Основна залежність, що вивчається у спектрофотометрії — залежність інтенсивності поглинання падаючого світла від довжини хвилі. Випромінювання розкладається в спектр призмою або дифракційною ґраткою. За допомогою діафрагми-щілини зі спектра виділяється вузький монохроматичний пучок, який подається на приймач. Знаючи залежність між потужністю випромінювання і реакцією приймача, будують графік залежності (напр. світлового потоку від довжини хвилі), який і характеризує спектр випромінювання.[3] При вимірюванні спектра поглинання чи пропускання перед приймачем розміщують зразок, спектр якого вимірюють. Спектр відбивання одержують порівнюючи характеристики монохроматичного випромінювання, відбитого від поверхні зразка і еталону. Спектрофотометр СФ - 46 працює на основі вимірювання відносини двох світлових потоків: потоку проходячого через досліджуваний зразок, і потоку, що падає на досліджуваний зразок (або що пройшов через контрольний зразок). З освітлювача світловий пучок потрапляє, через вхідну щілину, в монохроматор і розкладається в спектр дифракційної гаткою. Далі в монохроматичний потік випромінювання, що надходить з вихідної щілини в кюветне відділення, куди по черзі вводяться досліджувані зразки. Пройшло через зразок випромінювання потрапляє на катод чутливого фотоелемента в приймально-підсилюваючому блоці. Електричний струм в анодному ланцюзі фотоелемента, створює падіння напруги на резисторі Rн, пропорційне потоку випромінювання, який падає на фотокатод. Передача сигналів на вхід вольтметра забезпечується підсилювачем постійного струму, і значення напруги висвічується на цифровому табло вольтметра. Для того щоб спектрофотометр міг працювати в широкому спектральному діапазоні в нього вбудовані два джерела випромінювання суцільного спектра і два фотоелементи. Сурм'яно-цезієвий фотоелемент має вікно з кварцового скла, і використовується для вимірювань в області спектра 190 - 700 нм, а киснево-цезієвого фотоелемент - для вимірювань в області спектра 600 - 1100 нм. Довжина хвилі, при якій необхідно переходити від вимірювань з одним фотоелементом до вимірювань з іншим, вказана в паспорті спектрофотометра або визначається експериментально (для даного приладу - 642 нм). Дейтерієва лампа використовується в області спектра від 190 до 350 нм, лампа розжарювання - для роботи в області спектра від 340 до 1100 нм. Для перевірки і калібрування монохроматора використовується ртутно-гелієва лампа. [3] Вимірювання значення коефіцієнта відбиття R досліджуваних зразків проводилося за допомогою спеціальної приставки на спектрофотометрі СФ-46 в порівнянні з коефіцієнтом відображення алюмінієвого дзеркала, залежність коефіцієнта відбиття від довжини хвилі для якого була виміряна незалежно.
Скануюча електронна мікроскопія - різновид електронної мікроскопії, в якій для зондування досліджуваної поверхні використовується сканування по ній сфокусованого пучка електронів. Для формування зображення використовується детектування різних сигналів, включаючи вторинні електрони, назад розсіяні електрони, рентгенівське випромінювання і струм через зразок. Двовимірна карта знімаємого сигналу і являє собою зображення поверхні. У скануючому електронному мікроскопі пучок електронів з первинною енергією |
