эпитаксия. Содержание введение 3 Основная часть 415 Заключение 16 Список использованных источников 17 введение
 Скачать 0.55 Mb. Скачать 0.55 Mb.
|
|
СОДЕРЖАНИЕ Введение 3 Основная часть 4-15 Заключение 16 Список использованных источников 17 ВВЕДЕНИЕ Электроника по праву считается основой современного этапа научно-технического прогресса. Используемые во всех сферах деятельности общества приборы, датчики, накопители и преобразователи информации, вычислительные системы, создаваемые в микроэлектронике на основе полупроводниковых материалов, обеспечивают выполнение требований, предъявляемых современной экономикой по быстродействию, габаритам и потребляемой мощности. Причем требования к воспроизводимости и оптимизации технологических процессов в микроэлектронике превосходят аналогичные требования в других отраслях промышленности. Одной из основных проблем, активно разрабатываемых в ряде научных центров как отечественных, так и зарубежных, является проблема использования процессов самоорганизации в создании квантовых нитей и квантовых точек. Последние экспериментальные исследования показали, что структура ступеней поверхности может быть использована для создания системы квантовых нитей, а образование островков в гетероэпитаксиальных слоях - квантовых точек. Однако, без знания закономерностей формирования и эволюции структур в условиях протекания процессов самоорганизации на поверхности полупроводниковых кристаллов невозможно решение такого центрального вопроса, как целенаправленное и контролируемое использование фундаментальных пределов технологических методов наноэлектроники. При осаждении одного материала на подложку из другого материала возможно три варианта формирования поверхностных структур. Они показаны на рис. 1. Это — послойный (двумерный) рост сплошной пленки в режиме, называемом модой Франка - Ван дер Мерве, образование и рост островков (трехмерный рост) - мода Волмера - Вебера и комбинированный режим - мода Странского - Крастанова, когда пленка сначала растет послойно, а затем трансформируется в островковую структуру. Режим (мода) формирования поверхностных структур определяется рассогласованием параметров решеток подложки и наносимого материала, а также соотношением между поверхностной энергией и энергией границы раздела этих материалов. Важно отметить, что все энергетические аргументы справедливы лишь для равновесного состояния системы. Формирование же эпитаксиальных пленок происходит в условиях, отличающихся от равновесных, что затрудняет анализ этого процесса и интерпретацию результатов по одним лишь энергетическим критериям. Кинетические эффекты, контролируемые температурой подложки и скоростью осаждения материала, существенно влияют на режим формирования поверхностных структур. 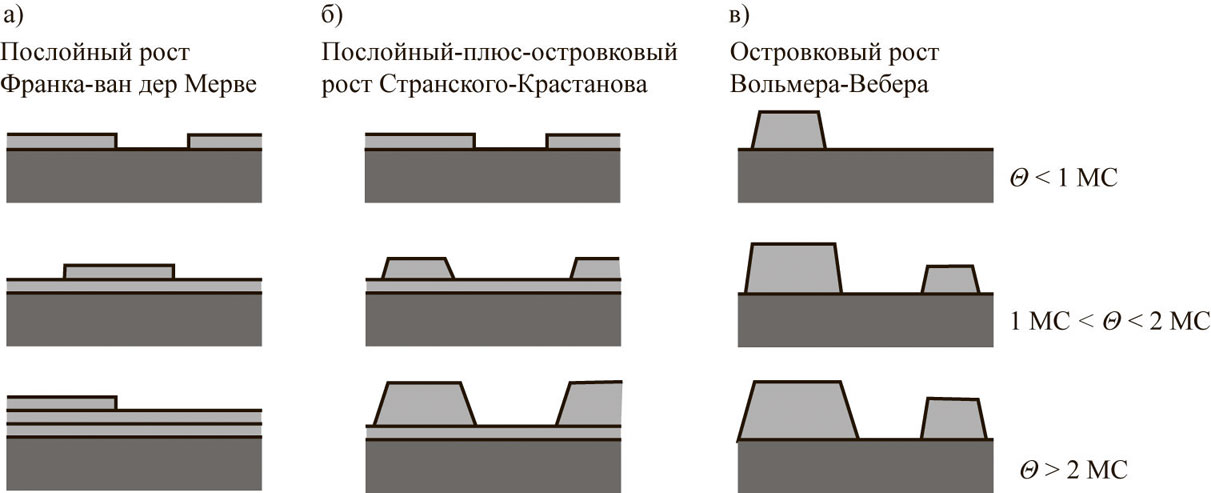 Рис. 1. Режимы роста тонких пленок Режим (мода) формирования поверхностных структур определяется рассогласованием параметров решеток подложки и наносимого материала, а также соотношением поверхностной энергии и энергии границы раздела этих материалов. Важно отметить, что все энергетические аргументы справедливы для равновесного состояния системы. Формирование же эпитаксиальных пленок происходит в условиях, отличающихся от равновесных, что затрудняет их анализ и интерпретацию по энергетическим критериям. Кинетические эффекты, контролируемые температурой подложки и скоростью осаждения материала, существенно влияют на режим формирования поверхностных структур. Тем не менее, энергетические соображения, рассматриваемые ранее, полезны для многих практических случаев, поскольку, по крайней мере, предсказывают поведение различных систем в равновесных и квазиравновесных условиях. В системе, образованной материалами с согласованными параметрами решеток, режим роста определяется только соотношением поверхностной энергии и энергии границы раздела. Если сумма поверхностной энергии эпитаксиальной пленки и энергии границы раздела меньше, чем поверхностная энергия подложки (осаждаемый материал смачивает подложку), наблюдается послойный рост пленки в режиме Франка-Ван-дер-Мерве. При этом формируются однородные когерентные псевдоморфные и напряженные сверхрешетки. Этот режим пригоден также для создания самоорганизующихся квантовых шнуров на вицинальных поверхностях кристаллов. Вицинальными называют поверхности, которые не являются равновесными для данного кристалла (теорема Вульфа). Обычно это поверхности, слегка разориентированные относительно низкоиндексных плоскостей кристалла – на практике чаще всего используют разориентацию относительно (001) и (311) плоскостей. Эпитаксиальное осаждение в режиме Странского-Крастанова успешно используется для изготовления квантовых точек с размерами 2-40 нм из полупроводников  , ,  , SiGe, Ge. Они могут быть достаточно однородны по размеру. В них нет дислокаций несоответствия, поскольку благодаря трехмерной релаксации напряжений в окрестностях островка его высота может превышать критическую для псевдоморфного роста толщину. Разработано несколько методов задания областей зарождения островков с нанометровым разрешением. Эти методы основаны на эпитаксиальном осаждении в окна маски, созданной путем электронно-лучевой или зондовой литографии. , SiGe, Ge. Они могут быть достаточно однородны по размеру. В них нет дислокаций несоответствия, поскольку благодаря трехмерной релаксации напряжений в окрестностях островка его высота может превышать критическую для псевдоморфного роста толщину. Разработано несколько методов задания областей зарождения островков с нанометровым разрешением. Эти методы основаны на эпитаксиальном осаждении в окна маски, созданной путем электронно-лучевой или зондовой литографии.Предложены также и безмасочные методы контролируемого создания центров зарождения островков зондом сканирующего туннельного или атомного силового микроскопа. Один из них, использующийся для формирования квантовых точек из InAs, проиллюстрирован на рис. 2. 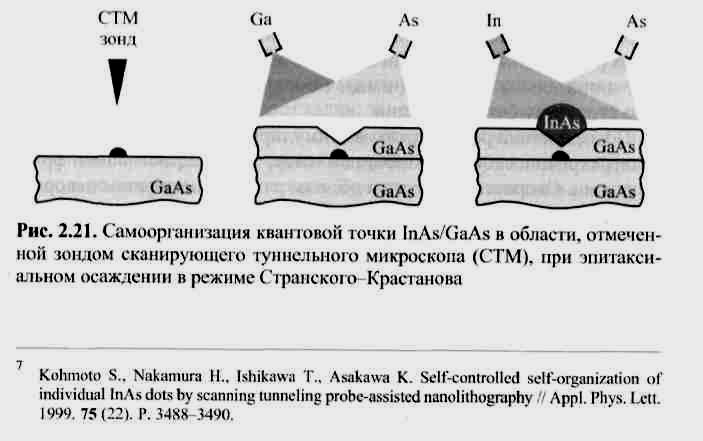 Рис. 2. Самоорганизация квантовой точки InAs/GaAs в области, отмеченной зондом сканирующего туннельного микроскопа (СТМ), при эпитаксиальном осаждении в режиме Странского-Крастанова Сначала материал с острия вольфрамового зонда наносится на поверхность подложки GaAs путем подачи на зонд нескольких импульсов напряжения. Сканируя зонд вдоль поверхности подложки, наноразмерные образования создают в местах желательного расположения квантовых точек. Нанесенный материал должен быть стабилен в парах мышьяка при температурах до 610 °С, поскольку он играет роль наномаски при последующем эпитаксиальном осаждении GaAs. На начальных этапах эпитаксии GaAs сформированные ранее наноостровки остаются непокрытыми, однако по мере увеличения толщины осажденного слоя GaAs они постепенно закрываются за счет бокового роста над островком, в результате чего образуются пирамидальные впадины. Затем проводят эпитаксиальное осаждение InAs. Зарождение и рост самоорга-низующихся островков InAs происходит исключительно в этих впадинах. На рис. 4.3 представлено СТМ-изображение сформированной таким образом наноструктуры. 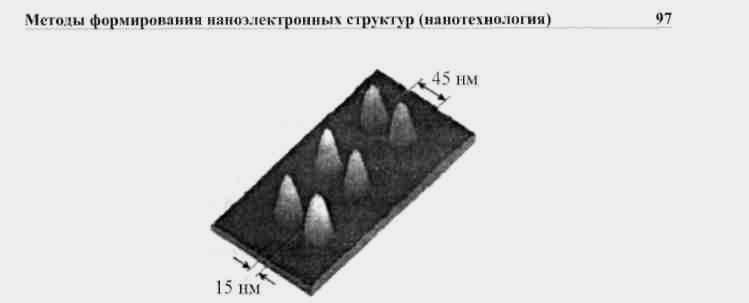 Рис. 3. Полученное в сканирующем туннельном микроскопе изображение квантовых точек из InAs на GaAs, приготовленных путем самоорганизации. Каждая точка имеет высоту 6 нм и диаметр основания 30 нм Повторение операций осаждения GaAs и InAs позволяет создавать многослойные структуры с квантовыми точками из InAs, встроенными в GaAs. Квантовые точки в таких структурах располагаются строго друг над другом в местах, обозначенных предварительным нанесением маскирующего материала с зонда. Рассмотрим основные этапы формирования методом самосборки встроенных квантовых шнуров с использованием вицинальной поверхности кристалла (рис. 4). 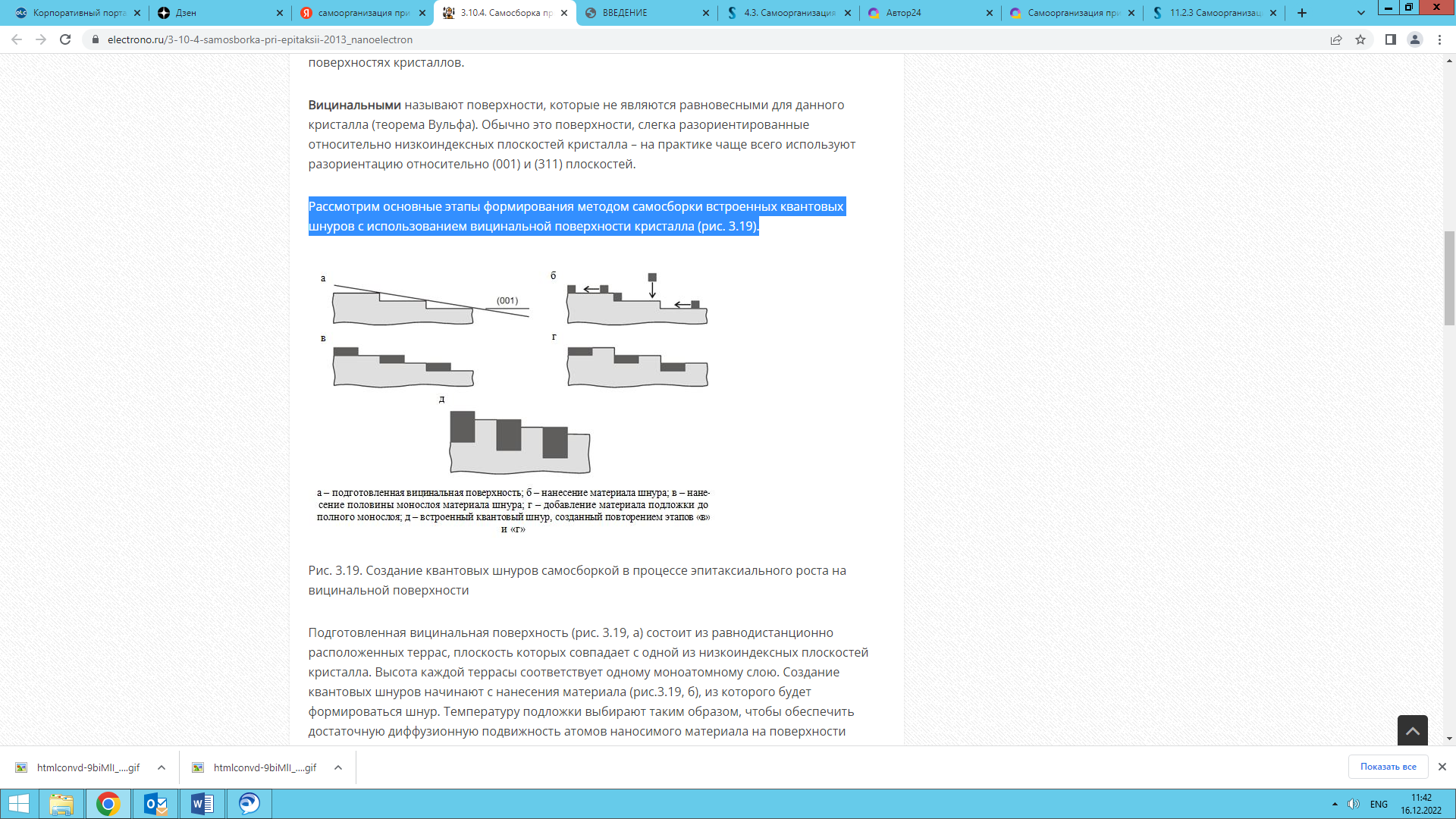 Рис. 4. Создание квантовых шнуров самосборкой в процессе эпитаксиального роста на вицинальной поверхности Подготовленная вицинальная поверхность (рис. 4, а) состоит из равнодистанционно расположенных террас, плоскость которых совпадает с одной из низкоиндексных плоскостей кристалла. Высота каждой террасы соответствует одному моноатомному слою. Создание квантовых шнуров начинают с нанесения материала (рис. 4, б), из которого будет формироваться шнур. Температуру подложки выбирают таким образом, чтобы обеспечить достаточную диффузионную подвижность атомов наносимого материала на поверхности подложки. Осажденным атомам энергетически более выгодно прикрепляться к ступеньке террасы, нежели находиться на ее поверхности. Количество наносимого материала составляет лишь долю от той величины, которая необходима для покрытия подложки сплошным моноатомным слоем. Это необходимо для того, чтобы оставить место на террасе для заполнения материалом подложки, что и делается после прекращения подачи материала шнура (рис. 4, г). Нанесение материала подложки продолжают до полного восстановления террас, которые при этом становятся на один моноатомный слой толще. Нанесение материала шнура, а затем подложки повторяют несколько раз, обеспечивая, таким образом, создание квантового шнура, встроенного в подложку. Основной проблемой в практической реализации представленного подхода является волнообразный характер границ террас, что приводит к таким же волнообразным шнурам. Чтобы получить строго линейные шнуры, поверхность искусственно профилируют канавками, вдоль которых и происходит самоорганизованный рост (сборка) квантовых шнуров. Однородные напряженные эпитаксиальные пленки начинают расти послойно, даже когда имеется рассогласование решеток наносимого материала и подложки. Накопление энергии в напряженном состоянии по мере увеличения толщины пленки неизбежно ведет к образованию островков, что понижает общую энергию в системе. Такие превращения происходят при эпитаксии в режиме Странского-Крастанова. При этом образуются самособирающиеся нанокристаллические эпитакисальные островки на монокристаллической подложке. Переход от двухмерного послойного роста сплошной пленки к трехмерному росту островков (2D→3D переход) происходит, когда межатомные расстояния в кристаллической решетке осаждаемого материала больше, чем в решетке подложки. Островковая структура энергетически более благоприятна для релаксации напряжений, нежели слоистая. Релаксация напряжений в двухмерном слое может осуществляться только в направлении, перпендикулярном плоскости этого слоя. В островковой структуре напряжения имеют возможность релаксировать как в самом островке, так и вокруг него. 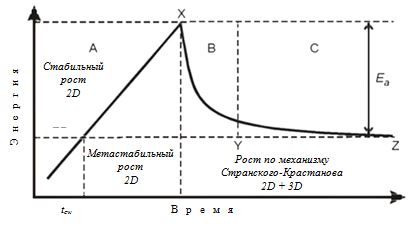 Рис. 5. Изменение во времени полной энергии эпитаксиальной структуры, растущей в режиме Странского-Крастанова Рассмотрим поведение общей энергии системы, образуемой рассогласованными кристаллическими решетками, в зависимости от продолжительности нанесения материала, полагая, что скорость нанесения материала мала для проявления динамических эффектов (рис. 5). Материал, подвергающийся сжатию на подложке, наносится с постоянной скоростью вплоть до момента времени X. Различимы три основных периода (А, В и С). В начальный период А послойным ростом формируется двухмерная эпитаксиальная пленка. Поверхность подложки идеально смочена наносимым материалом. Упругие напряжения линейно возрастают с увеличением объема нанесенного материала. В момент времени tcw смачивающий слой достигает критической толщины, когда послойный рост становится метастабильным. При дальнейшем поступлении материала создаются суперкритические условия, в которых все еще сплошной эпитаксиальный слой готов к разрыву и переходу в режим роста трехмерных островков по механизму Странского-Крастанова. Временной диапазон существования метастабильного состояния определяется высотой энергетического барьера для этого перехода Еа. Период В, представляющий 2D→3D-переход, т.е. фрагментацию суперкритического смачивающего слоя, начинается, когда накопленной упругой энергии становится достаточно для преодоления энергетического барьера этого перехода в момент времени X. Предполагается, что, уже начавшись, 2D→3D-переход может продолжаться без дальнейшего поступления материала, при этом используется материал, запасенный в суперкритическом смачивающем слое. Период В включает две стадии – зарождение островков и их последующий рост. Флуктуации толщины пленки или напряжений по поверхности подложки приводят к зарождению островков в определенных местах. 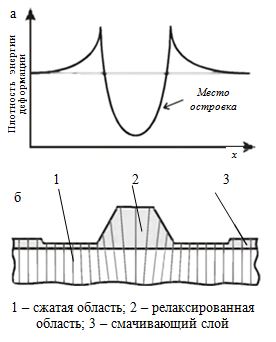 Рис. 6. Локальные напряжения на границе с подложкой (а) и деформациярешетки вкогерентном островке (б) Толщина смачивающего слоя, при которой начинается спонтанное зарождение островков, зависит от рассогласования параметров решеток материалов, а также от наносимого материала и от анизотропии свойств подложки. Например, при эпитаксии германия на монокристаллическом кремнии это происходит, когда толщина германия превышает несколько монослоев. Для контролируемого расположения островков в определенных местах подложки ее подвергают предварительной обработке для создания на ее поверхности неоднородностей, служащих центрами зарождения. Стадия зарождения определяет поверхностную плотность островков. Образование первого сверхкритического зародыша немедленно приводит к фрагментации всего смачивающего слоя. Предполагаемое распределение напряжений в окрестности островка показано на рис. 6. Поверхность островка благоприятна для понижения напряжений, максимальная величина которых – у границы с подложкой. Благодаря релаксации напряжений в объеме островка, на поверхности они минимальны. Островок имеет монокристаллическую напряженную бездислокационную структуру. Наногофрированные структуры Метод молекулярно-лучевой эпитаксии открывает новые возможности создания квантово-размерных структур, туннельно связанных структур. Рассмотрим процесс создания туннельно связанных периодических 3D-наноструктур, которые могут рассматриваться как латеральные молекулы из квантовых точек. Основой процесса является использование напряженных пленок, выращенных с помощью молекулярной эпитаксии, а также процессы самоорганизации, происходящие при отсоединении от подложки сжатых пленок. Упрощенную последовательность формирования выпуклой InAs плен-ки, освобожденной от связи с InP-подложкой в локальной области длиной L, схематично иллюстрирует рис. 11.2.11. 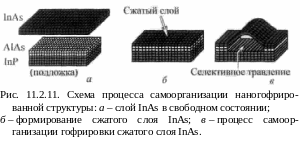 Исходная сжатая пленка при ее освобождении упруго релаксирует, увеличивая свою длину, и выпучивается с амплитудой А, которая зависит от длины и несоответствия постоянных решеток Δа/а:  где Δа/а = 5%. Размеры слоя InAs превышают размеры подложки InP вследствие большего размера постоянной решетки. При создании гетеросттуры InAs/AlAs/InP формируется сжатый слой InAs. При селективном травлении такой сэндвич-структуры происходит выпучивание, или гофрировка слоя InAs в результате упругой релаксации. При этом слой InAs частично освобождается от подложки. Методом самоорганизации при эпитаксиальном росте с последующим травлением жертвенных слоев созданы периодически гофрированные нано-структуры на основе сверхтонких напряженных полупроводниковых пленок и гетеропленок (InAs, InGaAs/GaAs, SiGe/Si). Для достижения прецизионности вводятся ограничения на амплитуду гофрировок. Для этого на этапе молекулярной эпитаксии в структуру дополнительно водятся расположенные выше и ниже на заданном расстоянии от напряженного слоя ненапряженные слои, которые и ограничивают период и амплитуду (рис. 11.2.12). 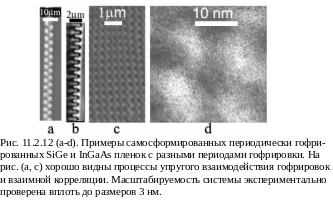 Поскольку молекулярная эпитаксия позволяет задавать толщину эпитаксиальных слоев, а следовательно, и расстояние между слоями, с атомарной точностью, то получаемые вышеописанным способом гофрировки будут иметь прецизионные амплитуду и период. Гофрированная пленка — это периодически расположенные локально изогнутые области. При изгибе внешние слои пленки растягиваются, внутренние сжимаются, что существенно изменяет ширину запрещенной зоны в данных областях. Оценить возникающую деформацию ε и изменение ширины запрещенной зоны ΔЕ можно, исходя из простых геометрических соображений. Деформация изогнутой пленки с радиусом изгиба R равна разности длин внешней и внутренней окружностей.  При этом в тонких пленках деформация может достигать 10%, такая гигантская деформация существенно изменяет ширину запрещенной зоны в месте изгиба, создавая квантовую яму. Действительно, изменения ширины запрещенной зоны ΔЕ (в простейшем случае) связаны с деформацией ε и величиной деформационного потенциала D соотношением ΔЕ = εD. Оценка ΔЕ в ультратонких пленках дает величину до ≈ 1 эВ, т. е. имеющиеся в гофрированных структурах упругие деформации вызывают сдвиги краев зон и приводят к появлению системы потенциальных ям. Как показали расчеты, при периодах гофрировки ниже 100 нм электронные состояния локализованы в отдельных ямах. При уменьшении периода система может рассматриваться как система взаимодействующих квантовых точек. Энергетическое положение уровней изменяется при изменении толщины и периода гофрировки. ЗАКЛЮЧЕНИЕ При осаждении одного материала на подложку из другого материала возможно три варианта формирования поверхностных структур: 1) послойный рост сплошной пленки (двухмерный рост) в режиме, называемом модой Франка-Ван-дер-Мерве (Frank-van der Merwe); 2) образование и рост островков (трехмерный рост) – мода Волмера-Вебера (Volmer-Weber); 3) комбинированный режим – мода Странского-Крастанова (Stranski-Krastanov), когда изначально пленка растет послойно, а затем трансформируется в островковую структуру. Независимо от вида эпитаксии, наращивание тонких слоёв на поверхность подложки имеет такие преимущества: - Применяется в различных сферах деятельности для улучшения физических качеств основного материала. - Эпитаксию можно наносить локально. - Проводимость наращиваемой плёнки можно изменять до нужных параметров, дополняя вещество различными примесями. - Выполнять покрытие объекта можно, независимо от его размера, объёма, формы. - Покрытие полностью повторяет контур исходного кристалла и может заполнять имеющиеся на его поверхности дефекты. Кроме того, нанесение тонкого слоя, отличающегося от самого слитка на его поверхность, позволяет снизить концентрацию углерода и кислорода. Из-за чего повышается устойчивость объекта к повреждениям, и снижается количество дефектов. СПИСОК ИСПОЛЬЗОВАННЫХ ИСТОЧНИКОВ Борисенко В.Е. «Наноэлектроника» // М., 2013, С. 366; Данилина Т.И.,. Чистоедова И.А «Оборудование для создания и исследования свойств объектов наноэлектроники» // Томск, 2011, С. 156; Киреев В.Ю. «Нанотехнологии в микроэлектронике. Нанолитография: процессы и оборудование» // М., 2016, С. 148; Кирчанов В.С. «Наноматериалы и нанотехнологии» // Пермь, 2016, С 200; Рембеза С.И. «Низкоразмерные структуры для микро- и наноэлектроники» // Воронеж, 2015, С. 115. |
