КР Микроэлектроника. Курсовая. Введение Интегральный биполярный транзистор
 Скачать 0.81 Mb. Скачать 0.81 Mb.
|
|
Содержание Введение………………………………………………………………………....3 Интегральный биполярный транзистор………………………………….....4 Расчёт распределения примеси в кремнии после диффузионного легирования при создании биполярного n-p-n-транзистора……………...8 Расчёт базового слоя…………………………………………………..8 Расчёт эмиттерного слоя……………………………………………...10 Построение графиков распределения примеси в биполярном транзисторе n-p-n-типа……………………………………………………………………..13 Заключение…………………………………………………………………..15 Список использованных источников……………………………………….16 Введение Электроника – это область науки, техники и производства, охватывающая исследование и разработку электронных приборов и принципов их использования. Микроэлектроника – это раздел электроники, охватывающий исследования и разработку качественно нового типа электронных приборов – интегральных микросхем – и принципов их применения. Интегральная микросхема (или просто интегральная схема - ИС) – совокупность большого количества взаимосвязанных компонентов (транзисторов, диодов, конденсаторов, резисторов…), изготовленная в едином технологическом цикле, на одной и той же несущей конструкции – подложке, и выполняющая определённую функцию преобразования информации. К таким полупроводниковым структурам относятся контакты металл-полупроводник, электронно-дырочные переходы, структуры металл-диэлектрик-полупроводник (МДП). ИС, являющиеся элементной базой микроэлектроники, предназначены для реализации подавляющего большинства аппаратурных функций. Их элементы, аналогичные обычным радиодеталям и приборам, выполнены и объединены внутри или на поверхности общей подложки, электрически соединены между собой и заключены в общий корпус. Термин «интегральная схема» (ИС) отражает факт интеграции отдельных компонентов схемы и конструктивно единый прибор, а также факт усложнения выполняемых этим прибором функций по сравнению с функциями дискретных компонентов. Компоненты ИС не могут быть выделены в качестве самостоятельных элементов. Основной задачей микроэлектроники является комплексная микроминиатюризация электронной аппаратуры – вычислительной техники, аппаратуры связи, устройств автоматики. На определённых этапах становится невозможно решать новые задачи старыми методами, например, с помощью электронных ламп, дискретных транзисторов. Решением этой проблемы служит микроэлектроника, основные критерии которой – это массогабаритные характеристики, надёжность, стоимость, мощность. В микроэлектронике, в целях упрощения и ускорения технологического процесса, применяется групповой метод производства, где, на одной пластине полупроводникового материала изготавливается сразу большое количество ИС. И, если позволяет технологический процесс, то одновременно обрабатываются десятки таких пластин. В последние годы линейные размеры элементов микроэлектроники приблизились к единицам и десятым долям микрометра (100нм). Также имеет место применение структур с размерами менее 100нм. 1 Интегральный биполярный транзистор Биполярный транзистор – это полупроводниковая структура, состоящая из двух последовательных p-n-переходов. Существует два основных типа биполярных транзисторов, различных по структуре: p-n-p-структура и n-p-n-структура. Интегральные биполярные транзисторы изготавливаются по планарной или планарно-эпитаксиальной технологии. Методом диффузии в кристалле создаются области коллектора, базы и эмиттера (рис. 1.1). На рисунке транзистор показан в разрезе и в плане. Структура транзистора углубляется в кристалл не более чем на 15 мкм, а линейные размеры транзистора на поверхности не превышают нескольких десятков микрометров. 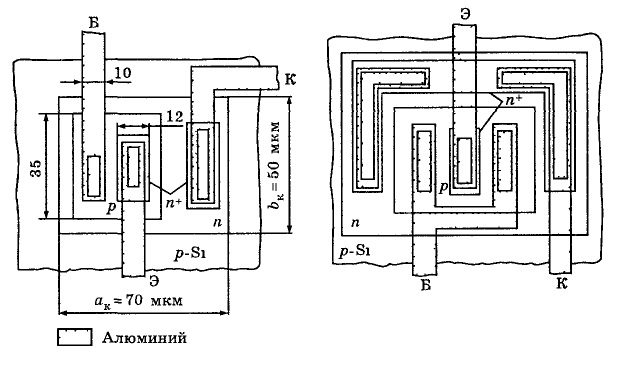 Рисунок 1.1 – Структура интегрального биполярного транзистора Как правило, изготовляются транзисторы типа n-p-n. Внутренний (скрытый) слой с повышенной концентрацией примесей n+ в коллекторе служит для уменьшения сопротивления и, следовательно, потерь мощности в области коллектора. Но у коллекторного перехода область коллектора должна иметь пониженную концентрацию примесей, чтобы переход имел большую толщину. Тогда емкость у него будет меньше, а напряжение пробоя выше. Область эмиттера также часто делают типа n+ для уменьшения сопротивления и увеличения инжекции. Сверху на транзисторе создается защитный слой оксида SiО2. От областей коллектора и базы часто делают по два вывода, для того чтобы можно было соединить данный транзистор с соседними элементами без пересечений соединительных линий. Такие пересечения весьма нежелательны, так как они значительно усложняют производство. Действительно, в месте пересечения на нижнюю соединительную линию надо нанести диэлектрическую пленку, а поверх нее нанести верхнюю соединительную линию, т. е. надо сделать две лишние технологические операции. Кроме того, место пересечения всегда представляет опасность в отношении пробоя от случайных перенапряжений. Типичные параметры биполярных транзисторов полупроводниковых ИС таковы: коэффициент усиления тока базы 200, граничная частота до 500 МГц, емкость коллектора до 0,5 пФ, пробивное напряжение для коллекторного перехода до 50 В, для эмиттерного до 8 В. Удельное сопротивление n - и p -слоев составляет несколько сотен, а n+-слоев - не более 20 Ом/см. Необходимо обратить внимание на то, что в полупроводниковых ИС всегда образуются некоторые паразитные элементы. Например, из рис. 4.9 видно, что наряду с транзистором типа n-p-n созданным в кристалле типа р, существует паразитный транзистор p-n-p, который образуется кристаллом, областью коллектора и областью базы транзистора. А транзистор n-p-n вместе с кристаллом образует паразитный тиристор n-p-n-p. Вследствие наличия обратного напряжения на изолирующем переходе паразитные транзисторы и тиристор нормально заперты, но при попадании в них каких-либо импульсов помех, может произойти нежелательное отпирание и срабатывание этих элементов. 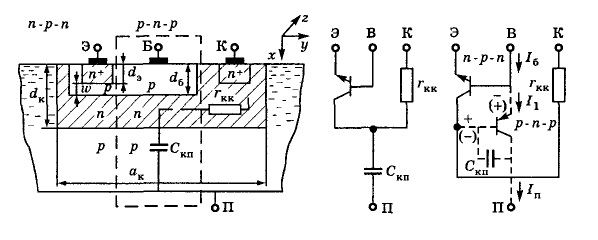 Рисунок 1.2 – Структура биполярного n-p-n-транзистора с выделенным паразитным p-n-p-транзистором С целью создания диодных и транзисторных структур применяется диффузионное легирование полупроводниковой пластины при высоких температурах. Так же имеет место иной способ легирования – ионная имплантация. Диффузия может быть общей – когда она осуществляется по всей поверхности пластины, и локальной – в определённых участках, через окна маски. 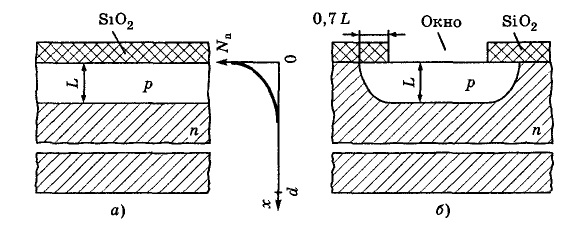 Рисунок 1.3 – Общая (а) и локальная (б) диффузия примесей в кремний При общей диффузии происходит неоднородное распределение примеси по глубине  (рис. 1.3а). В случае локальной диффузии, примесь распространяется не только в глубь, но в перпендикулярных направлениях, т.е. под маску (рис. 1.3б). (рис. 1.3а). В случае локальной диффузии, примесь распространяется не только в глубь, но в перпендикулярных направлениях, т.е. под маску (рис. 1.3б).Диффузию можно производить многократно. Например, в пластину n-типа во время первой стадии внедрить слой p-типа, а во время второй стадии – в полученный слой p-типа внедрить донорную примесь, но уже на меньшую глубину. Тем самым получится 3-х слойная структура. Также следует иметь в виду, что концентрация каждой новой вводимой примеси должна превышать концентрацию предыдущей. В  недрение примесей обычно производят с помощью газотранспортных систем, например, в однозонных, либо двухзонных диффузионных печах (рис. 1.4). недрение примесей обычно производят с помощью газотранспортных систем, например, в однозонных, либо двухзонных диффузионных печах (рис. 1.4).Рисунок 1.4 – Схема двухзонной диффузионной печи Двухзонные печи используются в случае твёрдых диффузантов. В таких печах имеются 2 высокотемпературные зоны (рис. 1.4): одна – для испарения диффузанта, вторая – для диффузии. Пары диффузанта, полученные в первой зоне, примешиваются к потоку нейтрального газа-носителя и поступают во вторую зону с пластинами. Во второй зоне температура выше чем в первой, здесь атомы диффузанта внедряются в пластины кремния, а другие составляющие химического соединения уносятся газом-носителем из зоны. В случае жидких или газообразных диффузантов нет необходимости в их высокотемпературном испарении, поэтому используются однозонные печи, в которые источник диффузанта поступает уже в газообразном состоянии. Теория диффузии основана на двух законах Фика. 1-ый закон Фика связывает плотность потока частиц с градиентом их концентрации:  где  - коэффициент диффузии, - коэффициент диффузии,  - концентрация. - концентрация.2-ой закон Фика характеризует скорость накопления частиц:  Решая уравнение (1.2) при условии неограниченного источника примеси – когда примесь непрерывно поступает к пластине, можно получить функцию распределения примеси  : : где  – дополнительная функция ошибок, близкая к экспоненциальной функции – дополнительная функция ошибок, близкая к экспоненциальной функции  , ,  – приповерхностная концентрация примеси, – приповерхностная концентрация примеси,  – время протекания процесса, – время протекания процесса,  – глубина. – глубина.При условии ограниченного источника примеси – когда в поверхностный слой вводят некоторое количество атомов диффузанта, после чего источник диффузии отключают и атомы примеси перераспределяются по глубине пластины при неизменном их общем количестве, мы получим так называемую функцию Гаусса.:  где  - количество атомов примеси на единицу площади. - количество атомов примеси на единицу площади.2 Расчёт распределения примеси в кремнии после диффузионного легирования при создании биполярного n-p-n-транзистора Исходные данные: Акцепторная примесь – В (бор); Температура процесса диффузии для акцепторной примеси – Т = 1400 К; Время диффузии для акцепторной примеси – t = 2 ч = 7200 сек; Донорная примесь – Р (фосфор); Температура процесса диффузии для донорной примеси – Т = 1350 К; Время диффузии для донорной примеси – t = 2.2 ч = 7920 сек; Формирование базового слоя проводят диффузией из ограниченного источника примеси. На поверхность пластины наносятся атомы акцепторной примеси с концентрацией –  . . Формирование эмиттерного слоя проводят диффузией из бесконечного источника донорной примеси. Поверхностная концентрация примеси, близкая к значениям предельной твердой растворимости примеси в данном полупроводниковом материале –  . .Эпитаксиальный слой n-типа, в который проводят диффузию, имеет концентрацию примеси –  . .2.1 Расчёт базового слоя С помощью закона Аррениуса для температурной зависимости коэффициента диффузии найдём коэффициент диффузии акцепторной примеси:  где  – коэффициент, зависящий от рода полупроводника и диффундирующей примеси; – коэффициент, зависящий от рода полупроводника и диффундирующей примеси;  – энергия активации процесса диффузии – энергия активации процесса диффузии  ; ;  – постоянная Больцмана; – постоянная Больцмана;  – абсолютная температура процесса диффузии, – абсолютная температура процесса диффузии,  . .Согласно справочной литературе, для диффузии атомов бора в кремнии – коэффициент  , энергия активации процесса , энергия активации процесса   . Тогда: . Тогда:  Рисунок 2.1.1 – График температурной зависимости коэффициента диффузии бора Распределение примеси подчиняется закону Гаусса (1.4):  Введём в расчётную таблицу 2.1.1 значения глубины залегания примеси  , соответствующие им значения экспоненциального множителя , соответствующие им значения экспоненциального множителя  и значения функции и значения функции  . Множитель . Множитель  - остаётся неизменным и равен: - остаётся неизменным и равен: Таблица 2.1.1 – Расчёт значений концентрации акцепторной примеси
 Рисунок 2.1.2 – График примесного профиля базовой области 2.2 Расчёт эмиттерного слоя С помощью закона Аррениуса (2.1) для температурной зависимости коэффициента диффузии найдём коэффициент диффузии донорной примеси. Согласно справочной литературе, для диффузии атомов фосфора в кремнии – коэффициент  , энергия активации процесса , энергия активации процесса   . Тогда: . Тогда:  Рисунок 2.2.1 – График температурной зависимости коэффициента диффузии фосфора Условия проведения диффузии донорной примеси соответствуют уравнению (1.3):  Введём в расчётную таблицу 2.2.1 значения глубины залегания примеси  , соответствующие им значения функции , соответствующие им значения функции  и значения функции и значения функции  - предварительно рассчитанные в программе Mathcad. - предварительно рассчитанные в программе Mathcad.Таблица 2.2.1 - Расчёт значений концентрации донорной примеси
 Рисунок 2.2.2 – График примесного профиля эмиттерной области Файл Mathcad – расчёт функции  : : 3 Построение графиков распределения примеси в биполярном транзисторе n-p-n-типа Глубина коллекторного перехода определяется расстоянием, на котором концентрация акцепторной примеси равна концентрации донорной примеси эпитаксиального слоя (  ). Глубина эмиттерного перехода определяется расстоянием, на котором концентрация донорной примеси эмиттерного слоя равна концентрации акцепторной примеси базового слоя. ). Глубина эмиттерного перехода определяется расстоянием, на котором концентрация донорной примеси эмиттерного слоя равна концентрации акцепторной примеси базового слоя.Построим совмещённый график распределения примеси  эмиттерной, базовой и коллекторной областей. эмиттерной, базовой и коллекторной областей.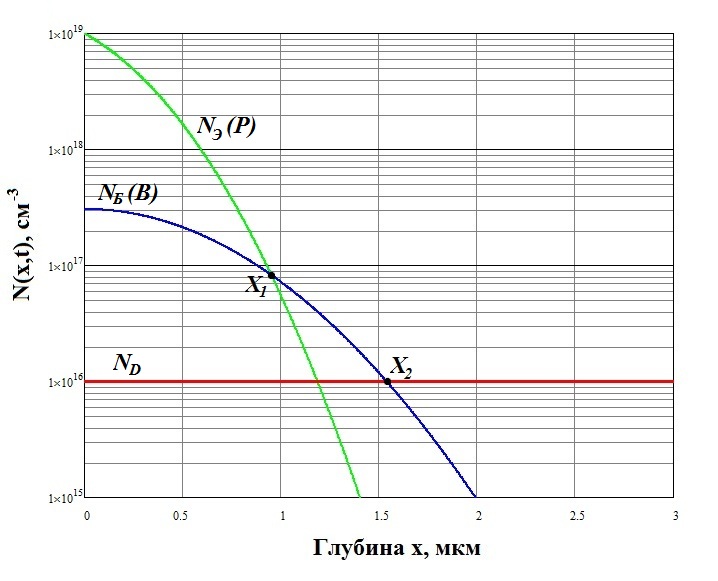 Рисунок 3.1 – Совмещённый график распределения примеси в транзисторе Для определения глубины залегания эмиттерной области необходимо вычислить  –координату точки пересечения графиков распределения донорной примеси эмиттерной области и акцепторной примеси базовой области. Так же, для определения глубины залегания базовой области, следует вычислить –координату точки пересечения графиков распределения донорной примеси эмиттерной области и акцепторной примеси базовой области. Так же, для определения глубины залегания базовой области, следует вычислить  –координату точки пересечения графика распределения акцепторной примеси базовой области с уровнем концентрации донорной примеси эпитаксиального слоя (коллекторной области). Для этого воспользуемся программой Mathcad. –координату точки пересечения графика распределения акцепторной примеси базовой области с уровнем концентрации донорной примеси эпитаксиального слоя (коллекторной области). Для этого воспользуемся программой Mathcad.Файл Mathcad – расчёт точек пересечения графиков:  Глубина залегания эмиттерной области:  мкм. В этой точке концентрация донорной примеси эмиттерной области равна концентрации акцепторной примеси базовой области: мкм. В этой точке концентрация донорной примеси эмиттерной области равна концентрации акцепторной примеси базовой области:  Глубина залегания базовой области:  мкм. В этой точке концентрация акцепторной примеси базовой области равна концентрации донорной примеси эпитаксиального слоя: мкм. В этой точке концентрация акцепторной примеси базовой области равна концентрации донорной примеси эпитаксиального слоя: Отсюда ширина базового слоя:  мкм мкмПостроим итоговый график концентраций примесей в каждой области транзистора. 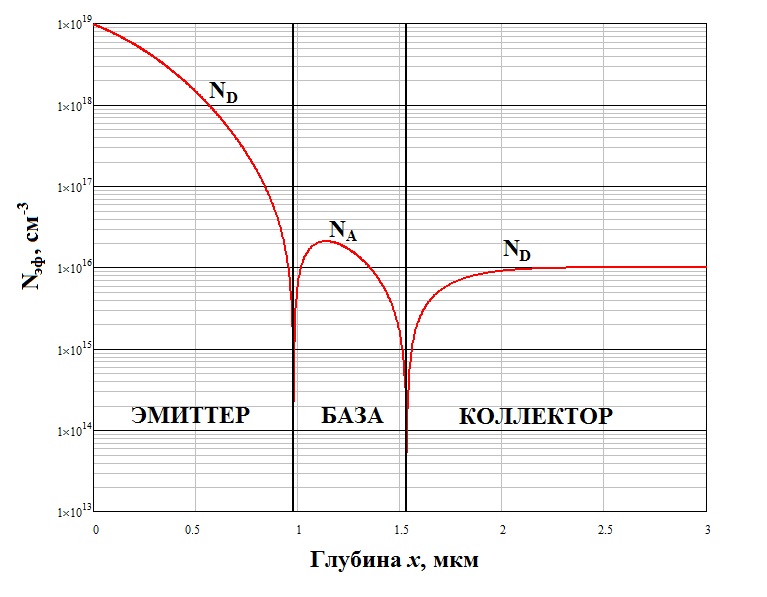 Рисунок 3.2 – График распределения эффективных концентраций примесей в биполярном n-p-n транзисторе Заключение В ходе выполнения данной работы были изучены технологические процессы моделирования микроэлектронных устройств, изучены методики расчета параметров интегрального биполярного транзистора. При расчётах были применены основные законы диффузии и рассмотрены зависимости параметров полученных компонентов от условий технологического процесса их формирования. Также приобретены навыки информативного представления расчётных данных, а также получены навыки работы с компьютерным ПО автоматизированного проектирования и математических расчётов. Список использованных источников Степаненко И.П. Основы микроэлектроники: Учебное пособие для вузов.- 2 изд., перераб. И доп.-М.:Лаборатория базовых знаний, 2001.-488 с. Основы микроэлектроники: Учебное пособие для вузов / Н.А.Аваев, Ю.Е. Наумов, В.Т. Фролкин.- М.:Радио и связь, 1991.-288 с. Коэффициенты диффузии и энергии активации бора и фосфора взяты из источника: В.А. Никоненко. Математическое моделирование технологических процессов. Практикум. –М: МИСиС, 2001. –48с. |

































































