Лабораторная работа 7 Определение характеристик структуры металлполупроводник вольтфарадным методом Авторы доцент Анфалова Е. С
 Скачать 1.6 Mb. Скачать 1.6 Mb.
|
|
ГОСКОМИТЕТ РОССИЙСКОЙ ФЕДЕРАЦИИ ПО ВЫСШЕМУ ОБРАЗОВАНИЮ МОСКОВСКИЙ ОРДЕНА ТРУДОВОГО КРАСНОГО ЗНАМЕНИ ИНСТИТУТ ЭЛЕКТРОННОЙ ТЕХНИКИ (ТЕХНИЧЕСКИЙ УНИВЕРСИТЕТ) "УТВЕРЖДАЮ" Зав.кафедрой КФН _____________ Горбацевич .А.А “___"_________ 2009 г. Лабораторная работа № 7 Определение характеристик структуры металл-полупроводник вольтфарадным методом Авторы: доцент Анфалова Е.С Ст.преподаватель Бурзин С.Б. Ведущий инженер Михалин В.В МОСКВА 2009 г Физика твердого тела и полупроводников Лабораторная работа № 7 Определение характеристик структуры металл-полупроводник вольтфарадным методом Вольтфарадный (C-V) метод широко используется для измерения электрофизических параметров структур металл-диэлектрик-полупроводник (МДП), диодов Шоттки, резких р-n переходов. Метод основан на измерении емкости приповерхностной области полупроводника в зависимости от приложенного напряжения, обедняющего приповерхностный слой полупроводника основными носителями. В настоящей работе измеряются C-V характеристики диодов Шоттки в структуре металл-полупроводник на основе арсенида галлия. 1. Контакт металл-полупроводник. 1.1. Образование контакта металл-полупроводник Рассмотрим свойства идеального контакта металл-полупроводник. Предположим, что полупроводник не вырожден, на границе между полупроводником и металлом отсутствуют поверхностные состояния (ПС), полупроводник однородно легирован донорной примесью с концентрацией ND и вся примесь ионизирована, последовательным сопротивлением подложки можно пренебречь. Термодинамическая (или внутренняя) работа выхода электрона из твердого тела S - это разница между энергией электрона в вакууме E0 и энергией Ферми в твердом теле FS. Внешняя работа выхода (или электронное сродство) – это разность между энергией электрона в вакууме и энергией дна зоны проводимости ЕС. (рис.1(а)). Термодинамическая работа выхода электрона из полупроводника определяется следующим соотношением.
где eVn = ЕC - FS - разность между энергией дна зоны проводимости ЕC и уровнем Ферми FS полупроводника. Сродство к электрону - это внутреннее свойство полупроводника, оно не изменяется при образовании контакта с металлом. Обозначим работу выхода из металла M. Если M>S, то при контакте металла и полупроводника часть электронов из полупроводника перейдет в металл, и на границе раздела образуется потенциальный барьер еB (рис.1(6)), который называют барьером Шоттки, а структуру металл-полупроводник с таким барьером - диодом Шоттки. При установлении термодинамического равновесия уровни Ферми в металле и полупроводнике совпадают, поэтому
Величина VB=(M - S)/e - контактная разность потенциалов. Из (2) следует, что
Величина потенциального барьера зависит лишь от природы материалов контакта. На рис.1(б) представлена энергетическая диаграмма барьера Шоттки при термодинамическом равновесии, то есть когда внешнее напряжение отсутствует (U=0). Энергетические диаграммы потенциального барьера при прямом (U>0) и обратном (U<0) смещениях на металлическом электроде изображены на рис.1(в) и 1(г), соответственно.  1.2. Область пространственного заряда При наличии потенциального барьера еB приповерхностная область полупроводника n-типа проводимости толщиной w обеднена электронами и заряжена положительно. Эта область называется областью пространственного заряда (ОПЗ). Потенциал V(x) в ОПЗ отрицателен и определяется уравнением Пуассона.
где - диэлектрическая проницаемость полупроводника, 0 - диэлектрическая постоянная, е=1.6∙10-19 Кл – абсолютное значение заряда электрона, ND - концентрация донорной примеси в полупроводнике; n(х) - концентрация свободных электронов в ОПЗ. Полупроводник однородно легирован, тогда n0=ND, где n0 - концентрация электронов в нейтральном объеме полупроводника. Для невырожденного полупроводника можно записать.
Тогда уравнение Пуассона (4) можно представить в следующем виде.
Будем искать решение, удовлетворяющее граничным условиям.
Уравнение (6) удобно проинтегрировать по переменной V. Для этого умножим обе части уравнения на 2(dV/dx) и, используя тождество
представим уравнение (6) в следующем виде.
Проинтегрируем (7) и найдем
где A - постоянная интегрирования. Из граничных условий (6а) следует, что
Для потенциального барьера на границе (х=0) всегда выполняется условие
Разделяя переменные x и V в (9) и интегрируя, получим
где x0 - постоянная интегрирования, которую определим из (10) с помощью граничного условия V(0)=VB.
Возведя обе части выражения (10) в квадрат и учитывая (11), получим
где тепловой потенциал Пренебрегая величиной теплового потенциала T по сравнению с VB, запишем зависимость потенциала V от координаты х в ОПЗ следующим образом.
Из (11 6) найдем толщину w области пространственного заряда, на границе которой V(w)=0.
Если к структуре приложить внешнее напряжение U>0, то высота потенциального барьера со стороны полупроводника уменьшится, основные носители подтянутся к контакту, и толщина ОПЗ, согласно (11в), также уменьшится (рис.1(в)).
При обратном смещении U<0 ширина ОПЗ увеличивается (рис.1(г)). Величина потенциального барьера eVB снижается еще и за счет положительного заряда, индуцируемого полем электронов в ОПЗ полупроводника. Расчет методом "сил зеркального изображения" дает для величины понижения барьера е следующую величину.
где Е(0) – напряженность электрического поля на поверхности полупроводника. Величина в S1 и GaAs мала. Так, в поле Е(0)1*105 В/см она не превышает нескольких сотых вольта. В полях же, близких к пробивным (1*106 В/см), может составлять десятые доли вольта. 1.3. Емкость области пространственного заряда Вычислим поверхностную плотность заряда в ОПЗ полупроводника QSC.
С помощью (9) вычислим производную
Поверхностная плотность заряда ОПЗ является нелинейной функцией приложенного потенциала. Введем удельную дифференциальную емкость Csc(U).
Получена формула для емкости плоского конденсатора, у которого расстояние между обкладками обратно пропорционально U1/2. Очевидно, что величина
На рис.2 представлены вольтфарадная характеристика контакта C=f(U) и характеристика C-2=f(U).  Учитывая, что измеряемая емкость контакта C является произведением удельной емкости Csc на площадь барьерного электрода, то есть C= Csc·S, можно записать следующее выражение концентрации легирующей примеси ND.
Прямая С-2=f(U) пересекает ось напряжений в точке Ui=VB, Определив экспериментально Ui,с помощью формул (2) и (3), можно выразить через нее высоту потенциального барьера на границе металл-полупроводник.
В формуле (18) учтено уменьшение высоты потенциального барьера Δφ за счет учета сил изображения. Величина Vn определяется уровнем легирования полупроводника. Если полупроводник не вырожден, легирован однородно и вся примесь ионизирована, то для Vn справедливо следующее соотношение.
Если ND не постоянна, то зависимость С-2=f(U) не линейна, и формулы (17) и (17а) нельзя использовать для всех точек ОПЗ. В этом случае не линейная зависимость С-2=f(U) используется для численного дифференцирования, в результате которого рассчитывается профиль распределения электрически активной примеси в приповерхностном слое полупроводника ND(x). 1.4. Влияние поверхностных состояний В реальных структурах металл-полупроводник соотношение (3), как правило, не выполняется, так как на поверхности полупроводника или в тонкой диэлектрической прослойке, часто присутствующей между металлом и полупроводником, обычно имеются локальные электронные состояния, называемые поверхностными состояниями (ПС). Е  сли плотность ПС достаточно велика, то реализуется ситуация соответствующая равновесию между поверхностными состояниями и состояниями в объеме полупроводника при отсутствии термодинамического равновесия между полупроводником и металлом. В этом случае все поверхностные состояния, расположенные ниже уровня Ферми, заполнены. Когда контакт металла и полупроводника приходит в термодинамическое равновесие, уровень Ферми полупроводника понижается относительно уровня Ферми металла на величину, равную контактной разности потенциалов, в результате чего в зазоре между металлом и полупроводником возникает электрическое поле. сли плотность ПС достаточно велика, то реализуется ситуация соответствующая равновесию между поверхностными состояниями и состояниями в объеме полупроводника при отсутствии термодинамического равновесия между полупроводником и металлом. В этом случае все поверхностные состояния, расположенные ниже уровня Ферми, заполнены. Когда контакт металла и полупроводника приходит в термодинамическое равновесие, уровень Ферми полупроводника понижается относительно уровня Ферми металла на величину, равную контактной разности потенциалов, в результате чего в зазоре между металлом и полупроводником возникает электрическое поле. Если поверхностные состояния принимают весь дополнительный положительный заряд, возникающий по мере уменьшения толщины зазора между металлом и полупроводником, без заметного сдвига уровня Ферми, то величина объемного заряда в полупроводнике остается прежней. То есть в этом случае высота потенциального барьера определяется только свойствами поверхности полупроводника и не зависит от работы выхода металла. Величина потенциального барьера еB в общем случае определяется не только разностью работ выхода, но, в основном, плотностью заряда поверхностных состояний на границе металл-полупроводник (рис.3). Тогда вместо формулы (3) для величины барьера справедливо следующее соотношение.
где eφ0 – разность между уровнем Ферми и потолком валентной зоны. По известной плотности поверхностных состояний на единицу интервала энергии – GS можно найти плотность их заряда QSS, которая и будет определять величину потенциального барьера на поверхности.
Для Si, GaAs и GaP величина eφ0 составляет обычно около 0.3 эВ, а плотность поверхностных состояний GS = (2 – 10)*1013 эВ-1 см-2. В общем случае высота потенциального барьера зависит и от работы выхода металла и от плотности поверхностных состояний. 1.5. Ограничения вольтфарадного метода Выражение (14) для емкости барьера Шоттки справедливо для режима обеднения ОПЗ. При достаточно малом изгибе зон условие При комнатной температуре минимальный потенциал на границе х=0 равен Vmin=0.13 В. Предельному значению Vmin соответствует минимальная толщина ОПЗ wmin.
только за пределами которой можно определить ND(x) по формуле (17) с погрешностью не более 5%. Из выражений (11 а) - (11 в) следует, что граница между ОПЗ и нейтральным объемом не является в действительности резкой, степень ее размытости характеризуется длиной Дебая
Длиной LD, поэтому, определяется точность пространственного разрешения профиля легирования. В кремнии wmin обычно составляет величину порядка удвоенной длины Дебая. Так при ND = 1015 см-3 длина Дебая LD=0.13 мкм. Толщины мелкозалегающих слоев, создаваемых при ионном легировании, могут оказаться сравнимыми с LD, что исключает возможность определения профиля ND(x) вблизи поверхности с помощью измерения вольтфарадной характеристики диода Шоттки. Максимальная толщина ОПЗ, на которой возможно определение концентрации примеси методом вольтфарадной характеристики, ограничена явлением электрического пробоя ОПЗ. Отметим, что высокая точность измерения емкости барьерного контакта достигается при условии, что токи утечки через барьер пренебрежимо малы. Токи утечки возрастают с увеличением уровня легирования полупроводника, поэтому верхний предел измерения концентрации примеси с помощью вольфарадных характеристик диода Шоттки не превышает 5*1017 – 1*1018 см-3. Эквивалентная схема диода Шоттки на основе арсенида галлия представлена на рис.4.  Использованы следующие обозначения: С – дифференциальная емкость барьерного контакта, RB - дифференциальное сопротивление барьерного контакта, RS - сопротивление объема полупроводника. Сопротивление объема полупроводника RS, включенное последовательно с емкостью барьера, должно быть мало по сравнению с емкостным сопротивлением барьера. Чтобы измеряемая емкость соответствовала емкости барьера, необходимо выполнение условий RS «1/ωС«RB. 1.6. Погрешность измерений Вычисление концентрации легирующей примеси требует проведения численного дифференцирования экспериментальной зависимости C-2=f(V). Случайная погрешность определения ND складывается из погрешностей измерения величин, входящих в (17). Погрешность в определении напряжения на контакте при использовании цифро-аналогового преобразователя очень мала, и ее можно не учитывать. Определение емкости измерителем Е7-12 производится с погрешностью не более 1%. Опыт показывает, что погрешность в определении концентрации легирующей примеси составляет около 5%. 2. Экспериментальная часть 2.1. Измерительная установка В настоящей работе измерение зависящей от напряжения емкости контакта металл-полупроводник проводят на макете автоматизированной установки измерения вольтфарадных характеристик (ВФХ) полупроводниковых структур. Этот макет позволяет измерять высокочастотных ВФХ структур с барьером Шоттки в заданных областях на пластине; осуществлять сбор и хранение полученных данных и представление полученной информации в графическом и цифровом виде. Блок-схема макета автоматизированной установки представлена на рис.5. 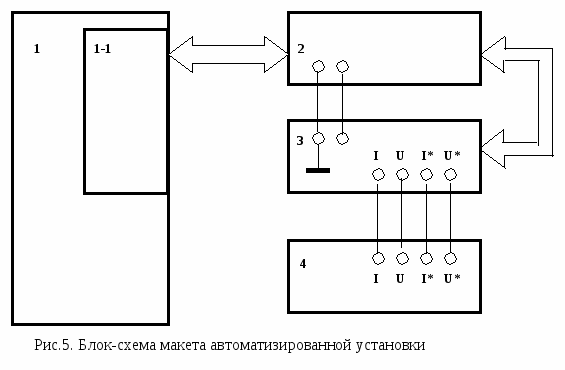 В состав макета автоматизированной установки входят следующие блоки.
Измерение ВФХ производится на переменном токе частотой 1 МГц и амплитудой 30 мВ. 2.2. Образец для измерений В качестве объекта измерений служит часть пластины или целая полупроводниковая пластина (GaAs или Si) с барьерными контактами металл-полупроводник, созданными на монокристаллической подложке или эпитаксиальном слое n-типа проводимости, выращенном на высоколегированной подложке того же типа проводимости. Материал подложки, площадь и материал затвора (металлического электрода) сообщаются отдельно. Контакт к подложке осуществляется с ее обратной стороны при помощи контактного стола, контакт к затвору – при помощи зонда устройства зондового. В настоящей работе в качестве образца может быть использована часть пластины (n-n+ эпитаксиальной структуры GaAs), которая посредством расплавленного индия закреплена на носителе – низкоомной пластине кремния n-типа проводимости с удельным сопротивлением 0.01 Ом·см, служащей носителем для исследуемого образца. Поперечное сечение структуры с барьером Шоттки схематично представлено на рис.6.  2.3. Подготовка к проведению измерений После составления конспекта описания получите у преподавателя допуск к работе. Проверьте соединение блоков установки по схеме коммутации (рис. 5). Проверьте, что органы управления на лицевой панели измерителя Е7-12 находятся в следующих исходных положениях.
Проверьте, что переключатели в правой части задней панели измерителя Е7-12 находятся в следующих положениях:
Интерфейсный кабель должен быть подключен к разъему КОП в правой части задней панели измерителя Е7-12. Проверьте, что переключатель СМЕЩЕНИЕ в левой части задней панели измерителя Е7-12 находится в положении ВНЕШ. (вверх). Провода от внешнего программируемого источника напряжения должны быть подключены в два левых гнезда ±200 V. max КОНТРОЛЬ. Включите входящие в состав установки блоки в следующей последовательности.
Установите пластину с измеряемыми диодами с барьером Шоттки на контактный стол. При помощи микроскопа найдите на пластине диод с барьером Шоттки и расположите конец зонда над его затвором. Откройте кран вакуумной присоски. 2.3. Проведение измерений Запустите на исполнение прикладную измерительную программу измерения ВФХ и расчета параметров контактов с барьером Шоттки. Она запускается ярлыком “CV_Sch”. Путь к этому ярлыку: Рабочий стол \ папка «Лаб.работы» \ папка «ФТТ и ПП». После загрузки программы на экране видеомонитора появляется главное меню первого уровня (рис.7).  Главное меню служит для выбора одной из четырех опций, которым соответствуют четыре меню первого уровня.
Кнопка «Выход» в каждом меню первого уровня предназначена для выхода из программы измерений. 2.3.1. Проведение реальных измерений, опция «Измерения». Откройте опцию «Измерения» меню первого уровня, а в ней пункт «Ввод» (рис.8).  Щелкните левой кнопкой мыши по пункту меню первого уровня «Ввод». На экране видеомонитора появится окно, содержащее меню опции «Ввод условий измерения» (рис.9), в котором надо произвести необходимые изменения.  В окне ввода условий измерения вводится справочная информация (номер группы, фамилия измерителя, номер образца), температура окружающей среды в [в oC], начальное и конечное напряжения и шаг по напряжению в [В], при которых производится измерения ВФХ, площадь затвора в [см2], выбираются материалы подложки (n-кремний или n-арсенид галлия) и затвора (Al или V). После изменения данных в окне ввода условий измерения нажмите кнопку «OK» и выйдите в главное меню. Снова откройте опцию «Измерение» меню первого уровня, а в ней пункт «Измерение». На экране видеомонитора появится окно индикации измерений емкости, в верхней половине которого расположены следующие указания измерительной программы.
В нижней половине этого окна отображается значение емкости между контактами зондового устройства (либо между зондом и столом, либо между первым и вторым зондами). Если зонд не контактирует с металлическим электродом то в нижней половине окна индицируется значение паразитной емкости. Если значение паразитной емкости превышает 0.1 пФ, то следует провести компенсацию паразитной емкости, для чего надо нажать клавишу «C». После перехода к началу измерений (нажатие клавиши «M») в верхней половине окна индикации емкости появляются новые указания измерительной программы. Измерителю следует опустить зонд на металлический электрод. В результате контактирования зонда с электродом должна резко возрасти индицируемая в нижней половине окна емкость между зондом и столом контактирующего устройства. После этого надо закрыть крышку измерительной камеры и нажать клавишу «M». В нижней половине окна будет отображаться значения напряжения на контакте МП в [В] и соответствующие им значения емкости в [пФ] вплоть до его окончания. После этого окно «Измерения» закрывается. Откройте меню первого уровня «Измерения» и щелкните левой кнопкой мыши по пункту меню первого уровня «График» (рис.8). На экране появится окно, содержащее графики измеренной вольтфарадной характеристики контакта C(U) и характеристики C-2(U) (рис.10).  Клавиша «Выход» предназначена для выхода в главное меню в случае, если результаты измерения не удовлетворительны. Клавиша «Ввод» - для построения линейной регрессии зависимости C-2(U). С  убъективно оцените диапазон напряжений, в котором участок зависимости C-2(U) можно считать линейным и «нажмите» клавишу «Ввод». После этого на фоне графика появляется окно ввода границ аппроксимации (рис.11) зависимости C-2(U) прямой линией. убъективно оцените диапазон напряжений, в котором участок зависимости C-2(U) можно считать линейным и «нажмите» клавишу «Ввод». После этого на фоне графика появляется окно ввода границ аппроксимации (рис.11) зависимости C-2(U) прямой линией.Введите в соответствующие окна выбранные значения границ аппроксимации по напряжению 1 и 2 и «нажмите» клавишу «График». На экране видеомонитора снова появится окно, содержащее графики измеренной вольтфарадной характеристики контакта металл-полупроводник C(U) и характеристики C-2(U) (рис.12). График характеристики C-2(U) аппроксимирован прямой линией (отрезок зеленого цвета).  Под графиками выведена справочная информация (первом и втором столбцах) и результаты определения параметров контакта металл-полупроводник (в третьем столбце). Использованы следующие обозначения.
Под графиком расположены две клавиши. Клавиша «Выход» предназначена для выхода в главное меню. Клавиша «Печать» предназначена для вывода на печать результатов измерения в виде графиков, справочной информации и рассчитанных параметров контакта (рис.12). Для сохранения результатов измерения откройте меню первого уровня «Измерения» и щелкните левой кнопкой мыши по пункту меню «Запись файла». На экране видеомонитора появится окно «Сохранить как» (рис.13). Для того, чтобы потом можно было впоследствии воспользоваться файлом данных, он должен иметь расширение «dat». Имя файла при этом может быть любым. На рис.13 в окне «Сохранить как» представлен перечень файлов данных ранее измеренных ВФХ контактов металл-полупроводник, имя которых состоит из латинской буквы f, даты проведения измерений (без года) и порядкового номера записи файла в день проведения измерений. При необходимости измерения ВФХ на других контактах с барьером Шоттки на этой же пластине внесите, если надо, изменения в меню второго уровня. Откройте крышку измерительной камеры и поднимите зонд. После этого откройте кран вакуумной присоски и, перемещая стол с пластиной, при помощи микроскопа найдите на пластине другой диод с барьером Шоттки и расположите конец зонда над его затвором. Откройте кран вакуумной присоски. Далее повторите действия, которые проводились при первом измерении. При необходимости других измерения ВФХ контактов с барьером Шоттки на другой пластине, смените пластину и повторите вышеуказанные действия. 2.3.2. Использование опции «Результаты» О  бработка результатов предыдущих измерений ВФХ контакта металл-полупроводник производится при помощи опции «Результаты» главного меню измерительной программы. бработка результатов предыдущих измерений ВФХ контакта металл-полупроводник производится при помощи опции «Результаты» главного меню измерительной программы.Для загрузки файла данных одного из предыдущих измерений и обработки результатов этого измерения щелкните левой кнопкой мыши по пункту главного меню «Результаты». На экране видеомонитора появится окно «Загрузка файла» (рис.14), в котором находится подкаталог файлов данных. Выберите имя файла данных и щелкните по нему левой кнопкой мыши, после чего нажмите клавишу «График». На экране появится окно, содержащее графики ранее измеренной вольтфарадной характеристики контакта C(U) и характеристики C-2(U) (рис.10). Обработка этого графика производится таким же образом, как и после проведения реальных измерений. 2.3.3. Проведение виртуальных измерений (опция «Имитация») Для проведения имитационных (виртуальных) измерений не требуются измерительные приборы. Необходим только компьютер. Меню первого уровня опции «Имитация» полностью повторяет меню первого уровня опции «Измерения» (рис.8). В целом проведение виртуальных измерений прямой ветви ВАХ полупроводникового диода и обработка полученных результатов аналогично проведению реальных измерений. Отличия заключаются лишь в окне «Ввод условий измерения», в котором параметры режима измерения фиксированы. 2.4. Завершение измерений Откройте крышку измерительной камеры и поднимите зонд. Закройте кран вакуумной присоски. Придвиньте стол на себя, снимите с него пластину и положите ее в кассету. Для выхода из программы измерений щелкните по прямоугольнику «Выход» в любом меню первого уровня. Закройте все окна, открытые на рабочем столе компьютера. Выключите блоки измерительной установки в следующей последовательности.
3. Требования к отчету. Отчет о должен содержать следующее.
4. Требования техники безопасности. При выполнении работы по настоящей методике существует опасность поражения электрическим током. Для предупреждения поражения электрическим током необходимо соблюдать «Инструкцию № 26-09 по охране труда при выполнении работ на электроприборах, электроустановках в помещениях лаборатории кафедры КФН». 5. Контрольные вопросы
Основная литература.
Дополнительная литература.
|

 .
.
 b=VB+ Vn=φB.
b=VB+ Vn=φB.