2 тема метод изоляции обратносмещенным p-n-переходом. Изоляция обратносмещенным рn переходом
 Скачать 199.17 Kb. Скачать 199.17 Kb.
|
|
Рымжина А.Р., гр.6367-110304D Изоляция обратносмещенным р-n переходом Изоляция обратно–смещенными p–n переходами обладает высокой технологичностью, операции создания изолирующей области естественным образом вливаются в технологический маршрут, не требуют ни дополнительного оборудования, ни использования новых материалов. Эта общность процессов изготовления обеспечивает однородность и экономичность технологии. Конструкция транзистора изолированного от других элементов микросхемы p–n переходом, показана на рис. 35, а. К подложке прикладывается наиболее отрицательное напряжение схемы. При этом р-n переход образует высокоомный запирающий слой, который электрически отделяет диффузионную область n-типа проводимости от подложки. Недостатком этой конструкции является то, что площадь изолирующей области сравнима с площадью, отводимой под транзистор, и даже превышает ее. Попытка устранить хотя бы частично этот недостаток без изменения способа изоляции привела к созданию транзистора, изображенного на рис. 35, б, в котором изолирующая область сформирована диффузией примеси n–типа на всю глубину эпитаксиального слоя до соприкосновения со скрытым n+–слоем и используется в качестве коллекторной области транзистора. 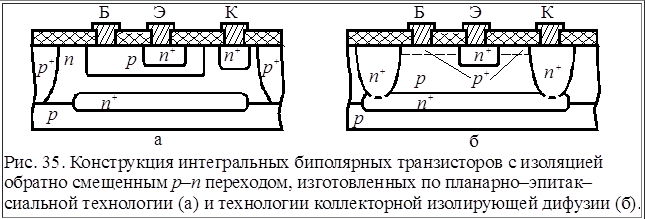 Существует несколько вариантов изоляции обратносмещенным p-n-переходом: Первый вариант Создание диффузионных областей n-типа проводимости в подложке р-типа проводимости. В качестве защитной маски используют слой окисла, в котором при помощи фотолитографии вскрыты окна, через которые формируют диффузионные области n-типа проводимости глубиной 15—20 мкм. В каждой из них можно получить последующей диффузией один или несколько интегральных элементов. Второй вариант. Встречная диффузия примеси в подложку n-типа проводимости. Основой является подложка n-типа проводимости, на которой создан защитный рельеф Si02. С помощью диффузии акцепторной примеси как с верхней стороны подложки, так и с нижней стороны создаются области n-типа проводимости, находящиеся под защитной маской и имеющие глубину примерно до половины толщины подложки. Третий вариант. Создание диффузионных изолирующих перемычек р-типа проводимости в эпитаксиальном слое n-типа проводимости. На кремниевой подложке р-типа проводимости эпитаксиальным наращиванием создают слой n-типа проводимости. После его окисления фотолитографией вскрываются тонкие окна в форме перемычек, образующие на поверхности подложки не связанные между собой участки окисла. Через эти окна диффузией сквозь эпитаксиальный слой n-типа толщиной примерно 20 мкм создаются изолирующие перемычки р-типа проводимости. При этом поверхность подложки, предназначенная для создания интегральной микросхемы, разбивается на отдельные изолированные области, в которых затем формируются отдельные элементы. Этот метод в настоящее время наиболее распространен. Этапы изготовления На подложке р-типа формируется эпитаксиальный слой n-типа (рисунок 4.4а). Затем проводится термическое окисление (рисунок 4.4б), и методом фотолитографии формируются окна под разделительную диффузию, т.е. маска из слоя SiO2 остается на тех местах, где будут изготовляться биполярные транзисторы и другие элементы схемы (рисунок 4.4в). Следующим этапом проводится разделительная диффузия акцепторной примесью (рисунок 4.4в) так, чтобы атомы примеси достигли подложки под эпитаксиальным слоем и в результате получается, что элементы схемы будут отделены друг от друга полупроводником р-типа. Проводится второе термическое окисление, вторая фотолитография и вторая диффузия акцепторной примесью с тем, чтобы сформировать базовый слой транзистора (рисунок 4.4г). Эта диффузия требует меньшее время, так как глубина базового слоя 2,5-2,7 мкм меньше, чем при разделительной диффузии. Затем проводятся ещё одно термическое окисление, фотолитография, при которой вскрываются окна под эмиттерную область и вывод коллектора, и проводится последняя диффузия донорной примесью (рисунок 4.4д). В этих областях создается максимальная концентрация примеси. Глубина n+- слоев составляет примерно 2 мкм. Максимальная концентрация примеси в месте вывода коллектора исключает появление выпрямляющего контакта металл-полупроводник (диод Шоттки). После четвертого заключительного термического окисления и ещё одной фотолитографии вскрываются окна для межэлементных соединений металлической пленкой (рисунок 4.4е). В результате термического напыления получается сплошная пленка алюминия (рисунок 4.4ж). На заключительном этапе проводится последняя фотолитография, при которой из пленки Al формируются межэлементные соединения (рисунок 4.4з). Вид на транзистор в плане с размерами показан на рисунке 4.5. Таким образом, в процессе формирования транзистора использовались: пять фотолитографий, четыре термических окисления, три процесса диффузии, по одному процессу эпитаксии и термическому напылению алюминия не считая ряда вспомогательных операций: очистка, промывка, удаление фоторезиста и т.д. 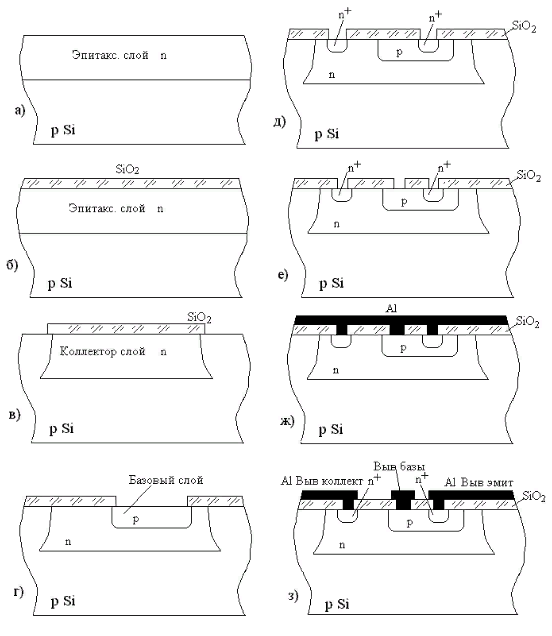 Рисунок 4.4 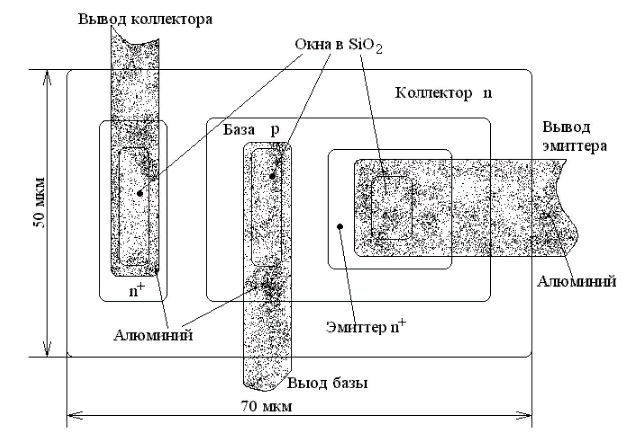 Рисунок 4.5 Изоляция элементов полупроводниковых микросхем с помощью обратно смещенного p–n перехода имеет такие недостатки, как большая паразитная емкость изолирующих p–n переходов; необходимость подачи на изолирующий p–n переход определенного по величине и знаку напряжения смещения; наличие четырехслойных структур n–p–n и p–n–p типа, которые обладают положительной обратной связью по току. На высоких частотах через емкости обратносмещенных р-n переходов осуществляется связь между изолированными областями (на высокой частоте значение емкости составляет 1—10 пФ и зависит от размера элемента микросхемы и используемой технологии изготовления), что приводит к уменьшению верхней граничной частоты интегральных схем. Указанные недостатки не позволяют добиться существенных успехов в росте быстродействия микросхем, увеличения степени их интеграции, радиационной стойкости и стабильности в широком интервале температур. СПИСОК ЛИТЕРАТУРЫ
|
