Курс лекций по дисциплине Электроника и схемотехника 1
 Скачать 1.54 Mb. Скачать 1.54 Mb.
|
Удельная электрическая проводимость полупроводниковσ = q  n∙μn+ q n∙μn+ q p∙μp, p∙μp,где q - заряд электрона, п и р концентрация электронов и дырок, n и р - подвижность электронов и дырок, т. е. средняя скорость направленного движения носителей заряда, отнесенная к напряженности электрического поля. В электронном полупроводнике nn  рn, следовательно можем записать: рn, следовательно можем записать: σn = q  nn∙μ nn∙μВ дырочном полупроводнике рр  nр, следовательно имеем: nр, следовательно имеем:σp = q  pp∙μp pp∙μpПри увеличении температуры, увеличиваются тепловые колебания кристаллической решетки, подвижность носителей падает. Так как в рабочем диапазоне температур, концентрация основных носителей примесных полупроводников неизменна, их электропроводность уменьшается с ростом температуры из-за снижения подвижности. ЛЕКЦИЯ 2. Процессы в электронно – дырочном р – n переходе В полупроводниковых приборов используются кристаллы полупроводника с двумя и более слоями, характеризующиеся различным током проводимости. При получении двухслойной структуры со слоями п - типа и р - типа, обычно концентрация примесей в слоях несимметрична: N  NДили наоборот. Один из слоев имеет более высокую концентрацию основных носителей и большую электропроводность, например, на рисунке 1.2 показана двухслойная структура, где Na NДили наоборот. Один из слоев имеет более высокую концентрацию основных носителей и большую электропроводность, например, на рисунке 1.2 показана двухслойная структура, где Na  NД, и рр NД, и рр  nn. nn.. 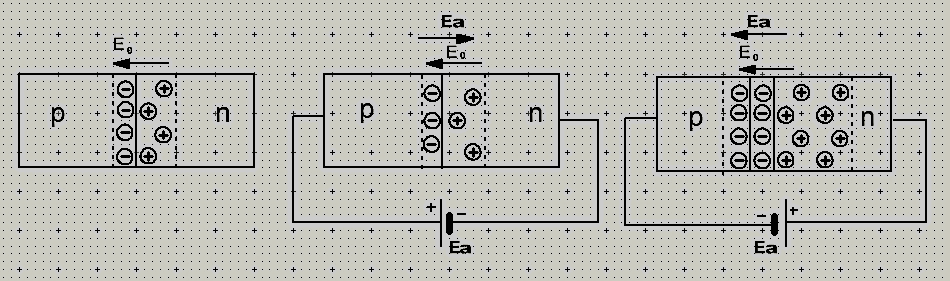 б) в) Рисунок 1.2 – Электронно - дырочный переход при отсутствии внешнего электрического поля (а) , при приложении прямого (б) и обратного (в) напряжений Область полупроводника, расположенная вблизи металлургической границы между р и п слоями, называется электронно - дырочным переходом или р - п переходом. Образование р - п перехода. При отсутствии внешнего поля, из - за разности концентраций основных носителей в р и n слоях происходит процесс диффузии через переход носителей заряда из области с повышенной в область с пониженной концентрацией н осителей. При этом основные носители в р - области это дырки, которые диффундируют в n- слой, а основные носители n - слоя (электроны) диффундируют в р - слой. Диффузионный ток через переход равен: Iдиф = Iдиф.р + Iдиф.n. Этот ток примерно равен Iдиф р, так как рр  nn . nn .Перейдя под воздействием сил диффузии металлургическую границу, носители рекомбинируют с основными носителями другого слоя. За счет ухода основных носителей из одного слоя и их рекомбинации в другом, вблизи металлургической границы возникает область, обедненная подвижными основными носителями заряда и обладающая высоким сопротивлением (запирающий слой). В запирающем слое нарушается баланс положительных и отрицательных зарядов, так как при уменьшении концентрации подвижных носителей оказывается нескомпенсированным объемный заряд неподвижных ионов примесей. В р - слое - отрицательных, в n - слое - положительных ионов. Этот двойной электрический слой (рисунок 1.2, а) создает электрическое поле с напряженностью Еo и приводит к появлению на кривой распределения потенциала  в полупроводнике потенциального барьера 0. Электрическое поле, возникшее внутри запирающего слоя, вызывает направленное движение носителей через переход - дрейфовый ток, направленный навстречу диффузионной составляющей тока через переход и равный : Iдр = Iдр.р + Iдр.n. в полупроводнике потенциального барьера 0. Электрическое поле, возникшее внутри запирающего слоя, вызывает направленное движение носителей через переход - дрейфовый ток, направленный навстречу диффузионной составляющей тока через переход и равный : Iдр = Iдр.р + Iдр.n.Диффузия носителей приводит к росту электрического поля и потенциального барьера, при этом растет дрейфовый ток. Рост двойного электрического слоя прекращается тогда, когда суммарный ток через переход равен нулю, т. е. Iдиф = - Iдр. Такой режим соответствует равновесному состоянию р - п перехода при отсутствии внешнего электрического поля. Результирующий ток через переход в этом случае равен нулю. Ширина запирающего слоя в р и п слоях зависит от концентрации ионов примесей в слоях и тем меньше, чем больше концентрация примесей. Поэтому при рассматриваемом соотношении примесей Naмногобольше NД, переход имеет двойной электрический слой, ширина которого в слабо легированной n - области больше . Прямое с мещение р - п перехода. Если двухслойный полупроводник включить в электрическую цепь (рисунок 1.2,б) и приложить прямое напряжение Uа (плюс к р - слою, минус к n- слою), то это напряжение практически все оказывается приложенным к запирающему слою, как к участку с наибольшим сопротивлением. Из – за встречного направления внутреннего Еои внешнего Еа полей результирующая напряженность поля в запирающем слое снижается и потенциальный барьер равен: = о - Uа. В результате этого возрастает количество носителей, обладающих энергией, достаточной для преодоления потенциального барьера, и увеличивается диффузионная составляющая Iдиф тока через переход. Дрейфовая составляющая определяется только количеством неосновных носителей, подошедших к запирающему слою в процессе теплового движения, причем неосновные носители по-прежнему втягиваются полем перехода. Поэтому дрейфовый ток неосновных носителей от приложенного напряжения не зависит. Таким образом, суммарный ток через переход Iа = Iдиф - Iдр > 0. Это прямой ток р - п перехода. Потенциальный барьер о измеряется долями вольта, поэтому для протекания прямого тока к р - п переходу достаточно приложить напряжение, измеряемое тоже долями вольта. Уменьшение результирующего поля у р-п перехода приводит к уменьшению объемного заряда и сужению запирающего слоя. Обратное смещение р - п перехода (рисунок 1.2, в) приводит к увеличению результирующего поля в запирающем слое и росту потенциального барьера: = о+Uа. Диффузия носителей через переход становится практически невозможной, поэтому ток Iа = Iдиф - Iдр = - Iдр. В этом случае поле р - п перехода втягивает все подошедшие к нему неосновные носители независимо от потенциального барьера и через переход протекает только ток неосновных носителей: ток дырок из n– области в р - слой и электронов из р - областив n - слой. Однако ток неосновных носителей, или обратный ток, значительно меньше прямого тока через р - п переход, так как число неосновных носителей в полупроводнике мало. Соотношение прямого и обратного токов р - п перехода позволяет говорить об однонаправленной проводимости р - п перехода, т. е. о его выпрямляющем действии. Обратный ток неосновных носителей через переход Ioбр = Iдр иногда называют тепловым током, так как сильно зависит от температуры: при нагреве полупроводника увеличивается генерация неосновных носителей; при этом тепловой ток удваивается при нагреве на 8° у германиевых приборов или на 10 °С у кремниевых приборов. При обратном смещении р-п перехода суммарная напряженность электрического поля перехода возрастает, поэтому возрастает заряд двойного электрического слоя и ширина запирающего слоя. Зависимость тока через р - п переход от приложенного напряжения Iа = f(Uа) называется вольт-амперной характеристикой (ВAХ) электронно-дырочного перехода ( рисунок 1.3) 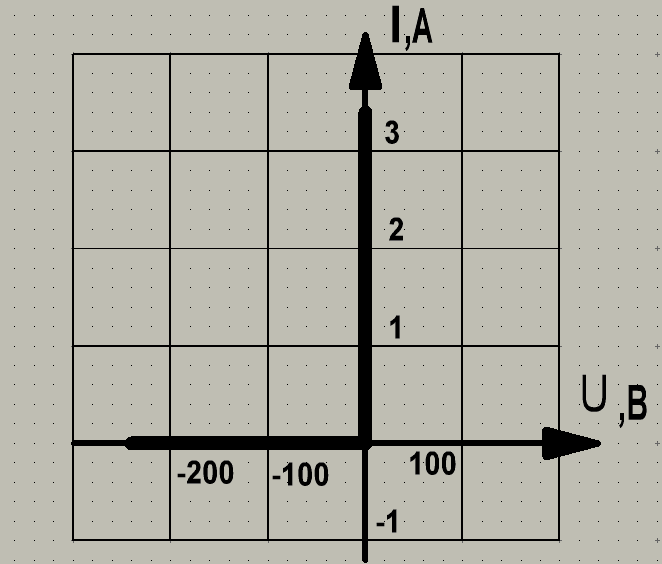 Рисунок 1.3 - ВАХ р - п перехода Лекция 3. Полупроводниковые диоды Полупроводниковый диод представляет собой полупроводниковый кристалл с двумя слоями проводимости, заключенный в корпус и снабженный двумя выводами для присоединения во внешнюю цепь. В основе структуры диода лежит р - п переход. ВАХ реального диода приведена на рисунке 1.4.  Ia Ua Uпроб  Р исунок 1.4 - ВАХ полупроводникового диода Прямое падение напряжения на диоде больше напряжения на р - п переходе на значение падения напряжения. При прохождении тока через толщу слоев полупроводника, главную роль играет падение напряжения в слабо легированном высокоомном слое. Обратная ветвь ВАХ диода имеет три характерных участка. На участке I протекает небольшой обратный ток утечки по поверхности кристалла. При достижении отрицательного напряжении на аноде равным напряжению пробоя Uпроб., происходит резкое увеличение обратного тока - участок II. Резкое увеличение обратного тока диода обусловлено электрическим пробоем р - п перехода. Для выпрямительных диодов характерен лавинный пробой, заключающийся в том, что под действием сильного электрического поля неосновные носители заряда, попавшие в переход, за время пробега между столкновениями с узлами кристаллической решетки приобретают энергию, достаточную для ударной ионизации атомов. При этом образуется пара свободных носителей заряда. В свою очередь эти носители, ускоряясь в поле, также могут произвести ионизацию. Процесс лавинного пробоя подобен горной лавины, что и вызывает резкое нарастание тока через переход. При снятии отрицательного напряжения, ток через прибор прекращается и диод пригоден к дальнейшему использованию. Поэтому электрический является обратимым. Другой разновидностью обратимого электрического пробоя на участке II может быть полевой пробой. В тонких переходах напряженность электрического поля велика, при этом энергия, необходимая для разрыва связи в кристаллической решетке, уменьшается, увеличивается генерация неосновных носителей, резко возрастает обратный ток. На участке III происходит тепловой пробой. При увеличении приложенного обратного напряжения растет обратный ток, а также мощность, выделяемая в р - п переходе. Повышение температуры кристалла усиливает генерацию неосновных носителей и дальнейшее увеличение обратного тока. Увеличение обратного тока вызывает рост мощности, температура перехода еще более повышается, что в конечном счете приводит к разрушению р -п перехода и выходу прибора из строя. Этот вид пробоя, приводит к разрушению прибора и является нежелательным. Основными параметрами выпрямительных диодов являются: - максимально допустимый прямой ток, величина которого определяется допустимым нагревом прибора при приложении прямого напряжения; - обратное напряжение пробоя. По мощности выпрямительные диоды подразделяются на: - маломощные (прямой ток до 0,3 А); - средней (ток от 0,3 до 10 А) ; большой мощности (ток от 10 до 1000 А и выше). Широкое применение на практике получили стабилитроны- разновидность диодов применяемых для стабилизации выпрямленных напряжений Лекция 4. Биполярные транзисторы Управление током и усиление сигналов в схемах полупроводниковой электроники осуществляют с помощью транзисторов.  a) б) Рисунок 1.5 - Схемные обозначения транзистора n-p-n (а) и p-n-p(б) 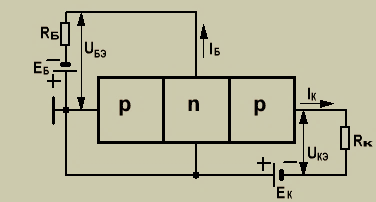 Рисунок 1.6 – Схема включения транзистора с общим эмиттером Биполярный транзистор представляет собой кристалл полупроводника, состоящий из трех слоев с чередующейся проводимостью и снабженный тремя выводами (электродами) для подключения к внешней цепи. На рисунке 1.5,а и б показано схемное обозначение двух типов транзисторов p - n - pи и п – р – п. Крайние слои называют эмиттером (Э) и коллектором (К), между ними находится база (Б). В трехслойной структуре имеются два электронно-дырочных перехода: эмиттерный переход между эмиттером и базой, коллекторный переход между базой и коллектором. Принцип действия р – п - р транзистора. Транзистор включают последовательно с сопротивлением нагрузки Rк в цепь источника коллекторного напряжения Ек. На вход транзистора подается управляющая ЭДС ЕБ ( рисунок 1.6, а). Такое включение транзистора, когда входная (ЕБ,,RБ) и выходная (Ек Rк.) цепи имеют общую точку - эмиттер, является наиболее распространенным и называется включением с общим эмиттером (ОЭ, нашедшая наибольшее применение. При отсутствии напряжений (ЕБ = 0, Ек = 0) , эмиттерный и коллекторный переход находятся в состоянии равновесия, токи через них равны нулю. Оба перехода имеют двойной электрический слой, состоящий из ионов примесей, и потенциальный барьер о , различный на каждом из переходов. Полярность внешних источников ЕБ и Ек выбирается такой, чтобы на эмиттерном переходе было прямое напряжение, а на коллекторном переходе было обратное напряжение, причем напряжение Uкэ > U БЭ . В результате приложения к эмиттерному переходу прямого напряжения начинается усиленная диффузия дырок из эмиттера в базу. Электронной составляющей диффузионного тока через эмиттерный переход можно пренебречь, так как концентрация дырок много больше концентрации электронов , р  п. . Таким образом, ток эмиттера будет примерно равен диффузионному току, Iэ п. . Таким образом, ток эмиттера будет примерно равен диффузионному току, Iэ  Iэдиф. Эти дырки захватываются полем коллекторного перехода, смещенного в обратном направлении, так как это поле является ускоряющим для неосновных носителей – дырок в базе n - типа. Ток дырок, попавших из эмиттера в коллектор, замыкается через внешнюю цепь, источник ЕК. При увеличении тока эмиттера на величину Iэдиф. Эти дырки захватываются полем коллекторного перехода, смещенного в обратном направлении, так как это поле является ускоряющим для неосновных носителей – дырок в базе n - типа. Ток дырок, попавших из эмиттера в коллектор, замыкается через внешнюю цепь, источник ЕК. При увеличении тока эмиттера на величину  э ток коллектора возрастет на э ток коллектора возрастет на  Iк = ∙ Iк = ∙ Iэ, где - коэффициент передачи. Iэ, где - коэффициент передачи.IК = ∙IЭ + I Кб0 . Выходной или коллекторной ВАХ транзистора называется зависимость коллекторного тока от напряжения между коллектором и эмиттером Iк = (Uкэ), снятая при неизменном токе базы IБ = const. Семейство выходных вольт - амперных характеристик транзистора приведено на рисунке 1.7, а. Зависимость тока от напряжения как видно из рисунка, является нелинейной и может быть разбита на ряд участков. На большей части характеристик UКЭ  UКЭ.н , ток коллектора почти не зависит от напряжения UКЭ ( пологий участок характеристик ). Пологий участок соответствует активному или усилительному режиму работы транзистора. На этом участке транзистор может характеризоваться как прибор со свойствами управляемого источника тока, то есть источника коллекторного тока IK, значение которого можно изменять путем изменения тока базы IБ. UКЭ.н , ток коллектора почти не зависит от напряжения UКЭ ( пологий участок характеристик ). Пологий участок соответствует активному или усилительному режиму работы транзистора. На этом участке транзистор может характеризоваться как прибор со свойствами управляемого источника тока, то есть источника коллекторного тока IK, значение которого можно изменять путем изменения тока базы IБ. 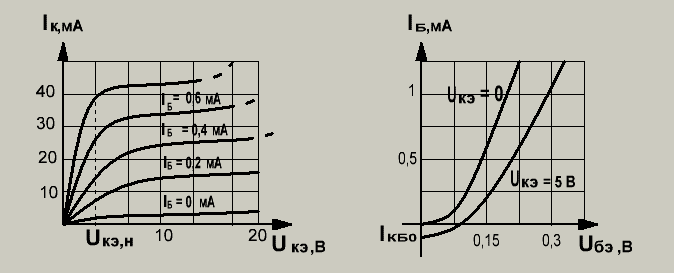 а) б) Рис.1.7. Выходные (а ) и входные ( б ) характеристики биполярного транзистора Для изменения входного тока базы, например, для его увеличения, увеличивают напряжение источника ЕБ. При этом растут прямое напряжение на эмиттерном переходе и инжекция носителей из эмиттера в базу и ток эмиттера IЭ увеличивается на значение  Э. Увеличение тока базы обусловлено увеличением рекомбинации части дырок в тонкой базе. Основная часть приращения эмиттерного тока вызывает приращение тока коллектора Э. Увеличение тока базы обусловлено увеличением рекомбинации части дырок в тонкой базе. Основная часть приращения эмиттерного тока вызывает приращение тока коллектора  К = К =  ∙ ∙ Э = ∙ Э = ∙  Б. На практике, величина коэффициента для различных типов транзисторов лежит в диапазоне от 10 до 100. Б. На практике, величина коэффициента для различных типов транзисторов лежит в диапазоне от 10 до 100.Небольшой наклон пологого участка выходной характеристики обусловлен тем, что при увеличении напряжения Uкэ увеличивается напряжение на коллекторном переходе и расширяется двойной электрический слой коллекторного перехода, что приводит к уменьшению толщины базы. В более тонкой базе меньше вероятность рекомбинации, поэтому значения коэффициентов передачи тока  и несколько увеличиваются. При увеличении коэффициента передачи возрастает коллекторный ток. и несколько увеличиваются. При увеличении коэффициента передачи возрастает коллекторный ток.Входные характеристики транзистора представляют собой зависимостей тока базы от напряжения между базой и эмиттером, IБ = ( UБЭ )  при постоянном напряжении UКЭ. При UКЭ = 0 оба перехода в транзисторе работают при прямом напряжении, токи коллектора и эмиттера суммируют в базе. Входная характеристика в этом режиме представляет собой ВАХ двух р - п переходов, включенных параллельно . при постоянном напряжении UКЭ. При UКЭ = 0 оба перехода в транзисторе работают при прямом напряжении, токи коллектора и эмиттера суммируют в базе. Входная характеристика в этом режиме представляет собой ВАХ двух р - п переходов, включенных параллельно .Токи в транзисторе сильно зависят от температуры окружающей среды, что является общим недостатком полупроводниковых приборов. Коэффициенты передачи токов транзистора  и зависят от частоты. Это обусловлено инерционностью процессов, происходящих в транзисторе при прохождении носителей заряда через базовый слой, и изменением концентрации носителей в базе при диффузия неосновных носителей к коллектору. За счет инерционности этих процессов приращения выходного тока запаздывают по фазе относительно приращений входного тока. В справочниках приводится граничная частота коэффициента передачи тока fгр, на которой = 1. и зависят от частоты. Это обусловлено инерционностью процессов, происходящих в транзисторе при прохождении носителей заряда через базовый слой, и изменением концентрации носителей в базе при диффузия неосновных носителей к коллектору. За счет инерционности этих процессов приращения выходного тока запаздывают по фазе относительно приращений входного тока. В справочниках приводится граничная частота коэффициента передачи тока fгр, на которой = 1. Лекция 5. Полевые транзисторы Биполярные транзисторы нашли широкое применение в различных областях электронной техники. Однако в ряде случаев их использование затруднено, так как эти приборы управляются током, в результате потребляют заметную мощность от входной цепи. Это препятствует их использованию при подключении к маломощным источникам. Указанного недостатка нет у полевых транзисторов(униполярных), которые управляются напряжением и практически не потребляют ток из входной цепи. Полевые транзисторы подразделяются на два типа, отличающихся друг от друга принципом действия: а) с р - п переходом; б) МДП - типа. Условное обозначение полевых транзисторов с р - п переходом приведено на рисунке 1.8, где обозначено: З- затвор; И - исток; С - сток. а) б) Рисунок 1.8 – Условное обозначение полевых транзисторов с р - п переходом, проводящим каналом n(а) и p(б) типов Структура полевого транзистора с р - n переходом приведена на рисунке 1.9. Слой с проводимостью р - типа называется каналом. Слои с проводимостью п типа , окружающие канал, соединены между собой и имеют вывод во внешнюю цепь.. 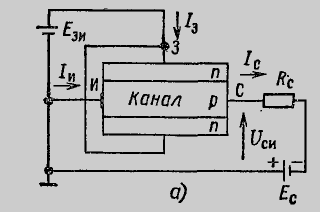 Рисунок 1.9 - Структура полевого транзистора с р - n переходом, включенного по схеме с общим истоком Семейство стоковых(выходных) характеристик приведено на рисунке 1.10.  Рисунок 1.10 - Стоковые ВАХ полевого транзистора с р - n переходом В отличие от биполярных транзисторов полевые транзисторы управляются напряжением, и через цепь затвора протекает только малый тепловой ток p-п перехода, находящегося под действием обратного напряжения. Стоковые характеристики, так же как и коллекторные характеристики биполярного транзистора, имеют два участка: крутой и пологий. Пологий используется при работе транзистора в усилительных устройствах, а крутой участок используется при работе в переключательных устройствах. Полевые транзисторы МДП - типа («металл - диэлектрик - полупроводник») имеют изолированный затвор. На рисунке 1.11 показана структура МДП - транзистора. 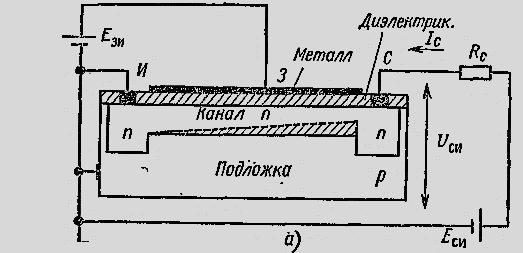 Рисунок 1.11- Структура(а) и стоковые характеристики МДП - транзисторов с встроенным каналом (б) и индуцированным каналом( в ). При приложении положительного напряжения к затвору электрическое поле притягивает электроны из подложки, они скапливаются в области канала, сопротивление канала уменьшается и ток стока растет ( режим обогащения ) (рисунок 1.11, б при Uси > 0 ). При отрицательном напряжении на затворе электрическое поле выталкивает электроны из канала в подложку, сопротивление канала увеличивается и ток стока Iс падает ( режим обеднения ). Таким образом, при изменении управляющего напряжения Uзи изменяется выходной ток прибора Iс. Связь приращений выходной и входной величин определяется крутизной, равной: S =  Iс / Uзи при Uси = const. Iс / Uзи при Uси = const.Рассмотренные МДП - транзисторы являются приборами со встроенным каналом. Помимо этого выпускаются МДП - транзисторы с индуцированным каналом . При изготовлении этих транзисторов специальный канал между областями, связанными со стоком и истоком, не создается. При напряжении Uзи = 0 выходной ток отсутствует, Iс =0. Транзистор может работать только в режиме обогащения, когда поле затвора притягивает носители соответствующего знака, создающие проводящий канал между областями истока и стока. Семейство стоковых характеристик МДП-транзисторов с индуцированным каналом n-типа приведено на рисунке 1.11, в. При напряжении на затворе меньшем напряжения отсечки, ток стока Iс практически отсутствует. Условное обозначение МДП - транзисторов с встроенным и индуцированным каналами n - типа и р - типа показано на рис. 1.12.  а) б) в) г) Рисунок 1.12 - Условные обозначения МДП – транзисторов с встроенным (а, б) и индуцированным (в, г) каналами Лекция 7. Биполярные транзисторы с изолированным затвором IGBT. Тиристоры Высоковольтными силовыми приборами с большими уровнями токов и напряжениями до единиц киловольт заняли биполярные транзисторы с изолированным затвором IGBT. IGBT - прибор представляет собой биполярный p – n - p транзистор, управляемый от низковольтного полевого транзистора с индуцированным каналом n - типа, эквивалентная схема которого приведена на рисунке 1.13.  Рисунок 1.13 - Эквивалентные схемы IGBT транзистора IGBT- приборы являются компромиссным техническим решением, позволившим объединить положительные качества как биполярных (малое падение напряжения в открытом состоянии, высокие коммутируемые напряжения), так и полевых транзисторов (малая мощность управления, высокие скорости коммутации). Максимальное напряжение IGBT-транзисторов ограничено только технологическим пробоем и в настоящее время выпускаются приборы с рабочим напряжением до 4000 В. При этом, остаточное напряжение на транзисторе во включенном состоянии, не превышает 2…3 В. Семейство выходных вольт- амперных характеристик IGBT-транзисторов приведены на рисунке 1.14.  Рисунок 1.14 - Семейство выходных ВАХ IGBT - транзистора Условные графические обозначения IGBT – транзисторов приведены на рисунке 1.15.  Рисунок 1.15 - Условные графические обозначения IGBT-транзисторов В настоящее время IGBT-транзисторы находят широкое применение в устройствах силовой электроники и ряде других областей |
