Лаб. Практикум 1 по курсу физические основы электроники москва 2015 План умд на 20142015 уч г
 Скачать 0.84 Mb. Скачать 0.84 Mb.
|
|
ЛАБОРАТОРНАЯ РАБОТА № 4 ИССЛЕДОВАНИЕ МДП–СТРУКТУРЫ 1. Цель работы Изучение особенностей структуры металл – диэлектрик – полупроводник (МДП) и возможностей её применения в электронике. 2. Задание 1. Ознакомиться с типами и физическими свойствами МДП–структур. 2. Ознакомиться с основными параметрами МДП–структур и возможностями их изменения при изготовлении. 3. Пользуясь программой лабораторной работы, определить для заданного варианта исходных данных параметры МДП–структуры и МДП–транзистора на её основе. 4. Предложить способы улучшения параметров, доказать возможность этого повторением расчётов при самостоятельно изменённых исходных данных. 3. Краткие теоретические сведения МДП–структура представляет собой контакт, образованный тремя слоями: металла, диэлектрика и полупроводника. Наиболее распространена структура с кремнием (Si) p- или n- типа в качестве полупроводника и с двуокисью кремния (SiO2) в качестве диэлектрика. Структура с кремнием р- типа более распространена, поскольку в канале n- типа ток определяется дрейфом свободных электронов, обладающих более высокой подвижностью (рис. 1). 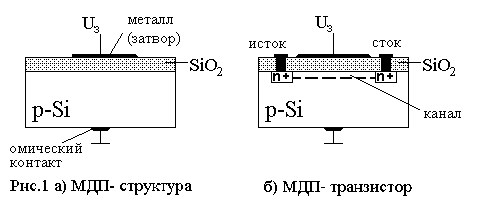 Оба эти материала отличаются высокими электрофизическими характеристиками, механической и химической прочностью, хорошей совместимостью с технологией изготовления интегральных схем. При добавлении двух электродов – истока и стока, МДП–структура превращается в наиболее распространённый на сегодняшний день тип транзистора – МДП–транзистор (рис. 1, б). В дальнейшем будут рассматриваться МДП–структура и транзистор на основе р-кремния. Основное свойство МДП–структуры заключается в возможности управления свойствами полупроводника электрическим полем металлического слоя - затвора (полевой эффект). Для этого диэлектрический слой должен иметь достаточно малую толщину d. Утолщениедиэлектрика приводит к ослаблению электрического поля в подзатворной области. Сегодня уже существуют МДП–транзисторы с d равной нескольким межатомным расстояниям, для питания и управления которыми достаточны напряжения 1...2 В. Именно такие МДП–транзисторы образуют основу цифровых процессоров современных компьютеров. При подаче на затвор структуры вида рис. 1,а отрицательного напряжения электрическое поле затвора втягивает в подзатворную область дополнительные дырки из более глубоких слоев полупроводника. Подзатворная область обогащается основными носителями (режим обогащения). При подаче положительного напряжения, напротив, дырки вытесняются из подзатворной области (режим обеднения). При достаточно сильном положительном поле концентрация дырок и электронов сравниваются, полупроводник в подзатворной области становится собственным. Такое состояние называют пороговым, напряжение на затворе — пороговым напряжением U0. При напряжении на затворе U3 > U0 концентрация свободных электронов превышает концентрацию дырок, т.е. полупроводник в подзатворной области приобретает свойства n-полупроводника (режим инверсии). В МДП–транзисторе появляется так называемый канал – полоска полупроводника n-типа, соединяющая внутренние контакты стока и истока (островки кремния n+- типа, рис. 1, б). Если подано напряжение Uси, в канале МДП–транзистора протекает ток. В отсутствие канала тока между истоком и стоком нет. Такой транзистор называется МДП-транзистором с индуцированным (появляющимся) каналом n- типа. Пороговое напряжение U0 является важнейшим параметром МДП–структуры. От его величины, в частности, зависит то минимальное напряжение источника питания МДП ИС при котором, с одной стороны, минимизируется потребляемая мощность, а с другой стороны обеспечивается надёжное отпирание транзисторных ключей. Идеализированная МДП–структура характеризуется пороговым напряжением где C0 – удельная емкость МДП–структуры, В выражениях (1) и (2): d – толщина диэлектрика; q – элементарный электрический заряд; N – концентрация примеси в полупроводнике. Зная удельную ёмкость, можно оценить важнейший параметр МДП– транзистора – ёмкость затвор-канал где W – ширина канала МДП–транзистора; L – длина канала. Более точное значение U0 находится с учётом поверхностного потенциала, который зависит от дефектов кристаллической решётки поверхности полупроводника, наличия посторонних примесей и других трудно прогнозируемых факторов. Поэтому фактические величины U0 могут сильно отличаться от найденных по (1) и параметры транзисторов сильно отклоняются от ожидаемых. Современная технология позволяет ослабить влияние указанных факторов. В настоящей работе поверхностный потенциал полагается равным нулю. Другой важнейшей характеристикой МДП–структуры является удельная крутизна B, определяющая степень влияния UЗ на состояние канала и ток МДП–транзистора. Чем больше B, тем при меньшем измененииUЗ управляется транзистор (в ключе – замыкается и размыкается). Ток стока Ic определяется выражениями, в зависимости от режима, или В обоих случаях степень влияния UЗ на IC определяет удельная крутизна где Анализируя (1) – (5), можно прийти к следующим выводам: 1. Уменьшение U0 и увеличение B, т.е. улучшение управляемости МДП–структуры достигается, прежде всего, уменьшением толщины диэлектрического слоя. Естественным ограничением при этом является уменьшение его электрической прочности и рост тока утечки между затвором и каналом. 2. Увеличение Bдостигается уменьшением длины канала, что ограничено разрешающей способностью интегральной технологии (порядка нескольких нанометров в 2015 г.). 3. Увеличение Bдостигается использованием полупроводников с большим коэффициентом подвижности. Поэтому кремниевые n-канальные МДП–транзисторы предпочтительнее p-канальных, а ещё лучшие результаты обеспечивает применение арсенида галлия, отличающегося наиболее высокой подвижностью свободных электронов. Заряд и разряд ёмкости затвор – канал МДП–транзистора является главным фактором инерционности. Из (1) и (5) следует, что не в ущерб U0 и Bбыстродействие МДП–транзистора можно улучшить, только уменьшив площадь канала Имеются сообщения о разработке МДП–транзисторов с размерами порядка десяти нанометров и менее и с толщиной диэлектрического слоя в несколько межатомных расстояний (компания Intel). Такие транзисторы позволяют построить процессор для компьютера с тактовой частотой до нескольких десятков ГГц и количеством транзисторов на кристалле 106 и более. 4. Методические указания по выполнению работы 4.1. Вызвать программу, ярлык которой LAB4 находится на рабочем столе. 4.2. Пользуясь данными табл. 1, для заданного преподавателем варианта, ввести исходные данные. Большие и малые числа вводятся в экспоненциальной форме. Например, концентрацию примесей N = 0,51017 см –3 следует ввести как 0.5Е17. 4.3. Полученные результаты занести в табл. 2. 4.4. Самостоятельно изменить исходные данные так, чтобы было достигнуто уменьшение порогового значения напряжения. Результат занести в табл. 2. 4.5. Самостоятельно изменить исходные данные так, чтобы было достигнуто увеличение удельной крутизны. Результат занести в табл. 2. 4.6. Самостоятельно изменить исходные данные так, чтобы было достигнуто уменьшение ёмкости затвор-канал МДП - транзистора. Результат занести в табл. 2. 5. Содержание отчёта 1. Название и цель работы. 2. Рисунки, поясняющие устройство МДП–структуры и МДП–транзистора. 3. Полностью заполненную табл. 2 с результатами расчетов. 6. Контрольные вопросы 1. Назовите основные режимы МДП–структуры. При каких условиях они возникают? 2. В чем заключается полевой эффект? 3. Как устроен и работает МДП–транзистор? 4. Что такое пороговое напряжение МДП–структуры и от чего оно зависит? 5. Что такое удельная емкость МДП–структуры и от чего она зависит? 6. Что такое удельная крутизна МДП–структуры и от чего она зависит? 7. Как совершенствуется МДП–транзистор? Таблица 1. Исходные данные для расчетов
Таблица 2. Результаты расчетов
ЛАБОРАТОРНАЯ РАБОТА № 5 ИССЛЕДОВАНИЕ БИПОЛЯРНОГО ТРАНЗИСТОРА 1. Цель работы Ознакомление с физическими принципами функционирования биполярного транзистора (БТ), с особенностями его изготовления и взаимосвязью конструкции, размеров и параметров. 2. Краткие теоретические сведения. Биполярный транзистор является прибором с двумя р-n переходами (рис. 1). Поэтому, для понимания процессов в БТ, необходимо изучить основные типы контактов в электронике (л.р. № 1 и л.р. № 2). 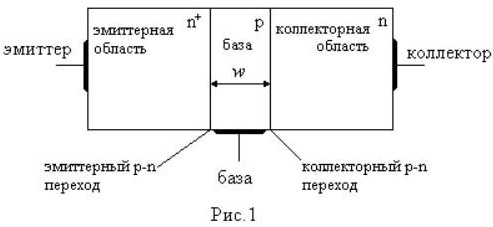 На рис. 1 изображён БТ со структурой n+ – р – n, хотя возможна, но менее распространена, и p+ – n - p структура. В работе этих структур принципиальных отличий нет. Области БТ получили следующие названия: n+ – эмиттер (область, “испускающая” носители); р – база и n (на рис. 1 – область справа) – коллектор (т.е. область, “собирающая” носители). Каждая область снабжена омическими контактами металл-полупроводник, служащими для подключения к внешним цепям. Названия внешних контактов такие же, как у областей – эмиттер, база, коллектор. P-n переход между эмиттером и базой получил название “эмиттерный переход” (ЭП), между базой и коллектором – “коллекторный переход” (КП). Важнейшими особенностями конструкции являются: 1) малая толщина базы, не более 0,5 мкм; 2) малая концентрация примеси в базе (порядка 1016 см-3); 3) большая концентрация примеси в эмиттере, до 1020 см-3. Только при соблюдении перечисленных условий БТ способен проявлять свои главные свойства: усиливать электрические сигналы, а также работать в режиме ключа. На рис. 2 изображена одна из распространённых схем включения БТ – схема с общей базой (здесь база – общий электрод и для входной и для выходной цепи). 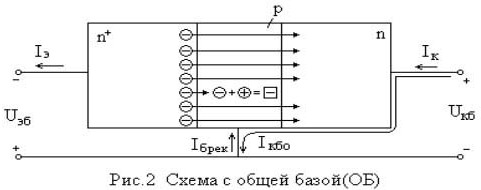 Наиболее распространённый усилительный (активный) режим здесь создаётся двумя внешними напряжениями: 1) UЭБ – входное напряжение, прямое для эмиттерного перехода; 2) UКБ – выходное напряжение, обратное для коллекторного перехода. В открытом ЭП, благодаря прямому напряжению, понижается потенциальный барьер и поэтому протекает большой диффузионный ток основных носителей IЭ. При этом IЭ имеет электронную IЭn и дырочную IЭp составляющие. Так как концентрация свободных электронов в эмиттере на несколько порядков больше, чем дырок в базе, IЭn >> IЭp. Поэтому в ЭП наблюдается практически односторонний ток свободных электронов в базу, (так называемая инжекция). Свободные электроны в базе являются неосновными носителями. Так как их больше вблизи ЭП, откуда они поступают, в базе возникает градиент концентрации Так как база тонкая и слаболегированная, при продвижении неосновных носителей через базу только небольшая их часть рекомбинирует с основными носителями базы (не более 1…2%). В противном случае наблюдалось бы значительное уменьшение выходного тока IК . Рекомбинация в базе несколько уменьшает концентрацию её основных носителей — дырок. Электрическая нейтральность базы нарушается, в ней образуется отрицательный заряд некомпенсированных ионов акцепторной примеси. Этот заряд создаёт так называемый рекомбинационный ток в выводе базы IБРЕК. Еще одна составляющая тока базы легко обнаруживается при разорванной цепи эмиттера. Тока в ЭП при этом нет, но в КП протекает небольшой по величине обратный ток коллектора IКБ0, создаваемый обратным напряжением UКБ. Таким образом, в указанном режиме в БТ действительны следующие соотношения токов: IЭ = IК + IБ (закон Кирхгофа для БТ, рассматриваемого как узел цепи) (1) IБ = IБРЕК – IКБ0 (2) IК = α IЭ + IКБ0 (3) В кремниевых транзисторах, наиболее распространённых сегодня, IКБ0 пренебрежимо мал, поэтому из (3) следует: Статический коэффициент передачи эмиттерного тока α является важнейшим параметром БТ. Можно показать, что коэффициент усиления по мощности БТ с общей базой определяется выражением где RН –сопротивление нагрузки, включаемое в разрыв коллекторной цепи; rЭ - сопротивление открытого ЭП, обычно очень малое. Так как БТ в отношении нагрузки является источником тока (сопротивление закрытого КП очень велико), RН может на несколько порядков превышать rЭ. Поэтому, согласно (4), КР может достигать многих тысяч раз. На величину коэффициента усиления влияют следующие особенности конструкции. Качество работы ЭП характеризуется коэффициентом инжекции где IЭn – полезный ток инжекции; IЭр – бесполезный встречный дырочный ток; NЭи NБ – концентрация примесей в базе и эмиттере. Увеличивая NЭ, можно получить γ = 0,999 и более. Качество процессов в базе характеризуется коэффициентом переноса Этот коэффициент тем ближе к идеальному значению — единице, чем тоньше база и меньше степень её легирования (меньше концентрация примесей). Перемножив (5) на (6) получим: Увеличению коэффициента усиления способствует также неоднородное легирование базы: примесей вводят больше вблизи ЭП, с уменьшением концентрации к КП. В такой базе нескомпенсированных ионов примеси, появляющихся из-за рекомбинации основных и неосновных носителей больше вблизи ЭП. В результате в базе возникает собственное электрическое поле, рис. 3. 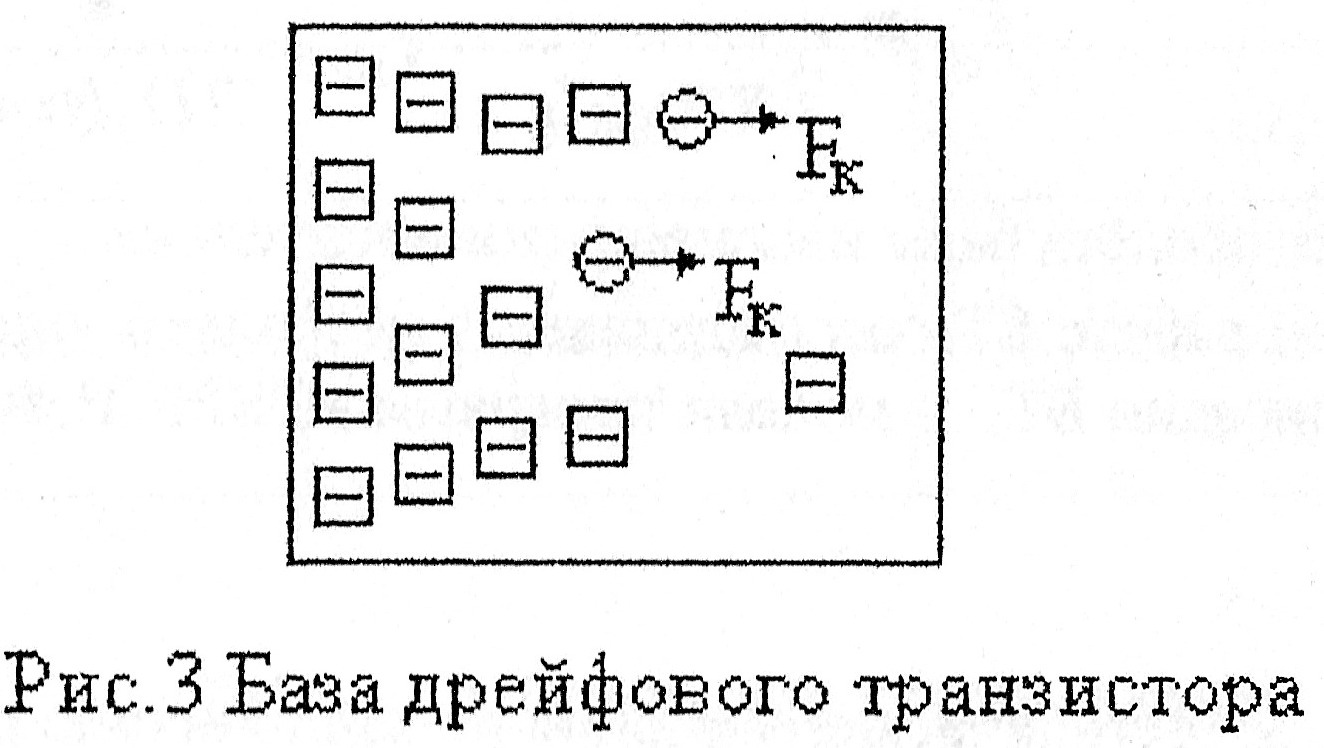 Нетрудно убедиться, что собственное поле в такой базе – ускоряющее для неосновных носителей и сила Кулона FK заставляет их дрейфовать к КП и в результате пересекать базу быстрее (дрейфовый транзистор). Поэтому время пребывания в такой базе (время пролёта) меньше, вероятность рекомбинации и потери из-за неё меньше, частотные и импульсные свойства – лучше. Более точный анализ процессов в БТ приводит к следующим, более точным соотношениям, которые используются в расчётах в настоящей работе.  , (8) , (8)где DБ, DЭ – коэффициенты диффузии в эмиттере и базе; NБ, NЭ – концентрация примесей в эмиттере и базе; w – толщина базы; LЭ, LБ – средняя диффузионная длина неосновных носителей в эмиттере и базе; η – коэффициент неоднородности базы (в бездрейфовом БТ с однородной базой η = 0, в дрейфовом транзисторе η = 2...3). Коэффициент переноса более точно рассчитывается по формуле:  (9) (9)В настоящей работе определяется статический коэффициент передачи тока в схеме с общим эмиттером β (она наиболее распространённая) β  (10) (10)В число рассчитываемых параметров включается также предельная частота передачи тока в схеме с ОБ В настоящей работе БТ рассматривается несколько упрощённо. В наиболее точном и сложном описании БТ, в модели программы PSPICE, насчитывается до 60 параметров. 3. Методические указания по выполнению работы 3.1. Вызвать программу, ярлык которой LAB5, находится на рабочем столе. 3.2. Ввести исходные данные согласно заданному преподавателем номеру варианта 1–6 и данным табл. 1. При вводе больших и малых чисел пользоваться экспоненциальной формой записи. Например, число 0.51017 следует ввести как 0.5Е17. После набора каждого числа нажимать ENTER. 3.3. Перенести в отчёт рисунок БТ с экрана. 3.4. Перенести в табл. 2. результаты расчёта исходного варианта. 3.5. Повторить расчёт для случая однородной базы (диффузионный транзистор), результаты занести в табл. 2. Все неуказанные в п.п. 3.5–3.8 параметры оставлять равными исходным. 3.6. Повторить расчёт для случая повышенной концентрации примесей в эмиттере NЭ, увеличив её на порядок. Результаты занести в табл. 2. 3.7. Повторить расчёт для случая повышенной концентрации примесей в базе NБ, увеличив её на порядок. Результаты занести в табл. 2. 3.8. Повторить расчёт для случая увеличенной толщины базы w, увеличив её вдвое. Результаты занести в табл. 2. Таблица 1. Исходные данные (дрейфовый кремниевый n-p-n БТ)
Таблица 2. Результаты исследований
4. Содержание отчёта – название и цель работы; – рисунок схемы ОБ с поясняющими подписями; – полностью заполненная табл. 2. 5. Контрольные вопросы 1. Изобразить n-p-n БТ в схеме с общей базой с указанием полярности напряжений и направления токов. 2. Изобразить p-n-р БТ в схеме с общей базой с указанием полярности напряжений и направления токов. 3. Пояснить физические процессы в БТ в схеме ОБ в активном режиме. 4. Как и почему на свойства БТ влияет степень легирования эмиттера? 5. Как и почему на свойства БТ влияет степень легирования базы? 6. Как и почему на свойства БТ влияет толщина базы? 7. Что такое инжекция, экстракция и рекомбинация в базе? 8. Что такое дрейфовый БТ и почему он лучше диффузионного БТ? 9. Как возникает ток базы и какие он имеет составляющие? 10. Почему усиление БТ по мощности может достигать тысяч раз? |

 араметры
араметры