Технология изготовления интегральных микросхем. Эпитаксиальнопланарная технология
 Скачать 47.02 Kb. Скачать 47.02 Kb.
|
|
Технология изготовления интегральных микросхем Эпитаксиально-планарная технологияСущность этой технологии состоит в выращивании на поверхности кремния р-типа эпитаксиального слоя, создания в нем карманов n-типа и формировании в них вертикальных n–р–n-транзисторных структур. Технологический процесс состоит из следующих основных операций (рис. 1.14): 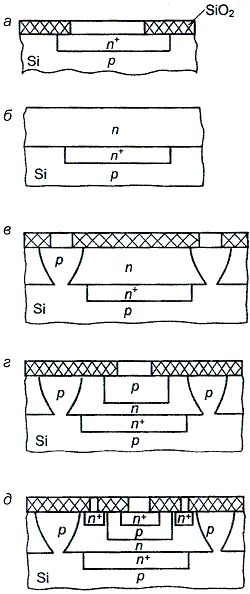 Рис. 1.14 а) на подложке Si р-типа создается слой SiО2, в котором вытравливаются окна для осуществления диффузии доноров, формируется скрытый слой; б) удаляется слой SiO2 и наращивается эпитаксиальный n-слой; в) окисляется поверхность, делаются окна в SiO2, через которые вводят акцепторную примесь, в результате чего эпитаксиальный слой «разрезается» на отдельные островки-карманы с проводимостью n-типа; г) создается новый окисный слой С окном для введения акцепторов, формируется базовая область; д) опять создается новый слой SiO2 с окнами для диффузии доноров, формируется эмиттер и n+-области для осуществления выводов от коллектора. На последующих этапах технологического процесса формируются окна для осуществления выводов от эмиттера, базы и коллектора, напыляется сплошная пленка алюминия и методом фотолитографии формируется рисунок внешних проводниковых соединений на поверхности SiO2. Изопланарная технологияЭтот вариант технологии обеспечивает повышение плотности размещения элементов микросхемы. Технологический процесс состоит из следующих операций (рис. 1.15): 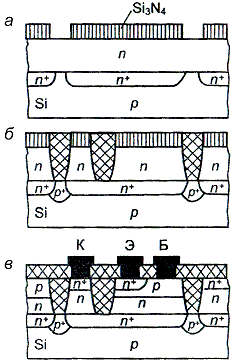 Рис. 1.15 а) в подложке р-типа формируют скрытый слой n+-типа, наращивают эпитаксиальный n-слои, на поверхности которого создают слой нитрида кремния, а в нем окна; б) через окна в пленке нитрида кремния осуществляют травление кремния почти до скрытого n+-слоя и ионную имплантацию противоканальных р-областей, а затем проводят длительное низкотемпературное окисление канавок (глубина травления выбирается такой, чтобы после окисления поверхность подложки была бы ровной); в) удаляется слой нитрида кремния и вместо него на поверхности создается слой диоксида кремния, через окна в котором формируется n–р–n-структура транзистора. В ИС, изготовленных по изопланарной технологии, достигается самая высокая плотность размещения элементов. Технология изготовления МДП-структурТехнология изготовления МДП ИС значительно проще технологии изготовления биполярных интегральных схем. Так, число основных технологических операций примерно на 30 % меньше, чем при изготовлении и биполярных ИС. Наибольший практический интерес представляет изопланарная технология изготовления МДП-структур, особенностью которой является изоляция МДП-структур толстым слоем оксида кремния. Применение этой технологии позволяет совместно формировать на одной подложке как биполярные, так и МДП-структуры. Процесс поэтапного формирования МДП-структуры представлен на рис. 1.16: а) на поверхности кремниевой подложки р-типа формируют маску из нитрида кремния, через отверстия в которой внедряют ионы бора, в результате чего формируются противоканальные р+-области; б) окислением через маску создают разделительные слои диоксида кремния, после чего удаляют слой нитрида кремния, затем ионным легированием бора создают слой с повышенной концентрацией акцепторов, который необходим для снижения порогового напряжения; в) формируют тонкий подзатворный слой диоксида кремния и наносят на него слой поликремния (затвор); г) ионным легированием мышьяка формируют n+-области истока и стока; д) химическим паровым осаждением наносят слой диоксида кремния, формируют в нем окна, напыляют пленку алюминия и методом фотолитографии создают рисунок металлических проводников. |
