Лекции по электронике2. Е. Ю. Салита
 Скачать 10.66 Mb. Скачать 10.66 Mb.
|
|
6.14. Полевые транзисторы Полевым транзистором называется электропреобразовательный прибор, в котором ток канала управляется электрическим полем, возникающим с приложением напряжения между затвором и истоком, и который предназначен для усиления мощности электромагнитных колебаний. Каналом называется центральная область транзистора. Электрод, из которого в канал входят носители заряда, называется истоком, а электрод, через который основные носители уходят из канала – стоком. Электрод, служащий для регулирования поперечного сечения канала, называется затвором. Так как в полевых транзисторах ток определяется движением носителей только одного знака, ранее их называли униполярными, что подчеркивало движение носителей заряда одного знака. Полевые транзисторы изготавливают из кремния и, в зависимости от электропроводности исходного материала, подразделяют на транзисторы с p- каналом и транзисторы с n-каналом. Главное достоинство полевых транзисторов – высокое входное сопротивление. Идея устройства полевого транзистора с управляющим p-n-переходом принадлежит У. Шокли (1952 г.), а транзистора с изолированным затвором – М. Атолле и Д. Кангу (1960 г.). Классификация и условные графические обозначения полевых транзисторов приведены на рис. 6.27.  Рис. 6.27. Классификация и условные графические обозначения полевых транзисторов 6.14.1. Полевой транзистор с управляющим p-n-переходом Полевой транзистор с управляющим p-n-переходом – это транзистор, у которого затвор электрически отделен от канала закрытым p-n-переходом. В транзисторе с n-каналом (рис. 6.28) основными носителями заряда в канале являются электроны, которые движутся вдоль канала от истока с низким потенциалом к стоку с более высоким потенциалом, образуя ток стока Iс. Между затвором и истоком приложено напряжение, запирающее p-n-переход, образованный n-областью канала и р-областью затвора. В полевом транзисторе с n-каналом полярности приложенных напряжений должны быть следующие: Uси110, Uзи 0. В транзисторе с p-каналом основными носителями зарядов являются дырки, которые движутся в направлении снижения потенциала, поэтому полярности приложенных напряжений должны быть иными: Uси 0, Uзи 0. Работа полевого транзистора с n-каналом, а соответственно и изменение поперечного сечения канала происходит при подаче определенных напряжений на электроды транзистора.  а  б Рис. 6.28. Структурная схема (а) и схема включения (б) полевого транзистора с управляющим p-n-переходом (с n-каналом) Рассмотрим работу транзистора на примере трех рисунков. При подаче запирающего (обратного) напряжения Uзи на p-n-переход, между затвором и каналом на границах канала возникает равномерный слой (рис. 6.29), обедненный носителями зарядов и обладающий высоким удельным сопротивлением. Это приводит к уменьшению проводящей ширины канала.  Рис. 6.29. Формирование равномерного обедненного слоя в транзисторе с управляющим p-n-переходом при подаче запирающего напряжения Uзи Напряжение, приложенное между стоком и истоком, приводит к появлению неравномерного обедненного слоя (рис. 6.30), так как разность потенциалов между затвором и каналом увеличивается в направлении от истока к стоку и наименьшее сечение канала расположено вблизи стока.  Рис. 6.30. Формирование неравномерного обедненного слоя в транзисторе с управляющим p-n-переходом при подаче напряжения UСИ Если одновременно подать напряжения Uси > 0 и Uзи 0 (рис. 6.31), то толщина обедненного слоя, а следовательно и минимальное сечение канала будут определяться действием этих двух напряжений. Когда суммарное напряжение достигнет значения напряжения запирания: Uзап = Uси + |Uзи |, обедненные области смыкаются и сопротивление канала резко возрастает.  Рис. 6.31. Формирование неравномерного обедненного слоя в транзисторе с управляющим p-n-переходом при подаче напряжений Uси > 0 и Uзи 0 Включение полевых транзисторов (как и биполярных) может быть произведено по трем схемам: с общим истоком (ОИ), общим стоком (ОС) и общим затвором (ОЗ). Чаще применяется схема с общим истоком (рис. 6.32). В схеме с ОИ цепь сток-исток (с n-типом электропроводности) является выходной цепью усилительного каскада. Эта цепь питается от источника Uси и в нее и включается сопротивление нагрузки. Входная (управляющая) цепь образована с помощью третьего электрода (затвора) с другим типом электропроводности (p-типа). Источник напряжения затвор-исток Uзи создает на p-n-переходе обратное напряжение, которое изменяет ширину запирающего слоя (эффект модуляции ширины базы). Во входную цепь включается источник сигналов (ИС).  Рис. 6.32. Схема включения полевого транзистора с общим истоком 6.14.2. Вольт-амперные характеристики полевого транзистора с управляющим p-n-переходом Схема включения транзистора с управляющим p-n-переходом имеет следующие характеристики (рис. 6.33): – выходную (стоковую) Ic = f(Uси) при Uзи = const; – передаточную (стоко-затворную) Ic = f(Uзи). На выходной (стоковой) характеристике можно выделить три области: – область I – область сильной зависимости тока стока Ic от напряжения Uси; – область II – область слабой зависимости тока стока Ic от напряжения Uси; – область III– область пробоя p-n-перехода. При напряжении Uзи = 0 в области малых значений влияния напряжения Uси на проводимость канала не велико. На участке (0-а) практически линейная зависимость (рис. 6.33, а). С увеличением напряжения Uси (участок (а-б)) сужение токопроводящего канала оказывает существенное влияние на ток стока Iс. Точка (б) – точка смыкания p-n-переходов. Дальнейшее повышение напряжения Uси (в области II) не должно приводить к изменению тока стока Iс. Некоторое увеличение тока стока связано с наличием утечек и влиянием сильного поля в p-n-переходе. Область III – область лавинного пробоя p-n-перехода по цепи «сток-затвор». Напряжение пробоя соответствует напряжению Uси в точке (в).  а б а б Рис. 6.33. Вольт-амперные характеристики транзисторов с управляющим p-n-переходом: а – выходная (стоковая); б – передаточная (стоко-затворная) Приложение к затвору обратного напряжения вызывает сужение канала, поэтому точки б1, б2, … б4 расположены ниже. Важным параметром является значение напряжения Uзи 0 (напряжение запирания или отсечки), при котором ток стока стремится к нулю. Передаточная (стоко-затворная) характеристика Ic = f(Uзи) приведена на рис 6.33, б. При Uзи = 0 ток стока имеет максимальное значение. 6.14.3. Основные параметры полевого транзистора с управляющим p-n-переходом Основными параметрами полевого транзистора с управляющим p-n-переходом являются:
2) максимальное значение напряжения сток-исток Uси макс (в 1,2-1,5 раз меньше напряжения участка сток-затвор (точка в’ ) при Uзи=0); 3) напряжение отсечки (запирания) Uзи 0 = Uзап, при котором ток стока Iс макс стремится к нулю; 4) внутреннее сопротивление (характеризует наклон выходных характеристик на участке II):  (6.23) (6.23) 5) крутизна стоко-затворной характеристики (отражает влияние напряжения Uзи на выходной ток стока Iс ):  (6.24) (6.24) 6) входное сопротивление (определяется сопротивлением p-n-переходов, смещенных в обратном направлении; даже при больших приращениях Uзи приращение тока затвора приблизительно равно нулю, а значит входное сопротивление очень большое):  (6.25) (6.25)7) выходное сопротивление  (6.26) (6.26)В режиме насыщения значительное приращение напряжения dUси вызывает незначительное приращение тока dIс, поэтому выходное сопротивление Rвых большое и составляет десятки кОм; 8) коэффициент усиления  (6.27) (6.27)Показывает во сколько раз изменение напряжения dUзи сильнее влияет на изменение тока dIс, чем напряжение Uси. Обычно = 10-100. 6.14.4. Полевые транзисторы с изолированным затвором В транзисторах с изолированным затвором затвор отделен от полупроводникового канала тонким слоем диэлектрика. Иначе эти приборы называют МДП-транзисторы (металл-диэлектрик-полупроводник). МДП-транзисторы выполняют из кремния. В качестве диэлектрика используют оксид (окисел) кремния SiO2, отсюда и другое название – МОП-транзисторы (металл-оксид-полупроводник). Наличие диэлектрика обеспечивает высокое входное сопротивление (1012-1014 Ом). Принцип действия МДП-транзисторов основан на эффекте изменения проводимости приповерхностного слоя полупроводника на границе с диэлектриком под воздействием поперечного электрического поля. Приповерхностный слой полупроводника является токоведущим каналом. 6.14.4.1. МДП-транзисторы со встроенным каналом Структура и схема включения МДП-транзистора со встроенным каналом приведены на рис. 6.34. В исходной пластине чистого или слаболегированного кремния (p-типа), называемого подложкой, созданы области стока, канала и истока n-типа. Четвертый электрод – подложку в большинстве схем соединяют с истоком (рис. 6.34). Подачей управляющего напряжения Uзи на затвор транзистора, за счет создаваемого электрического поля в его структуре, осуществляется управление величины тока стока Iс. Рассмотрим характеристики МДП-транзистора со встроенным каналом. ВАХ полевых транзисторов с изолированным затвором в основном аналогичны характеристикам транзисторов с управляющим p-n-переходом. Стоковые (выходные) характеристики транзистора Ic = f(Uси) при Uзи = const приведены на рис. 6.35. Изолированный затвор позволяет работать в области положительных значение напряжений затвор-исток Uзи. На рис. 6.35 показаны три семейства выходных характеристик в зависимости от значений напряжения Uзи.  Рис. 6.34. Схема включения МДП-транзистора со встроенным каналом Первое семейство (Uзи = 0). Ток стока Iс определяется исходной проводимостью канала. При малых значениях влияние напряжения Uси на проводимость канала мало, так как по мере приближения к стоку, потенциал возрастает и увеличивается запорный слой (модуляция). При увеличении значений напряжения Uси канал сужается, ток уменьшается. В точке б канал сужается до минимума. Второе семейство (Uзи < 0). При Uзи < 0 электрическое поле выталкивает электроны, что приводит к уменьшению концентрации их в канале, снижая его проводимость. Этот режим называется режимом «обеднения» канала.  Рис. 6.35. Стоковые (выходные) характеристики МДП-транзистора со встроенным каналом Третье семейство (Uзи > 0). При Uзи > 0 электрическое поле притягивает электроны из p-области, увеличивается концентрация их и повышается проводимость канала. Этот режим называется режимом «обогащения» канала носителями. Стоко-затворная (передаточная) характеристика Ic = f(Uзи) при Uси = const приведена на рис. 6.36.  Рис. 6.36. Стоко-затворная (передаточная) характеристика МДП-транзистора со встроенным каналом Меняя полярность и значение напряжения затвор-исток Uзи, можно изменить проводимость канала и, следовательно, ток стока Iс при неизменном значении напряжения сток-исток Uси. В отличие от полевых транзисторов с управляющим p-n-переходом, при этом изменяется не площадь сечения канала, а концентрация основных носителей заряда. 6.14.4.2. МДП-транзистор с индуцированным каналом Схема включения МДП-транзистора с индуцированным каналом приведена на рис. 6.37.  Рис. 6.37. Структурная схема МДП-транзистора с индуцированным каналом Канал проводимости тока в этом типе транзистора не создается, а индуцируется благодаря притоку электронов из p-области при приложении к затвору напряжения положительной полярности. Транзистор с индуцированным каналом работает только в режиме обогащения. ВАХ транзистора с индуцированным каналом приведены на рис. 6.38.  а б а бРис 6.38. Вольт-амперные характеристики транзистора с индуцированным каналом: а – стоковая Ic = f(Uси) при Uзи = const (выходная); б – стоко-затворная Ic = f(Uзи) при Uси = const (передаточная) 6.14.5. Достоинства и недостатки полевых транзисторов Достоинствами полевых транзисторов являются: 1) высокое входное сопротивление, что соответствует повышенному коэффициенту усиления по мощности управления; 2) обусловленность рабочего тока только основными носителями заряда и, как следствие, высокое быстродействие. Время переключения современных МОП-транзисторов составляет единицы наносекунд (10-9с). Такая скорость переключения обусловлена тем, что в них практически исключены токи накопленных зарядов неосновных носителей; 3) почти полное разделение выходного сигнала от входного; 4) малый уровень шумов; 5) возможность работы на высокой частоте (до 100 кГц). К недостаткам полевых транзисторов можно отнести: 1) низкие значения коммутируемого тока (десятки ампер) и напряжения (до 500-600 В); 2) высокие значения прямых потерь вследствие большого сопротивления во включенном состоянии (0,2-0,5 Ом). Полевые транзисторы имеют такую же маркировку как и биполярные, но с заменой второй буквы на букву П. Например, КП-302 А, КП-904 Б. 6.15. Технологии изготовления транзисторов Имеются различные технологические способы изготовления полупроводниковых транзисторных структур: сплавления, диффузии, эпитаксиально-диффузионный, планарно-эпитаксиальный, ионной имплантации и др. При сплавлении на поверхность кремния помещается, например, алюминий и нагревается в атмосфере инертного газа. После охлаждения расплава образуется капля смеси Аl–Si, в которой формируется область, насыщенная акцептором. Эпитаксия представляет метод выращивания кристалла в результате химической реакции на поверхности исходного монокристалла кремния. Через нагретый до 1150 °С очищенный исходный кремний в кварцевом реакторе продувается поток водорода с примесью SiС14 или SiН4, и атомы кремния выпадают в осадок, наращивая кристаллическую решетку подложки. Добавляя в газовую смесь РН3 или В2Н6, можно получить донорную или акцепторную примеси. Получается тонкая пленка с точно дозируемой концентрацией примеси. Метод ионной имплантации связан с воздействием на поверхность кремниевой пластины ионов примеси, разогнанных в вакууме до энергий в несколько килоэлектрон-вольт. Это наиболее контролируемый и точный способ внедрения примеси. Для биполярных транзисторов используются диффузионно-сплавная с меза-структурой и планарная технологии (рис. 6.39). Полупроводниковая структура (рис. 6.39, а), полученная диффузионно-сплавным способом, включает в себя низкоомный высоколегированный кремний (диффузия, эпитаксия), области р- и n-типов (диффузия) с вплавленным электродом базы и область р-типа (сплавление) на границе с металлом вывода эмиттера. Выемка меза-структуры выполнена для ограничения активной области структуры для снижения собственной емкости. Планарная технология (от английского слова planar – плоский) – высокопроизводительный метод группового изготовления полупроводниковых приборов и интегральных микросхем с предварительным нанесением "маски" на кремний. Технология включает в себя следующие основные операции: нанесение тонкой диэлектрической пленки на поверхность кремния, удаление способом фотолитографии или электронно-фотолитографическим способом определенного участка этой пленки, введение в кристалл через образовавшиеся "окна" донорных или акцепторных примесей, металлизация области вывода электродов. Пленка наносится на исходную кремниевую подложку, чтобы предотвратить проникновение примеси в определенные области структуры. Наиболее удобна "маска" из слоя SiO2. Для этого кремниевая пластина помещается в печь и нагревается в атмосфере влажного кислорода. Образуется пленка SiO2 толщиной около 1 мкм. 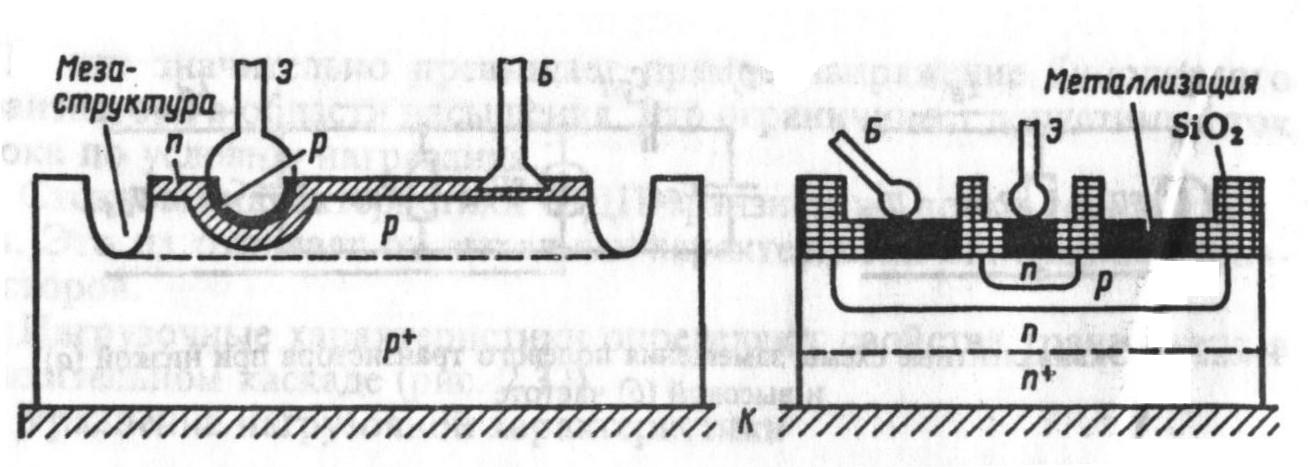 а б Рис. 6.39. Диффузионно-сплавная (а) и планарная (6) полупроводниковые структуры биполярных транзисторов Планарная полупроводниковая структура (рис. 6.39, 6) получена диффузией алюминия в исходный кремний n-типа. Эмиттерный переход и n+-слой сформированы диффузией фосфора в исходный кремний n-типа со стороны вывода коллектора и в диффузионный p-слой через центральное "окно" в пленке SiO2. Металлизация выполнена напылением алюминия. Подобная технология обеспечивает получение высокоомного коллектора, что по мере увеличения напряжения на коллекторе приводит к расширению объемного заряда в основном в сторону коллектора. Благодаря этому эффект модуляции базы выражен незначительно. Высокоомный слой в ключевом режиме транзистора вызывает значительное падение напряжения на коллекторе. Такая структура используется в высоковольтных транзисторах. В этом случае применяется кремниевая структура в форме диска (как в диодах), выполняется фаска. Для снижения толщины высокоомного слоя коллектора в низковольтных транзисторах применяется эпитаксиальное наращивание тонкого n-слоя на исходной пластине низкоомного n+-кремния. Для уменьшения явления вытеснения эмиттерного тока в небольшой участок около базового вывода применяют специальную разветвенную сеть базовых и эмиттерных электродов мощных транзисторов. Применяется гребенчатая, эвольвентная и многоэмиттерная конструкция эмиттерных переходов. Полупроводниковые структуры полевых транзисторов изготавливаются методом планарной технологии. Полупроводниковая структура транзистора обычно помещается в герметический корпус из металла (рис. 6.40, а), пластмассы или керамики. Транзисторы малой мощности могут изготавливаться в бескорпусном исполнении (рис. 6.40, б). В транзисторе с металлическим корпусом полупроводниковая структура 1 закрепляется на коваровом фланце 2, электроды эмиттера и базы (истока и затвора) 3 выводятся из корпуса через стеклянные изоляторы 4. Герметический корпус 5 приваривается к фланцу швом холодной сварки 6. Размеры транзистора такой конструкции могут иметь значения: Н = 2,5 + 12 мм и D1=13,7 + 30 мм. Мощные транзисторы на токи до сотен ампер имеют конструкцию, аналогичную силовым диодам, имеющую дополнительный третий вывод.  а б Рис. 6.40. Конструкции транзисторов в металлическом корпусе (а) и бескорпусные (б) На рис. 6.40, б показан один из видов бескорпусного транзистора, используемого в гибридных микросхемах с гибкими выводами. К полупроводниковому кристаллу 1 методом термокомпрессии припаивают к контактным площадкам гибкие выводы 2 из золотой проволоки диаметром 30-50 мкм. Выводы дополнительно механически закрепляют с помощью защитного компаунда 3. Кроме указанных основных конструктивных типов различают транзисторы других модификаций р–n–р- и n–р–n-типов, в стеклянно-металлическом, пластмассовом и металлокерамическом корпусах, с гибкими и жесткими выводами. |
