Руководство по применению IGBT и IPM. Руководство по применению биполярных транзисторов с изолированным затвором
 Скачать 1.65 Mb. Скачать 1.65 Mb.
|
|
3.3. Область безопасной работы Защита IGBT от повреждений, вызванных перегрузкой по току или по напряжению, является важной проблемой проектирования в большинстве применений, связанных с переключениями IGBT. В случае жесткого переключения, например в инверторе или схемах прерывате- ей для управления двигателем и нагрузкой преобразователя, об- асть безопасной работы при выключениях и стойкость к коротким замыканиям являются двумя наиболее важными регламентированными величинами для IGBT. 3.3.1. Область безопасной работы при выключении IGBT Область безопасной работы (SOA) при выключении очень похожа на область безопасной работы при обратном смещении дарлингтоновс- ких транзисторов (RBSOA). Процесс переключения в типичной мосто- вой схеме инвертора (рисунок 3.11) будет характеризоваться током - 67 - и напряжением, показанными на рисунке 3.12. При выключении тока индуктивной нагрузки возрастание напряжения предшествует спаду тока. Когда напряжение на затворе снижается до величины ниже его порогового значения, интраструктурный канал MOSFET блокируется и инжекция электронов прекращается. Начинается перемещение накоп- енных неосновных носителей (дырок) в “п-” области базы, и в те- чение этого интервала времени р-п-р транзистор с широкой базой работает благодаря своим характеристикам усиления по току, вызы- вая продолжение протекания тока коллектора. Таким образом, хвос- товая часть тока при выключении IGBT существует главным образом благодаря току “дырок”. Некоторые из дырок в “п-” области базы продолжают пересекать С-В-переход паразитного п-р-п транзистора и перемещаться горизонтально ниже “п-” слоя эмиттера (рисунок 3.13.).  Рис.3.11. Полумостовая схема проверки переключений  Рис.3.12. Осциллограммы тока и напряжения при переключении (полумостовой инвертор) Этот поток дырок вызывает падение потенциала через сопротив- ение р-тела, RD , и стремится активизировать п-р-п транзистор. - 68 - Включение п-р-п транзистора в то время, как р-п-р транзистор все еще включен, может привести к запиранию р-п-р транзистора, что означает потерю управления затвором и в конце концов к разрушению устройства. Данная проблема устранена в IGBT фирмы Митсубиси пу- тем тщательной оптимизации геометрии устройства. 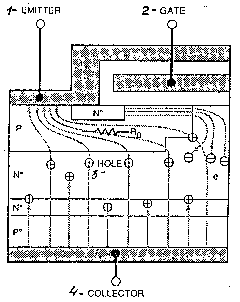 Рис. 3.13. Высокая инжекция. Электронный и дырочный токи рабочего состояния внутри структуры IGBT 1 - эмиттер 2 - затвор 3 - дырка 4 - коллектор - 69 -  Рис. 3.14. Область безопасной работы при выключении и схема проверки 1 - предел для 2 - переменная 3 - переменное (внешнее сопротивление затвора) Кривая области безопасной работы при переключении является геометрическим местом точек, определяющих допустимое одновремен- ное наличие тока коллектора и напряжения между коллектором и эмиттером во время выключения. Рисунок 3.14. показывает, что IGBT Н-серий имеют область безопасной работы прямоугольной формы для устройств на 600 В и 1200 В при двухкратном регламентированном токе. 3.3.2. Область безопасной работы при коротком замыкании Большинство устройств преобразования энергии требует, чтобы примененный переключатель выдерживал короткое замыкание на выходе системы без каких либо повреждений. При обсуждении способности противостоять коротким замыканиям модулей IGBT обычно рассматри- ваются два различных случая: - 70 - Случай 1 -> включение IGBT в цепи короткозамкнутого контура Случай 2 -> короткое замыкание нагрузки или замыкание на землю через включенный IGBT. На рисунке 3.15. показаны схемы и осциллограммы для каждого случая. В случае 1, когда IGBT включается, начальная скорость подъема IC определяется индуктивностью монтажа L1 . Во время заряда индуктивности L1 напряжение VCE падает до некоторой величины ниже напряжение VCC. Вскоре после этого напряжение VCE переключается обратно до почти полного напряжения VCC. Величина dv/dt при об- ратном переключении связана с емкостью затвора через емкость об- ратной передачи, т.о. вызывая мгновенный подъем напряжения на затворе. Это избыточное напряжение на затворе мобилизует большую электронную и дырочную плазму внутри структуры модуля IGBT. Это, в свою очередь, приводит к увеличению амплитуды тока коллектора в течение нескольких микросекунд. Схемные решения (т.е. компоновка, условия смещения, выбор Rg , максимальное напряжение питания и т.п.) важны для ограничения величины тока короткого замыкания в этом состоянии высокой инжекции.  Рис. 3.15. Случаи короткого замыкания 1 - короткое замыкание 2 - IGBT включен - 71 - 3 - включенное состояние 4 - нагрузка закорочена 5 - случай Благодаря высокой плотности тока внутри силикона внутренняя температура IGBT поднимается и это приводит к снижению амплитуды тока короткого замыкания до величины, которая соответствует так называемому току насыщения. Для защиты устройства от разрушения этот ток необходимо отключить в пределах оговоренного интервала времени, который обычно определяется шириной входного импульса затвора,tw. При выключении IGBT быстрый спад тока коллектора че- рез индуктивность проводников питания L1, вызывает выброс напря- жения VCE, равный VCE = L1 diC /dt Мгновенное значение напряжения коллектор - эмиттер, VCE, включая указанный выброс напряжения, не должно выходить за уста- новленные пределы напряжения, указанные в SCSOA - (см. рис. 3.16.). - 72 -  Рис. 3.16. SCSOA - область безопасной работы при коротком замыкании 1 - условия В случае 2 внешнее короткое замыкание возникает, когда IGBT уже находится во включенном состоянии (см. рис. 3.15b). Возраста- ющий ток короткого замыкания заставляет чип IGBT выйти из насыще- ния, вызывая подъем напряжения коллектор - эмиттер от величины VCE(sat) до почти полного напряжения VCC. Скорость изменения нап- ряжения dv/dt в течение выхода IGBT из насыщения может быть выше, чем в случае 1, и имеет обратную связь через емкость обратной пе- редачи, которая в этом случае выше при малом напряжении насыщения и может привести к более высокому всплеску напряжения на затворе. - 73 - В результате величина тока короткого замыкания в случае 2 может достигать значительно более высоких значений, чем в случае 1. На рисунке 3.16. самоограничение тока короткого замыкания для случая 1 показано белым участком диаграммы. В случае 2 должны быть пре- дусмотрены все меры для того, чтобы ток короткого замыкания не возрос более десятикратного регламентированного тока, являющегося абсолютным пределом (затемненный участок на рисунке 3.16.). Примечания 1. SCSOA действительна для длительности импульса на затворе tw <,= 10 мкс. 2. SCSOA характеризует устойчивость к неповторяющимся корот- ким замыканиям. Модули IGBT Н-серий могут выдерживать до100 случаев короткого замыкания. 3.4. Кривые рабочих характеристик Кривые показывают типовые электрические характеристики и максимальный переходный тепловой импеданс IGBT и рекуперационного диода. 3.4.1. Выходные характеристики Выходные характеристики определяют величину напряжения VCE, которое имеет IGBT при протекании заданного IC для заданного зна- чения VCE. IGBT предназначен для работы в ключевом режиме, и диа- пазон практического использования напряжения VCE ограничен об- ластью насыщения. 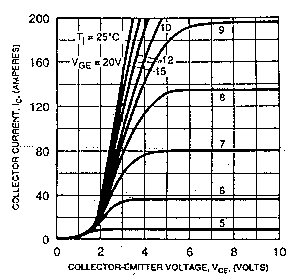 Рис. 3.17. Выходные характеристики (типовые) - 74 - 3.4.2. Напряжение насыщения коллектор - эмиттер Напряжение VCE(sat) (падение напряжения IGBT во включенном состоянии) является функцией температуры р-п перехода, тока кол- ектора и напряжения затвор - эмиттер. Большее напряжение VGE увеличивает проводимость канала и, следовательно, понижает VCE(sat)(см. рис. 3.19.). Напряжение VCE(sat) также увеличивается с увеличением тока. Напряжение VCE(sat) IGBT Н-серий уменьшается при малых токах IС с увеличением температуры, т.е. оно имеет отрицательный температур- ный коэффициент, тогда как после точки перехода температурный ко- эффициент становится положительным (см. рис. 3.18.). 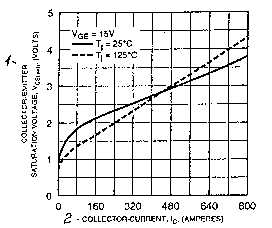 Рис. 3.18. Зависимость напряжения насыщения коллектор - эмиттер от тока IС 1 - напряжение насыщения коллектор - эмиттер 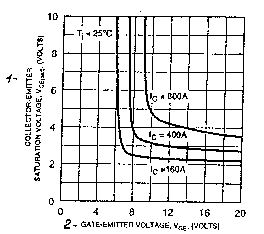 2 - ток коллектора IС (амперы) 2 - ток коллектора IС (амперы)Рис. 3.19. Зависимость напряжения насыщения коллектор - эмиттер от VGE 1 - напряжение насыщения коллектор - эмиттер 2 - напряжение затвор - эмиттер (вольты) - 75 - 3.4.3. Емкость устройства Так как IGBT является МОП - устройством, управляемым затво- ром, он имеет три характерных емкости: Cjes, Coes и Cres. Эти ем- кости указаны в справочных данных потому что их легко измерить. Они могут быть использованы для определения емкостей р-п перехода IGBT и диффузионных физических емкостей CGE, CGC и CCE по форму- ам, приведенным в таблице ниже Cjes = CGE + CGC (параллельное соединение) (измеряется при закороченном С-Е) Coes = CCE + CGC (параллельное соединение) (измеряется при закороченном G-Е) Cres = CGC 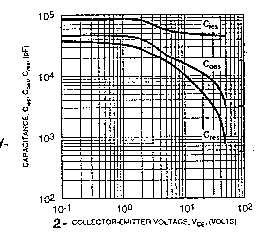 Рис.3.20. Типовые значения емкостей IGBT 1 - емкость 2 - напряжение коллектор - эмиттер (вольты) Все три указанные емкости малы, когда устройство находится в выключенном состоянии. Однако большая доля диффузионной емкости, которая содержится в емкости “ затвор - коллектор”, приводит к их существенному увеличению при малых напряжениях коллектор - эмит- тер (рис.3.20.). Кривые входной емкости приведены для напряжения VGE = 0 В. 3.4.4. Заряд на затворе Так как входная емкость изменяется с изменением напряжения VCE, для определения энергии, требуемой для включения и выключе- - 76 - ния IGBT, применяется другой параметр: количество заряда, накоп- енного на затворе. Кривая зависимости заряда QG от напряжения VGE (см. рис. 3.21a) показывает заряд, необходимый для переключе- ния IGBT. Первый наклон кривой соответствует входной емкости в промежутке времени, когда напряжение VCE = VCC. Когда напряжение VGE достигает порогового напряжения VGE(th), IGBT включается и напряжение VCE уменьшается. В течение спада напряжения VCE ем- кость CCG быстро возрастает, т.о. предупреждая дальнейшее увели- чение напряжения VGE свыше порогового напряжения VGE инжектиро- ванным зарядом затвора. После того, как IGBT полностью включает- ся, величина емкости снова стабилизируется и инжектированный за- ряд на затворе приводит к дальнейшему увеличению напряжения VGE. При выключении IGBT требуется рассосать такой же заряд в противоположном направлении. 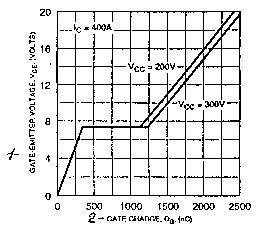 Рис. 3.21а. Заряд на затворе (типовая характеристика) - VGE 1 - напряжение затвор - эмиттер VGE (в вольтах) 2 - заряд на затворе (нК) 3.4.5. Характеристики переключений Время переключений, указанное в справочных данных как элект- рические характеристики, дано для переключения резистивной наг- рузки, а кривые рабочих характеристик представлены для полумосто- вой индуктивной нагрузки. Время переключений определяется по рис.3.9. и показано на рисунке 3.21b. ton = td(on) + tr toff = td(off) + tf Время задержки включения td(on) - это время, требуемое для - 77 - притягивания избыточных электронов в область, находящуюся непос- редственно под затвором. Время нарастания tr - это время, требуемое для увеличения тока коллектора от 10% до 90% его конечного значения. Время на- растания ограничивается, главным образом, характеристиками импе- данса затвора, которые частично являются функцией геометрии кон- такта затвора и частично - функцией входных емкостей, рассмотрен- ных выше. 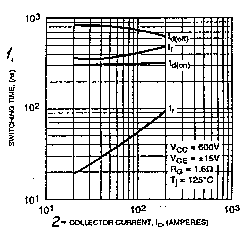 Рис. 3.21b. Характеристики переключения полумостовой схемы (типовые) 1 - время переключений (нс) 2 - ток коллектора, IC (в амперах) Время задержки выключения td(off) определяется, главным об- d(off) разом, емкостью затвора, ограничивающей скорость разряда области под затвором. Поскольку зарядам не требуется покидать силиконовый кристалл, как в случае с биполярными устройствами, время задержки выключения IGBT значительно короче, чем время сохранения заряда у биполярных устройств. Время спада tf не зависит от емкости устройства. Оно включа- ет время, необходимое для рекомбинации избыточных носителей, на- копленных в п- буфере (хвостовая часть тока). 3.4.6. Характеристики рекуперационного диода На рисунке 3.22. показано падение напряжения VCE между ано- дом и катодом при протекании прямого тока через рекуперационный диод. - 78 - 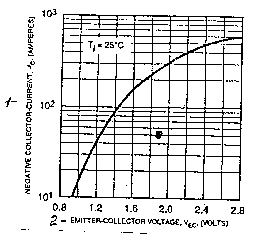 Рис.3.22. Прямые характеристики рекуперационного диода (типовые значения) 1 - отрицательный ток коллектора (в амперах) 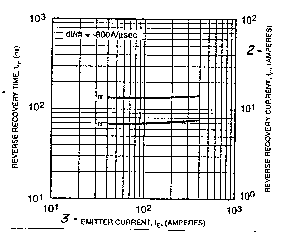 2 - напряжение эмиттер - коллектор (в вольтах) 2 - напряжение эмиттер - коллектор (в вольтах)Рис.3.23. Типовые характеристики обратного восстановления рекуперационного диода 1 - время обратного восстановления (нс) 2 - ток обратного восстановления (амперы) 3 - ток эмиттера (амперы) Типовые характеристики обратного восстановления рекупераци- онного диода (антипараллельного IGBT) показаны на рисунке 3.23. Измерения выполнены для схемы, работающей как полумост с индук- тивной нагрузкой (рис. 3.10.) Малые значения времени trr и тока Irr, а также их относи- тельная независимость от прямого тока являются уникальной особен- ностью рекуперационных диодов, примененных в модулях IGBT Н-се- рий. - 79 - 3.4.7. Переходный тепловой импеданс Переходный тепловой импеданс Zth(j-c) показывает подъем тем- пературы р-п перехода относительно температуры корпуса на каждую единицу мощности, приложенной в течение заданного промежутка вре- мени (рисунки 3.24. и 3.25.) 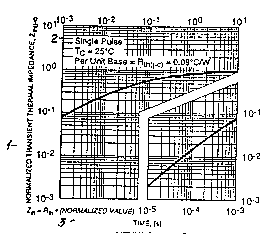 Рис. 3.24. Характеристики переходного теплового импеданса (часть IGBT) 1 - нормированный тепловой импеданс 2 - одиночный импульс 3 - нормированная величина 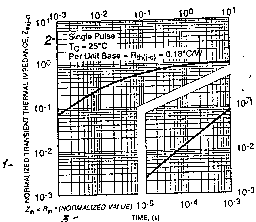 Рис. 3.25. Характеристики переходного теплового импеданса (часть рекуперационного диода) 1 - нормированный тепловой импеданс 2 - одиночный импульс 3 - нормированная величина - 80 - Примечание. Величина Zth(j-c) получается путем умножения значения Rth(j-c) на нормированный коэффициент, взятый по кривым для инте- ресующего нас момента времени. Тепловое сопротивление в установившемся режиме Rth(j-c) - это установившееся значение Zth(j-c). Если оно меньше, максималь- ные допустимые потери мощности (РC ) устройства становятся больше. Tj(max) - TC PC = —————————— Rth(j-c) |
