Руководство по применению IGBT и IPM. Руководство по применению биполярных транзисторов с изолированным затвором
 Скачать 1.65 Mb. Скачать 1.65 Mb.
|
|
3. ИСПОЛЬЗОВАНИЕ МОДУЛЕЙ IGBT Модули IGBT Н-серий третьего поколения фирмы Митсубиси сконструированы стойкими, имеющими низкие потери и легкими в при- менении. Применение передовых технологий обработки дает IGBT Н-серий малое напряжение насыщения при высокой скорости переклю- чения, требующейся для работы на частоте 20 кГц. Представленная в данном разделе информация поможет пользователям модулей IGBT Н-серий применять данные устройства эффективно и надежно. 3.1. Структура и работа модуля IGBT IGBT - биполярный транзистор с изолированным затвором - это переключающий транзистор, который управляется напряжением, прик- адываемым к затвору. Работа устройства и его структура подобны работе и структуре полевых транзисторов с изолированным затвором, более известным, как MOSFET (МОП - транзисторы). Принципиальное различие между двумя типами устройств заключается в том, что IGBT использует модуляцию проводимости для снижения потерь электропро- водности в рабочем режиме. Краткое сравнение структур IGBT, MOSFET и n-p-n биполярного транзистора (BJT) представлено на рис. 3.1. n-p-n BJT - трехпереходное устройство, требующее про- должительного протекания тока в области базы для подачи достаточ- ных зарядов, позволяющих переходам проводить ток. Т.к. MOSFET и IGBT являются устройствами, управляемыми напряжением, им требует- ся только наличие напряжения на затворе для поддержания проводи- мости через устройство. IGBT имеет на один p-n переход больше, чем MOSFET, и это позволяет осуществить модуляцию проводимости, как описано ниже. Однако, этот дополнительный p-n переход в IGBT ограничивает частоту переключений. - 55 -  Рис. 3.1. Внутренняя структура трех основных полупроводниковых устройств 1 - n-p-n силовой биполярный; 2 - n-канальный силовой MOSFET4 3 - n-канальный силовой IGBT; 4 - малое падение напряжения в открытом состоянии; 5 - устройство управления током, большая мощность управле- ния; 6 - средняя скорость переключений; 7 - большое падение напряжения в открытом состоянии для основных носителей; 8 - управление напряжением, малая мощность управления; 9 - очень быстрое переключение; 10 - среднее падение напряжения в открытом состоянии; 11 - управление напряжением, малая мощность управления; 12 - быстрое переключение; 13 - преимущество; 14 - недостаток. - 56 - 3.1.1. Силиконовая структура Силиконовая структура IGBT показана на рисунке 3.2. Положи- тельное напряжение на затворе притягивает электроны из “р” облас- ти затвора по направлению к силиконовой поверхности под затвором. эти электроны преобразуют “р” область непосредственно под затво- ром в “п” область, создавая путь для протекания заряда между “п” областью коллектора и “п” областью эмиттера. Нулевое или отрица- тельное напряжение (в зависимости от устройства) на затворе соз- дается выключающим смещением. 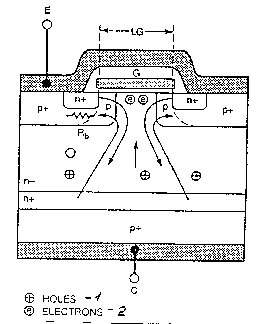 Рис. 3.2. Разрез IGBT и силиконовая структура 1 - дырки 2 - электроны 3.1.2. Работа устройства Когда устройство включено, коллектор находится под более вы- соким напряжением чем эмиттер и, следовательно, неосновные носи- тели инжектируются из р+ области коллектора в область объема бу- фера коллектора (п+ буферный слой и “п” область коллектора). Под- вижные “n” и “p” заряды снижают сопротивление области объема бу- фера коллектора и поэтому падение напряжения коллектор - эмиттер снижается (относительно VDS(on) MOSFET, где имеются только “п” носители). При первой подаче положительного напряжения на затвор ток затвора протекает до тех пор, пока не зарядится емкость затвора и напряжение затвора поднимется до уровня “включение”. При снятии - 57 - напряжения с затвора заряды, инжектированные в область буфера коллектора должны быть устранены до того, как высокое напряжение может быть снято. Поверхность эмиттера IGBT состоит из совокупности полос в противоположность ячеисто-базовой геометрии полевого транзистора. IGBT использует те же преимущества малых устройств что и MOSFET, но полосовая геометрия дает большую механическую прочность и ус- тойчивость к запиранию паразитного тиристора, показанного на ри- сунке 3.3а. Модель типичного IGBT показана на рисунке 3.3b. В IGBT Н-серий применены оптимизированные буферный слой, р± хорошее легирование и выравнивание, конструкция затвора и конструкция по- верхностной кристаллической решетки. Технология управления време- нем жизни неосновных носителей позволяет снизить коэффициент уси- ения “р-п-р” биполярного элемента и свести до минимума побочное значение RBE, т.о. предотвращая самопроизвольное запирание. Сле- довательно, эквивалентная схема IGBT Н-серий сводится к схеме, приведенной на рис.3.3b. 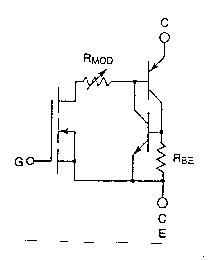 Рис. 3.3а. Модель обычного типа - 58 - 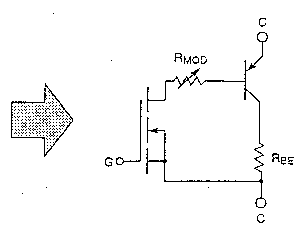 Рис. 3.3b. Модель усиленного IGBT Н-серий 3.1.3. Обработка плат Силиконовый материал является двойной эпитаксиальной струк- турой, и области затвора и эмиттера являются диффузными и/или ионноимплантируемыми в эмиттер. При обработке области эмиттера применяются выборочное легирование, электронное облучение и дру- гие технологические методы обработки. 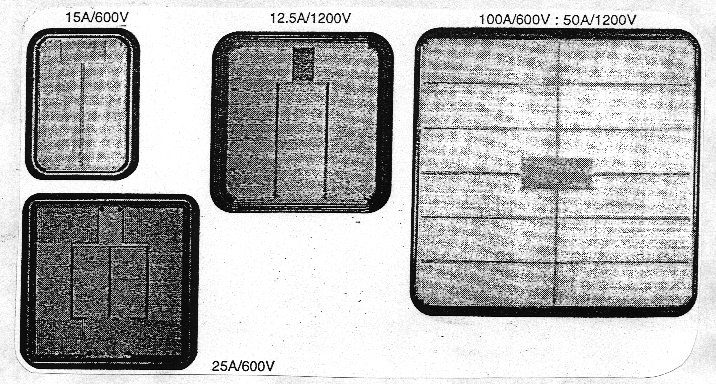 Рис.3.4. Чипы IGBT При производстве IGBT применяются многие технологические ме- тоды обработки, аналогичные технологии изготовления FET устройств - 59 - (полевых транзисторов). Высокая стойкость к пробою вследствие быстрого нарастания тока di/dt и напряжения dv/dt полевых тран- зисторов FET происходит в результате управления неосновными носи- телями вблизи “р” области и границы “п-” области коллектора. Та- кая технология плюс дополнительные шаги по управлению продолжи- тельностью жизни носителей носителей вблизи “п+” буферной области коллектора помогают выработать устойчивость к запиранию и повы- сить механическую прочность при переключениях IGBT Н-серий. Сверхчистое оборудование и последовательные проверки плат способствуют согласованной обработке, т.о. обеспечивая наивысшее качество и надежность чипов. 3.1.4. Компоновка модулей Конструкция и расположение Модули IGBT состоят из нескольких чипов, смонтированных на изолированной подложке, которая, в свою очередь, смонтирована на теплоотводящей медной пластине. модули IGBT Н-серий используют базовую пластину с изолирую- щей подложкой, непосредственно связанной медной пайкой с базовой пластиной (рисунок 3.6.). Этот метод монтажа позволяет осущест- влять высокоавтоматизированную сборку модулей при минимальном тепловом импедансе. IGBT модули Н-серий используют материалы с близкими тепловыми коэффициентами расширения, так что тепловая нагрузка невелика. Поэтому можно ожидать, что IGBT модули Н-серий обеспечат большую продолжительность жизни при периодических изме- нениях температуры, чем существующие транзисторные модули. Рекуперационные диоды также монтируются в модуле для облег- чения сборки системы и сведения до минимума индуктивности выво- дов, как внутри, так и снаружи модуля. Соединения внутри модуля выполняются с применением массивных шин для облегчения сборки. Шины также позволяют симметричное размещение внутренних компонен- тов так, что паразитная индуктивность снижается и механическая прочность модуля повышается. Пример компоновки модуля показан на рисунке 3.5. - 60 - 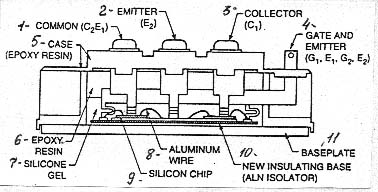 Рис. 3.5. Конструкция модуля IGBT Н-серий 1 - общий 2 - эмиттер 3 - коллектор 4 - затвор и эмиттер 5 - корпус (эпоксидная смола) 6 - эпоксидная смола 7 - силиконовый гель 8 - алюминиевый провод 9 - силиконовый чип 10 - новое изолирующее основание 11 - основание (ALN изолятор) 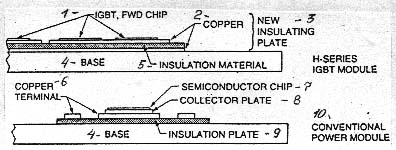 Рис.3.6. Конструкция основания силового модуля 1 - IGBT, чип рекуперационного диода 2 - медь 3 - новая изолирующая пластина 4 - база 5 - изоляционный материал 6 - медный вывод 7 - полупроводниковый чип 8 - пластина коллектора 9 - изоляционная пластина 10 - силовой модуль обычного типа - 61 - 3.2. Номинальные значения параметров и характеристик IGBT модулей 3.2.1. Максимальные регламентированные значения Регламентированные величины, как показано ниже, наиболее важны для работы IGBT и окружающей среды. Максимальное регламен- тированное значение - это величина, которая определяется либо са- мим устройством, либо условиями эксплуатации (максимальными или минимальными) для электронного устройства. Оно определяется для установленного значения условий окружающей среды и рабочего режи- ма. Нельзя использовать IGBT модуль за пределами его максимальных или минимальных регламентированных значений. +————————————————————————————————————————————————————————————————+ ¦Обозначение¦ Параметр ¦ Определение ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ VCES ¦Напряжение кол-¦Макс. допустимое напряжение кол-¦ ¦ ¦лектор-эмиттер в¦лектор-эмиттер в выключенном сос-¦ ¦ ¦выключенном сос-¦тоянии при закороченном с эмитте-¦ ¦ ¦тоянии ¦ром затворе ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ VGES ¦Напряжение зат-¦Макс. допустимое напряжение зат-¦ ¦ ¦вор-эмиттер ¦вор-эмиттер при закороченном с¦ ¦ ¦ ¦эмиттером коллекторе ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ IС ¦Ток коллектора ¦Макс. постоянный ток ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ ICM ¦Амплитудное зна-¦Макс. допустимая амплитуда тока¦ ¦ ¦чение тока кол-¦коллектора (Tj <=150°C) ¦ ¦ ¦лектора ¦ ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ IE ¦Ток рекуперацион-¦Макс. допустимый постоянный ток¦ ¦ ¦ного диода ¦рекуперационного диода ¦ +———————————+—————————————————+——————————————————————————————————¦ - 62 - +———————————+—————————————————+——————————————————————————————————¦ ¦ IEM ¦Амплитудное зна-¦Макс. допустимая амплитуда тока¦ ¦ ¦чение тока реку-¦рекуперационного диода (Tj<=150 C)¦ ¦ ¦перационного дио-¦ ¦ ¦ ¦да ¦ ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ PC ¦Рассеяние на кол-¦Макс. допустимое рассеяние мощнос-¦ ¦ ¦лекторе ¦ти на каждое переключение IGBT при¦ ¦ ¦ ¦T = 25 C ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Tj ¦Температура пере-¦Диапазон допустимых температур р-п¦ ¦ ¦хода ¦перехода IGBT во время работы ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ TStg ¦Температура хра-¦Диапазон допустимых температур ок-¦ ¦ ¦нения ¦ружающей среды без приложения к¦ ¦ ¦ ¦модулю напряжения или протекания¦ ¦ ¦ ¦тока ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ VISO ¦Пробивное напря-¦Макс. напряжение (переменный ток,¦ ¦ ¦жение ¦f= 60 Гц, 1 мин.) между основанием¦ ¦ ¦ ¦и выводами модуля (все силовые и¦ ¦ ¦ ¦сигнальные выводы закорочены сна-¦ ¦ ¦ ¦ружи модуля ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ - ¦Монтажное усилие ¦Макс. допустимое монтажное закру-¦ ¦ ¦ ¦чивающее усилие для выводов и мон-¦ ¦ ¦ ¦тажных винтов ¦ +———————————+—————————————————+——————————————————————————————————¦ - 63 - 3.2.2. Электрические характеристики +————————————————————————————————————————————————————————————————+ ¦Обозначение¦ Параметр ¦ Определение ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ ICES ¦Ток утечки кол-¦IC при VCE =VCES и закороченных вы-¦ ¦ ¦лектор-эмиттер ¦водах затвор-эмиттер ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ VGE(th) ¦Пороговое напря-¦Напряжение затвор-эмиттер при¦ ¦ ¦жение зат-¦IC =10-4 * (номинальное значение¦ ¦ ¦вор-эмиттер ¦тока коллектора) и напряжении¦ ¦ ¦ ¦VCE=10 В ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ IGES ¦Ток утечки зат-¦IG при VGE = VGES и закороченных вы-¦ ¦ ¦вор-эмиттер ¦водах коллектор-эмиттер ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ VCE(sat) ¦Напряжение насы-¦Напряжение IGBT во включенном сос-¦ ¦ ¦щения коллек-¦тоянии при регламентированном токе¦ ¦ ¦тор-эмиттер ¦коллектора и установленных услови-¦ ¦ ¦ ¦ях (см. рис. 3.7.) ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Cies ¦Входная емкость ¦Емкость затвор-эмиттер при закоро-¦ ¦ ¦ ¦ченных выводах коллектора и эмит-¦ ¦ ¦ ¦тера ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Coes ¦Выходная емкость ¦Емкость коллектор-эмиттер при за-¦ ¦ ¦ ¦короченных выводах затвора и эмит-¦ ¦ ¦ ¦тера ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Cres ¦Емкость обратной¦Емкость затвор-коллектор ¦ ¦ ¦связи ¦ ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ QG ¦Общий заряд зат-¦Заряд на затворе при VCC =0,5 или¦ ¦ ¦вора ¦0,6 VCES,регламентированное значе-¦ ¦ ¦ ¦ние тока IC; VGE=15 В ¦ +———————————+—————————————————+——————————————————————————————————¦ - 64 - +———————————+—————————————————+——————————————————————————————————¦ ¦ td(on) ¦Время задержки¦резистивная нагрузка ¦ ¦ ¦включения ¦ ¦ +———————————+—————————————————¦ ¦ ¦ tr ¦Время нарастания¦время переключений ¦ ¦ ¦при включении ¦ ¦ +———————————+—————————————————¦ ¦ ¦ td(off) ¦Время задержки¦при регламентированных условиях¦ ¦ ¦выключения ¦(см. рис. 3.9.) ¦ +———————————+—————————————————¦ ¦ ¦ tf ¦Время спада при¦ ¦ ¦ ¦включении ¦ ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ VEC ¦Прямое напряжение¦Прямое напряжение рекуперационного¦ ¦ ¦рекуперационного ¦диода при регламентированном токе¦ ¦ ¦диода ¦и стандартизованных условиях (см.¦ ¦ ¦ ¦рис. 3.8.) ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ trr ¦Время восстанов-¦Время обратного восстановления FWD¦ ¦ ¦ления рекупераци-¦при переключениях индуктивной наг-¦ ¦ ¦онного диода ¦рузки (см. рис.3.10.) ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Qrr ¦Заряд обратного¦Заряд обратного восстановления FWD¦ ¦ ¦восстановления ¦при регламентированном токе и¦ ¦ ¦рекуперационного ¦di/dt=-IEM-мкс ¦ ¦ ¦диода ¦ ¦ +————————————————————————————————————————————————————————————————+ - 65 - 3.2.3. Тепловое сопротивление +————————————————————————————————————————————————————————————————+ ¦Обозначение¦ Параметр ¦ Определение ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Rth(j-c) ¦Тепловое сопро-¦Макс. значение теплового сопротив-¦ ¦ ¦тивление “р-п пе-¦ления между р-п переходом и корпу-¦ ¦ ¦реход - корпус” ¦сом на каждое переключение ¦ +———————————+—————————————————+——————————————————————————————————¦ ¦ Rth(c-f) ¦Контактное тепло-¦Макс. значение теплового сопротив-¦ ¦ ¦вое сопротивление¦ления между корпусом и пластиной¦ ¦ ¦ ¦на каждое переключение (пара IGBT¦ ¦ ¦ ¦- FWD) при тепловой смазке, приме-¦ ¦ ¦ ¦ненной в соответствии с рекоменда-¦ ¦ ¦ ¦циями по монтажу ¦ +————————————————————————————————————————————————————————————————+ 3.2.4. Схемы и условия проверки Для оценки характеристик IGBT применяются следующие схемы проверки. При измерениях температуры р-п перехода Tj, измерения напря- жений VCE(sat) и VCE должны проводится кратковременно и с большой скважностью. 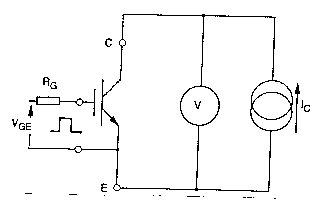 Рис. 3.7. Проверка напряжения VCE(sat) IGBT  Рис. 3.8. Проверка напряжения VCE диода - 66 -  Рис. 3.9. Проверка параметров переключений при резистивной нагрузке 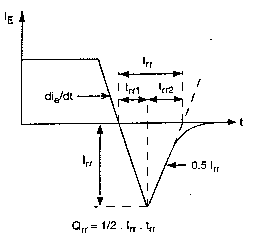 Рис. 3.10. Осциллограмма тока при восстановлении диода |
