Териалы электронной техники
 Скачать 2.56 Mb. Скачать 2.56 Mb.
|
kT, способна разорвать химическую связь, что приводит к образованию равного количества электронов в зоне проводимости ni и дырок в валентной зоне pi. Процесс термогенерации носителей заряда носит вероятностный характер, и в случае генерации собственных носителей заряда их концентрации определяются соотношением 1.5. Контрольные вопросы1. Почему металлы обладают высокой электрической проводимостью? 2. Чем обусловлено возрастание удельного сопротивления металлов при нагревании? 3. Почему удельное сопротивление металлических сплавов типа твердых растворов выше, чем у чистых металлов, являющихся компонентами сплава? 4. Почему металлические сплавы обладают меньшим температурным коэффициентом удельного сопротивления, чем чистые металлы? 5. При каких условиях возникает термоэлектродвижущая сила? 2. Исследование электрических свойств полупроводниковых материалов Цель работы: сравнение температурных зависимостей сопротивления полупроводников с различной шириной запрещённой зоны; определение ширины запрещённой зоны и энергии ионизации легирующих примесей в материалах. 2.1. Основные понятия и определения Полупроводники – материалы, которые по своему удельному сопротивлению занимают промежуточное положение между проводниками и диэлектриками (при комнатной температуре условный диапазон Характерной особенностью полупроводниковых материалов является сильно выраженная зависимость удельной проводимости от внешних энергетических воздействий, а также от концентрации и типа примесей. Качественные различия свойств полупроводников и проводников определяются типом их химических связей. В металлах валентные электроны атомов кристаллической решетки являются частью коллектива равноценных носителей заряда, называемого электронным газом (металлическая связь). Количество этих носителей заряда n | ||||||||||||||||||||||||||||||||||||||||||||||||||||
 .
.Графически температурная зависимость собственной концентрации носителей заряда ni обычно представляется в полулогарифмическом масштабе
…………
На рис.2.1 представлены температурные зависимости концентрации собственных носителей заряда в полупроводниках, отличающихся шириной запрещенной зоны, в которых ΔЭ1>ΔЭ2,
 |
| Рис. 2.1. Температурные зависимости концентрации собственных носителей заряда в полупроводниках |
Чтобы управлять значением проводимости и типом электропроводности полупроводника, в узлы решетки вводят легирующие примеси, валентность которых отличается на ±1 от валентности собственных атомов (водородоподобные доноры или акцепторы). Такие примеси создают в запрещенной зоне полупроводника дополнительные уровни вблизи краев соответствующих зон: доноры – вблизи дна зоны проводимости, акцепторные – вблизи потолка валентной зоны. Энергия термогенерации носителей заряда, обусловленных введением примесей ∆Эпр, в 50…100 раз меньше ширины запрещенной зоны ∆Э, так что при температурах работы полупроводниковых приборов (
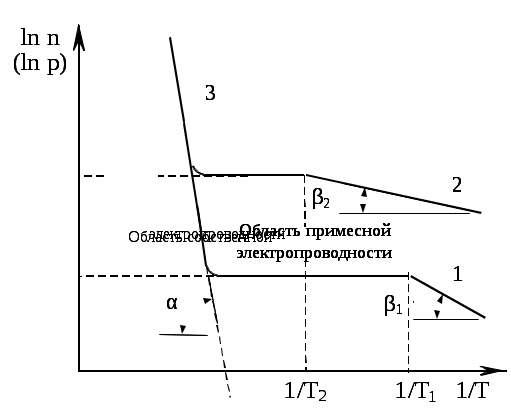 |
| Рис. 2.2. Температурные зависимости концентрации носителей заряда в полупроводниках, содержащих различные концентрации примеси: 1 – Nпр 1; 2 – Nпр 2; 3 - |
Зависимости 1, 2, 3 соответствуют различным концентрациям легирующих примесей, при этом в области примесной электропроводности
 ,
,  .
.С увеличением концентрации примесных атомов уменьшаются расстояния между ними, что приводит к перекрытию электронных оболочек примесных центров и расщеплению дискретных энергетических уровней в примесные зоны. Соответственно уменьшается энергия ионизации примесей, поэтому
ΔЭпр1> ΔЭпр2> ΔЭпр3. При достаточно большой концентрации
При повышении температуры происходит переход в область собственной электропроводности и зависимость 4 отражает процесс термогенерации собственных носителей заряда (ni):
Суммарная концентрация носителей заряда в полупроводнике определяется как собственными носителями заряда ni, так и примесными, обусловленными термической ионизацией легирующих примесей, nпр:
n≈ ni + nпр.
Как видно из рис. 2.2, в области низких температур концентрация носителей заряда, в основном, определяется примесями (область примесной электропроводности), а при высоких температурах вклад nпр может оказаться малым по сравнению с ni (область собственной электропроводности).
Квазисвободные носители заряда (и электроны, и дырки), обладая средней тепловой энергией kT, совершают хаотическое броуновское движение со скоростью теплового движения υт ≈ 105 м/с. Внешние воздействия (электрическое поле, электромагнитное, градиент температуры, градиент концентрации и т. д.) лишь чуть-чуть «упорядочивают» этот хаос, направляя носители заряда в соответствии с направлением приложенного воздействия. Если этот внешний фактор – электрическое поле, то возникает направленное движение носителей заряда – ток дрейфа jдр:
jдр = qnυдр, (2.1)
где n – концентрация носителей заряда, υдр –средняя скорость направленного движения носителей заряда под действием внешнего электрического поля напряженностью E.
Как правило, в слабых полях выполняется закон Ома, т. е. роль внешнего электрического поля – лишь направлять носители заряда, не изменяя их энергии. При этом скорость движения носителей заряда остается υт 105 м/с, а скорость дрейфа υдр, характеризующая эффективность направленного движения коллектива носителей заряда, зависит от того, как «сильно мешают» этому движению различные дефекты в кристаллической решетке. Отношение средней скорости направленного движения к напряженности электрического поля называется подвижностью носителей заряда:
 . (2.2)
. (2.2)Очевидно, чем больше дефектов в решетке, участвующих в рассеянии носителей заряда, тем меньше μдр. Под рассеянием понимают изменение квазиимпульса направленного движения носителей заряда, обусловленное влиянием дефектов. Кроме того, так как в кристалле всегда присутствуют различные типы дефектов (тепловые колебания атомов, примеси и т. д.), то подвижность носителя заряда определяется самым эффективным механизмом рассеяния:
 ,
,где μрез - результирующая подвижность носителей заряда в полупроводнике, μi – подвижность, обусловленная i-м механизмом рассеяния.
Так, в области высоких температур μрез определяется рассеянием носителей заряда на тепловых колебаниях узлов кристаллической решетки (μрез μт), и с ростом температуры μрез уменьшается пропорционально Т−3/2.
В области низких температур, когда носители заряда имеют малую скорость теплового движения vт, на результирующую подвижность μрез оказывает влияние рассеяние на ионизированных примесях. Вследствие малой энергии ионизации примесные атомы оказываются ионизированными уже при низких температурах, и движущиеся носители заряда оказываются в поле их кулоновского взаимодействия (притяжения или отталкивания). Именно этот механизм рассеяния определяет величину результирующей подвижности μрез в полупроводниках при низких температурах (μрез μион Т3/2 ). Качественно температурные зависимости подвижности μрез (T) в полупроводниках при различных концентрациях примеси Nпр представлены на рис. 2.3.
Рисунок иллюстрирует тот факт, что возрастание концентрации примесей (Nпр2 > Nпр1) уменьшает подвижность μрез в области низких температур, оставляя неизменным механизм теплового (решеточного) рассеяния в кристалле.
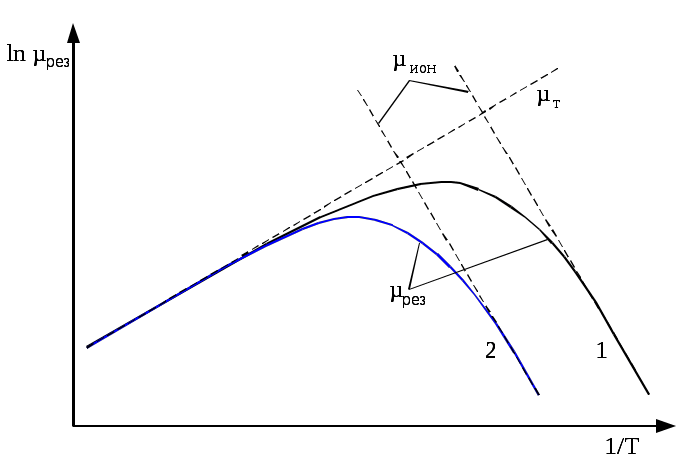 |
| Рис. 2.3. Температурные зависимости подвижности носителей заряда в полупроводниках: 1 – Nпр1; 2 – Nпр2; Nпр2 >Nпр1 |
Выражение закона Ома в дифференциальной форме (2.1) с учетом (2.2) имеет вид:
jдр = qnμдрE = γE. (2.3)
Температурная зависимость удельной проводимости γ(Т) полупроводников (рис. 2.4), определяемая концентрацией nи подвижностью носителей заряда μдр в соответствии с (2.3), представляется как суперпозиция температурных зависимостей n(T) и μдр (T), представленных на рис. 2.2 и рис. 2.3 соответственно.
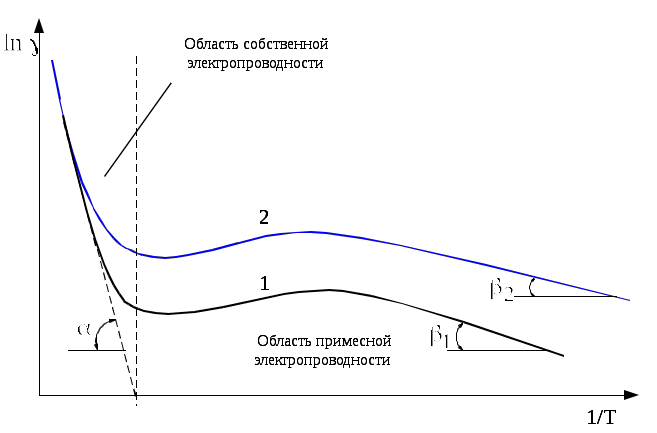 |
| Рис. 2.4. Температурные зависимости проводимости в полупроводниках содержащих различные концентрации примесей: 1 – Nпр1; 2 – Nпр2; Nпр2 >Nпр1 |
Очевидно, что в полупроводниках, отличающихся значениями ширины запрещенной зоны ∆Э. и концентрацией примесей, качественный характер зависимостей γ(T) одинаков, чего нельзя сказать о количественном соответствии.
2.2. Описание образцов полупроводников, использованных в работе
В работе предлагается исследовать в одном и том же температурном интервале зависимость γ(T)в кремнии (Si), германии (Ge), антимониде индия (InSb) и карбиде кремния (SiC) – полупроводниках, характеризующихся различной шириной запрещенной зоны.
Основные параметры полупроводниковn типа электропроводности, исследуемых в работе, приведены в табл. 2.1. Данные соответствуют температуре 300 К. Nc, Nv – эффективные плотности состояний, приведенные соответственно ко дну зоны проводимости и потолку валентной зоны; μn, μp – подвижности электронов и дырок.
Таблица 2.1.
| Полупро-водник | ∆Э, эВ | μn, м2/В∙с | μp, м2/В∙с | Nc∙10−25, м−3 | Nv∙10−25, м−3 | ∆Эпр, эВ |
| Si Ge InSb SiC | 1,12 0,66 0,18 2,90 | 0,13 0,39 7,8 0,04 | 0,05 0,19 0,075 0,006 | 2,74∙ 1,02∙ 3,7∙10−3∙ 1,44 | 1,05∙ 0,61 0,63 1,93 | 0,04 – 0,05 0,01 0,005–0,003 0,04–0,40 |
2.3. Описание установки
Исследование температурной зависимости сопротивления полупроводников производится на установке, содержащей термостат с образцами полупроводниковых материалов и внешние измерительные приборы.
Исследуемые образцы имеют форму параллелепипедов длиной l и поперечным сечением S с двумя омическими контактами на торцах, к которым подсоединяются выводы для подключения к омметру. Образцы помещены в термостат, который расположен внутри испытательного модуля.
Измерения температуры осуществляются с помощью термопары, подключенной к милливольтметру. Шкала прибора, расположенного на лицевой панели испытательного модуля, проградуирована в градусах Цельсия.
Подключение образцов к омметру осуществляется с помощью переключателя, выведенного на лицевую панель.
На лицевой панели расположен и регулятор температуры термостата. Здесь же указаны геометрические размеры образцов и приведены формулы для вычисления подвижности носителей заряда.
2.4. Проведение испытаний
Перед измерениями подготовить к работе омметр, включив его в сеть и прогреть не менее 5 мин.
Подключая к омметру поочередно образцы полупроводниковых материалов, измерить их сопротивления при комнатной температуре.
Вывести переключатель ступеней нагрева термостата в крайнее левое положение и включить термостат.
Измерять сопротивления образцов полупроводников при температурах, соответствующих установившемуся режиму на каждой ступени нагрева термостата (время установления режима около 5 мин).
Контроль установившегося режима термостата производить по показаниям омметра.
Таблица 2.2
| t, °C | R, Ом | |||
| Si | Ge | SiC | InSb | |
| t1 . . . tmax | | | | |
Результаты измерений оформить в виде табл. 2.2.
После проведения измерений регулятор «Установка температуры» вернуть в крайнее левое положение и выключить нагрев и саму установку.
2.5. Обработка результатов
1. Рассчитать удельное сопротивление исследуемых полупроводниковых материалов для каждой температурной точки табл. 2.2 по формуле:
ρ = RS/l,
где R – сопротивление образца; S – площадь поперечного сечения образца; l – длина образца.
Вычислить соответствующие удельные проводимости образцов по формуле
γэксп, = 1/ρ.
Результаты занести в табл. 2.3.
2. По данным табл. 2.3 построить температурные зависимости удельной проводимости полупроводников, откладывая по оси абсцисс параметр T−1, а по оси ординат – значения ln γэксп,.
Графики ln γ=f(T−1) для всех исследованных полупроводниковых материалов привести на одном рисунке.
Таблица 2.3.
| Исследуемый материал | T, К | T−1,К−1 | R,Ом | ρ, Ом∙м | γэксп, См/м | ln γ (См/м) |
| | | | | | | |
3. По данным табл. 2.1, рассчитать концентрации собственных носителей заряда в полупроводниках Si, Ge, InSb иSiC при T = 300 К по формуле:
4. Оценить значения собственной удельной проводимости в этих полупроводниках при 300 К:
Значения подвижностей носителей заряда указаны в табл. 2.1.
5. Сравнивания полученные в результате расчетов значения γi со своими экспериментальными данными γэксп (табл. 2.3), решить, какие же носители (собственные или примесные) определяют электрическую проводимость исследуемых образцов в интервале температур от Tmin = 300 К до Тmax – максимальной температуры измерений.
Такой сравнительный анализ позволит ответить на следующий вопрос: какой области температурной зависимости γ=f(Т) - собственной или примесной соответствует проводимость исследованных полупроводников в температурном интервале (Tmax – Tmin).
Если, согласно проведенному анализу, в полупроводнике наблюдается только примесная электропроводность (γэксп >> γi), следует оценить, все ли примеси ионизированы в исследованном температурном интервале или нет. Для этого следует сравнить энергию ионизации примеси ∆Эпр с энергией тепловой генерации kTmax. Если ∆Эпр<<kTmax, то примеси в полупроводнике с большой вероятностью ионизированы: nпр ≈ Nпр. По значению γэксп следует определить всю концентрацию этих примесей.
Если в полупроводнике не все примеси ионизированы, то по наклону кривой
ΔЭпр =
 .
.Рассчитывая n(T) по значению γэксп (T), будем полагать, что изменения подвижности носителей заряда при изменении температуры μ(T) при неполной ионизации примесей значительно слабее, чем n(T).
5. Для полупроводников, у которых γэксп ≈ γi, определить ∆Э по формуле
ΔЭ =
 .
.Значения температур T2 иT1 выбираются таким образом, чтобы соответствующие значения γэксп располагались на прямолинейном участке построенной зависимости
6. Значение nэксп рассчитать по формуле

7. Для каждого из материалов на построенных зависимостях
ионизации примеси;
истощения примеси;
собственной электропроводности.
2.6. Контрольные вопросы
Что такое собственный полупроводник? Какими свойствами он обладает? Может ли примесный полупроводник обладать собственной электропроводностью?
Дайте определение понятий: удельного электрического сопротивления, удельной электрической проводимости, подвижности носителей заряда. В каких единицах измеряются эти величины в системе СИ?
Какие примеси в ковалентных полупроводниках являются донорами, а какие – акцепторами?
Как определить ширину запрещенной зоны полупроводника по температурной зависимости концентрации носителей заряда?
Объясните, чем обусловлена сложная температурная зависимость удельной проводимости полупроводников.
Каким образом примеси влияют на удельную проводимость полупроводников.
Каким образом влияет на свойства полупроводника величина ширины запрещенной зоны материала?
Укажите основные области применения исследованных полупроводников.
3. ИССЛЕДОВАНИЕ ФОТОЭЛЕКТРИЧЕСКИХ СВОЙСТВ ПОЛУПРОВОДНИКОВЫХ МАТЕРИАЛОВ
ЦЕЛЬ РАБОТЫ: исследование спектральных зависимостей фотопроводимости полупроводников СdS и СdSE и зависимостей фотопроводимости от уровня оптического облучения.
3.1. Основные понятия и определения
Фотоэлектрические свойства полупроводника описывают изменение электрических характеристик материала при воздействии электромагнитного излучения оптического диапазона. Возникающие при этом процессы называют фотоэлектрическими эффектами (фотоэффектами). В однородных полупроводниках наиболее важным является фоторезистивный эффект (ФРЭ), который состоит в уменьшении сопротивления полупроводника под воздействием света. Для возникновения ФРЭ полупроводник необходимо облучать потоком фотонов с энергиями, достаточными для ионизации собственных или примесных атомов. При этом происходит увеличение концентрации свободных носителей заряда и возрастает удельная проводимость полупроводника. Добавочную проводимость, возникающую при фотоактивном поглощении, называют фотопроводимостью γф. Фотопроводимость равна разности проводимостей полупроводника на свету γс и в темноте γт:
Различают собственную и примесную фотопроводимость. Собственная фотопроводимость обусловлена оптическими переходами электронов из валентной зоны в зону проводимости. Примесная фотопроводимость связана с оптическими переходами электронов с примесных уровней в зону проводимости или же с захватом электронов валентной зоны на примесные уровни (образованием дырок в валентной зоне).
Важнейшим свойством ФРЭ является зависимость фотопроводимости от энергии (длины волны) падающего фотона, описываемой спектральной характеристикой. Для возбуждения собственной фотопроводимости энергия фотонов должна превышать пороговое значение, определяемое шириной запрещенной зоны полупроводника:
 , (3.2)
, (3.2)где h = 4,1410-15 эВс– постоянная Планка, c = 3108 м/с - скорость света, Э – ширина запрещенной зоны.
Пороговое значение длины волны λпор, соответствующее Э, называют красной границей фотоэффекта. При уменьшении длины волны излучения от λпор интенсивность оптических переходов возрастает, что приводит к увеличению концентрации неравновесных носителей заряда и соответствующему росту фотопроводимости.
С другой стороны, при больших энергиях фотонов (малых λ) существенно возрастает коэффициент оптического поглощения, что сопровождается уменьшением глубины проникновения света в полупроводник. При этом неравновесные носители заряда, возбуждаемые в тонком поверхностном слое, быстро рекомбинируют через уровни поверхностных дефектов. Это приводит к спаду фотопроводимости после некоторого максимума на спектральной характеристике ФРЭ.
Важное значение имеет фоточувствительность материалов. При фотооблучении возникают неравновесные носители заряда, которые при снятии облучения исчезают вследствие рекомбинации.
Основной принцип повышения фоточувствительности материала заключается в увеличении времени жизни неравновесных носителей заряда.
Для этого в материал вводятся примеси, создающие в запрещённой зоне уровни, называемые «ловушками захвата». В отличие от рекомбинационных уровней, на них могут захватываться носители заряда только одного знака, а вероятность захвата носителей другого знака крайне мала. Вследствие этого время жизни носителей другого знака значительно увеличивается и, соответственно, возрастает их концентрация, что обуславливает высокую фотопроводимость (фоточувствительность).
Зависимость фотопроводимости от интенсивности облучения называется световой характеристикой. При увеличении уровня облучения полупроводника возрастает интенсивность оптических переходов и, следовательно, растет фотопроводимость.
В области слабых световых потоков характеристика обычно имеет линейный характер. Однако с повышением интенсивности света линейность нарушается, что объясняется усилением роли процесса рекомбинации вследствие того. что часть ловушек захвата начнет превращаться в рекомбинационные центры. Это служит причиной замедления роста фотопроводимости.
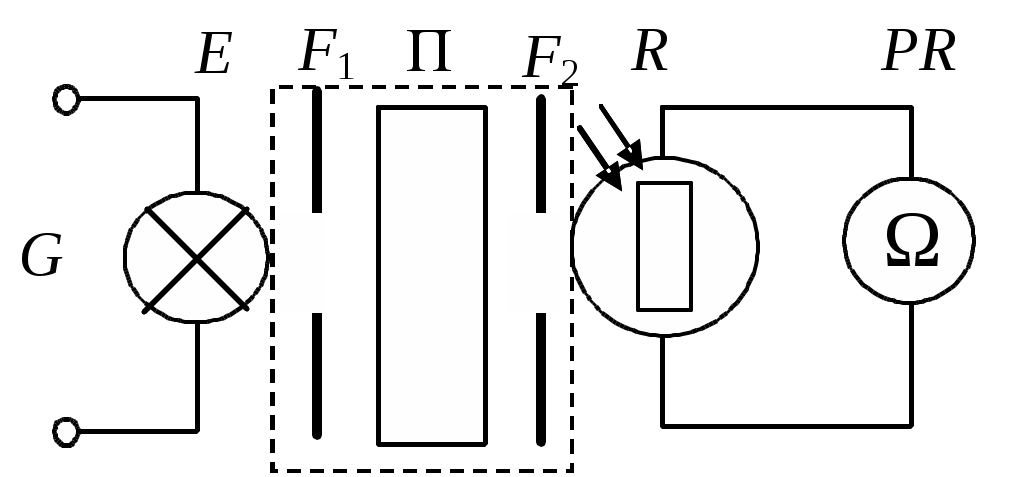 |
| Схема для исследования фотоэлектрических свойств полупроводников |
3.2. Описание установки
В настоящей работе на установке, схема которой представленной на рисунке, исследуются фотоэлектрические свойства полупроводниковых материалов, которые широко используются для производства промышленных фоторезисторов – сульфида кадмия (CdS) и селенида кадмия (CdSe), обладающих высокой чувствительностью к излучению видимого диапазона спектра.
Основной частью установки для исследования фотоэлектрических свойств полупроводников является монохроматор (см. рисунок). Световой поток от лампы E, питаемой от источника G, через входную щель монохроматора
На выходе монохроматора (щель
3.3. Проведение испытаний
3.3.1. Исследование спектральной зависимости фотопроводимости
Включить цифровой омметр PR и дать ему прогреться в течение 5 мин. Открыть полностью щель
Перед измерениями спектральных характеристик измерить темновое сопротивление обоих образцов.
Включить лампу E.
Установить барабан монохроматора на деление (около 600), начиная с которого наблюдается снижение сопротивления исследуемого образца.
Изменяя положение диспергирующего устройства П поворотом барабана от 600 до 3500 делений, измерять установившееся значение сопротивления полупроводника на свету Rс через каждые 100 делений барабана. Результаты записать в табл. 3.1. Отметить в таблице положение барабана, соответствующее минимальному сопротивлению полупроводника.

 .
.