Ответы по Методам Исследования. 1. двухзондовый метод
 Скачать 4.56 Mb. Скачать 4.56 Mb.
|
50-100 эВ, когда l составляет неск. моноатомных слоев, достигается наиб. чувствительность метода к свойствам поверхности. При большей и меньшей энергии глубина зондирования возрастает.
50-5000 эВ. В зависимости от используемой энергии первичных электронов в Э. с. (и в дифракции электронов) различают два случая. Если энергия лежит в интервале от десятков до 20. Измерение распределения потенциала и емкости. Кельвин мода (мода распределения поверхностного потенциала) - регистрируется напряжение U0, необходимое для подавления колебаний кантилевера инициируемых электродинамической силой, на частоте возбуждения, выбираемой для увеличения чувствительности в полосе резонансных колебаний кантилевера. Бесконтактная емкостная мода (мода распределения подповерхностной емкости) - измеряется электродинамическая сила, инициирующая колебания кантилевера на второй гармонике возбуждающего переменного напряжения; регистрацию контраста можно производить по амплитуде, фазе или амплитудно-фазовым характеристикам. Разработка и постановка методик измерения локальных электрофизических характеристик сегнетоэлектрических пленок с толщиной менее 100 нм является актуальной прикладной задачей. Для всестороннего исследования таких объектов требуется создание тестовых структур, что не всегда может быть реализовано из-за малой толщины сегнетоэлектрической пленки (5-100 нм). Одним из возможных вариантов исследования электрофизических параметров наноразмерных сегнетоэлектрических пленок является использование сканирующего зондового микроскопа в режиме зонда Кельвина. На примере образца со структурой диэлектрическая подложка (сапфир)/нижний электрод/пленка ЦТС производилось сканирование заданного участка поверхности образца в режиме зонда Кельвина, представляющего собой двухпроходную АСМ методику. На первом проходе снимается топография образца в полуконтактной моде, на втором проходе зонд перемещается на заданном расстоянии от поверхности, повторяя ее рельеф и регистрируя распределение поверхностных потенциалов. В эксперименте варьировались скорость движения зонда, подаваемый потенциал и время воздействия на образец в одной точке. Данная методика представляет практический интерес для локального тестирования наноразмерных элементов и покрытий сегнетоэлектрических материалов в изделиях механотроники и сенсорики. 21, 23. Обратное резерфордовское рассеяние. Кинематика упругих столкновений. Сечение и прицельный параметр. Обратное резерфордовское рассеяние является простым для понимания и применения методом исследования материалов, поскольку основывается на классическом представлении менханизма рассеивания. Суть метода заключается в столкновении легкого иона с атомами исследуемого вещества, в результате столкновения часть энергии передается атомам мишени. Измеряя отношение энергий падающих и рассеяных ионов можно идентифицировать материал мишени (отношение энергий зависит от массы иона и материала мишени, а также от угла рассеивания). Пучок ионов разгоняется в ускорителе до энергий в несколько МэВ, проходит через коллиматор и попадает в мишень, рассеяные ионы регистрирутся детектором.  После столкновения значения скоростей и энергий падающих частиц и атома мишени определяются углом рассеяния и углом отдачи. Законы сохранения энергии и импульса записываются следующим образом:  Из этих уравнений можно выразить отношения скоростей и энергий частицы до и после столкновения:        22. Рассеяние ионов низких энергий (LEIS)    24. Особенности рассеяния медленных ионов    25. Каналирование. Физические принципы и методы измерения       26. Вторично-ионная масс-спектроскопия (ВИМС) метод исследования в-ва путём определения масс атомов и молекул, входящих в его состав, и их кол-в. Совокупность значений масс и их относит. содержаний наз. м а с с - с п е к т р о м (рис.). В М.-с. используется разделение в вакууме ионов с разными отношениями массы m к заряду е под воздействием электрич. и магн. полей (см. МАСС-СПЕКТРОМЕТР). Поэтому исследуемое в-во прежде всего подвергается ионизации (если оно не ионизовано, напр. в электрич. разряде или в ионосферах планет). В случае жидких и тв. в-в их либо предварительно испаряют, а затем ионизуют, либо же применяют поверхностную ионизацию. Чаще исследуют положит. ионы. При бомбардировке поверхности ионами высокой энергии происходит выбивание из поверхности составляющих ее атомов или кластеров, в том числе и в заряженном состоянии. Исследуя распределение вылетающих ионов по массе, можно изучать состав поверхности. Этот метод получил название вторичной ионной масс-спектроскопии (ВИМС). В качестве первичных обычно используются ионы Cs+, Ar+, O2+ с энергией от 1 до 30 кэВ 3. Во вторичном пучке атомы с низким потенциалом ионизации чаще присутствуют в виде положительных ионов, а атомы с большим сродством к электрону – в виде отрицательных ионов. Различают две разновидности метода – статический и динамический. В статическом методе плотность тока первичных ионов составляет 10-10 − 10-9 А/см2. В таком режиме изучается непосредственно состав поверхности. В динамическом методе ВИМС плотность тока первичного пучка ионов существенно выше: 10-5 − 10-4 А/см2. При таких токах скорость распыления поверхности достаточно велика и изучается распределение атомов различного сорта по глубине. 27. Самое важное значение в вопросе о возможностях ВИМС как метода анализа поверхностей имеет взаимосвязь между параметрами пучка первичных ионов, скоростью распыления поверхности и порогом чувствительности для элементов. Из-за отсутствия информации о такой взаимосвязи часто возникают неправильные представления о возможностях метода. Соотношения между током первичных ионов, диаметром и плотностью пучка, скоростью распыления поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на фиг.5. Скорость удаления (число монослоев в секунду) атомов мишени при заданной энергии ионов пропорциональна плотности их тока DP, а порог чувствительности при регистрации методом ВИМС (минимальное количество элемента, которое можно обнаружить в отсутствие перекрывания пиков масс-спектра) обратно пропорционален полному току ионов IP. Коэффициент пропорциональности между порогом чувствительности ВИМС и IP определяется исходя из результатов измерений для ряда элементов в различных матрицах путем приближенной оценки, основанной на экспериментальных значениях для типичных пар элемент - матрица. При построении графика на фиг.5 предполагалось, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется в масс-спектрометрии, если диаметр области, из которой поступают ионы, не превышает 1 мм. 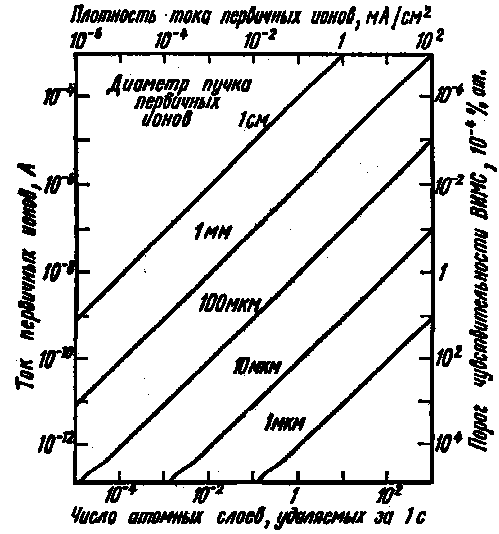 Оборудование ВИМС. Установка ВИМС состоит из четырех основных блоков: источника первичных ионов и системы формирования пучка, держателя образца и вытягивающей вторичные ионы линзы, масс-спектрометра для анализа вторичных частиц по отношению массы к заряду (m/е) и высокочувствительной системы регистрации ионов. Для получения первичных ионов в большинстве установок используются газоразрядные или плазменные источники. Совместно с соответствующей системой формирования и транспортировки пучка эти источники обеспечивают широкие пределы скорости распыления поверхности - от 10-5 до 103 А/с. Разделение вторичных частиц по m/е производится либо магнитными, либо квадрупольными анализаторами. Наиболее широко распространенным анализатором в установках ВИМС, очень удобным при анализе состава образцов и обнаружении малых количеств (следов) элементов в них, является магнитный спектрометр с двойной фокусировкой (в котором осуществляется анализ по энергии и по импульсу), что связано с его высокой чувствительностью к относительному содержанию. Для таких многоступенчатых магнитных спектрометров фоновый сигнал, возникающий из-за хвостов основных пиков материала матрицы (рассеяние стенками, на атомах газа и т.д.), может быть сведен к уровню менее 10-9 для общего фона и всего 10-6 для масс, близких к основному пику. Все же в отдельных конкретных случаях более практичным может оказаться менее дорогой квадрупольный анализатор. 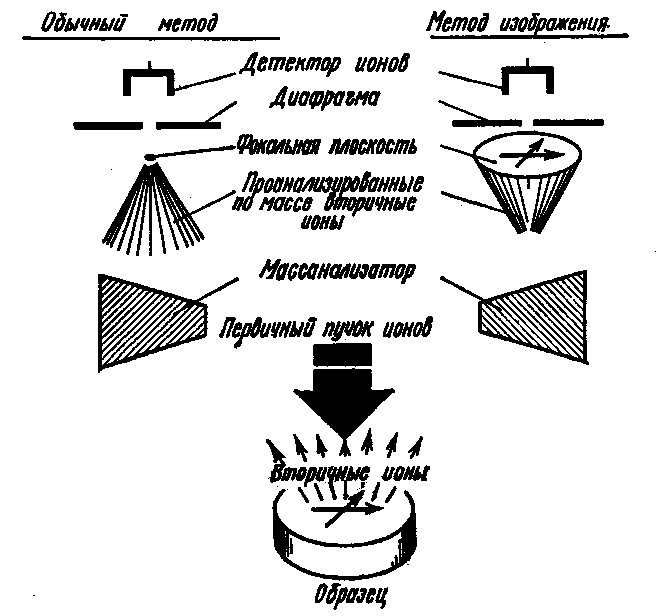 При исследовании распределения того или иного элемента по слоям, параллельным поверхности образца, для обнажения глубоколежащих слоев твердого тела in situ в большинстве методов анализа поверхности (не только ВИМС) применяют распыление ионами. При этом разрешение по глубине, обеспечиваемое выбранным методом анализа поверхности, оказывается не очень существенным, поскольку разрешение будет определяться в основном перемешиванием в приповерхностных слоях и другими процессами, сопровождающими травление поверхности. Разрешение по глубине, обеспечиваемое при данном методе определения профилей концентрации, можно характеризовать тем уширением профиля тонкого поверхностного слоя или резкой границы раздела между двумя различными материалами, которое обусловлено самим процессом измерения. Измерение профилей методом ВИМС сводится к регистрации сигнала вторичных ионов интересующего нас элемента как функции времени распыления. В случае однородной матрицы это время, выполнив соответствующие градуировочные измерения (распыление пленки известной толщины, измерения глубины кратера, коэффициентов распыления и т.д.), можно пересчитать в глубину залегания элемента. Изменение интенсивности вторичных ионов не всегда отражает относительное изменение концентрации элемента; поэтому нужна осторожность при интерпретации глубинных профилей, особенно вблизи самой поверхности, т. е. когда глубина меньше RP+2DRP, а также пленок, состоящих из различающихся по составу слоев, или матриц с неоднородным распределением следов элементов, которые способны даже при малой концентрации сильно повлиять на вторично-эмиссионные свойства образца. Пригодность метода ВИМС для определения глубинного профиля наряду с его высокой чувствительностью к большинству элементов делает его весьма привлекательным как метод изучения тонких пленок, ионной имплантации и диффузии. Факторы, существенные при проведении глубинного анализа методом ВИМС, могут быть разделены на две группы: приборные и обусловленные особенностями сочетания ион – матрица. 28. Методы Исследования. Методы электронной спектроскопии. ЭЛЕКТРОННАЯ СПЕКТРОСКОПИЯ - совокупность методов анализа свойств вещества по энергетич. спектрам, угл. распределениям, спиновой поляризации и др. характеристикам электронов, эмитируемых веществом под влиянием к--л. внеш. воздействий (электронных, ионных и др. зондов). Методы Э. с. позволяют изучать элементный состав образца, структуру, электронное строение, тепловые колебания атомов и молекул веществ в твёрдой, жидкой и газовой фазе, а также получать др. информацию на микроскопич. уровне. Для твёрдого тела и жидкости информация может относиться как к поверхности и припо-верхностной области, так и к объёму. В зависимости от природы зонда различают: фотоэлектронную спектроскопию, в к-рой для выбивания из вещества электронов используют: излучение от красного до рентг. диапазона; и о н н о-э л е к т р о н н у ю с п е к т р о с к о п и ю, в к-рой изучаемый объект бомбардируют ионами разл. энергии; в т о р и ч н о-э л е к т р о н н у ю с п е к т р о с к о п и ю (ВЭС), основанную на изучении рассеяния в веществе потоков ускоренных электронов, и т. д. В зависимости от природы зонда различают: фотоэлектронную спектроскопию, в к-рой для выбивания из вещества электронов используют: излучение от красного до рентг. диапазона; и о н н о-э л е к т р о н н у ю с п е к т р о с к о п и ю, в к-рой изучаемый объект бомбардируют ионами разл. энергии; в т о р и ч н о-э л е к т р о н н у ю с п е к т р о с к о п и ю (ВЭС), основанную на изучении рассеяния в веществе потоков ускоренных электронов, и т. д. [1 ]. Помимо фотоэлектронной спектроскопии, наиб. результативны методы ВЭС. В них информацию получают, регистрируя и анализируя изменения, претерпеваемые первичными электронами вследствие определённых элементарных актов взаимодействия их с изучаемым объектом (спектроскопия отражённых электронов); носителями информации являются также вторичные электроны, возникающие в результате генерации их воздействующим агентом или при релаксации создаваемого им возбуждения в веществе (спектроскопия истинно-вторичных электронов). Имеются также методики, в к-рых обе группы электронов исследуются совместно. Т. к. отражение электронов может быть упругим, квазиупругим и неупругим, различают неск. методов регистрации отражённых частиц. В спектроскопии упруго рассеянных электронов (УРЭ) изучают угл. распределения частиц. В этих распределениях содержится в осн. информация о структуре исследуемых объектов, т. к. распределения формируются в результате когерентного сложения волн, упруго рассеиваемых атомами вещества, и результат сложения-дифракция электронов- чувствителен к пространств. расположению атомов. Для объекта с кристаллич. структурой распределения УРЭ представляет собой совокупность резких максимумов, для газа или пара на более или менее равномерном фоне появляются относительно плавные максимумы и минимумы, связанные с особенностями дифференц. сечений упругого рассеяния электронов на отд. атомах; эти максимумы являются источником сведений об особенностях рассеивающих частиц. Для аморфных тел и жидкостей появление сглаженных максимумов или минимумов может быть связано и с ближним порядком расположения в них атомов, к-рый при определ. условиях также можно исследовать (см. Электронография ).Детальный анализ структуры линий УРЭ в области энергии 10-20 кэВ может применяться для количественного элементного анализа приповерхностной области образца [2]. Квазиупруго отражённые электроны исследует спектроскопия потерь энергии электронов высокого разрешения. Информацию об объекте в этом случае получают, исследуя структуру энергетич. спектра вблизи пика УРЭ в диапазоне потерь энергии от единиц до сотен мэВ, где регистрируемые потери обусловлены возбуждением фононов, ко-лебат. и вращат. мод атомов, молекул вещества и адсорбированных атомных частиц, плазменных колебаний свободных носителей в полупроводниках и др. Данным методом возможно исследовать дисперсию поверхностных фононов, адсорбционно-десорбционные процессы и реакции на поверхности, механич. напряжения, возникающие в приповерхностном слое твёрдого тела при нанесении разл. покрытий, межфазовые границы в полупроводниковых структурах, включая сверхрешётки, и др. [3, 4]. 29. Анализ энергетич. спектров неупруго рассеянных электронов составляет основу с п е к т р о с к о п и и х а р а к т ер и с т и ч е с к и х п о т е р ь энергии электронов, исследующей коллективные (плазменные) и одночастичные возбуждения валентных электронов с энергией до |


