Экзаменационные ответы по электротехническим материалам. Шпаргалка Электротехнические материалы. 1 Классификация материалов. Атомнокристаллическое строение и виды связи в материалах. Влияние дефектов на свойства материалов
 Скачать 1.25 Mb. Скачать 1.25 Mb.
|
|
31 Вентильные свойства p–n-перехода: прямое включение p-n перехода, обратное включение p-n перехода. P–n-переход, обладает свойством изменять свое электрическое сопротивление в зависимости от направления, протекающего через него тока. Это свойство называется вентильным, а прибор, обладающий таким свойством, называется электрическим вентилем. Рассмотрим p–n-переход, к которому подключен внешний источник напряжения Uвн с полярностью « +» к области p-типа, «–» к области n-типа. Такое подключение называют прямым включением p–n-перехода (или прямым смещением p–n-перехода). Тогда напряженность электрического поля внешнего источника Eвн будет направлена навстречу напряженности поля потенциального барьера E и, следовательно, приведет к снижению результирующей напряженности Eрез : Eрез = E - Eвн , (1.14). Это приведет, в свою очередь, к снижению высоты потенциального барьера и увеличению количества основных носителей, диффундирующих через границу раздела в соседнюю область, которые образуют так называемый прямой ток p–n-перехода. При этом вследствие уменьшения тормозящего, отталкивающего действия поля потенциального барьера на основные носители, ширина запирающего слоя По мере увеличения внешнего напряжения прямой ток p–n-перехода возрастает. Основные носители после перехода границы раздела становятся неосновными в противоположной области полупроводника и, углубившись в нее, рекомбинируют с основными носителями этой области. Но, пока подключен внешний источник, ток через переход поддерживается непрерывным поступлением электронов из внешней цепи в n-область и уходом их из p-области во внешнюю цепь, благодаря чему восстанавливается концентрация дырок в p-области. Введение носителей заряда через p–n-переход при понижении высоты потенциального барьера в область полупроводника, где эти носители являются неосновными, называют инжекцией носителей заряда. При протекании прямого тока из дырочной области р в электронную область n инжектируются дырки, а из электронной области в дырочную – электроны. Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером; слой, в который происходит инжекция неосновных для него носителей заряда, -базой. Если к р-n-переходу подключить внешний источник с противоположной полярностью «–» к области p-типа, «+» к области n-типа то такое подключение называют обратным включением p–n-перехода (или обратным смещением p–n-перехода). В данном случае напряженность электрического поля этого источника Eвн будет направлена в ту же сторону, что и напряженность электрического поля E потенциального барьера; высота потенциального барьера возрастает, а ток диффузии основных носителей практически становится равным нулю. Из-за усиления тормозящего, отталкивающего действия суммарного электрического поля на основные носители заряда ширина запирающего слоя Теперь через р–n-переход будет протекать очень маленький ток, обусловленный перебросом суммарным электрическим полем на границе раздела, основных носителей, возникающих под действием различных ионизирующих факторов, в основном теплового характера. Процесс переброса неосновных носителей заряда называется экстракцией. Этот ток имеет дрейфовую природу и называется обратным током р–n-перехода. Выводы: 1. P–n-переход образуется на границе p- и n-областей, созданных в монокристалле полупроводника. 2. В результате диффузии в p–n-переходе возникает электрическое поле - потенциальный барьер, препятствующий выравниванию концентраций основных носителей заряда в соседних областях. 3. При отсутствии внешнего напряжения Uвн в p–n-переходе устанавливается динамическое равновесие: диффузионный ток становится равным по величине дрейфовому току, образованному неосновными носителями заряда, в результате чего ток через p–n-переход становится равным нулю. 4. При прямом смещении p–n-перехода потенциальный барьер понижается и через переход протекает относительно большой диффузионный ток. 5. При обратном смещении p–n-перехода потенциальный барьер повышается, диффузионный ток уменьшается до нуля и через переход протекает малый по величине дрейфовый ток. Это говорит о том, что p–n-переход обладает односторонней проводимостью. Данное свойство широко используется для выпрямления переменных токов. 6. Ширина p–n-перехода зависит: от концентраций примеси в p- и n-областях, от знака и величины приложенного внешнего напряжения Uвн. При увеличении концентрации примесей ширина p–n-перехода уменьшается и наоборот. С увеличением прямого напряжения ширина p–n-перехода уменьшается. При увеличении обратного напряжения ширина p–n-перехода увеличивается. 32 Вольт-амперная характеристика (ВАХ) p–n-перехода, теоретическая, практическая Вольт-амперная характеристика (ВАХ) p-n-перехода представляет собой зависимость тока от величины и полярности приложенного напряжения и описывается выражением: 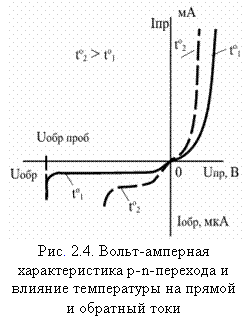  , ,где I0 – тепловой обратный ток p-n-перехода; Uд – напряжение на p-n-переходе; jт = k T/ q – тепловой потенциал, равный контактной разности потенциалов (jк) на границе p-n-перехода при отсутствии внешнего напряжения (при T = 300 К, jт = 0,025 В); k – постоянная Больцмана; T – абсолютная температура; q –заряд электрона При отрицательных напряжениях порядка 0,1…0,2 В экспоненциальной составляющей, по сравнению с единицей, можно пренебречь (е4 » 0,02), при положительных напряжениях, превышающих 0,1 В, можно пренебречь единицей (е4 » 54,6). Тогда вольт-амперная характеристика p-n-перехода, будет иметь вид, приведенный на рис 2.4. По мере возрастания положительного напряжения на p-n-переходе прямой ток диода резко возрастает. Поэтому незначительное изменение прямого напряжения приводит к значительному изменению тока, что затрудняет задание требуемого значения прямого тока с помощью напряжения. Вот почему для p-n-перехода характерен режим заданного прямого тока. Вольт-амперная характеристика (см. рис. 2.4) имеет две ветви: прямую, расположенную в первом квадранте графика, и обратную, расположенную в третьем квадранте. Обратный ток создается дрейфом через p-n-переход неосновных носителей заряда. Поскольку концентрация неосновных носителей заряда на несколько порядков ниже, чем основных, обратный ток несоизмеримо меньше прямого. 33 Виды пробоев p–n-перехода.  Пробоем p-n-перехода (рис. 2.5) называют, как было сказано, резкое уменьшение обратного сопротивления, вызывающее значительное увеличение тока при достижении обратным напряжением критического для данного прибора значения (Uобр.проб). Пробой p-n-перехода происходит при повышении обратного напряжения вследствие резкого возрастания процессов генерации пар «свободный электрон – дырка». В зависимости от причин, вызывающих дополнительную интенсивную генерацию пар носителей заряда, пробой может быть электрическим и тепловым. Электрический пробой, в свою очередь, делится на лавинный и туннельный. Лавинный пробой – электрический пробой p-n-перехода, вызванный лавинным размножением носителей заряда под действием сильного электрического поля. Он обусловлен ударной ионизацией атомов быстро движущимися неосновными носителями заряда. Движение этих носителей заряда с повышением обратного напряжения ускоряется электрическим полем в области p-n-перехода. При достижении определенной напряженности электрического поля они приобретают достаточную энергию, чтобы при столкновении с атомами полупроводника отрывать валентные электроны из ковалентных связей кристаллической решетки. Движение образованных при такой ионизации атомов пар «электрон – дырка» также ускоряется электрическим полем, и они, в свою очередь, участвуют в дальнейшей ионизации атомов. Таким образом, процесс генерации дополнительных неосновных носителей заряда лавинообразно нарастает, а обратный ток через переход увеличивается. Ток в цепи может быть ограничен только внешним сопротивлением. Лавинный пробой возникает в высокоомных полупроводниках, имеющих большую ширину p-n-перехода. В этом случае ускоряемые электрическим полем носители заряда успевают в промежутке между двумя столкновениями с атомами получить достаточную энергию для их ионизации. Напряжение лавинного пробоя увеличивается с повышением температуры из-за уменьшения длины свободного пробега между двумя столкновениями носителей заряда с атомами. При лавинном пробое напряжение на p-n-переходе остается постоянным, что соответствует почти вертикальному участку в обратной ветви 1 вольт-амперной 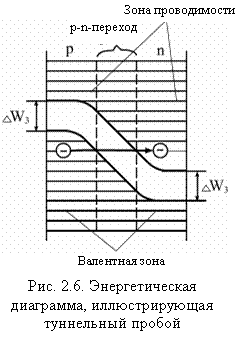 характеристики (см. рис. 2.5). характеристики (см. рис. 2.5).Туннельный пробой – это электрический пробой p-n-перехода, вызванный туннельным эффектом. Он происходит в результате непосредственного отрыва валентных электронов от атомов кристаллической решетки полупроводника сильным электрическим полем. Туннельный пробой возникает обычно в приборах с узким p-n-переходом, где при сравнительно невысоком обратном напряжении (до 7 В) создается большая напряженность электрического поля. При этом возможен туннельный эффект, заключающийся в переходе электронов валентной зоны р-области непосредственно в зону проводимости n-области. Объясняется такое явление тем, что при большой напряженности электрического поля на границе двух областей с разными типами электропроводности энергетические зоны искривляются так, что энергия валентных электронов р-области становится такой же, как энергия свободных электронов n-области (рис. 2.6). Электроны переходят на энергетической диаграмме (см. рис. 2.6) как бы по горизонтали из заполненной зоны в находящуюся на том же уровне свободную зону соседней области, а в полупроводниковом приборе, соответственно, через p-n-переход. В результате перехода дополнительных неосновных носителей заряда возникает туннельный ток, превышающий обратный ток нормального режима в десятки раз. Напряжение на p-n-переходе при туннельном пробое остается постоянным (см. рис. 2.5, вертикальный участок кривой 2). При повышении температуры напряжение туннельного пробоя уменьшается. Оба вида электрического пробоя, как лавинного, так и туннельного, не разрушают p-n-переход и не выводят прибор из строя. Процессы, происходящие при электрическом пробое, обратимы: при уменьшении обратного напряжения свойства прибора восстанавливаются. Тепловой пробой вызывается недопустимым перегревом p-n-перехода, когда отводимое от перехода в единицу времени тепло меньше выделяемого в нем тепла при протекании большого обратного тока, в результате чего происходит интенсивная генерация пар носителей заряда. Этот процесс развивается лавинообразно, поскольку увеличение обратного тока за счет перегрева приводит к еще большему разогреву и дальнейшему росту обратного тока. Тепловой пробой носит обычно локальный характер: из-за неоднородности p-n-перехода может перегреться отдельный его участок, который при лавинообразном про цессе будет еще сильнее разогреваться проходящим через него большим обратным током. В результате данный участок p-n-перехода расплавляется; прибор приходит в негодность. Участок теплового пробоя на вольт-амперной характеристике (см. рис. 2.6, кривая 3) соответствует росту обратного тока при одновременном уменьшении падения напряжения на p-n-переходе. Тепловой пробой может наступить как следст вие перегрева из-за недопустимого увеличения обратного тока при лавинном или туннельном пробое, при недопустимом увеличении обратного напряжения, а также в результате общего перегрева при плохом теплоотводе, когда выделяемое в p-n-переходе тепло превышает отводимое от него. Повышение температуры уменьшает напряжение теплового пробоя и может вызвать тепловой пробой при более низком, чем при возникновении электрического пробоя, напряжении. Для предотвращения теплового пробоя в паспорте прибора указывается интервал рабочих температур и допустимое обратное напряжение (примерно 0,8 от пробивного). 34 Структура и основные режимы работы биполярных транзисторов. Биполярный транзистор – трёхполюсный полупроводниковый прибор с двумя p–n-переходами. Он состоит из чередующихся областей полупроводника, имеющих электропроводность различных типов. В зависимости от последовательности чередования n- и p-областей различают транзисторы n–p–n- и p–n–p-типов. На практике используются транзисторы обоих типов; принцип действия их одинаков. Основными носителями заряда в транзисторе n–p–n-типа являются электроны, а в p–n–p- транзисторе – дырки. Так как в кремнии электроны обладают большей подвижностью, чем дырки, то чаще используют транзисторы n–p–n-типа. На рис. 6.1, а изображена идеализированная структура биполярного n–p– n-транзистора. На рис. 6.1, б приведено его условное графическое обозначение. На рис. 6.1, в, г показаны структура и условное графическое обозначение p–n– p-транзистора. Заметим, что n–p–n- и p–n–p-транзисторы имеют обратные полярности напряжений. Соответственно противоположные направления имеют и токи. Ц 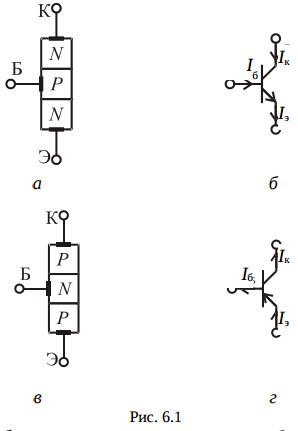 ентральная область транзистора, называемая базой, заключена между коллектором и эмиттером. Толщина базы мала и не превышает нескольких микрон. Переход между базой и эмиттером называется эмиттерным, а между базой и коллектором – коллекторным. ентральная область транзистора, называемая базой, заключена между коллектором и эмиттером. Толщина базы мала и не превышает нескольких микрон. Переход между базой и эмиттером называется эмиттерным, а между базой и коллектором – коллекторным.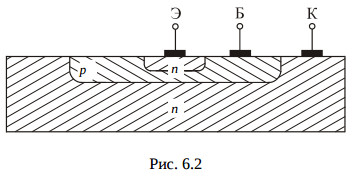 Симметричные структуры биполярных транзисторов, показанные на рис. 6.1, являются идеальными. Структура реального транзистора несимметрична (рис. 6.2). Площадь коллекторного перехода значительно больше, чем I б Iк Iэ Iб Iк Iэ эмиттерного. Симметричные структуры биполярных транзисторов, показанные на рис. 6.1, являются идеальными. Структура реального транзистора несимметрична (рис. 6.2). Площадь коллекторного перехода значительно больше, чем I б Iк Iэ Iб Iк Iэ эмиттерного.Каждый из p–n-переходов транзистора может быть смещён либо в прямом, либо в обратном направлениях. В зависимости от этого различают четыре режима работы транзистора: 1) активный (усиления). Эмиттерный переход смещён в прямом направлении, а коллекторный – в обратном; 2) отсечки. Оба перехода смещены в обратном направлении; 3) насыщения. Оба перехода смещены в прямом направлении; 4) инверсный. Эмиттерный переход смещён в обратном направлении, а коллекторный -– в прямом. Рассмотрим подробнее каждый из режимов работы транзистора на примере прибора n–p–n-типа. Активный режим. Так как эмиттерный переход смещён в прямом направлении, происходит инжекция носителей из эмиттера в базу. Поскольку область эмиттера легирована сильнее, чем область базы, поток электронов преобладает над потоком дырок. Из-за малой толщины базы почти все электроны, пройдя базу, достигают коллектора. Только малая доля электронов рекомбинирует в базе с дырками. Коллекторный переход смещён в обратном направлении, поэтому электроны, достигшие коллекторного перехода, втягиваются полем перехода в коллектор. Происходит экстракция электронов в коллектор. Токи транзистора, работающего в активном режиме, связаны соотношениями:  Множитель α называют коэффициентом передачи тока эмиттера. У интегральных транзисторов α = 0.99–0.995. Из равенств (6.1) следует, что к Множитель β называют коэффициентом усиления тока базы. Так как величина α близка к 1, то β может принимать большие значения. Для интегральных n–p–n-транзисторов оно составляет от 50 до 200. Связь между напряжением эмиттерного перехода и током эмиттера имеет n n p экспоненциальную форму:  . .Обратный ток эмиттерного перехода э0 I обратно пропорционален ширине базы и прямо пропорционален площади эмиттерного перехода. Последнее свойство часто используется разработчиками интегральных схем при конструировании источников постоянного тока (см. параграф 6.9). В зависимости от размеров транзистора величина э0 I составляет от 12 10 − до 18 10 − А. Ток э0 I зависит от температуры, удваиваясь при увеличении температуры примерно на 7 °С. Таким образом, работа биполярного транзистора в активном режиме основана на сочетании процессов инжекции носителей через один переход и собирания их на другом переходе. Концентрация примесей в эмиттере значительно больше, чем в базе и коллекторе. Поэтому электронная составляющая тока n–p–n-транзистора является преобладающей. В активном режиме ток коллектора управляется током эмиттера (или напряжением эмиттерного перехода) и почти не зависит от напряжения на коллекторном переходе, поскольку последний смещен в обратном направлении. Активный режим является основным, если транзистор используется для усиления сигналов. Режим отсечки. Инжекция основных носителей в область базы наблюдается в том случае, если эмиттерный переход смещён в прямом направлении. Если напряжение Uбэ меньше пороговой величины (0.6 В для кремниевых транзисторов), заметной инжекции носителей в базу не наблюдается. При этом I э = Iб = 0 . Следовательно, ток коллектора также равен нулю. Таким образом, для режима отсечки справедливы условия: Uбэ < 0.6 В или Iб = 0 Режим насыщения. Если оба перехода смещены в прямом направлении, носители инжектируются в базу как из эмиттера, так и из коллектора. В этом режиме ток коллектора не зависит от тока базы. Коллекторный переход отпирается, если напряжение коллектор-база Uкб < -0,4 BПри этом напряжение коллектор-эмиттер не превышает напряжение насыщения: Uкэ ≤Uкэ нас. Значение Uкэ нас находится в пределах 0,2–0,3 В. Режимы отсечки и насыщения биполярных транзисторов являются основными, когда они работают в ключевых и логических схемах. Инверсный режим. Биполярный транзистор является симметричным прибором в том смысле, что область полупроводника с одним типом проводимости располагается между двумя областями с другим типом проводимости. Поэтому транзистор можно включить так, что коллекторный переход смещен в прямом направлении, а эмиттерный – в обратном. При этом эмиттер играет роль коллектора, а коллектор – эмиттера. Такой режим работы биполярного транзистора называют инверсным. Однако коллектор и эмиттер изготавливают неодинаковыми (см. рис. 6.2), с тем, чтобы наибольшее усиление достигалось в активном режиме. В инверсном режиме усиление транзистора невелико. Такой режим используют в некоторых цифровых схемах. В табл. 6.1 приведены типичные параметры биполярных транзисторов n– p–n и p–n–p-типов, используемых в микросхемах малой и средней степени интеграции, где Аэ – площадь эмиттерного перехода, 0 I – обратный ток эмиттерного перехода, β – коэффициент усиления тока базы, Uкэ пр – напряжение пробоя коллекторного перехода.  Из табл. 6.1 следует, что характеристики p–n–p-транзисторов значительно уступают характеристикам n–p–n-транзисторов. В частности, коэффициент усиления тока базы p–n–p-транзисторов не превышает 50. Значительное отличие характеристик транзисторов с различными типами проводимостей является существенным недостатком биполярных технологий. |
