Конспект по електронике. Навчальний посібник за загальною редакцією С.І. Проценка Рекомендовано вченою радою Сумського державного університету Суми
 Скачать 2.49 Mb. Скачать 2.49 Mb.
|
|
Типи структур напівпровідникових інтегральних мікросхем Питання практичного заняття: Зобразити та описати на прикладі транзистора послідовність формування таких структур напівпровідникових мікросхем: дифузійно-планарної; епітаксійно-планарної без прихованого шару; епітаксійно-планарної з прихованим шаром; структури з діелектричною ізоляцією; ізопланарної структури; поліпланарної структури (з ізолювальним V-каналом); комплементарної структури (КМОН); n-канальної; p-канальної; КМОН-КНС (кремній на сапфірі). Елементи теорії. Якприклад наводиться послідовність формування дифузійно-планарної структури, що зображена на рис. 1. Як вхідна заготовка використовується монокристалічна пластина кремнію, рівномірно легована акцепторними домішками (має провідність р-типу). На першому етапі на пластину наноситься шар оксиду кремнію SiO2 (рис. 1а). У цьому шарі шляхом літографії вибірково витравлюють ділянки прямокутної форми (рис. 1б) та через утворені вікна, шляхом термічної дифузії, вводяться атоми домішки донора. Після цього проводиться термічне окиснення (рис. 1 в).  Рисунок 1 – Послідовність формування дифузійно-планарної структури У результаті на поверхні монокристалу знову утворюється суцільний шар SiO2. Таким чином, одночасно створюються колекторні області всіх транзисторів та ізолювальні області резисторів. Вторинним повторним травленням вікон менших розмірів у шарі оксиду та подальшої дифузії акцепторної домішки формуються базові області транзисторів з провідністю р-типу (рис. 1 г, д). Далі, в результаті послідовних циклів – літографії, дифузії та окиснення – виготовляються області емітерів, а також високолеговані ділянки з провідністю n-типу для створення низькоомних контактів (рис. 1 е, є). Для створення міжелементного зв’язку в шарі оксиду відкриваються вікна (рис. 1 ж) і пластина покривається суцільною металевою плівкою, як правило, з алюмінію (рис. 1 з), при цьому в місцях, вільних від оксиду, утворюються контакти з відповідними областями кремнію. Заключний цикл літографії по плівці алюмінію дозволяє створити систему з’єднань та периферійні контактні площадки в кристалах (рис. 1 і). Список літератури Парфенов О. Д. Технология микросхем / О. Д. Парфенов. – Москва : Высшая школа, 1986. – 320 с. Технологія електронної техніки / З. Ю. Готра. – Львів : Видавництво Національного університету «Львівська політехніка», 2010. – Т. 1. – 888 с. Прищепа М. М. Мікроелектроніка. Ч. 1. Елементи мікроелектроніки / М. М. Прищепа, В. П. Погребняк. – Київ : Вища школа, 2004. – 432 с. Коледов Л. А. Технология и конструирование микросхем, микропроцессоров и микросборок / Л. А. Коледов. – Санкт-Петербург : Издательство «Лань», 2009. – 400 с. Заняття 6 Схема технологічного процесу виготовлення різних типів структур напівпровідникових інтегральних мікросхем Питання практичного заняття: Розробити схему технологічного процесу виготовлення таких структур напівпровідникових мікросхем: дифузійно-планарної; епітаксійно-планарної без прихованого шару; епітаксійно-планарної з прихованим шаром; структури з діелектричною ізоляцією; ізопланарної структури; поліпланарної структури (з ізолювальним V-каналом); комплементарної структури (КМОН); n-канальної; p-канальної; КМОН-КНС (кремній на сапфірі). Елементи теорії. Як приклад наведено схему технологічного процесу виготовлення дифузійно-планарної структури.     Колекторна дифузія n- домішки 1- ша фотоліт. на SiO2 Окислена пластина р-типу Окиснення         2 - га фотоліт. на SiO2 Базова дифузія p- домішки Окиснення 3 - тя фотоліт. на SiO2         Емітерна дифузія n+ - домішки Металізація Al 4 - та фотолітог. на SiO2 Окиснення         Відпалю-вання контактів Контроль електричних параметрів МСХМСХ Розділення пластин на кристали 5 - та фотоліт. на Al         Випробування ІМС Монтаж зовнішніх виводів Монтаж кристала в корпус Герметизація      Маркування, пакування Рисунок 1 – Схема технологічного процесу виготовлення дифузійно-планарної структури Список літератури Парфенов О. Д. Технология микросхем / О. Д. Парфенов. – Москва : Высшая школа, 1986. – 320 с. Технологія електронної техніки / З. Ю. Готра. – Львів : Видавництво Національного університету «Львівська політехніка», 2010. – Т. 1. – 888 с. Прищепа М. М. Мікроелектроніка. Ч. 1. Елементи мікроелектроніки / М. М. Прищепа, В. П. Погребняк. – Київ : Вища школа, 2004. – 432 с. Коледов Л. А. Технология и конструирование микросхем, микропроцессоров и микросборок / Л. А. Коледов. - Санкт-Петербург : Издательство «Лань», 2009. – 400 с. Заняття 7–8 Легування монокристалічних напівпровідникових пластин методом термічної дифузії та іонної імплантації Питання практичного заняття 1. Фiзичнi основи процесу термічної дифузiї. 2. Практичнi способи проведення дифузiї. 3. Методи вивчення характеристик дифузiйних шарiв. 4. Загальна характеристика іонної iмплантацiї. 5. Фiзичнi основи процесу іонної імплантації. 6. Практичні методи проведення іонної iмплантацiї Елементи теорії Розрахунок параметрів термічної дифузії. Особливістю дифузії в планарній технології є розбивка її на дві стадії. Стадія заганяння домішки здійснюється протягом короткого часу t1 при сталій поверхневій концентрації С0. Введена при заганяння кількість домішкових атомів N (ат/см2) служить джерелом дифузанта при подальшому розгоні протягом часу t2 з поверхневою концентрацією, що змінюється в часі:  Для побудови профілю розподілу домішки у разі двостадійної дифузії необхідно знати температури і тривалості заганяння і розгону. Температура Т1 задає коефіцієнт дифузії домішки D1 і поверхневу концентрацію С01, обумовлену граничною розчинністю домішки. Розподіл домішки після стадії заганяння визначається виразом  Використовуючи апроксимацію   У свою чергу, температура Т2 задає коефіцієнт дифузії D2. Поверхнева густина атомів домішки, введеної на стадії заганяння, визначається інтегруванням розподілу домішки:  Розподіл домішки після стадії розгону визначається виразом  Під глибиною дифузійного шару (глибиною дифузії) розуміють координату х = xj, при якій концентрація введеної домішки C дорівнює концентрації вихідної домішки CВ. Величину СВ неважко знайти, знаючи питомий опір вихідної пластини напівпровідника ρ, Ом∙см: а) після заганяння домішки:  б) після розгону домішки  Завдання 1 Побудувати профілі розподілу домішки і визначити глибину залягання р-n-переходу після заганяння та розгону у разі двостадійної дифузії домішки в кремній з електропровідністю х-типу з питомим опором ρ Ом∙см, проведеної в режимі Т1, t1, Т2, t2. Вихідні дані типу домішки, типу провідності пластини, її питомого опору, температури та часу заганяння і розгону зазначені в табл. 1. Під час розв’язання задачі користуватися залежностями з рис. 1–3. 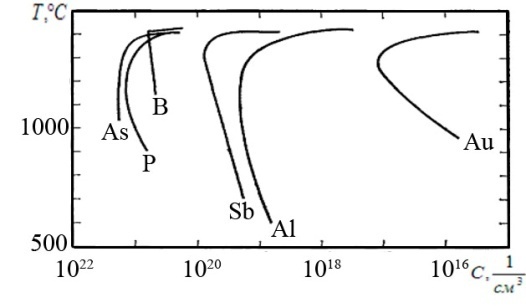 Рисунок 1 – Діаграма твердої розчинності домішок у кремнії  Рисунок 2 – Залежність коефіцієнтів дифузії домішок у кремнії від температури Таблиця 1 – Вихідні дані до завдання 1
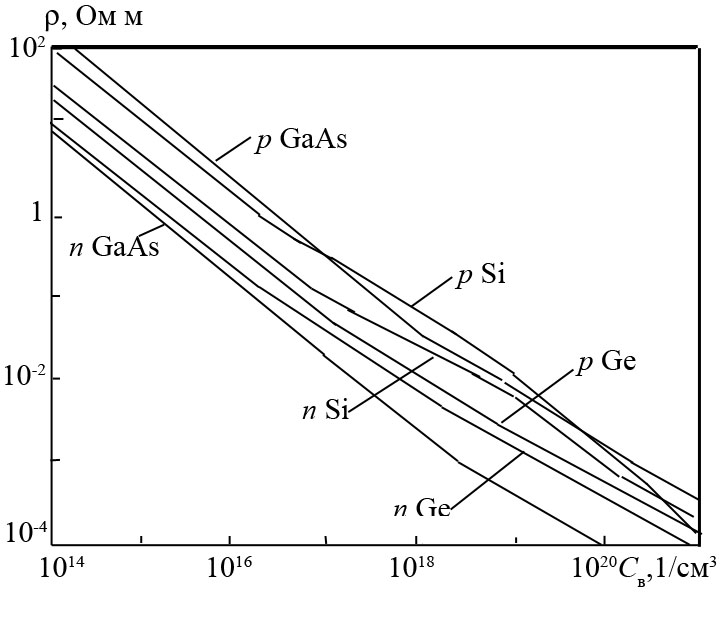 Рисунок 3 – Залежність питомого опору Si, Ge і GaAs від концентрації домішки |
