Конспект по електронике. Навчальний посібник за загальною редакцією С.І. Проценка Рекомендовано вченою радою Сумського державного університету Суми
 Скачать 2.49 Mb. Скачать 2.49 Mb.
|
|
Фотошаблони та методи їх виготовлення. Зображення у шарі фоторезисту формується за допомогою фотошаблонів – прозорих пластин із рисунком топології одного із шарів структури мікросхеми. Як правило, використовують метало-скляні шаблони, в яких рисунок утворюється тонкою металевою плівкою. Для виготовлення фотошаблонів використовують в основному два методи. Суть одного із них полягає у механічному вирізанні першого оригіналу (збільшеного у 200 - 500 разів рисунка) з послідовним фотографічним зменшенням розмірів рисунка. У другому методі – фотонаборі – увесь топологічний рисунок розділяється на прямокутники різної площі та з різним відношенням сторін залежно від розмірів та форми складових його елементів. Ці прямокутники послідовним фотодруком наносяться на фотопластину, де в кінці утворюється проміжний фотошаблон із десятикратним збільшенням рисунка порівняно із заданим. Для проведення фотодруку розроблені спеціальні мікронаборні установки (рис. 5). 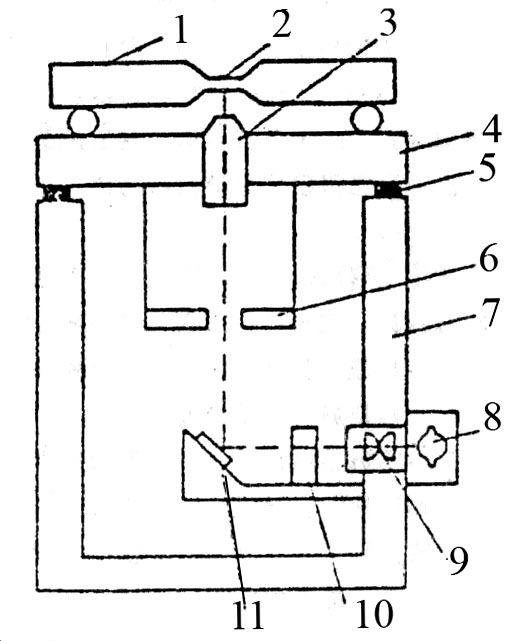 Рисунок 5 – Схема мікронаборної установки: 1 – координатний стіл; 2 – фотопластина; 3 – проектор; 4 – основа; 5 – гумова прокладка; 6 – наборна діафрагма; 7 – тумба; 8 – освітлювач; 9 – конденсор; 10 – затвор; 11 – дзеркало Основним вузлом установки є набірна діафрагма, що складається із чотирьох пластинок. Дискретним переміщенням цих пластинок формується прямокутне вікно із заданими розмірами сторін. Крок переміщення становить у різних установках 10 – 100 мкм. Електродвигун може здійснювати поворот (до 45) усієї діафрагми. Світловий пучок, пройшовши знизу вверх через прямокутну діафрагму та проектор, засвічує фотопластинку. Фотопластина закріплюється у координатному столі фоточутливим шаром знизу. Робота на фотонаборних установках здійснюється за допомогою комп'ютера. Типові технічні характеристики сучасних мікронаборних установок такі: розмір фотопластини – 70×70 мм, крок переміщення – 2,5 мкм, точність позиціювання– ±1,5 мкм, продуктивність – 900 експозицій/год. Можливості фотолітографії обмежені довжиною хвилі випромінювання, оскільки внаслідок дифракції світла, відбувається розширення одержаного елемента. У реальних процесах серійного виробництва контактна фотолітографія дозволяє одержати у шарі фоторезисту мінімальний розмір до 0,8 мкм, проекційна фотолітографія до 0,4 мкм. Із урахуванням особливостей рідинного хімічного травлення розмір збільшується до 2 – 3 мкм. Використання іоноплазмових та плазмохімічних методів обробки дозволяє одержати розміри рисунків у робочих плівках близько до розміру ділянки засвіченого фоторезисту. Оскільки мінімальний розмір елементів інтегральних мікросхем визначається щільністю упаковки, надійністю, вартістю, швидкодією, то одержання субмікронних розмірів елементів є одним із основних завдань технології великих і надвеликих інтегральних схем. Зі зменшенням довжини хвилі дифракційне розсіювання зменшується, тому перспективні короткохвильова фотолітографія, рентгенівська, електронна та іонна літографії. Електронна літографія Метод електронної літографії будується на використанні для експонування резистивних плівок електронного пучка. При взаємодії такого пучка з резистом розриваються міжатомні зв'язки, що приводить до перебудови молекулярної структури резисту. Довжина хвилі електрона, прискореного напругою U,  . Якщо U= 1,510-4 В, то вона дорівнює 0,01 нм, тобто на декілька порядків нижча за довжину хвилі світлового випромінювання. На малих довжинах хвилі розміри рисунків при експонуванні резистів визначаються не дифракційним розсіюванням, а умовами взаємодії електронного пучка з системою резист-підкладка. На цьому етапі розроблені пристрої для експонування речисту гостросфокусованим пучком електронів (сканувальна електронна літографія) та установки для проекційної електроної літографії. . Якщо U= 1,510-4 В, то вона дорівнює 0,01 нм, тобто на декілька порядків нижча за довжину хвилі світлового випромінювання. На малих довжинах хвилі розміри рисунків при експонуванні резистів визначаються не дифракційним розсіюванням, а умовами взаємодії електронного пучка з системою резист-підкладка. На цьому етапі розроблені пристрої для експонування речисту гостросфокусованим пучком електронів (сканувальна електронна літографія) та установки для проекційної електроної літографії.Сканувальна електронна літографія. Установка складається з електронної гармати, системи фокусування та відхилення електронного пучка, системи переміщення по координатних осях предметного столика (на якому розміщують підкладку). Ввімкнення та вимкнення електронного пучка, його сканування, а також керування предметним столиком здійснюється за допомогою комп'ютера. В установках сканувальних електронної літографії використовують два типи систем відхилення пучків – растрові та векторні. У растрових системах електронний пучок сканує поверхню підкладки незалежно від наявності або відсутності рисунка. На ділянках, які не повинні експонуватись, електронний пучок переривається. У векторних системах електронний пучок сканує тільки ті ділянки підкладки, які повинні бути експоновані, при цьому має здійснюватися точний вивід променя у початок координат подальшої експонованої ділянки. В обох системах розмір експонованої ділянки становить декілька квадратних міліметрів. Для експонування топологічного рисунка на всій підкладці потрібно переміщувати предметний столик із підкладкою у двох взаємно перпендикулярних напрямках, при цьому одночасно відбувається експонування. Швидкість руху столика має бути такою, щоб за час сканування смуги та зворотного повернення променя столик переміщувався на ширину лінії експонування. Точність переміщення столика – до 0,1 мкм. Таблиця 4 - Технічні характеристики установки для сканування
При використанні електронної літографії безпосередньо для виготовлення мікросхем, необхідно забезпечити точність суміщення рисунків різних топологічних шарів. Положення підкладки при першій літографії беруть за еталонне. При повторному розміщенні підкладки на предметний столик можуть з'являтися відхилення від еталонного положення, тому необхідно вводити корекцію на положення підкладки. Для проведення процесів суміщення на підкладці створюються спеціальні маркерні позначки. Вони повинні бути виконані так, щоб при скануванні по них електронного променя на відповідних детекторах виникали сигнали, обумовлені або відбитими, або вторинними електронами. При суміщенні використовують електронний промінь значно меншої потужності, ніж під час експонування. Маркерні позначки в основному використовують у вигляді виступу (декілька мікрометрів) на поверхні підкладки. Установки для сканувальної електронної літографії мають характеристики, наведені у табл. 4. Резисти – це високомолекулярні сполуки, хімічні та фізичні властивості яких змінюються під дією іонізаційної реакції. Розроблені позитивні та негативні резисти; із останніх найбільш широко використовується резист на основі поліметилметакрилату (ПММА). Проекційна електронна літографія. Схема установки для проекційної електронної літографії наведена на рис. 6. 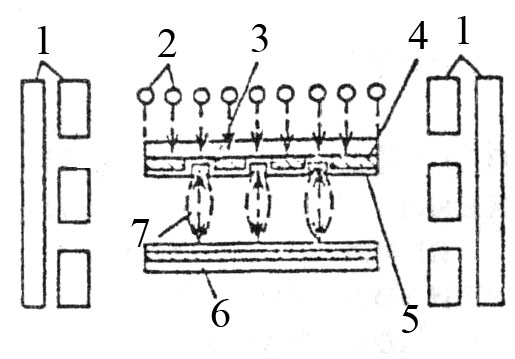 Рисунок 6 – Схема установки проекційної електронної літографії: 1 – система форсування та відхилення; 2 – ультрафіолетові лампи-освітлювачі; 3 – кварцова пластина; 4 – плівка двоокису титану; 5 – плівка паладію; 6 – окислена пластина кремнію з плівкою резисту; 7 – траєкторія електрона У цій установці основним елементом є освітлювач ультрафіолетовим світлом фотокатода. Останній є одночасно і джерелом електронів, і шаблоном із рисунком тієї конфігурації, яку потрібно одержати на підкладці. Фотокатод – це полірована кварцова пластина, на поверхні якої нанесена плівка двооксиду титану за рисунком, що відповідає одному із шарів мікросхеми. На цю плівку наносять шар паладію товщиною близько 4 нм. Вибір цих матеріалів обумовлений чудовим поглинанням ультрафіолетового світла плівками двооксиду титану та гарними фотоемісійними властивостями паладію. Ті ділянки паладію, що не захищені двооксидом титану, під дією ультрафіолетового світла випромінюють електрони. Електрони вилітають під різними кутами до поверхні, потім прискорюються електричним полем, фокусуються та направляються на покриту резистом підкладку. Суміщення рисунків проводять за допомогою маркерних знаків, створених у процесі першої літографії. Порівняно з установкою експонування ця вирізняється більш високою продуктивністю. Загальний недолік усіх систем електронної літографії полягає у необхідності тримати підкладки у вакуумі, що в цілому ускладнює технологічний процес літографії. Тому електронна літографія найбільш ефективно використовується для створення фотошаблонів та шаблонів для рентгенопроменевої та іонної літографій. Рентгенопроменева літографія При рентгенопроменевій літографії потік рентгенівського випромінювання (довжина хвилі 0,4–1,4 нм) спрямовується на шаблон, під яким розмішена підкладка, покрита резистом, чутливим до зазначеного випромінювання (рис. 7). Час експонування становить декілька хвилин. Для виготовлення шаблона використовуються плівки кремнію товщиною декілька мікрометрів, прозорі для рентгенівського випромінювання. Негативне зображення рисунка мікросхем створюється із плівки золота товщиною близько 0,3 мкм, нанесеної на тонкий шар кремнію. Вибір золота обумовлений його максимальною здатністю поглинати рентгенівське випромінювання порівняно з іншими поширеними матеріалами. Під час рентгенопременевої літографії суміщення рисунків може проводитися двома способами: із використанням рентгенівського випромінювання та оптичним. 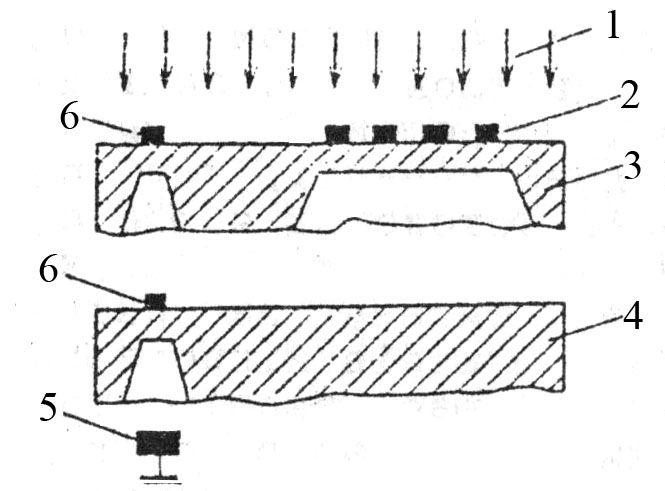 Рисунок 7 – Ілюстрація принципу рентгенопроменевої літографії: 1 – рентгенівське випромінювання; 2 – рисунок на основі плівки золота; 3 – кремнієвий шаблон; 4 – кремнієва підкладка; 5 – детектор рентгенівського випромінювання; 6 – маркерні знаки Мінімальний розмір елементів, одержаних рентгенопроменевою літографією, становить 0,1 мкм. Підвищення роздільної здатності обмежене утворенням вторинних електронів, що поширюються на відстань близько 0,1 мкм і здатні виразити структурні зміни у резисті. Поряд із високою роздільною здатністю рентгенопроменева літографія має ряд переваг: нечутливість до забруднення, процес проходить у безвакуумному середовищі на найбільш простому і дешевому обладнанні. Іонна літографія Для виготовлення мікросхем із субмікронними розмірами елементів, перспективним є метод іонної літографії. Він грунтується на тому, що потоки іонів різних газів (водень, гелій, неон, фреон) прискорюються до енергії 60 - 100 кеВ та можуть привести у деяких речовинах до перебудови молекулярної структури та зміни хімічних властивостей. Експонування резистів здійснюється фокусуванням або коліміруванням пучків іонів. У першому випадку заданий рисунок одержується скануванням сфокусованого пучка по поверхні підкладки з нанесеним резистом, у другому – опромінюванням шаблона, розміщеного над поверхнею підкладки. Шаблон – це кремнієва мембрана, на якій із плівки золота створюється рисунок маски. Товщина плівки золота достатня для поглинання іонів і становить 700 нм. Суміщення здійснюється у процесі детектування іонів, зворотно розсіяних від спеціально виготовлених маркерних поміток. Точність суміщення становить ±0,05–0,1 мкм, роздільна здатність – 0,2 мкм. Порівняно з електроннопроменевою літографією при іонній значно знижується розмір області, що експонується за рахунок дії на резист частинок, тому можна зменшити розмір елементів у субмікронному діапазоні і, таким чином, у два – п'ять разів підвищити ступінь інтеграції мікросхем. На відміну від електронної літографії, де з метою зниження розмірів елементів використовують тонкі шари резисту, при іонній використовують товсті шари до 1 мкм. Можливість збільшити товщину резисту призводить до того, що густина дефектів стає низькою, а це призводить до підвищення ймовірності виходу придатних мікросхем. На завершення потрібно відмітити, що, змінюючи склад іонів у пучках, можна повністю сформувати структуру напівпровідникових мікросхем, використовуючи при цьому пучки елементів III та V груп періодичної системи для легування приповерхневих шарів кремнію. Цей метод є найбільш перспективним і відкриває новий напрямок у технології мікросхем: формування структур елементів іонним проникненням домішок методом прецизійного сканування сфокусованого іонного пучка без використання резистів та шаблонів. Список літератури 1. Технологія електронної техніки / З. Ю. Готра. – Львів : Видавництво Національного університету «Львівська політехніка», 2010. – Т. 2. – 884 с. 2. Березин А. С. Технология и конструирование интегральных мікросхем / А. С. Березин, О. Р. Мочалкина. – Москва : Радио и связь, 1992. – 320 с. 3. Прищепа М. М. Мікроелектроніка. Ч. 1. Елементи мікроелектроніки / М. М. Прищепа, В. П. Погребняк. – Київ : Вища школа, 2004. – 432 с. 4. Коледов Л. А. Технология и конструирование микросхем, микропроцессоров и микросборок / Л. А. Коледов. – Санкт-Петербург : Издательство «Лань», 2009. – 400 с. Заняття 3 Семінар на тему «Загальна характеристика технологічного процесу виготовлення мікросхем» Питання семінару 1. Означення ІМС, загального і базового технологічного процесів. 2. Класифікація технологічних процесів за призначенням у виробництві. 3. Класифікація технологічних процесів оброблювальної групи. 4. Мікроклімат та виробнича гігієна. 5. Вимоги до напівпровідникових кремнієвих пластин. Список літератури Технологія електронної техніки / З. Ю. Готра. – Львів : Видавництво Національного університету «Львівська політехніка», 2010. – Т.1. – 888 с. 2. Прищепа М. М. Мікроелектроніка. Ч. 1. Елементи мікроелектроніки / М. М. Прищепа, В. П. Погребняк. – Київ: Вища школа, 2004. – 432 с. 3. Коледов Л. А. Технология и конструирование микросхем, микропроцессоров и микросборок / Л. А. Коледов. – Санкт-Петербург : Издательство «Лань», 2009. – 400 с. Заняття 4 Елементи напівпровідникових інтегральних мікросхем Питання практичного заняття 1. Зобразити, як виготовити на базі біполярного транзистора елементи напівпровідникових інтегральних мікросхем: діод, резистор, конденсатор. 2. Зобразити, як виготовити на базі МОН-транзистора елементи напівпровідникових інтегральних мікросхем: діод, резистор, конденсатор. Елементи теорії. Всі елементи НІМС виготовляються у єдиному технологічному процесі на основі єдиної транзисторної структури. У мікросхемах використовують біполярні транзистори, у більшості випадків зі структурою n-p-n+. Транзистори n-p-n+ типу колектор-база-емітер мають кращі характеристики порівняно з транзисторами p-n-p, що обумовлено рядом фізичних та технологічних факторів. Область емітера має провідність n+, тобто є сильно легованою донорними домішками. Біполярні транзистори в деяких випадках виготовляють із декількома колекторами та емітерами. Площа, яку займає одна транзисторна структура на поверхні мікросхеми, становить приблизно 0,01 – 0,05 мм2. 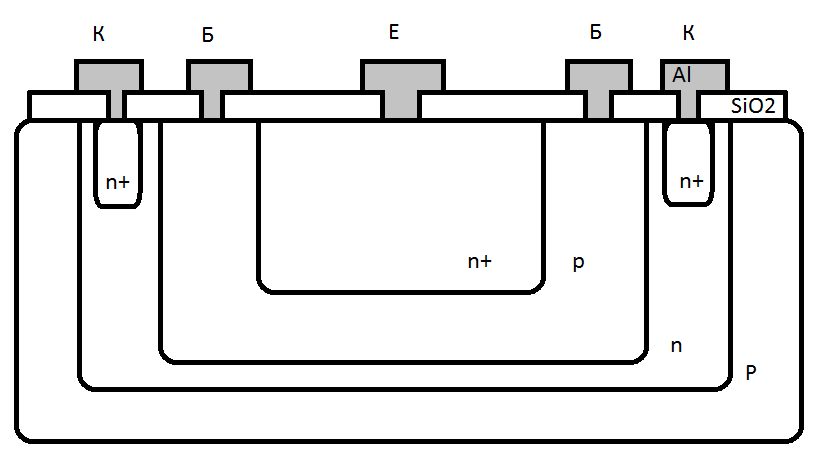 Рисунок 1 – Поперечний переріз біполярного транзистора 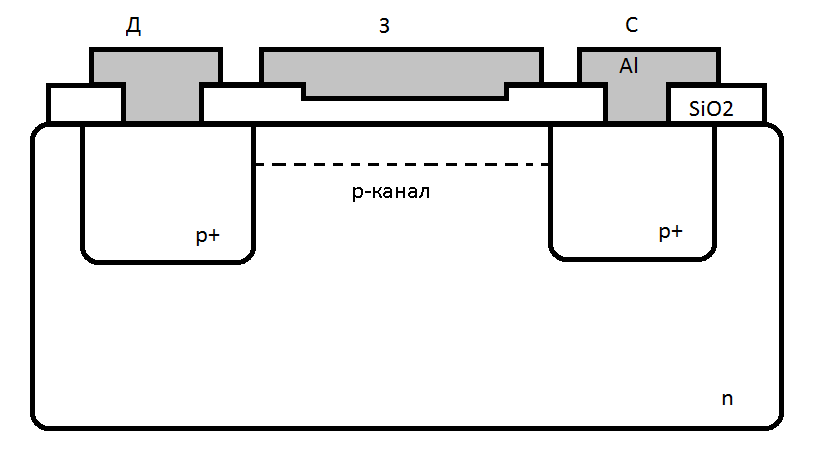 Рисунок 2 – Поперечний переріз МОН-транзистора Поряд із біполярними транзисторами використовують транзистори зі структурою метал-оксид-напівпровідник (МОН). Згадані транзистори за принципом дії належать до польових. НІМС на МОН = транзисторах є більш технологічними, дешевими та компактними порівняно з аналогічними схемами на біполярних транзисторах. Геометричні розміри МОН – транзисторів менші, ніж у біполярних, що дозволяє значно підвищити ступінь інтеграції. Площа, що займає такий транзистор становить 0,001–0,002 мм2. МОН = транзистори можуть бути використані як діоди, резистори та конденсатори. Існує п’ять способів увімкнення біполярного транзистора як діода, що відрізняються крутизною вольт-амперної характеристики, пробивною напругою, часом перемикання та ін. Найменший час перемикання має діод, одним електродом якого є емітер, а іншим – з’єднані разом колектор та база. Як резистори використовують структурні області бази або колектора транзистора. Резистори виготовляються одночасно з активними елементами. Вони виготовляються у вигляді прямокутної або зигзагоподібної форми. Дифузійні резистори залежно від ступеня легування шару напівпровідника, що використовується, можуть мати мінімальне значення опору від декількох Ом до десятків кОм. Як конденсатор використовують бар’єрну ємність зворотно ввімкненого n-p-переходу. Конденсатори мають ємність від декількох десятків до тисяч пікофарад. Список літератури Бочаров Л. Н. Электронные приборы / Л. Н. Бочаров. – Москва : Энергия, 1979. - 368 с. Технологія електронної техніки / З. Ю. Готра. – Львів : Видавництво Національного університету «Львівська політехніка», 2010. – Т. 1. – 888 с. Прищепа М. М. Мікроелектроніка. Ч. 1. Елементи мікроелектроніки / М. М. Прищепа, В. П. Погребняк. – Київ : Вища школа, 2004. – 432 с. Коледов Л. А. Технология и конструирование микросхем, микропроцессоров и микросборок / Л. А. Коледов. – Санкт-Петербург : Издательство «Лань», 2009. – 400 с. Заняття 5 |
