|
|
Конспект по електронике. Навчальний посібник за загальною редакцією С.І. Проценка Рекомендовано вченою радою Сумського державного університету Суми
Міністерство освіти і науки України
Сумський державний університет
Н.М.Опанасюк, Л.В.Однодворець, А.О.Степаненко,
С.І.Проценко
ТЕХНОЛОГІЧНІ ОСНОВИ ЕЛЕКТРОНІКИ (практикуми)
Навчальний посібник
за загальною редакцією С.І.Проценка
Рекомендовано вченою радою Сумського державного університету

Суми
Сумський державний університет
2013
УДК 621.382.+621.793
ББК 34.202я73
О-60
Рецензенти:
Ю.М. Лопаткін – доктор фізико-математичних наук, професор
Сумського державного університету, м. Суми;
С.М. Данильченко – кандидат фізико-математичних наук, ст. науковий співробітник Інституту прикладної фізики НАН України, м. Суми
Рекомендовано вченою радою Сумського державного університету
як навчальний посібник
(протокол №10 від 13.06.2013 р.)
Опанасюк Н. М.
О-60 Технологічні основи електроніки (практикуми): навчальний посібник / Н.М.Опанасюк, Л.В.Однодворець, А. О. Степаненко, С.І. Проценко. – Суми: Сумський державний університет, 2013.– 105 с.
У навчальному посібнику подані навчально-методичні матеріали та завдання до виконання лабораторних робіт та проведення практичних і семінарських занять із курсу «Технологічні основи електроніки».
Навчальний посібник призначений для студентів вищих навчальних закладів денної і заочної форм навчання за напрямами підготовки «Електронні пристрої та системи» та «Мікро- і наноелектроніка».
УДК 621.382.+621.793
ББК 34.202я73
© Опанасюк Н.М., Однодворець Л.В.,
Степаненко А.О., Проценко С.І., 2013
©Сумський державний університет, 2013
Зміст
С.
Передмова............................................................................. 5
Розділ 1 ЛАБОРАТОРНИЙ ПРАКТИКУМ................... 7
Правила техніки безпеки під час
виконання лабораторних робіт................................. 7
Лабораторний практикум
«Технологічні основи електроніки»......................... 9
Лабораторна робота 1 Вакуумні методи одержання
тонких плівок........................................................................ 9
Лабораторна робота 2Дослідження епітаксіального
росту тонких металевих плівок........................................... 18
Лабораторна робота 3Вивчення законів електролізу
та електролітів для одержання металевих плівок............. 26
Лабораторна робота 4Корпуси для інтегральних
мікросхем............................................................................... 33
Лабораторна робота 5Ультразвукове очищення
підкладок для виготовлення інтегральних мікросхем
та друкованих плат............................................................... 42
Лабораторна робота 6 Визначення області взаємодії
електрона з твердим тілом методом Монте-Карло...... 50
Розділ 2 ПРАКТИЧНІ ТА
СЕМІНАРСЬКІ ЗАНЯТТЯ............................................... 56
Заняття 1–2 Фізичні та технологічні основи літографії. Фотолітографія, електронна, рентгенівська та іонна літографія............................................................................... 56
Заняття 3Семінар на тему «Загальна характеристика
технологічного процесу виготовлення мікросхем»......... 78
Заняття 4Елементи напівпровідникових інтегральних
мікросхем............................................................................... 79
Заняття 5Типи структур напівпровідникових
інтегральних мікросхем....................................................... 82
Заняття 6Схема технологічного процесу
виготовлення різних типів структур
напівпровідникових інтегральних мікросхем.................... 84
Заняття 7–8Легування монокристалічних
напівпровідникових пластин методом термічної дифузії
та іонної імплантації............................................................. 86
Заняття 9Семінар на тему «Епітаксія»........................... 94
Заняття 10Семінар на тему «Технологiя
тонкоплiвкових інтегральних мікросхем»......................... 95
ПЕРЕДМОВА
Розвиток сучасної електронної техніки тісно пов'язаний із досягненнями промисловості зі створення ефективних багатофункціональних швидкодіючих мікроелектронних, сенсорних, радіотехнічних і телекомунікаційних пристроїв та систем.
Підготовка фахівців у галузі технологій електроніки проводиться за такими напрямами: конструювання і виробництво інтегральних мікросхем широкого застосування; розроблення електронної апаратури з використанням інтегральних мікросхем і мікропроцесорів. З цієї причини вивчення навчального курсу «Технологічні основи електроніки» необхідне для підготовки інженерів у галузі електроніки та телекомунікацій. Мета цього курсу полягає у формуванні знань основ технології виготовлення інтегральних мікросхем і приладів мікроелектроніки та розуміння фізичних процесів у них.
У цьому навчальному посібнику, що складається із двох розділів «Лабораторний практикум» і «Практичні заняття», наведені тексти лабораторних робіт і завдань до практичних і семінарських занять, що сприяють розвитку практичних навичок та розумінню теоретичних питань, пов'язаних з основними положеннями, принципами та проблемами технології формування інтегральних мікросхем, конструювання, виготовлення та застосування мікроелектронних виробів, основними етапами базових технологічних процесів: літографії, термічної дифузії, іонної імплантації та епітаксії.
У першому розділі на прикладі напівпровідникових матеріалів розглядаються питання, пов’язані з методами одержання плівкових матеріалів; аналізуються механізми епітаксіального росту тонких плівок; вивчаються методи очищення підкладок для виготовлення інтегральних мікросхем та друкованих плат. Оскільки розділ присвячений лабораторному практикуму, то він починається з правил техніки безпеки під час роботи з електронними та електричними приладами.
У другому розділі наведені тексти задач, плани семінарських занять, методичні вказівки для розв’язання практичних задач із тематики, пов’язаної з фізичними й технологічними основами літографії (фотолітографія, електронна літографія, рентгенолітографія та іонна літографія); технологічними процесами виготовлення елементів інтегральних мікросхем та легування напівпровідникових пластин методами термічної дифузії та іонної імплантації.
Наприкінці тексту кожної лабораторної роботи і практичного або семінарського заняття наводяться контрольні запитання і список рекомендованої літератури, що повинна сприяти засвоєнню та закріпленню студентами матеріалу в процесі аудиторних занять та індивідуальної підготовки.
Навчальний посібник призначений для студентів університетів, які навчаються за напрямами підготовки «Електронні пристрої та системи» та «Мікро- і наноелектроніка».
Автори висловлюють щиру подяку рецензентам навчального посібника д-ру фіз.-мат. наук, проф. Лопаткіну Ю. М. (Сумський державний університет) та канд. фіз.-мат. наук, ст. науковому співробітнику Данильченку С. М. (Інститут прикладної фізики НАН України), цінні зауваження та рекомендації яких сприяли покращанню змісту і стилю викладання матеріалу.
Розділ 1 ЛАБОРАТОРНИЙ ПРАКТИКУМ
1.1 Правила техніки безпеки під час виконання лабораторних робіт
Студенти, які працюють з електроустановками і електроприладами, повинні знати і дотримуватися правил технічної експлуатації та безпечної роботи.
При порушенні правил техніки безпеки під час роботи з вакуумними установками й електроприладами може виникнути небезпека ураження електричним струмом. Сила струму 0,06 А небезпечна для життя людини, а 0,1А –призводить до смерті. Електричний струм, пройшовши через організм людини, може викликати два види ураження – електричний удар та електричну травму. Більш небезпечним є електричний удар, тому що уражається весь організм. Смерть настає від паралічу чи припинення серцевої діяльності. Електричними травмами називають ураження струмом зовнішніх частин тіла. Це – опіки, металізація шкіри та ін. Ураження струмом мають змішаний характер і залежать від величини і роду струму, що проходить через тіло людини, довжини його впливу, шляхів, якими проходить струм, а також від фізичного і психічного стану людини у момент ураження. Найбільш небезпечний струм, частота якого дорівнює 50–60 Гц. Зі збільшенням частоти струми починають поширюватися по поверхні шкіри, викликаючи сильні опіки. При сухій неушкодженій шкірі опір людського тіла електричному струму дорівнює 40–100 кОм. Результат ураження багато в чому залежить також від шляху струму в тілі людини. Необхідно пам’ятати, що в просвічувальному електронному мікроскопі (ПЕМ-125К) використовується напруга до 125 кВ.
Електроприлади та вакуумні системи повинні бути заземлені. Для захисту від ураження електричним струмом необхідно використовувати інструменти з ізольованими ручками. Прилади й інструменти біля вакуумної установки необхідно розміщувати з урахуванням зручності та безпеки.
Усі роботи з підготовки до експерименту, складання схем під ковпаком вакуумної установки здійснювати тільки після вимкнення напруги живлення. Наявність напруги у схемах, випрямних блоках та інших електричних ланцюгах перевіряти тільки покажчиками напруги або вольтметрами. Категорично забороняється робити перевірку напруги на іскру і на дотик.
Під час роботи з матеріалами для конденсації плівкових зразків дотримуватися правил виробничої й особистої гігієни. У лабораторіях категорично забороняється користуватися відкритим вогнем.
Під час виконання лабораторних робіт обов’язково використовувати як загальне, так і місцеве освітлення.
1.2 Лабораторний практикум
«Технологічні основи електроніки»
Лабораторна робота 1
Вакуумні методи одержання тонких плівок
Мета роботи – ознайомитися з вакуумними методами осадження тонких плівок. Одержати тонкі плівки алюмінію методами електронно-променевого і магнетронного розпилення у вакуумі (установка ВУП-5М).
Елементи теорії. Термін «тонкі плівки» означає полікристалічні чи аморфні плівки різних речовин, що неорієнтовано наростають на поверхні моно-, полікристалічної чи склоподібної підкладки. Плівки, що формуються на поверхні ізотропних підкладок, можуть бути провідними, резистивними та діелектричними, а за будовою аморфними (склоподібними), моно- та полікристалічними. Тонкі плівки використовують для виготовлення не лише пасивних плівкових елементів ІМС, електродів електронних структур, але й активних елементів.
Одержувати нову фазу на поверхні підкладки під час простої (фізичної) конденсації можна з використанням пучків матеріальних частинок. Основні процеси, що відбуваються при цьому це створення молекулярного потоку джерела та конденсація його на поверхні, яка має нижчу температуру.
За способом переходу речовини в газоподібний стан процеси, що відбуваються під час нанесення речовини, поділяють на динамічні (термовакуумне випаровування, катодне та іонно-плазмове розпилення) і статичні (хімічне осадження, окиснення, анодування тощо).
Термічне випаровування з подальшою конденсацією з молекулярних пучків у вакуумі дає змогу одержувати плівки різних речовин. Ступінь забруднення контролюється тиском у камері залишкових газів. Термічним випаровуванням доцільно одержувати лише плівки порівняно простих за хімічним складом речовин. Високий ступінь термічної дисоціації або різні значення парціальних тисків окремих компонентів складних сполук значно ускладнюють відтворення в плівках хімічного складу таких сполук.
Катодним та іонно-плазмовим розпиленням осаджують плівки тугоплавких і складних за хімічним складом матеріалів, однорідні на великій площі. Однак під час катодного розпилення відбувається реакція осаджуваної речовини із залишковими газами у камері, що значно погіршує відтворюваність основних властивостей плівок.
Хімічні, електрохімічні методи осадження, окиснення, анодування дають змогу отримувати плівки в рідких, газових та плазмових умовах, однак їх характеристики значною мірою залежать від параметрів допоміжних матеріалів та методики проведення технологічних процесів.
Електронно-променеве (ЕП) випаровування. Під час бомбардування електронним пучком поверхні матеріалу, що випаровується, значна частина кінетичної енергії електронів перетворюється на тепло, і поверхня нагрівається до такої температури, що стає джерелом пари. У потоці пари розміщують підкладку, на якій конденсується частина пари, тобто відбувається напилювання.
Деякі труднощі виникають під час нанесення діелектричних матеріалів. Поверхневий заряд на них викликає мікропробої та руйнування суцільності. Потенціал на поверхні таких плівок може зростати до значень, близьких до прискорювальної напруги. З метою нейтралізації або зняття заряду в установках передбачаються розігрів підкладок, застосування пристроїв для видалення заряду.
Плівки особливо високої чистоти з малим вмістом розчинених газів отримують в електронно-променевих установках, що мають у робочій камері додатковий квазізамкнений об'єм. Усередині цього об'єму, обмеженого екранами з титану або ніобію, розміщують матеріал, шо випаровується, і підкладку. Центральна частина електронного потоку через отвір обмеженого діаметра вводиться всередину квазізамкненого об'єму, а його периферійна частина розігріває екрани. На початковому етапі розпилювання плівку конденсують на поворотному технологічному екрані. Сорбція газів щойно напиленою плівкою та розігрітими екранами з хімічно активних металів дає змогу знизити тиск залишкових газів усередині об'єму на 2–3 порядки порівняно з тиском у самій технологічній камері.
У процесі виготовлення тонких плівок використовують електронно-променеві випарники (ЕПВ) потужністю 2 кВт, 5 кВт, 8–10 кВт і 15–20 кВт. До електронної гармати діодного або тріодного типу подається напруга живлення до 10 кВ. У більшості випадків застосовують прямоканальні катоди у вигляді стрічки чи спіралі.
На рисунку 1 зображено електронно-променеву гармату, яку використовують у вакуумній установці ВУП-5М.
На технологічний процес істотно впливають вторинні електрони та іони пари. Відбиті від розплавленої поверхні, вторинні електрони виносять із собою матеріал у вакуум, потужність, що виділяється у разі їх потрапляння на деталі внутрішньокамерного устаткування, призводить до підвищеного газовиділення.

Рисунок 1 – Електронно-променева гармата: 1 – корпус; 2 – вольфрамовий анод із наважкою; 3 – катод; 4 – керамічна ізоляція; 5 – живлення високовольтного джерела; 6 – живлення катода; 7 – до заземлення
Істотним недоліком термічного методу є складність отримання плівок строго стехіометричного складу зі сплавів і складних хімічних сполук, а також низька адгезія, яка значною мірою залежить від стану поверхні підкладки та методів її очищення, від умов нанесення плівки тощо.
Магнетронне розпилення. Основними елементами магнетронних розпилювальних систем (МРС) є катод-мішень, анод і магнітна система. Існує велика кількість різноманітних розпилювальних систем, які можуть бути розподілені на 3 основні типи: системи Із циліндричним катодом, системи Із плоским катодом і кільцевим катодом S-типу.
Важливою перевагою методу магнетронного розпилення є відсутність бомбардування підкладки високоенергетичними вторинними електронами через їх захоплення магнітною пасткою. Це дозволяє уникнути перегрівання поверхні підкладки і дає можливість осаджувати плівки на матеріали з низькою термостійкістю. Цей факт має велике значення для сучасних технологій, зважаючи на широке використання полімерів і композитних матеріалів. Зокрема, в мікроелектроніці й комп'ютерній техніці широко використовують такі матеріали, як поліметилметакрилат (ПММА), поліамід, поліетилентерефталат, металополімерні плівки тощо, які мають температури пом'якшення і деструкції в діапазоні від 70 до 250 ºС.
Для магнетронних систем основними джерелами нагрівання підкладки стають:
кінетична енергія осаджуваних атомів (5 – 20 еВ/атом);
енергія конденсації розпилених атомів (3 – 9 еВ/атом);
випромінювання плазми (2 – 10 еВ/атом).
Сумарна теплова енергія, що розсіюється на підкладці, а відповідно і температура підкладки залежать не лише від конструкції та режимів системи розпилення, але і більшою мірою, від матеріалу, що розпилюють. Типові значення сумарної теплової енергії змінюються від 10 до 70 еВ/атом, а температура підкладки при цьому, залежно від осаджуваних атомів, знаходиться в межах від 70 до 200 ºС.
Вакуумний універсальний пост ВУП-5М містить у своєму складі приставку, призначену для отримання плівок зрізних матеріалів методом магнетронного розпилення. Прилад зроблено однією стойкою, у якій розміщені робоча камера, вакуумна система, блоки живлення та пульти керування. У робочій камері встановлені три магнетронні розпилювачі з плоскою мішенню, схематичне зображення яких показане на рисунку 2. Перед напиленням на магнетрон (2) встановлюють катод-мішень (3), закріплюють підкладку (6) на тримачі (4), перевіряють роботу екрана (7) і відкачують вакуумну камеру до тиску 10-4 Па. За допомогою крана (12) напускають робочий газ аргон, робочий тиск якого становить (0,55)×10-5 Па. На катод подають негативну напругу відносно анода.

до насоса
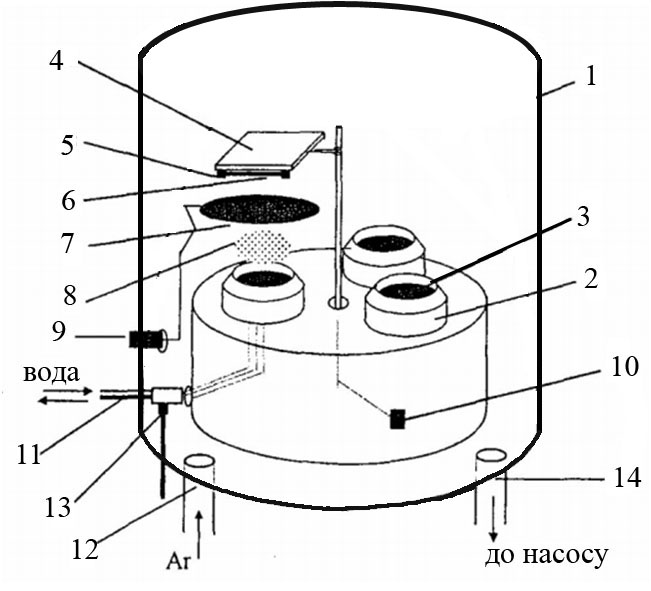
Рисунок 2 – Робоча камера магнетронної розпилювальної системи ВУП-5М:
1 – робочий об'єм; 2 – магнетрон; 3 – мішень; 4 – підкладкотримач; 5 – затискач; 6 – підкладка; 7 – екран; 8 – плазма тліючого розряду; 9 – ручка для обертання екрана у робочому об'ємі; 10 – ручка для обертання підкладкотримача у робочому об'ємі; 11 – водяний шланг; 12 – кран напуску робочого газу; 13 – високовольтний ввід; 14 – відкачування дифузійним насосом
Основні параметри і характеристики МРС ВУП-5М:
залишковий тиск у камері, що створюється дифузійним насосом при працюючій азотній пастці, – 1,3·10-4 Па;
максимальна напруга на виході високовольтного випрямляча джерела живлення магнетрона – не менше 0,9 кВ;
максимальний струм магнетрона – не менше 300 мА;
температура підкладки – до 1000 ºС;
час нагрівання підкладки – не більше 30 хв;
- час зміни підкладок не більше 7 с, швидкість обертання підкладок не менше 0,5 с. |
|
|
 Скачать 2.49 Mb.
Скачать 2.49 Mb.