Первый билет
 Скачать 2.86 Mb. Скачать 2.86 Mb.
|
Двенадцатый билет12. P-n переход: контактная разность потенциалов, толщина, напряжение пробоя, ёмкость p-n перехода.Контакт p и n полупроводников, или p-n переход, как и m-n переход, является одним из распространенных видов контактов, используемых в электронике. Его главным свойством является односторонняя проводимость, т.е. способность хорошо проводить ток только при одной полярности приложенного напряжения (прямое напряжение). При обратном напряжении ток на несколько порядков меньше. Как правило, одна из областей p-n перехода имеет намного более высокую концентрацию донорной примеси Nд или акцепторной примеси Nа. Область с большей концентрацией примесей называют также сильнолегированной областью, с меньшей –слаболегированной. Такие переходы называют асимметричными, их сильнолегированную область – эмиттером, слаболегированную – базой. Сильнолегированную область обозначают n + или p +, рис.15: 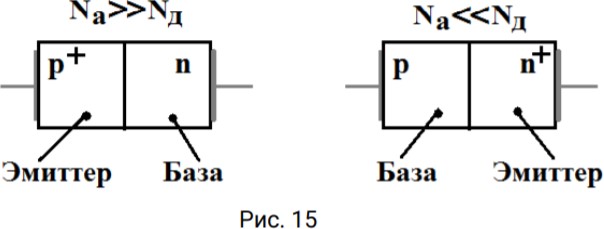 На границе p и n областей существуют значительные градиенты концентрации свободных электронов и дырок dn/dx и dp/dx. Поэтому в p-n переходе даже в отсутствие внешнего напряжения происходит диффузия основных носителей в смежную область, т.е. наблюдается диффузионный ток основных носителей Iдф. При этом в p-n + переходе dn/dx » dp/dx и поэтому будет преобладать электронная составляющая диффузионного тока Iдф.n. В p+ -n переходе dn/dx « dp/dx и поэтому будет преобладать дырочная составляющая Iдф.p. Контактнуюразностьпотенциаловв отсутствие внешнего напряжения k0 можно найти по формуле:  Подставив сюда значение термического потенциала при комнатной температуре T=0.025В, типичные значения концентрации примесей асимметричного p-n перехода для базы 1016, для эмиттера 1018 см-3 и собственную концентрацию кремния при комнатной температуреni≈1010 см-3, получим типичную величину: Другим важнейшим параметром p-n перехода является его толщина, или ширина, w. За w принимается протяженность приграничных областей с не скомпенсированными ионами примесей, или, что тоже самое, толщина обеднённого слоя:  Для кремниевого p-n перехода при указанных выше исходных данных w≈1мкм, что также является типичной величиной. При подаче прямого напряжения переход сужается, а при подаче обратного напряжения расширяется. В этих случаях его толщину можно рассчитать, подставляя вместо φk0 в (26б) φk из (23) или (24). От толщины перехода зависят его барьерная ёмкость (16), напряжение лавинного пробояи другие важные параметры. В предположении однородности поля p-n перехода его напряжённость составит величину Поэтому p-n переход при обратном напряжении можно использовать, как ёмкостный элемент. При прямом напряжении это невозможно, т.к. в этом случае появляется на несколько порядков больший активный прямой ток. Подставив (26) в (16) с учётом того, что при обратном напряжении к = к0 + Uобр, получим: 27. Компьютерное моделирование диодов и транзисторов.Компьютерное моделирование электронных элементов заключается в поиске их эквивалентных схем и математических описаний, делающих возможным достаточно точный компьютерный анализ сложных схем с такими элементами. Компьютерное моделирование электронных элементов заключается в поиске их эквивалентных схем и математических описаний, делающих возможным достаточно точный компьютерный анализ сложных схем с таким и элементами. Сегодня количество элементов в интегральных схемах может достигать 109 и более. Примерно столько же уравнений в описывающей схему системе уравнений. Решение таких систем иногда невозможно даже с использованием суперкомпьютеров. Поэтому разработка компьютерных моделей элементов – это всегда компромисс между их точностью и сложностью [4]. Рассмотрим возможности моделирования полупроводникового диода напримередиода на основе p-n перехода. Простейшей компьютерной моделью полупроводникового диодаявляется идеальный электронный ключ, обладающий нулевым сопротивлением при прямом напряжении и бесконечным – при обратном. Такая модель отражает главное свойство диода – одностороннюю проводимость. Однако при этом не учитывается наличие прямого и обратного сопротивлений, их нелинейность, наличие ёмкости p-n перехода и другие важные его свойства. Более совершенной является модель, основывающаяся на формуле Шокли (см.разд.4.3): Диод при этом моделируется как зависимый источник тока. Зависимость тока I от приложенного напряжения U описывается формулой Шокли (22). Но и такая модель не отражает важнейших свойств реального диода: возникновение пробоя при обратном напряжении, наличие наклона начальной части обратной ветви ВАХ, вырождение экспоненты в линейную зависимость тока от напряжения в области больших прямых токов(рис.51).Кроме того, эта модель не учитывает инерционные свойства диода: согласно(22), ток диода не зависит от частоты и времени, т.е. его частотные и импульсные свойства идеальны.  Более точной, наиболее сложной является модель на основе эквивалентной схемы рис. 52 и системы уравнений (54), (55), (56): 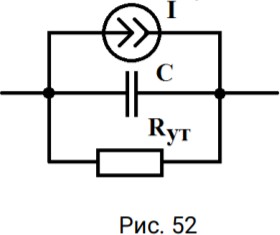  Здесь диод также моделируется зависимым источником тока, однако эта зависимость описывается не одним, а тремя уравнениями. Это позволяет отобразить два близких к прямой линии участка ВАХ простейшими уравнениями первой степени. Это участок пробоя, уравнение (54) и линейная часть ВАХ при прямом напряжении, уравнение (56). Уравнение (55)– уравнение Шокли, которое хорошо описывает начальную часть ВАХ диода при прямом и небольших обратных напряжениях. В качестве примера компьютерной модели транзисторарассмотрим модель БТ с n-p-n структурой. Её прототип изображён на рис.53: 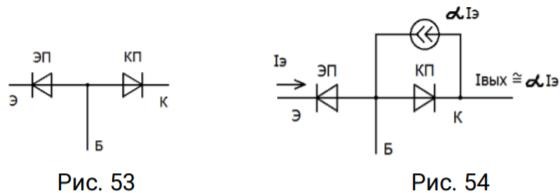 Здесь диоды моделируют эмиттерный (ЭП) и коллекторный (КП) переходы. Принадлежащем выборе параметров этих диодов можно получить точное воспроизведение входной и выходной характеристик. Однако такая «модель» не отражает главное в процессах в БТ: взаимодействие переходов. В частности, при любом значении входного тока в ЭП выходной ток в КП не появляется. Поэтому естественным шагом является введение в эквивалентную схему зависимого источника выходного тока αIэ, ток которого пропорционален входному току Iэ, рис.54. Такая модель отражает важнейшее свойство БТ: в активном режиме возникает выходной ток, пропорциональный входному току. Обратные токи ЭП и КП игнорируются ввиду их малости в наиболее распространённых кремниевых транзисторах. Дальнейшим шагом является добавление ещё одного зависимого 73 источника тока αiIк, который необходим в случае инверсного режима, когда входной ток подается в открытый КП, а в закрытом ЭП появляется выходной ток, рис.55: 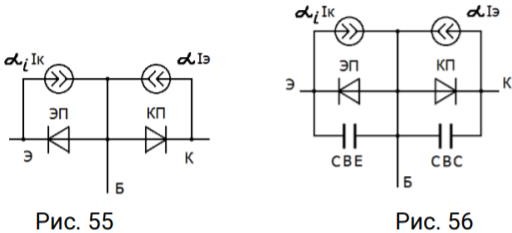 И хотя инверсный режим не применяется, как малоэффективный (α>>αi), он иногда возникает в реальных схемах и полноценная модель должна это отражать. Следующим шагом является учёт ёмкости переходов, что обеспечивается добавлением параллельно диодам полной ёмкости КП Скп и полной ёмкости ЭП Сэп, рис.56. Модель пополнится уравнениями, учитывающими то, что ёмкость p– nпереходаприпрямомнапряжениидиффузионная,приобратномбарьерная.Таи другая зависят не только от знака приложенного напряжения, но и от его величины. Дальнейшее уточнение модели связано с необходимостью учёта активного сопротивления эмиттерной области Rэ, базовой области Rб и коллекторной областей Rк, рис.57. Rэ -сопротивление наиболее легированной области, в связи с чем это сопротивление часто принимается равным нулю. Много большую величину имеет сопротивление базы Rб, в связи с обязательно слабым легированием этой области. Сопротивление Rк учитывают в ключевом режиме, т.к. оно влияет на сопротивление открытого состояния. 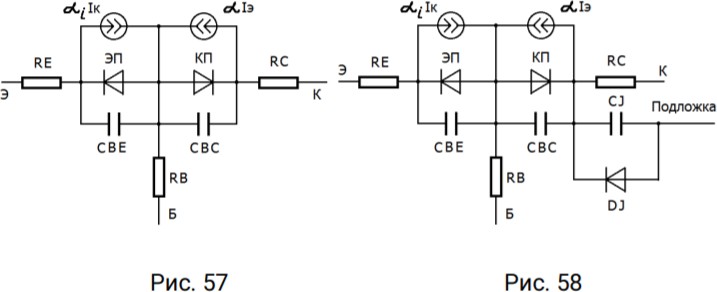 42. Ключ на МДП транзисторах с одинаковым каналом.Большое распространение получили ключи на полевых транзисторах, действие которых основано на управлении рабочим током входным напряжением (полем), имеющие структуру металл-окисел- полупроводник (МОП–транзисторы) или, что одно и то же, металл-диэлектрик-полупроводник (МДП- транзисторы). Для них характерно высокое входное сопротивление. 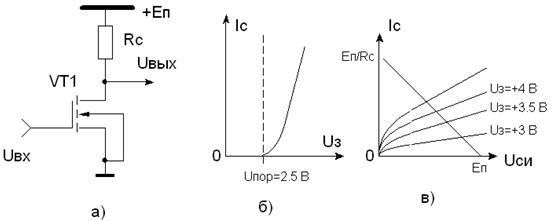 Рис2.7.КлючнаМДП-транзисторес индуцированнымn-каналом. При огромном входном сопротивлении Rвх>1012 Ом, нагрузочная способность ключа велика даже при больших Rc. Напряжение нижнего уровня МДП-ключа низкое (практически равно нулю), в отличие от ключа на биполярном транзисторе, у которого в насыщенном режиме на выходе имеется остаточное напряжение насыщения Uкэ нас. Быстродействие МДП-ключа целиком обусловлено только постоянной времени перезаряда паразитных емкостей – Свх и Свых. В составе ИС, вследствие малых размеров элементов на кристалле и, соответственно, малых паразитных емкостей, полевые ключи обладают высоким быстродействием. Классическая схема ключа с резистором Rc в стоковой цепи обладает неудовлетворительным быстродействием, так как паразитные емкости перезаряжаются через большие значения Rвх и Rc. Наличие высокоомных резисторов приводит к повышенному тепловыделению на кристалле, резисторы занимают значительную площадь, их изготовление в интегральной технологии взывает значительные трудности. Поэтому ключи со стоковой нагрузкой в современной интегральной схемотехнике не используется, но подобная схема широко используется в силовых МДП-ключах. 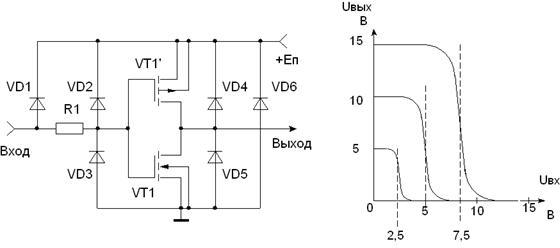 Интегральный КМДП инвертор, показанный на Рис 2.9 реализуется на МДП транзисторе с индуцированным n-каналом VT1 и комплементарным транзистором VT1’; тоже МДП, но с индуцированным p-каналом. Полярность истока транзистора VT1’ должна быть отрицательна относительно стока, поэтому исток VT1’ подключен к +Еп. Когда на вход подан низкий уровень, транзистор VT1, заперт, а транзистор VT1’ открыт; на выходе высокий уровень - напряжение +Еп. Если на вход подан высокий уровень, транзистор VT1 открыт, а транзистор VT1’ заперт; на выходе низкий уровень – практически нуль. Поскольку в каждом состоянии один из транзисторов заперт, а входное сопротивление следующего каскада очень велико, ток в нагрузку практически не ответвляется; сквозной ток в цепи питания отсутствует и статическая мощность, потребляемая от источника питания, ничтожно мала и определяется только токами утечки. 57. Приборы с зарядовой связью. Матрицы для фототехники.ПЗС-матрица состоит из поликремния, отделённого от кремниевой подложки, у которой при подаче напряжения через поликремниевые затворы изменяются электрические потенциалы вблизи электродов. До экспонирования – обычно, подачей определённой комбинации напряжений на электроды – происходит сброс всех ранее образовавшихся зарядов и приведение всех элементов в идентичное состояние. Далее комбинация напряжений на электродах создаёт потенциальную яму, в которой могут накапливаться электроны, образовавшиеся в данном пикселе матрицы в результате воздействия света при экспонировании. Чем интенсивнее световой поток во время экспозиции, тем больше накапливается электронов в потенциальной яме, соответственно тем выше итоговый заряд данного пикселя. После экспонирования последовательные изменения напряжения на электродах формируют в каждом пикселе и рядом с ним распределение потенциалов, которое приводит к перетеканию заряда в заданном направлении, к выходным элементам матрицы. В общем виде конструкция ПЗС-элемента выглядит так: кремниевая подложка p-типа оснащается каналами из полупроводника n-типа. Над каналами создаются электроды из поликристаллического кремния с изолирующей прослойкой из оксида кремния. После подачи на такой электрод электрического потенциала, в обеднённой зоне под каналом n-типа создаётся потенциальная яма, назначение которой — хранить электроны. Фотон, проникающий в кремний, приводит к генерации электрона, который притягивается потенциальной ямой и остаётся в ней. Большее количество фотонов (яркий свет) обеспечивает больший заряд ямы. Затем надо считать значение этого заряда, именуемого также фототоком, и усилить его. Существуют Матрицы: Матрицы с полнокадровым переносом Полнокадровая матрица Матрицы с буферизацией кадра Матрицы с буферизацией столбцов Матрицы с ортогональным переносом изображения |
