Курс лекций НЭ_ч4-ч5_Богач_2013. Курс лекций " Основы наноэлектроники"
 Скачать 3.44 Mb. Скачать 3.44 Mb.
|
0,0037 нм. ДОБЭ-картина обычно состоит из длинных узких полос, перпендикулярных к краю тени, создаваемой образцом. Полосы располагаются на расстоянии t друг от друга (рис. 1.22).5.3.Электронные микроскопы.Электронная микроскопия— это совокупность методов исследовании наноразмерных структур с помощью электронных микроскопов. Электронный микроскоп представляет собой электронный прибор для наблюдения и исследования многократно увеличенного изображения объекта, в котором используются пучки электронов (30 кэВ - 1000 кэВ). В электронных микроскопах используют возможность облучения образца коаксиальным пучком электронов с помощью электромагнитного поля, а также детекцию распределения электронной плотности в пучке после взаимодействия его с образцом. В 1928 году М. Кнолль и Е. Руска создали первый просвечивающий электронный микроскоп.(Нобелевская премия по физике). Затем был построен растровый микроскоп, работающий на принципе сканирования объекта. Различные конструкции электронных микроскопов позволили развить новый эффективный метод исследования объектов — электронную микроскопию. Метод электронной микроскопии позволяет исследовать микроструктуру объектов, их локальный состав, а также локализацию электрических и магнитных микрополей на поверхностях или в микрообъемах. В настоящее время разработаны конструкции различных электронных микроскопов. В основе их работы лежат как физическая основа корпускулярно-лучевых приборов, так и волновая природа электронов. В электронных микроскопах изображение нанообъектов формируется пучком электронов. 5.3.1.Просвечивающие электронные микроскопы.Просвечивающие электронные микроскопы (ПЭМ) являются универсальными приборами многоцелевого назначения. Просвечивающие электронные микроскопы используют волновые свойства движущихся электронов. Схема просвечивающего микроскопа приведена на рис. 1.33. 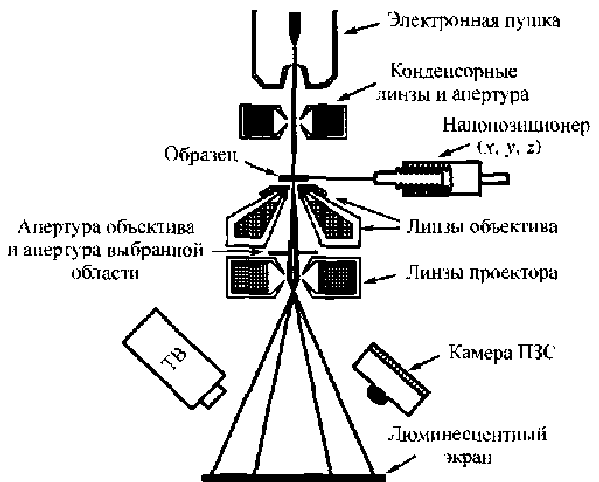 Рис. 1.33. Схема просвечивающего электронного микроскопа. Электронный пучок формируется электронной пушкой и конденсорными линзами с апертурой и фокусируется на исследуемом образце. Образец устанавливается на нанопозиционере, имеющем три степени свободы. С помощью электромагнитной линзы объектива и линзы проектора электронное изображение фокусируется на люминесцентный экран. Электроны возбуждают экран и формируют увеличенное изображение исследуемого объекта, которое может регистрироваться телевизионной камерой и камерой на приборах с зарядовой связью. При ускоряющем напряжении до 600 кВ можно получить разрешение порядка ангстрема. Просвечивающие электронные микроскопы используют для наблюдения изображения объектов в светлом и темном полях, а также изучения структуры объектов методом электронографии. В ПЭМ используются электроны энергией от 1 кэВ до 5 МэВ, позволяющие просветить электронным пучком объекты толщиной до десятка нанометров. Поверхностная геометрическая структура в ПЭМ исследуется с помощью реплик. Этот метод вызывает определенные неудобства. Разработаны конструкции сканирующего просвечивающего микроскопа, в котором исследуемый образец сканируется тонким электронным лучом. Исследования атомного строения вещества удобно проводить с помощью электронографов, которые реализованы по электроннооптической схеме ПЭМ. Узкий электронный пучок в электронографе направляется на исследуемую наноструктуру. На люминесцентном экране создается дифракционное изображение — электронограмма. На основе измерения рефлексов от структуры исследуемого объекта проводятся вычисления и формируется представление об объекте. 5.3.2.Растровые электронные микроскопы.Растровые электронные микроскопы (РЭМ) основываются на исследовании излучений, возникающих при взаимодействии электронного зонда с исследуемым объектом (рис. 1.34). 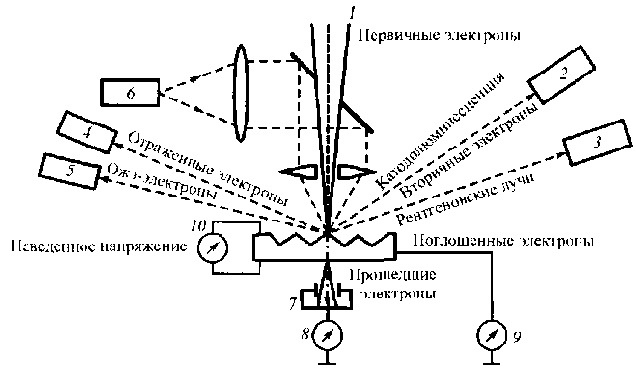 Рис. 1.34. Схема регистрации излучений в РЭМ: 1 — первичный пучок электронов; 2 — детектор вторичных электронов; 3 — детектор рентгеновского излучения; 4 — детектор отраженных электронов; 5 — детектор оже-электронов; 6 — детектор светового излучения; 7 — детектор прошедших электронов; 8 — прибор регистрации тока прошедших электронов; 9 — прибор регистрации тока поглощенных в объекте электронов; 10 — прибор регистрации наведенное потенциала. В процессе взаимодействия пучка электронов с веществом объекта возникают следующие основные виды излучений: вторичные, отраженные электроны, оже-электроны, тормозное рентгеновское излучение, рентгеновское характеристическое излучение, световое излучения, все эти виды излучения регистрируются, преобразуются в электрические сигналы, усиливаются и подаются на модулятор электронно-лучевой трубки или дисплей другого типа. Развертка пучка дисплея синхронизируется с разверткой электронного зонда. В результате на дисплее формируется увеличенное изображение объекта, а также локальное распределение химического состава, наличие р— п-переходов; возможно проведение одновременно рентгеноструктурного анализа, спектрального анализа и т. п. Высокая разрешающая способность РЭМ реализуется при формировании изображения с использованием вторичных электронов. Одновременно изображение можно получить с помощью отраженных электронов. Характеристическое рентгеновское излучение позволяет проверить спектрометрическое исследование объекта, локальный количественный анализ. Растровые оже-электронные микроскопы (РОЭМ) позволяют исследовать свойства оже-электронов и выявить распределение химических элементов в поверхностном слое объекта. Разработаны просвечивающие растровые электронные микроскопы (ПРЭМ), которые позволяют исследовать непосредственно более толстые образцы, чем в ПЭМ. Поиски в электронной микроскопии ведутся в области создания электронных голографических систем с целью формирования объемного изображения объектов. В соответствии с квантово-механической теорией, движение электрона массы т и импульса p — mv (v — скорость электрона) описывается плоской монохроматической волной де Бройля: λ=h/p=h/(mv), где h — постоянная Планка. В ускоряющем электрическом поле приобретенная энергия qU = mv2/2, где U — постоянная разность потенциалов. Подставляя в уравнение для волны де Бройли, имеем  Релятивистская поправка на изменение массы существенна при U > 105 В. Под медленными электронами будем понимать электроны, энергии которых лежат в пределах сотой эВ, а значение λ того же порядка, что и у рентгеновского излучения. Электроны с энергией в десятки кэВ соответствуют длине волны γ -излучения. Такие электроны называют быстрыми. В табл. 1.1 приведены значения λдля различных U.  Заметим, что при напряжении 100 В - 150 В соответствующий размер длины волны порядка размера атомов или межатомных расстояний. Такие медленные электроны использовали в свое время лауреат Нобелевской премии за открытие дифракции электронов на кристаллах К. Дэвиссон и Л. Джермер при исследовании дифракции электронов на гранях монокристалла. В отличии от рентгеновских лучей, которые рассеиваются на электронной плотности атомов, рассеивание электронов определяется их взаимодействием с электрическими полями атомов. Эти поля создаются как положительно заряженными ядрами, так и электронными оболочками атомов, поэтому рассеивание электронов зависит от атомного строения вещества. У различных химических элементов рассеивание электронов различно. Амплитуда атомного рассеивания электронов fэ(θ) пропорциональна атомному номеру элемента Z и определяется как  где: константа  fp – атомная амплитуда рассеяния рентгеновских лучей. С ростом θ — угла, под которым наблюдается дифракционный максимум, значения fэ(θ) падает: Атомная амплитуда рассеивания пучка определяется как fэ(θ)2. Электроны взаимодействуют с атомами на три порядка сильнее, чем рентгеновское излучение, и поэтому, амплитуда рассеивания электронов более чем на три порядка превышает амплитуду рассеивания рентгеновских лучей. 5.3.3.Метод дифракции медленных электронов (ДМЭ).Метод ДМЭ основан на дифракции электронов до сотен эВ и предназначен для исследования структуры поверхностных слоев монокристаллов. Толщина исследуемого слоя определяется глубиной проникновения электронов в кристалл без потери энергии. Исследование образцов методом ДМЭ можно проводить в вакуумной камере, представленной на рис. 1.20. 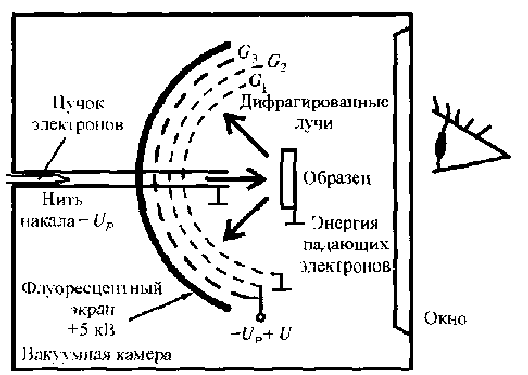 Рис. 1.20. Установка для исследования структуры на поверхности методом дифракции медленных электронов: Gi — сетки. Пучок электронов направляется на мишень и дифрагирует на поверхности кристалла. Электронные лучи, рассеянные обратно в вакуум, движутся в пространстве между кристаллом и сеткой G1. На сетках G2 и G3, общий центр которых находится на поверхности образца, подаются электрические потенциалы, которые способны задержать неупруго рассеянные на образце электроны и ускорить упруго рассеянные электроны, направив их на флуоресцентный экран. Две сетки позволяют компенсировать шумы устройства как анализатора энергий электронов. Падаюший пучок электронов фокусируется в пятно диаметром 0,1 мм - 1,0 мм, ток в нем не более 2 мкА. Дифракционная картина регистрируется на люминесцентном экране и характеризуется большим количеством максимумов, положение которых определяется условием рассеяния на двумерных структурах. На рис. 1.21 приведены типичные ДМЭ-картины. Рис. 1.21а типичен для большинства низкоиндексных металлических поверхностей. Имеются только пятна от неискаженной объемной плотности кристаллографической плоскости (100). Энергия первичного пучка составляет 150 эВ. На рис. 1.216 представлена чистая поверхность полупроводника Si (111). Между основными рефлексами в виде ярких пятен наблюдаются дополнительные рефлексы. Они соответствуют поверхностной ячейке, параллельной ячейке подложки, имеющей длину в 7 раз большую. Именно поэтому картин называется Si (111) (7x7) или Si (111)7. В этом случае энергия пучка электронов составляет 42 эВ. Если на поверхности металла абсорбируется кислород, то картина представляет собой структуру, представленную на рис. 1.21 в. Помимо ярких рефлексов основного материала подложки (W(110)), имеются рефлексы адсорбированного кислорода. В этом случае энергия пучка составляет 53 эВ. Симметрия картины ДМЭ отражает симметрию расположения атомов в поверхностном слое. В то же время интенсивности максимумов содержат информацию о межатомном взаимодействии.  Рис. 1.21. Типичные картины дифракции медленных электронов: а — чистая поверхность Cu (100); б — чистая поверхность Si (111); в — кислород, адсорбированный на вольфраме W(110). В методе ДМЭ измеряют угол распределения максимумов, зависимость распределения от начальной энергии электронов, производят измерения интенсивности максимумов в зависимости от температуры или наличия на поверхности адсорбируемых атомов. Это позволяет провести анализ дифракционной картины и установить истинную структуру приповерхностного слоя образца. Используя ДМЭ для анализа наноструктурных материалов в виде пленок на поверхности кристаллов, можно изучать межатомные взаимодействия в адсорбированных монослоях. Добавить, слабо по сеткам и по обработке, точности 5.3.4.Метод дифракции отраженных быстрых электронов (ДОБЭ).Mеmoд дифракции отраженных быстрых электронов основан на исследовании дифракции пучка быстрых электронов, падающих под скользящим углом на поверхность. Получившаяся дифракционная картина будет служить характеристикой конкретного расположения атомов на поверхности. Обычно используют потоки электронов с энергией E |





