Курс лекций НЭ_ч4-ч5_Богач_2013. Курс лекций " Основы наноэлектроники"
 Скачать 3.44 Mb. Скачать 3.44 Mb.
|
5.Методы исследования наноструктур.5.1.Сканирующая зондовая микроскопия.5.1.1.Сканирующая туннельная микроскопия.В 1978 году лауреаты Нобелевской премии Г. Бинниг и Г. Рорер создали сканирующий туннельный микроскоп. Сканирующий туннельный микроскоп представляет собой прибор для изучения поверхности твердых тел, основанный на сканировании острием, находящимся под потенциалом, поверхности образца на расстоянии до 10 Ангстрем и одновременном измерении туннельного тока между острием и образцом. Принцип действия сканирующего туннельного микроскопа (СТМ) заключается в измерении электронного тока обусловленного квантово-механическим туннелированием электронов. С этой целью используется проводящий зонд, который подводится к исследуемой поверхности на расстояние возникновения туннельного тока. Такую операцию можно осуществить с помощью пьезодвигателя, изменяющего свои размеры под действием управляющего напряжения (рис. 1.26). При приложении напряжения Us на промежутке острие—образец возникает туннельный ток, который поддерживается постоянным за счет цепи обратной связи. Одновременно цель обратной связи управляет положением острия по координате z с помощью пьезодвигателя Рz. В системе обратной связи формируется разностный сигнал, который усиливается и подается на исполнительный элемент. 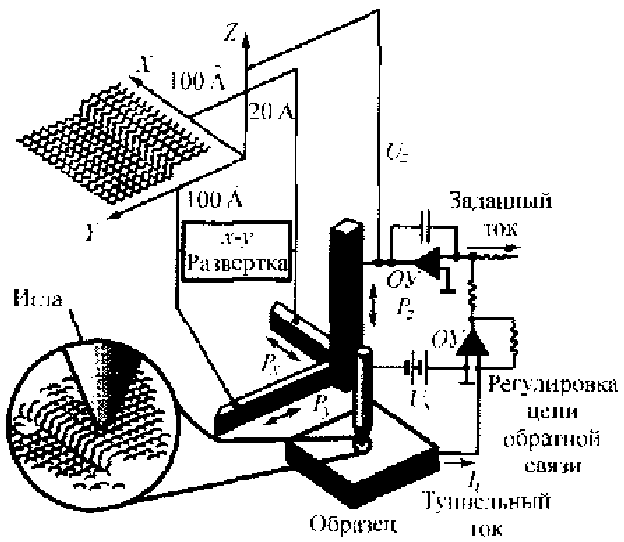 Рис. 1.26. Схема туннельного микроскопа: Рx, Рy, Pz — пьезодвигатели; ОУ — операционные- усилители. На основе полученного сигнала исполнительный элемент приближает или отодвигает острие от поверхности, нивелируя разностный сигнал. Точность удержания промежутка острие—поверхность может составить 0,01 Ангстрема. При перемещении острия по координатам х и у система обратной связи отрабатывает изменения разностного сигнала на исполнительных элементах Рx и Рy так, что сигнал оказывается пропорционален рельефу исследуемой поверхности. Изображение поверхности формируется следующим образом. Острие движется над образцом вдоль, например, оси x. Величина сигнала на исполнительном элементе Рz, пропорциональная рельефу поверхности, записывается в память компьютера. Так получается строчная развертка. Затем острие возвращается в исходную точку, переходит на следующую строку по координате у, и процесс сканирования повторяется до заполнения кадра строками. В этом случае говорят о кадровой развертке. Записанный при строчном и кадровом сканировании сигнал обратной связи обрабатывается компьютером, а изображение строится с помощью средств компьютерной графики. Существуют два режима формирования изображений поверхности: в режиме постоянного туннельного тока и в режиме постоянного среднего расстояния. При исследованиях в режиме постоянного туннельного тока (рис. 1.27а) острие перемешается вдоль поверхности. В процессе растрового сканирования изменение напряжения на z-электроде записывается в память в виде функции Uc = f(x,y). Напряжение на z электроде Uc = f(x,y) с большой точностью повторяет рельеф поверхности и после обработки средствами компьютерной графики адекватно изображает поверхность образца. Полученное изображение представляет собой физический рельеф, который отражает геометрию поверхности. В случае однородного (например, монокристаллического) образца регистрируемый рельеф поверхности максимально приближается к геометрическому.  Рис. 1.27. Два способа формирования изображения поверхности: режим постоянного туннельного тока (а); режим постоянного среднего расстояния (б). Режим постоянной высоты удобнее использовать при исследовании гладких поверхностей (рис. 1.27б). В этом случае зонд перемещается над поверхностью на расстоянии нескольких ангстрем. Изображение поверхности можно получить путем измерения туннельного тока в процессе сканирования поверхности и его компьютерной обработки. Этот режим позволяет реализовать высокие скорости сканирования и высокую частоту получения изображений, а также позволяет наблюдать за динамикой процессов на поверхности. Если острие заточить так, чтобы на его конце находился одиночный выступающий атом или кластер атомов, размер которого меньше характерного радиуса острия, то можно получить пространственное разрешение вплоть до атомного. Туннелирование может проходит только между теми объектами, волновые функции которых пересекаются. Следовательно, атомное разрешение возможно получить только в том случае, если на острие иглы сформируется один атом. Сканирующий метод туннельной микроскопии предназначен для визуализации атомов в элементарной ячейке. Этим методом можно определять расстояние вдоль поверхности с точностью 0,1 Ангстрема, однако он не позволяет определить расстояние между верхним и низлежащим слоями. Метод, с одной стороны, дает прямую картину расположения атомов на поверхности, а с другой стороны, он не предназначен для полного кристаллографического описания поверхности. С развитием метода сканирующей туннельной микроскопии связывают дальнейшие перспективы исследования поверхности. 5.1.2.Атомно-силовая микроскопия.Атомно-силовой микроскоп представляет собой прибор для изучения поверхноститвердых тел, основанный на сканировании острием поверхности и одновременном измерении атомно-силового взаимодействия между острием и образцом. Атомно-силовой микроскоп был изобретен в 1986 году К. Куэйтом и К. Гербером. В основе работы атомно-силового микроскопа лежит атомно-силовое взаимодействие между зондом и поверхностью. Это взаимодействие имеет сложный характер и определяется силами Ван-дер-Ваальса. Энергию ван-дер-ваальсовского взаимодействия двух атомов, находящихся на расстоянии r друг от друга, аппроксимируют потенциалом Леннарда—Джонса, который можно записать в виде  Качественный ход потенциала при изменении расстояния взаимодействия представлен на рис. 1.29. 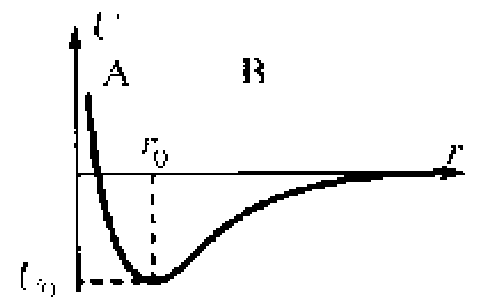 Рис. 1.29. Потенциал Леннарда-Джонса в зависимости от расстояния между атомами: А —зона oтталкивания зонда, В — зона притяжения зонда. В соответствии с распределением потенциала, зонд испытывает притяжение со стороны образца на больших расстояниях и отталкивание от образца на малых расстояниях. Технической задачей является регистрация малых изгибов зонда. В технике атомно-силовой микроскопии зондом служит кантилевер в виде балки с острием на конце (рис. 1.30). Регистрация малых изгибов консоли кантилевера осуществляется оптическим методом. С этой целью на кантилевер направляется луч полупроводникового лазера, который отражается и попадает на четырехсекционный полупроводниковый диод (рис. 1.31).  Рис. 1.30. Изображение зонда-кантилевера в виде балки прямоугольного сечения (а) и треугольной балки (б)  Рис. 1.31. Оптическая схема регистрации деформации кантилевера (а) и четырехсекционный фотоприемник (б). Важным моментом методики является то, что конец кантилевера с зондом перемещается вверх-вниз, а консоль с зеркалом изменяет угол положения в пространстве. Чувствительность определяется отношением полудлины консоли кантилевера и расстояния до фотодиода. Фотодиод калибруется так, что задаются исходные значения фототока в секциях фотодиода: I01, I02, I03, I04. При деформации консоли в секциях фотодиода будут зарегистрированы токи I1, I2, I3, I4. Величину и направление деформации кантилевера будут характеризовать разности токов ΔIz= (ΔI1+ ΔI2 )- (ΔI3+ ΔI4 ) (1.17) для нормали к поверхности образца; ΔIx,y = (ΔI1+ ΔI4 )- (ΔI2+ ΔI3 ) (1.18) для касательных к поверхности сил. Электронная часть атомно-силового микроскопа (ACM) похожа на электронную часть, включая систему обратной связи, сканирующего туннельного микроскопа (СТМ). В атомной силовой микроскопии разработаны следующие основные методы исследования поверхности. Контактная атомно-силовая микроскопия. В методе контактной атомно-силовой микроскопии острие зонда непосредственно соприкасается с поверхностью. В этом случае силы притяжения и отталкивания, действующие от образца, компенсируются силой упругости консоли. Изображение рельефа поверхности формируется либо при постоянной силе взаимодействия зонда с поверхностью, либо при постоянном среднем расстоянии между основанием зондового датчика и поверхностью образца. Изображение по этой методике характеризует пространственное распределение силы взаимодействия зонда с поверхностью образца (рис. 1.32).  Рис. 1.32. Схема формирования изображения поверхности при постоянной силе взаимодействия кантилевера с поверхностью (а) и при постоянном расстоянии между кантилевером и поверхностью (б). К недостаткам метода следует отнести непосредственное взаимодействие зонда с поверхностью, что приводит к поломке зондов или разрушению поверхности образа, а также затруднениям в получении воспроизводимых результатов при смене зонда и исследовании деформируемых материалов. Эта методика может быть использована для исследования поверхности с малой механической жесткостью. К ним относятся органические материалы, биологические объекты при условии учета последствий контактного взаимодействия. Колебательный метод атомно-силовой микроскопии. В процессе сканирования используются колебательные методики, которые позволяют уменьшить последствия механического взаимодействия зонда с исследуемой поверхностью. В бесконтактном режиме кантилевер возбуждают так, что бы он совершал вынужденные колебания с амплитудой приблизительно 1 нм. При приближении кантилевера к поверхности на него действуют ван-дер-ваальсовские силы. Градиент сил приводит к сдвигу амплитудно-частотной и фазочастотной характеристик системы. Это обстоятельство используется для получения фазового контраста в исследованиях поверхности методом атомно-силовой микроскопии. Технически измерения проходят в следующей последовательности. С помощью пьезовибратора возбуждают колебания кантилевера на частоте ω0, близкой к резонансной частоте, и амплитудой, которую система обратной связи поддерживает на уровне А0 (А0 < Аω). Напряжение записывается в компьютер в качестве АСМ-изображения рельефа поверхности. Одновременно в каждой точке регистрируются изменения фазы колебаний кантилевера. Данные записываются в виде распределения фазового контраста, что дает возможность получения дополнительной информации об объекте. Микроскопия электростатических сил. В основе метода микроскопии электростатических сил (МЭС) лежит принцип электростатического взаимодействия между кантилевером и образцом. Кантилевер находится на некотором расстоянии Δx: над поверхностью образца. Если образец и кантилевер изготовлены из проводящего электричество материала, то можно приложить между ними постоянное напряжение U0 и переменное U1 sin(ω∙t). Полное напряжение между образцом и кантилевером равно U = U0 – φ(x,y) + U1 sin(ω∙t), где φ(x,y) — величина поверхностного потенциала в точке измерения. При этом появится сила электростатического притяжении между образцом и зондом. Сила, с которой кантилевер будет притягивается к поверхности, равна F = dE/dx, где Е = CU2/2 — энергия конденсатора емкостью С. Для силы F получим выражение  Под действием силы F кантилевер будет колебаться, и переменная составляющая сигнала будет изменяться в соответствии с законом F(t). С помощью синхронного детектора можно выделить компоненты сигнала F на частоте ω или 2ω. МЭС реализуется в двухпроходном режиме. Во время первого прохода строки измеряется рельеф в обычном полуконтактном режиме, а при повторном сканировании строки регистрируется амплитуда резонансных колебаний кантилевера. Различают емкостную микроскопию и Кельвин-микроскопию. Режим емкостной микроскопии применяется для изучения емкостных свойств поверхности образцов, в частности, можно регистрировать распределение легирующей электроактивной примеси в полупроводнике, от которой напрямую зависит глубина обедненного слоя. Для эффективности работы методики средняя величина шероховатости рельефа поверхности образца должна быть меньше радиуса кривизны острия зонда. Кельвин-микроскопия предназначена для исследования поверхностей материалов, имеющих области с различными поверхностными потенциалами. Используя данную методику, можно регистрировать распределение зарядов на элементах поверхности, измерять и анализировать неоднородные заряженные области, определять работу выхода электронов. Среди других методик атомно-силовой микроскопии развиты электросилова микроскопия, магнитносиловая микроскопия, ближнепольная оптическая микроскопия. Эти специфические методики применяются для исследования пленок, локальных магнитных свойств. 5.1.3.Ближнепольная сканирующая оптическая микроскопия.Марголин 379с. Еще совсем недавно считалось, что предел возможностям оптики ставит фундаментальный рэлеевский критерий разрешения оптических приборов. Он заключается в том, что минимальный размер различимого объекта немного меньше длины волны используемого света и принципиально ограничен дифракцией излучения. Однако в последнее время появилась и вызывает все больший интерес возможность изучения и формирования оптическими методами различных структур нанометровых размеров, которые во много раз меньше длины световой волны λ. Такая возможность возникла в связи с развитием ближнепольной оптики (БПО) — нового и чрезвычайно перспективного направления физической и прикладной оптики. С физической точки зрения она основана на присутствии в дальней зоне излучения вполне идентифицируемых следов взаимодействия света с микрообъектом, находящимся в ближнем световом поле, которое локализовано на расстояниях, много меньших λ. В техническом смысле БПО в себе сочетает элементы обычной оптики и сканирующей зондовой микроскопии. Отличительным элементом ближнепольных приборов является оптический зонд (рис. 7.26), обычно представляющий собой заостренное оптическое волокно 1, наружная поверхность которого, за исключением вершины конуса, покрыта непрозрачным слоем металла 3 (d <<λ, h< λ). Окружность, показанная штриховой линией, ограничивает область ближнепольного контакта. Часть светового потока, распространяющегося по волокну, проходит через выходное сечение зонда, как сквозь диафрагму в металлическом экране, и достигает образца, расположенного в ближнем поле источника. Если расстояние z до поверхности образца и радиус rд диафрагмы удовлетворяют условию rд∙ z << λ, то размер светового пятна на образце близок к размеру диафрагмы. При перемещении зонда вдоль образца возможна реализация разрешения, не ограниченного дифракцией, или сверхразрешения. Подобная идея была предложена еще в 1928 г. Е. Сингхом, она намного опередила технические возможности своего времени, но осталась практически не замеченной. Ее первое подтверждение было получено Е.Эшем в опытах с микроволнами в 1972 г. В начале 1980-х гг. группа исследователей из Цюрихской лаборатории фирмы IBM во главе с Дитером Полем проникла внутрь дифракцитонного предела и продемонстрировала разрешение λ/20 на приборе, работающем в видимом оптическом диапазоне и получившем название ближнепольного сканирующего оптического микроскопа (БСОМ). Чуть раньше в этой же лаборатории был создан первый сканирующий туннельный микроскоп, принесший ей всемирную известность. 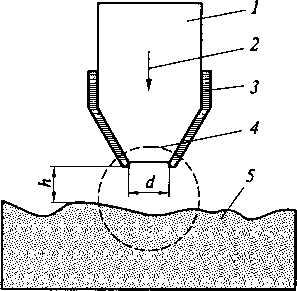 Рис. 7.26. Схема работы оптического микроскопа в ближнем поле: 1 — оптическое волокно; 2 — проходящее через зонд излучение; 3 — слой металла; 4 — выходная апертура зонда; h — расстояние между исследуемой поверхностью и апертурой зонда; d — выходной диаметр оптического волокна. В отличие от туннельного и атомно-силового микроскопов, сразу завоевавших признание, БСОМ некоторое время оставался в тени. Уникальные возможности БСОМ были убедительно продемонстрированы лишь в начале 1990-х гг., когда удалось решить две важные технические проблемы: существенно повысить энергетическую эффективность зондов и обеспечить надежный контроль расстояния между острием и образцом. В последние годы в десятках лабораторий успешно ведутся работы по использованию БСОМ при решении широкого круга задач физики поверхности, биологии, техники записи и считывания информации и др. С 1993 г. в США ведется промышленный выпуск приборов БПО. К настоящему времени создано около 20 типов БСОМ, различающихся особенностями оптической схемы и функциональным назначением зонда. В зависимости от наличия или отсутствия диафрагмы на конце зонда их можно подразделить на две основные группы: апертурные и безапертурные. Принцип действия апертурных БСОМ, составляющих преобладающее большинство современных приборов, заключается в том, что луч лазера (обычно гелий- неонового или аргонового) через согласующий элемент попадает в заостренное металлизированное волокно и на выходе сужается до размеров диафрагмы. Взаимное перемещение острия и образца в трех измерениях (х, у, z) осуществляется с помощью пьезодвижителей. Прошедшие через образец или отраженные и рассеянные фотоны улавливаются одним из микрообъективов и направляются в регистрирующий прибор, обычно фотоумножитель. Такой микрообъектив, как правило, входит в схему обыкновенного оптического микроскопа, что позволяет осуществить выбор исследуемого участка и его привязку к более широкому полю. Широко распространены приборы, работающие в режиме сбора фотонов, когда зонд переносит фотоны от образца, освещенного, например, через микрообъектив, к детектору. В комбинированном режиме (освещение/ сбор) зонд выполняет одновременно обе функции. Чтобы установить острие на нужной высоте над образцом, во всех сканирующих зондовых микроскопах используют зависимость величины / регистрируемого сигнала от z. В большинстве типов БСОМ зависимость I(z) неоднозначна, поскольку наряду с ближнепольным сигналом I1 регистрируется также периодически изменяющийся с z сигнал I2, вызванный интерференцией падающей и переотраженных волн в системе зонд —образец. Это затрудняет или делает полностью невозможным надежный контроль z по величине I= I1+ I2 при сближении острия с образцом. Лучшим решением проблемы является введение в БСОМ вспомогательных узлов, позволяющих им осуществлять также функции сканирующего туннельного или атомно-силового микроскопов, в которых определение z не вызывает существенных трудностей. В таких комбинированных приборах запись изображения осуществляется одновременно по двум каналам, один из которых воспроизводит рельеф поверхности, а другой — локальное распределение показателя преломления в тончайшем приповерхностном слое. Возможность различения оптического и топографического контрастов существенно упрощает интерпретацию изображения. Наибольшее распространение получил метод контроля z, основанный на изменении тангенциальной составляющей силы физического взаимодействия острия с образцом. Основной характеристикой БСОМ является пространственное разрешение, которое в большой степени зависит от условий освещения или, в более общем случае, от наблюдения образца, структуры его поверхности и микрогеометрии зонда. Известно, что функция импульсного отклика дифракционно ограниченной оптической системы описывается распределением Эри. Полуширина главного максимума распределения соответствует разрешению по Рэлею: где φ — апертурный угол. В пределе при При прохождении света через малую диафрагму из-за рассеяния и геометрических ограничений происходит искажение и расширение Δf спектра переносимых пространственных частот, которое также описывается распределением Эри: В результате при α→0 волновое поле непосредственно за диафрагмой содержит сколь угодно большие пространственные частоты, следовательно, В реальной ситуации из-за конечной проницаемости металлического экрана (покрытия) минимальный эффективный радиус диафрагмы определяется глубиной проникновения света в металл или толщиной δ скин-слоя. С учетом этого ожидаемое предельное разрешение, например для зонда с алюминиевым покрытием, в видимом диапазоне спектра составляет Δxmin = 2∙δ = 13 нм, что соответствует лучшим экспериментальным результатам. Отсутствие физических ограничений размера вершины зонда в безапертур- ных БСОМ позволяет реализовать в них разрешение выше 1 нм. Критерий Рэлея иллюстрирует принцип неопределенности Гейзенберга, согласно которому любая попытка повысить степень локализации или точность определения положения Δх источника света приводит к возрастанию неопределенности Δрх сопряженного импульса фотонов. При рассеянии фотонов в максимальном диапазоне углов  где Возможность реализации разрешения Ах « Х/2, казалось бы, противоречит одному из основных физических принципов. Однако следует иметь в виду, что соотношение неопределенности в самом общем виде относится к положению частицы в импульсно-координатном пространстве. Поэтому, ограничивая одну из компонент волнового вектора, оно позволяет варьировать другие. Можно принять, например, где γ — вещественное положительное число. Тогда  (7.17) (7.17)При γ →∞ область допустимых значений kх неограниченно растет, а Δх может быть сколь угодно малым. Мнимым kz соответствуют затухающие волны. Следовательно, при реализации субволнового разрешения антенна—зонд должна располагаться в пределах затухающего поля вблизи поверхности образца, т.е. заведомо при z <λ. Теперь мы можем уточнить понятие ближнего поля, ассоциируя его с областью существования затухающих и, следовательно, нерадиационных волн, амплитуда которых меняется с расстоянием z от границы раздела сред или малого рассеивающего объекта по закону Величина g-1 характеризует глубину проникновения затухающей волны и по порядку соизмерима с размерами субволнового рассеивателя. В частности, для диафрагмы радиуса rд в тонком проводящем экране g-1 = 2∙rд. Для поверхности со сложным рельефом величина g-1 определяется суммарным вкладом компонент спектра пространственных частот, причем т-я компонента с периодом dm<<λ обнаружима на расстоянии (В режиме сбора фотонов точность воспроизведения профиля поверхности возрастает с увеличением числа т компонент затухающего поля, участвующих в образовании изображения, а значит, с уменьшением z.) В дальнем поле при присутствуют лишь распространяющиеся волны, к которым применимы законы и ограничения обычной оптики. Естественно, что они также вносят вклад в результирующее поле в ближней волновой зоне. Структуру ближнего поля могут определять также и различного рода поверхностные резонансные электромагнитные моды, возбуждаемые светом вблизи выходного сечения зонда. Возможность улучшения на порядок и более локальности оптических методов исследования поверхности существенна при решении широкого круга научных и прикладных задач. Анализируя взаимодействие света с неоднородной поверхностью методами обычной оптики, приходится усреднять влияние многих дефектов находящихся в пределах облучаемого участка. Применение БСОМ облегчает исследование отдельных неоднородностей нанометрового размера. Первым подтверждением этой особенности стало обнаружение одночастичных плазмонов, возбуждаемых светом в металлизированных латексных сферах. К числу объектов, для которых проблема локальности оптического анализа играет первостепенную роль, относятся гетероструктуры с квантово-размерными свойствами. В них с помощью БСОМ удается не только локализовать отдельные центры люминесценции, что само по себе представляет значительный интерес, но и разделить их спектры. Такие исследования дают ценную информацию как о структурных особенностях системы, в том числе о шероховатости (на атомном уровне) границ раздела, так и о механизме диффузии и распада квазичастиц типа экситонов. Исследования в БСОМ эффекта наведенного фототока позволяют выявлять приповерхностные дефекты в полупроводниковых образцах с разрешением почти на порядок выше, чем разрешение широко используемых на практике методов OBIC и EBIC (optical/ electron beam induced current). Методы БПО интересны для наноэлектроники, так как позволяют исследовать поверхность и топологию элементов с высокой локальностью. Вместе с тем можно оказывать на поверхность и тонкий слой силовое воздействие (в частности, модифицировать их структуру), если ближнее поле характеризуется высокой напряженностью. Это направление применений БПО, называемое также нанооптикой, также интенсивно развивается. Примером может служить нанесение с помощью БСОМ различных рисунков, характерный размер элементов которых составляет 50...70 нм. Возможность в несколько раз улучшить разрешение при фотолитографии, а также на порядок и более повысить плотность записи информации (например, на магнитооптических средах) является очень перспективной и стимулирует большое число работ, направленных на решение этих задач. Однако переход от лабораторных исследований к разработке промышленных технологий сдерживается малой скоростью нанесения рисунка на поверхность путем сканирования зонда. Требуемая скорость сканирования связана с мощностью излучения, которая ограничена термической устойчивостью зонда. Как уже отмечалось ранее, в типичных условиях только 10-6... 10-4 часть светового потока попадает на образец, а основная часть поглощается металлическим покрытием зонда и нагревает его. Соответствующий анализ показал, что распределение температуры в зонде существенно зависит от его микрогеометрии и структуры поля вблизи вершины. Обычно наиболее нагретая область находится на значительном удалении от вершины. Однако этого достаточно, чтобы уже при световой мощности около 10 мВт, падающей на входное сечение стеклянного волоконного зонда с алюминиевым покрытием выходной конической части, при мощности дошедшего до образца излучения около 10 нВт происходило разрушение зонда из-за плавления алюминиевого покрытия, согласно результатам измерений. При рассмотрении эффективности воздействия интенсивного света на вещество в области ближнепольного контакта нужно иметь в виду, что длина свободного пробега неравновесных носителей, возникших при поглощении света, и размер области, где происходит разветвленный процесс фотовозбуждения и разогрева вещества, могут существенно превосходить размер апертуры зонда. В сканирующих ближнепольных оптических микроскопах используется луч света диаметром меньше, чем длины волны источника света. Свет подается по оптическому волокну, которое стравливается на острие. Такое технологическое новшество позволяет получить высокую степень разрешения микроскопа, превосходящую классическую оптику. Ближнепольный оптический микроскоп на основе светового волокна с малой апертурой на выходе весьма полезен при исследовании фоточувствительных структур, биологических объектов и наноструктурированных материалов. |
