Курс лекций НЭ_ч4-ч5_Богач_2013. Курс лекций " Основы наноэлектроники"
 Скачать 3.44 Mb. Скачать 3.44 Mb.
|
|
Курс лекций “Основы наноэлектроники” Ч.4. Технологии наноэлектроники; Кафедра электронной техники Севастопольского национального технического университета к.т.н., доцент кафедры ЭЛТ Богач Николай Владимирович сентябрь 2013г. 4 курс бакалавров специальности РАЗДЕЛЫ курса лекций 1) Физика квантовых явлений наноэлектроники; 2) Элементарные объекты наноэлектроники и их свойства; 3) Наноэлектронные приборы; 4) Технологии наноэлектроники; 5) Методы исследования наноструктур. 4. Технологии наноэлектроники 3 4.1. Молекулярно-лучевая эпитаксия. 3 4.2. Газофазная эпитаксия из металлоорганических соединений. 9 4.3. Нанолитография. 18 4.3.1. Разрешающая способность. 18 4.3.2. Оптическая литография. 21 4.3.3. Рентгеновская литография. 23 4.3.4. Электронная литография. 28 4.3.5. Ионная литография. 35 4.3.6. Возможности методов литографии в наноэлектронике. 36 4.3.7. Нанопечатная литография. 39 4.4. Процессы травления в нанотехнологии. 41 4.5. Процессы самосборки повторяющихся структур. 46 4.5.1. Самосборка в объемных материалах. 47 4.5.2. Самосборка при эпитаксии. 48 4.6. Пленки пористых материалов. 56 4.6.1. Пленки пористого кремния. 56 4.6.2. Пленки пористого оксида алюминия. 59 4.7. Пленки поверхностно-активных веществ. 73 4.7.1. Основные определения и механизмы. 74 4.7.2. Осаждение пленок ПАВ. 74 4.8. Пленки на основе коллоидных растворов. 81 4.8.1. Основные определения и свойства. 81 4.8.2. Золь-гель технология. 84 4.8.3. Методы молекулярного наслаивания и атомно-слоевой эпитаксии. 86 4.9. Зондовые нанотехнологии. 88 4.9.1. Физические основы зондовой нанотехнологии. 88 4.9.2. Контактное формирование нанорельефа. 93 4.9.3. Бесконтактное формирование нанорельефа. 94 4.9.4. Локальная глубинная модификация поверхности. 95 4.9.5. Межэлектродный массоперенос. 96 4.9.6. Электрохимический массоперенос. 98 4.9.7. Массоперенос из газовой фазы. 98 4.9.8. Локальное анодное окисление. 99 4.9.9. СТМ-литография. 102 5. Методы исследования наноструктур. 105 5.1. Сканирующая зондовая микроскопия. 105 5.1.1. Сканирующая туннельная микроскопия. 105 5.1.2. Атомно-силовая микроскопия. 108 5.1.3. Ближнепольная сканирующая оптическая микроскопия. 113 5.2. Масс-спектроскопия атомов и молекул. 120 5.2.1. Определения и возможности. 120 5.2.2. Конструкции масс-анализаторов. 120 5.2.3. Вторично ионная масс-спектроскопия. 127 5.3. Электронные микроскопы. 131 5.3.1. Просвечивающие электронные микроскопы. 132 5.3.2. Растровые электронные микроскопы. 134 5.3.3. Метод дифракции медленных электронов (ДМЭ). 136 5.3.4. Метод дифракции отраженных быстрых электронов (ДОБЭ). 139 5.3.5. Оже-электронная спектроскопия. 141 5.4. Фото-электронная спектроскопия. 143 5.5. Полевая эмиссионная микроскопия. 145 5.6. Эллипсометрия. 148 5.7. Конфокальная сканирующая оптическая микроскопия. 152 5.8. Радиоспектроскопия. 157 5.8.1. Электронный парамагнитный резонанс. 157 5.8.2. Ядерный магнитный резонанс. 158 5.8.3. Ядерный квадрупольный резонанс. 158 5.9. Рентгено-структурный анализ. 159 5.9.1. Метод Лауэ. 159 5.9.2. Метод Дебая-Шеррера. 159 5.9.3. Компьютерный метод ДШ. 159 4.Технологии наноэлектроники4.1.Молекулярно-лучевая эпитаксия.Эпитаксия является одним из важнейших технологических процессов при создании микро- и наноструктур. Под эпитаксией понимают ориентированный рост слоев, кристаллическая решетка которых повторяет решетку подложки. Если подложка и выращенный слой состоят из одного вещества, то такой процесс называется автоэпиаксией. Гетероэпитаксиальный процесс происходит при выращивании слоев из различных веществ. В процессе хемоэпитаксии происходит образование новой фазы при химическом взаимодействии вещества подложки с веществом формируемого слоя. Молекулярно-лучевая эпитаксия (МЛЭ) является одним из современных и перспективных технологических методов выращивания тонких монокристаллических слоев и полупроводниковых структур на их «лове. Молекулярно-лучевая эпитаксия основана на процессе взаимодействия нескольких молекулярных пучков с нагретой моно- кристаллической решеткой и последующего осаждения на ней элементарных компонентов. Формирование эпитаксиальных слоев происходит в процессе управляемого испарения вещества из одного или из нескольких источников, создающих молекулярные пучки, в условиях сверхвысокого вакуума. Рост эпитаксиальных слоев происходит на нагретой монокристаллической подложке при реакции между несколькими молекулярными пучками различной интенсивности и состава. При этом обеспечивается и легко воспроизводится предельно высокое качество слоев с заданным химическим составом, в том числе, исключительное совершенство структуры и однородность толщины эпитаксиального слоя. Метод МЛЭ обладает очень широкими возможностями: он позволяет использовать при выращивании различные способы маскирования, выращивать эпитаксиальные слои элементарных полупроводников, полупроводниковых соединений, металлов и диэлектриков, гетероструктуры с высоким качеством границ между слоями. Могут выращиваться гетеропереходы с сопряженными решетками и с постепенно изменяющимся периодом кристаллической решетки. Методом МЛЭ удается осуществлять гетероэпитаксию разнородных материалов, выращивая, например, соединения A3B5 на кремниевых или диэлектрических подложках, что чрезвычайно важно для интеграции в одном кристалле оптоэлектронных и интегрально-оптических систем на арсениде галлия с вычислительными модулями или с другими системами обработки информации на кремнии. Кроме того, в оборудовании для МЛЭ размещают приборы, дающие возможность анализировать параметры слоев непосредственно в процессе выращивания. Использование чистых источников напыляемых материалов, сверхвысокий вакуум, различные методы диагностики растущего слоя в сочетании с компьютерной системой управления параметрами процесса — все это привело к созданию качественно новой технологии. Установка молекулярно-лучевой эпитаксии состоит из двух камер: камеры роста и камеры анализа (рис. 2.1). В обеих камерах создается безмасляный сверхвысокий вакуум ( < 10-8 Па). 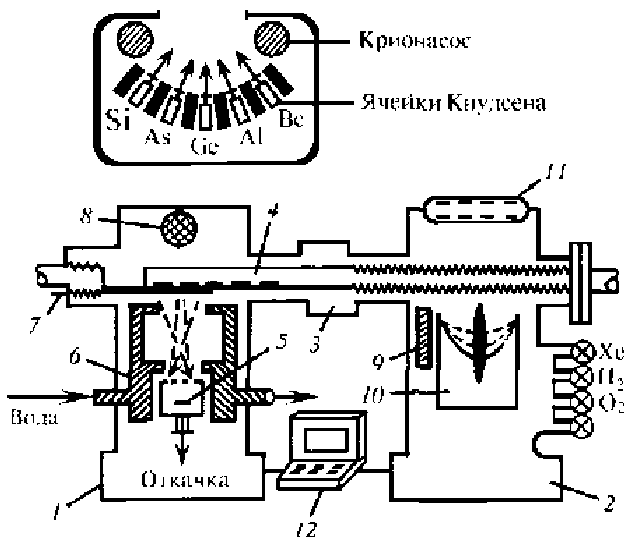 Рис.2.1 Схема установки молекулярно-лучевой эпитаксии: 1-камера роста; 2-камера анализа; 3- вакуумный клапан; 4- держатель подложки; 5-испарители; 6- охлаждаемые экраны; 7-заслонка; 8-квадрупольный масс-спектрометр; 9-ионная пушка; 10-дифрактометр медленных электронов и Оже-спектрометр; 11-окно; 12-компьютер. В камере роста происходит формирование эпитаксиальных пленок. Испарители представляют собой эффузионные ячейки Кнудсена, в которых происходит медленное истечение испаряемых молекул через малое отверстие (рис. 2.1, поз. 5). Из таких ячеек особенно хорошо испарять материалы, возгоняющиеся из твердой фазы и имеющие плохую теплопроводность. При их испарении с открытых источников может происходить откалывание мельчайших частиц материала и выбрасывание этих частиц в сторону подложки. Основным достоинством эффузионных ячеек Кнудсена является постоянство скорости истечения из нее пара испаряемого вещества во время процесса напыления. С целью уменьшения теплового взаимодействия и предотвращения взаимного загрязнения источников испарительные ячейки разделяют экранами, охлаждаемыми жидким азотом. В каждой испарительной ячейке содержится один из элементов, из которых выращивается слой. Температура каждой испарительной ячейки выбирается так, чтобы обеспечить выход из нее молекулярного пучка нужной интенсивности. Для некоторых материалов с низким давлением паров температуры, необходимые для обеспечения адекватной интенсивности пучка, столь высоки, что приходится использовать не испарение из ячеек с резистивным нагревом, а применять непосредственное испарение электронным пучком. Выбирая соответствующие температуры испарителей и подложки, можно получить эпитаксиальные слои требуемой стехиометрии состава. Между каждой из испарительных ячеек и подложкой установлены индивидуальные заслонки, которые позволяют очень быстро перекрывать пучки. Заслонки управляются внешними сигналам, в т.ч. от ПК. Это дает возможность изменять состав или уровень легирования выращиваемых структур буквально на межатомном расстоянии. Решающим для качества будущего слоя является качество приготовления подложки. Прежде всего, необходимо иметь неповрежденную атомарно чистую поверхность. Обычная процедура приготовления подложки включает химическую обработку раствором Вr2 с метанолом, а также смесями серной кислоты, перекиси водорода и воды в различных соотношениях (обычно 7:1:1). Для удаления оксида и следов углерода подложку разогревают до 555 ±5 oС в потоке мышьяка. Для удаления углерода используется также высокотемпературная ионная очистка. Смену подложек производят без разгерметизации камеры роста, используя для этой цели вакуумные шлюзы, так как достижение сверхвысокого вакуума — очень длительный процесс. Наличие вакуумных шлюзов позволяет работать в течение многих недель без разгерметизации камеры. Изготовление эпитаксиальных структур с атомными размерами толщины слоев требует выращивания атомно-гладких поверхностей при температурах подложки настолько низких, чтобы в процессе роста практически не происходило объемной диффузии. Оптимальная температура при осуществлении МЛЭ обычно на 100 – 200 оС ниже температуры, используемой при проведении эпитаксии из жидкой или газовой фазы. Для GaAs она составляет примерно 500 - 650 оС. Такой температуре соответствует низкая скорость роста слоя ≈ 0,1 нм/с, что эквивалентно выращиванию одного моноатомного слоя в секунду. Это обстоятельство приводит к необходимости поддержания особо высокого вакуума для обеспечения минимального неконтролируемого введения примесей в растущий слой. При выращивании слоев GaAs методом МЛЭ атомы галлия и молекулы As2 и As4 падают на подложку GaAs. К поверхности подложки «прилипают» практически все атомы галлия. Поток атомов мышьяка делается избыточным, но только один атом As на каждый атом Ga остается на подложке, формируя стехиометрический состав выращиваемого слоя (рис. 2.2).  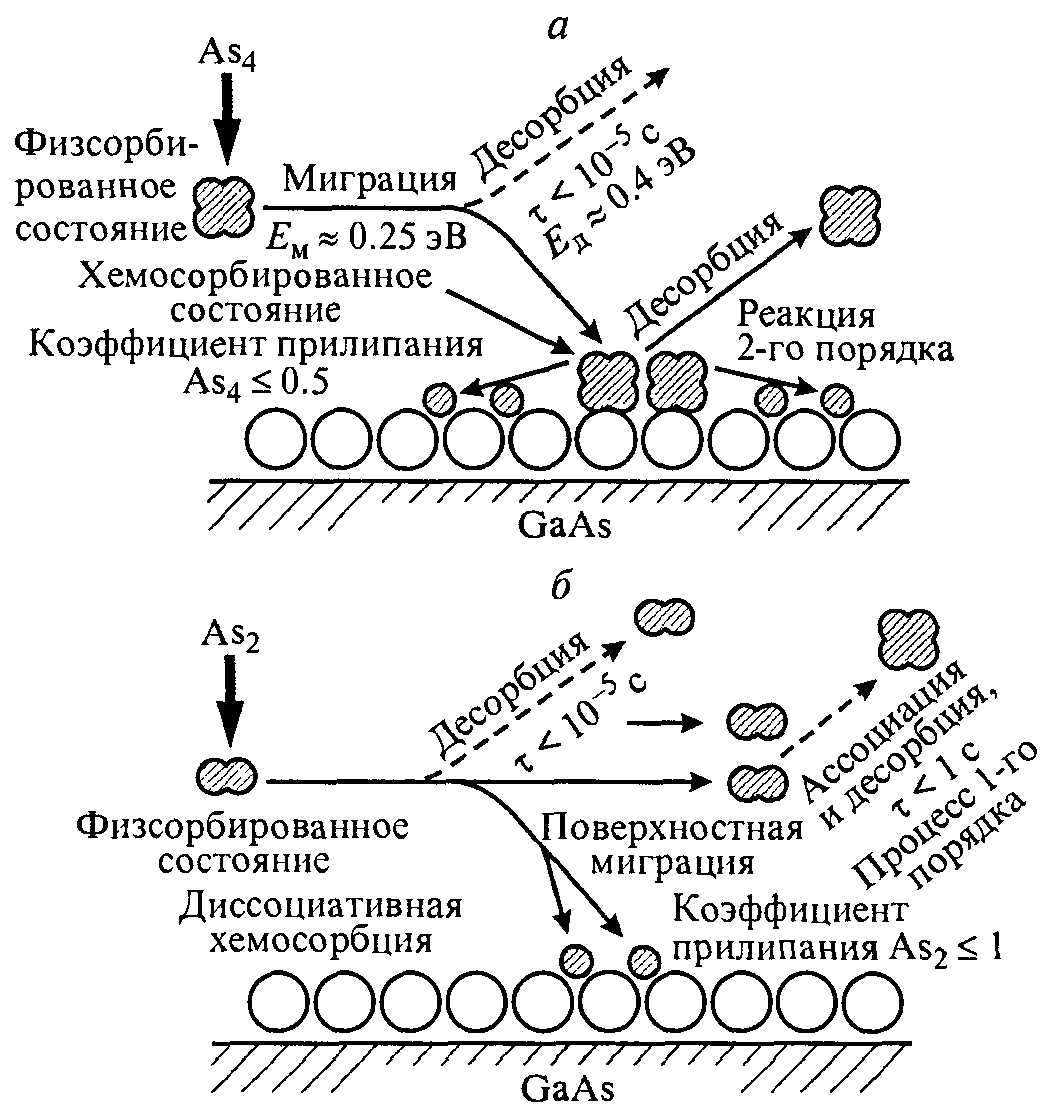 Рис.2.3. Модель механизма роста GaAs из молекулярных пучков Ga и As4 (а) и пучков Ga и As2 (б). Основным процессом является реакция диссоциативной хемосорбции молекул As2 на поверхностных атомах галлия. Коэффициент прилипания молекулы As2 близок к единице, в то время как для молекул As4 он не достигает значения 0.5. Атомы As, не образовавшие связи с Ga, испаряются с поверхности. Интенсивность молекулярных пучков и, следовательно, скорость осаждения можно варьировать, изменяя температуру галлиевого источника. Обычно плотность потока галлия близка к 1015 атом/(см2∙с), а для мышьяка она в 5 - 10 раз выше. Источником молекул мышьяка является, как правило, твердый мышьяк, источником галлия — твердый галлий. Здесь следует заметить, что вообще скорость роста слоев соединений А3В5 определяется плотностью потока атомов элемента А3, а стехиометрия слоя достигается поддержанием избыточного (по сравнению с А3) потока молекул В5. Это относится к тем соединениям А3В5, компоненты которых обладают существенно различными упругостями паров при температурах эпитаксии (GaAs, GaP, InAs, InP). Для выращивания соединений AlGaAs требуется источник Аl, при этом соотношение Al и Gа в растущем слое будет пропорционально соотношению плотностей потока в их пучках. Помимо температуры, в испарительной ячейке плотность потока зависит от молекулярной массы испускаемых атомов или молекул, от суммарной площади отверстий эффузионной ячейки и от расстояния до подложки. Свежеприготовленная для эпитаксии подложка соединений А3В5 покрыта пассивирующим слоем оксида, который служит защитой от атмосферных загрязнений перед эпитаксиальным ростом. После того, как система МЛЭ откачана, экраны охлаждены жидким азотом и эффузионные ячейки выведены на требуемую температуру, начинается нагрев подложки. В случае нагрева подложки из GaAs его оксид десорбируется в интервале температур 580 - 600 °С, а в случае InP — приблизительно при 520 °С, после чего подложка становится почти атомарно чистой и пригодной для эпитаксиального наращивания. Если подложка должным образом подготовлена и атомарно чиста, то эпитаксиальный слой будет атомарно гладким при условии, что отношение чисел атомов пятой и третьей групп в молекулярном пучке превосходит некоторое значение, обеспечивая As-стабилизированную структуру поверхности. Это значение также является функцией температуры подложки. В промышленных системах МЛЭ при температуре подложки 620 °С может быть достигнута скорость роста слоя GaAs до 10 мкм/ч. Поскольку процесс МЛЭ происходит в сверхвысоком вакууме, его можно контролировать с помощью различных диагностических методов, поместив в систему соответствующую аппаратуру, в частности, -масс-спектрометр для анализа как атомных, так и молекулярных пучков и фоновой атмосферы; -дифрактометр медленных электронов; -электронный оже-спектрометр с целью контроля состава слоя, резкости границ и взаимной диффузии; -ионный вакуумметр, контролирующий нейтральные атомные пучки; - квадрупольный масс-анализатор для контроля интенсивности пучков и -ионную пушку для очистки поверхности подложки. -для исследования слоев, выращенных методом МЛЭ, используются и многие другие приборы и методы. Возможность контроля непосредственно в процессе выращивания — одно из значительных преимуществ МЛЭ. Богатые возможности контроля и анализа дают МЛЭ существенные преимущества перед другими технологическими методами. Весь процесс контролируется и управляется компьютером. Молекулярно-лучевая эпитаксия обеспечивает: - получение монокристаллических слоев высокой чистоты, так как их рост осуществляется в сверхвысоком вакууме при высокой чистоте потоков веществ; -выращивание многослойных структур с резкими изменениями состава на границах слоев благодаря относительно низкой температуре роста, препятствующей взаимной диффузии; - получение гладких бездефектных поверхностей при гетероэпитаксии, что обусловлено ступенчатым механизмом роста; - получение сверхтонких слоев с контролируемой толщиной за счет точности управления потоками и относительно малых скоростей роста; создание структур со сложными профилями состава и (или) легирования. Метод МЛЭ является перспективным с точки зрения получения улучшенных характеристик, чрезвычайно высокой точности, однородности и высокого совершенства поверхности, он позволяет существенно повысить по сравнению с другими методами выход годных гетероструктур. В настоящее время МЛЭ представляет собой полностью отработанную технологию с большими потенциальными возможностями. Благодаря такому достоинству, как сглаживание поверхности эпитаксиального стоя в процессе роста, метод МЛЭ особенно удобно использовать для выращивания гетеропереходов, сверхрешеток и многослойных структур. В настоящее время доминирующей областью использования данного метода является получение структур низкой размерности и нанокомпозиций неорганической природы на основе соединений A3B5, A2B6, A4B4. Добавить из других книг |
