Курс лекций НЭ_ч4-ч5_Богач_2013. Курс лекций " Основы наноэлектроники"
 Скачать 3.44 Mb. Скачать 3.44 Mb.
|
4.4.Процессы травления в нанотехнологии.Марголин с.295 Создание резистного изображения на подложке не является самоцелью (за исключением вскрытия окон под диффузию, ионного легирования или окисления) — необходимо перенести изображение на находящуюся под резистом пленку или подложку. Применение химического травления вследствие изотропного характера для субмикронной технологии исключено. Необходимы прецизионные анизотропные методы удаления материала. Основным методом становится сухое травление, которое подразделяется на ионно-плазменное, ионно-лучевое травление (фрезерование), и реактивные методы, основанные на применении химических реакций, протекающих в плазменной среде. Часто под плазменным травлением подразумевают чисто химические реакции с применением плазмы в качестве катализатора. При ионно-плазменном и ионно-лучевом травлении поток ионов используется для распыления материала, как в процессах, связанных с напылением материалов. Но в данном случае распыленный материал просто удаляется. В качестве травителя используются высокоэнергетические (свыше 500 эВ) ионы инертного газа, которые тем или иным способом, чаще всего электрическим полем, ускоряются до требуемых энергий и бомбардируют обрабатываемую поверхность. Вектор электрического поля обычно нормален к поверхности, поэтому анизотропия травления очень высокая. Основным механизмом взаимодействия между бомбардирующими ионами и атомами материала является процесс передачи импульса, при котором за счет упругих столкновений атомы мишени непосредственно выбиваются с поверхности или после ряда актов рассеяния в приповерхностном слое, приводящих к повороту вектора импульса. Возможен также режим линейного каскада, когда первичный ион передает энергию атому мишени, который и инициирует удаление другого атома непосредственно или также путем каскадной передачи энергии. Чем выше энергия первичных ионов, тем выше вероятность каскадного механизма. Основным параметром процесса распыления является коэффициент распыления Кр (среднее число атомов, удаляемое с поверхности одной падающей частицей), который согласно теории Зигмунда определяется по формуле  где β — безразмерный коэффициент, зависящий от соотношения М1/М2; М1, М2 — атомная масса соответственно иона и атома мишени (здесь и далее при рассмотрении ионных процессов индекс 1 соответствует первичному иону, а индекс 2 — атому мишени); Ех — энергия первичного иона; Ес — энергия сублимации атома мишени. Поскольку, как следует из выражения (5.22), коэффициент распыления зависит от энергии ионов, должна существовать оптимальная энергия, при которой коэффициент максимален. Наиболее эффективная энергия иона Е1*, соответствующая максимальному значению Кр, согласно этой теории определяется по формуле  где а0 — боровский радиус атома водорода; Z1, Z2 — атомные номера соответственно иона и атома материала мишени. Кроме энергии иона, коэффициент распыления зависит от: - массы бомбардирующего иона (прямо пропорционально); - атомного номера распыляемого материала (сложная периодическая зависимость с пропорциональным ростом в пределах одного периода Периодической системы элементов Д. И. Менделеева); - угла падения ионов (в первом приближении A’p(G) = Ap(O)/cos0; - чистоты обработки поверхности (чем более шероховатая поверхность, тем меньше Кр) и - практически не зависит от температуры подложки. Для плазменного травления обычно применяют молекулярные газы, в состав которых входят галогены, которые в процессе взаимодействия с обрабатываемым материалом образуют летучие соединения при комнатной температуре, что обеспечивает качественный перенос рисунка. В основе плазменного травления лежат активируемые плазмой химические реакции между свободными атомами и радикалами и поверхностными атомами обрабатываемого материала. При этом обрабатываемый материал непосредственно находится в плазменной зоне, а результатом взаимодействия являются летучие соединения, легко удаляемые из зоны обработки. Активирующее воздействие оказывают непосредственно ионы и электроны и излучение плазмы. Воздействие заряженных частиц зависит от их энергии и потенциала обрабатываемой поверхности относительно плазмы. В зависимости от параметров процесса может возникать плавающий потенциал, значение которого определяется мощностью, вкладываемой в разряд, давлением и видом газа и обычно не превышает нескольких десятков вольт. Поэтому, разность потенциалов между плазмой и поверхностью (примерно 0,1) недостаточна для эффективного физического распыления, но энергия заряженных частиц и плазменного излучения достаточна для разрушения химической связи между поверхностными атомами материала, для активации химических реакций и стимулирования процессов десорбции образующихся продуктов. Этот способ является аналогом обычного жидкостного химического травления, но вместо жидкой фазы активной средой является плазменное облако. При проведении реактивного ионно-плазменного травления (РИПТ) обрабатываемые образцы находятся в контакте с плазмой и размещаются на электроде, подключенном к источнику высокочастотного напряжения. Удаление материала происходит как за счет непосредственного физического распыления ускоренными ионами химически активных газов, так и в результате химических реакций между свободными атомами и радикалами, образующимися в плазме, и атомами мишени. Плазма стимулирует процессы, происходящие как в газовой фазе, так и на поверхности материала, повышая скорость химических реакций, что, в свою очередь, ослабляет химические связи поверхностных атомов и увеличивает скорость физического распыления. Физический и химический процессы при РИГТТ имеют не аддитивный характер, т.е. количество материала, удаленного при одновременном протекании этих процессов существенно больше суммы количества материала, удаленного с помощью каждого процесса сепаратно. Соотношение между этими двумя ветвями процесса РИПТ зависит от рабочего газа, энергии ионов, вводимой в разряд мощности, давления газа, геометрии системы. Механизм действия ионов в ускорении реакции неясен. Возможно, ионы передают энергию для соединения активированных атомов и радикалов для соединения с атомами мишени и образования газовой фазы; возможно, просто разлагают адсорбированные поверхностью молекулы или, распыляя примеси и разрыхляя поверхность, облегчают непосредственно процесс травления. На интенсивность распыления (число атомов поверхности, выбитых одним падающим ионом) влияют энергия ионов и угол их падения на обрабатываемую поверхность. Очевидно, что энергия ионов должна превышать пороговую энергию удаления ионов с поверхности, которая составляет примерно 20 эВ, причем для достижения эффективного травления — намного превышать. Ионы, падающие на поверхность под некоторым углом, более эффективно выбивают атомы с поверхности, но это ухудшает анизотропию процесса. Большее значение имеет эффект катализа протекающих на поверхности химических реакций атомными соударениями. При этом ионная бомбардировка создает на поверхности дефекты, способствующие ускорению протекающих реакций, обеспечивает непосредственную диссоциацию молекул травящих газов и способствует удалению нелетучих остатков, замедляющих травление. Важным фактором является состав рабочего газа. На рис. 5.15 приведен график зависимости скорости травления W кремниевой подложки от концентрации К молекулярного кислорода в плазме CF4. 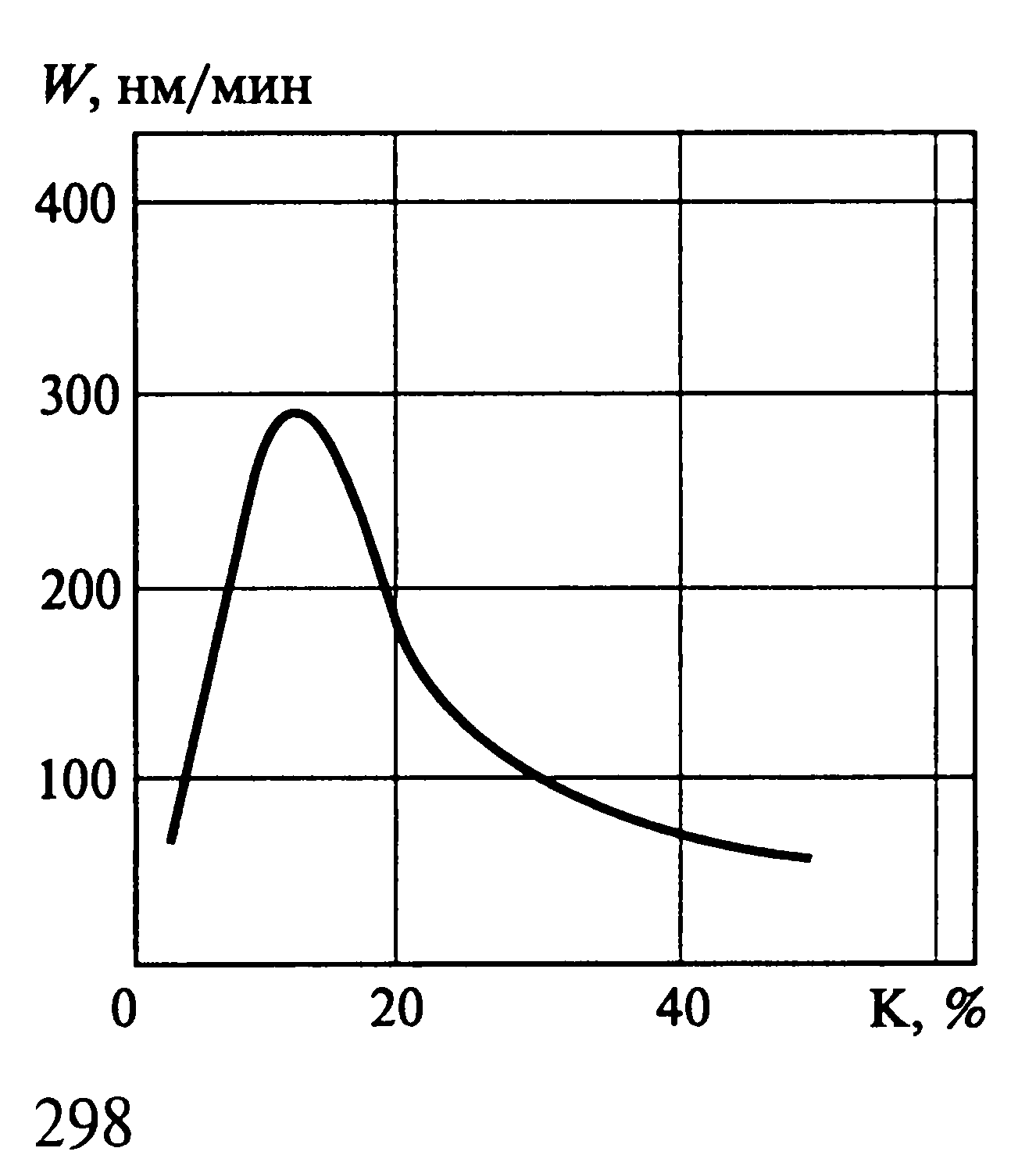 Рис.5.15. График зависимости скорости травления W кремниевой подложки от концентрации К молекулярного кислорода в плазме CF4. Максимальная скорость травления достигается примерно при 12 % содержания кислорода для Si (и 20 % для Si02). При дальнейшем повышении концентрации кислорода скорость травления уменьшается. Это связано с тем, что при диссоциации молекулы CF4 образуется атомарный фтор, который и травит кремний, но он активно рекомбинирует с радикалами CFX (х < 3), что снижает эффективность травления. Добавление кислорода уменьшает число этих радикалов за счет образования их соединений, что уменьшает скорость рекомбинации атомарного фтора и приводит к увеличению скорости травления. Температурная зависимость скорости реактивного травления в первом приближении подчиняется закону Аррениуса и пропорциональна экспоненте в степени (-Q/kT), где Q— энергия активации; k— постоянная Больцмана; Т— абсолютная температура, хотя и имеют место исключения, когда с ростом температуры скорость реакции уменьшается. Возможно, это связано с увеличением скорости термической десорбции травителя с поверхности. При методе сухого травления также надо учитывать влияние материала реактора и элементов конструкции, так как в процессе травления весь объем камеры подвержен ионной бомбардировке (в разной степени) и может распыляться. Этот распыленный материал осаждается на подложку и загрязняет обрабатываемую микросхему. Это явление существенно ограничивает, например, применение нержавеющей стали, поскольку происходит загрязнение полупроводниковой подложки атомами тяжелых металлов, которые резко уменьшают время жизни неосновных носителей. Влияние РИПТ на обрабатываемые материалы связано с бомбардировкой поверхности материалов (и конструкционных элементов установки) ионами и электронами. Связанное с этим радиационное воздействие приводит к возникновению электронных ловушек в материале мишени, которые могут изменять параметры создаваемых в подложке микроэлектронных элементов. За счет повреждений, вызываемых ионной бомбардировкой, могут возникать дефекты структуры и целые аморфные кластеры. Исследования процессов прецизионного травления продолжаются, и технология все время совершенствуется. Добавить из других книг. |
