_Павлов«Аддитивнаыйспособ повышения прочности титана имплантацие. Аддитивный способ повышения прочности титана имплантацией ионов инертного газа д т. н., проф каф. Элэт
 Скачать 2.33 Mb. Скачать 2.33 Mb.
|
|
«Аддитивный способ повышения прочности титана имплантацией ионов инертного газа» д.т.н., проф. каф.ЭЛЭТ Перинский В.В. Аннотация Работа содержит 84 страниц, 17 рисунков, 8 таблиц, 48 источников литературы. Целью работы является модернизация установки ионно-лучевого легирования «Везувий-5» так, чтобы появилась возможность проведения имплантации примесей в металлы, как для научных целей, так и для использования в производстве изделий микроэлектроники, биомедицинской техники; а также подбор оптимального режима работы ионного источника и масс-сепаратора ускорителя для исключения возможности попадания ионов различных масс в имплантируемую мишень при осуществлении аддитивного способа повышения прочности титана имплантацией ионов аргона в среде инертного газа. The summary The work contains 84 pages, 17 figures, 8 tables, 48 sources of literature. The aim of this work is modernization of ion-beam doping "Vesuvius-5" so that it became possible implantation of impurities in metals, both for scientific purposes and for use in the manufacture of microelectronics, biomedical engineering and implantology, as well as the selection of the optimal operation mode ion source and accelerator mass separator to avoid the possibility of entering ions of different masses in the implanted target. Содержание Введение…………………………………………………………………….……..6 Анализ научно-технической информации………………………………..……..8 1.1Установка и эффект ионно-лучевой пассивирующей обработки металлов, применяемых в медицинской технике. …....……………………………………8 Конструкция и принцип действия основных элементов установки ионно-лучевого легирования «Везувий-5». ……………………………………………9 Источник ионов аргона. ………………………………………………………..12 Масс-сепаратор. …………………….………………………………………..…15 Блок ускорения и фокусировки. …………………………………………..……16 Приёмная камера………………………………………………………….…..…17 Эффект ионно-лучевой пассивации поверхности металлов………………….19 Патентный обзор по технологии ионно-лучевой обработки изделий………………………………………………………………………….24 Исследовательская часть……………………………………………………..…33 3.1 Исследование спектров масс источника ионов ионно-лучевой установки «Везувий-5»………………………...………………………………………….…33 Конструкторская часть…………………………………………………………38 4.1 Модернизация приёмной камеры установки «Везувий-5» с целью контролируемого ведения технологического процесса ионно-лучевого легирования металлов………………………………………………………...…38 Технологическая часть………………………………………………….……….41 5.1 Усовершенствование исследованной технологической операции с использованием устройства подачи реакционного СО2-газа……………...…..41 5.2 Управление процессом ионно-лучевой имплантации и контроля дозы…45 Экологическая экспертиза……………………………………………………..54 Безопасность технического процесса…………………………………………62 Технико-экономическая оценка……………………………………………….69 Заключение……………………………………………………………….….….79 Список использованной литературы……………………………………..…….80 Приложения Введение Аддитивное ионное легирование – это многократное внедрение ионов примеси внутрь твердого тела мишени в различных газовых средах. Оно позволяет вводить в различные мишени (металлические, полупроводниковые, диэлектрические) ионы различных элементов, и получать требуемые значения и заданные распределения концентрации примеси. Сравнительно низкая температура обработки мишени, точный контроль глубины и профиля распределения примеси, гибкость и универсальность, возможность автоматизации процесса способствуют расширению применения технологии ионной имплантации в различных областях современного производства [1,48]. Начало планомерных исследований физико-химических особенностей и возможностей практического применения эффектов аномально сильного изменения химической активности имплантированных ионами металлов связано, по-видимому, с открытием уникальных химических свойств лунных материалов, подвергавшихся воздействию «солнечного ветра». Аналогичный эффект химической пассивации тонких металлических слоёв, облучённых ионами аргона с энергией до  эВ, был установлен рядом авторов ещё в 1980/81 гг. и в дальнейшем воспроизведён в Московском институте стали и сплавов, НИИ физических проблем, НИИ вакуумной техники (г. Москва), НИИ материаловедения (г. Зеленоград) и т.д. С 1982 года начали появляться зарубежные публикации (Япония, США) об исследовании и с 1990 г. – о практическом применении эффектов ионно-стимулированной пассивации металлов в процессах литографии, качественного травления топологических рисунков и для повышения коррозионной стойкости материалов. эВ, был установлен рядом авторов ещё в 1980/81 гг. и в дальнейшем воспроизведён в Московском институте стали и сплавов, НИИ физических проблем, НИИ вакуумной техники (г. Москва), НИИ материаловедения (г. Зеленоград) и т.д. С 1982 года начали появляться зарубежные публикации (Япония, США) об исследовании и с 1990 г. – о практическом применении эффектов ионно-стимулированной пассивации металлов в процессах литографии, качественного травления топологических рисунков и для повышения коррозионной стойкости материалов. Основной реакционно-активной составляющей твердотельных устройств является поверхность. Ионная имплантация открывает новые возможности для придания поверхности свойств, не зависящих от характеристик, определяемых всей массой материала. Таким образом, можно создавать уникальные структуры и составы: получать сплавы, которые в жидком состоянии не смешиваются, вводить одно вещество в другое в необходимых пропорциях, которые невозможно достичь даже при использовании высоких температур [19]. По отношению к полупроводникам ионная имплантация применяется почти исключительно для изменения их электрических свойств [14,27]. Что же касается металлов, то в этом случае на первый план выдвигаются задачи изменения их механических и химических свойств [26]. Такой способ получения желаемых свойств материалов ценен тем, что он не требует изменения размеров или объёмных свойств детали; к тому же адгезия имплантированных поверхностей не ухудшается в отличие от тех случаев, когда применяется различного рода покрытия. В настоящее время имплантационное регулирование химической активности металлов так же, как и имплантационная металлургия в целом, являются наиболее быстро развивающимися и перспективными направлениями радиационной физики и технологии материалов. До сих пор существуют и не изученные стороны процессов, которыми занимаются учёные многих стран мира. Таким образом, целью настоящей дипломной работы является модернизация установки ионно-лучевого легирования «Везувий-5» так, чтобы появилась возможность проведения имплантации металлов, как для научных целей, так и для использования в производстве изделий микроэлектроники, биомедицинской техники и импланталогии, а также увеличения эффективности работы ионного источника. Задачей дипломной работы является получение оптимальных режимов работы ионного источника и масс-сепаратора ускорителя для исключения возможности попадания ионов различных масс в имплантируемую мишень, а также создание устройства для дозированной ручной или автоматической подачи СО-газа в объём приёмной камеры с целью обеспечения проведения операций повышения антикоррозионных свойств, износостойкости и твёрдости металлических слоёв. Анализ научно-технической информации 1.1 Установка и эффект ионно-лучевой пассивирующей обработки металлов, применяемых в медицинской технике Для получения, формирования и ускорения ионных пучков легирующих веществ используют ионно-лучевые установки (рисунок 1), которые различаются по конструкции входящих в них систем, типу применяемых ионных источников и приемных камер, значению генерируемого ионного тока и максимальной энергии ионов. [47]  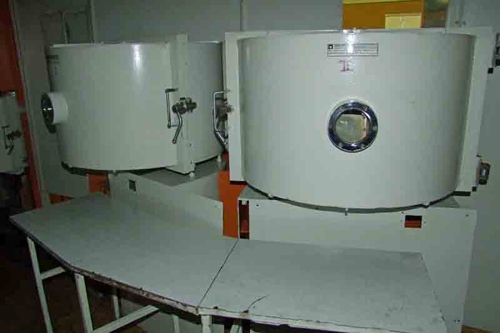 а) б) Рисунок 1 – Установка ионно-лучевого легирования: а) «Везувий-5», б) «Везувий-3». Вид со стороны приёмной камеры. Современные ионно-лучевые установки состоят из ионного источника, экстрагирующей и фокусирующей оптики, ускоряющей системы, масс-сепаратора, устройства сканирования ионного пучка, системы источников питания, приемной камеры, вакуумной системы, устройства контроля и управления технологическим процессом (рисунок 2). [45] 1.2 Конструкция и принцип действия основных элементов установки ионно-лучевого легирования «Везувий-5» Схема установки ионного легирования представлена на рисунке 2. Ионы образуются в разрядной камере ионного источника 1 за счет ионизации паров рабочего вещества в дуговом разряде и вытягиваются из нее при помощи вытягивающего электрода. Дуговой разряд в источнике происходит в поперечном магнитном поле, создаваемом постоянным магнитом самого источника. Вытягивающийся из источника ионный пучок, попадает в электромагнит масс-сепаратора 3, где происходит разделение ионов по массам, в зависимости от напряженности магнитного поля, создаваемого электромагнитом 2. Сепарированный ионный пучок попадает в систему фокусирующую 6, которая формирует его в вертикальной и горизонтальной плоскостях. Пройдя систему фокусирующую, ионный пучок ускоряется до заданной энергии ионов в ускорительной трубе 7 и попадает в систему отклоняющую 9, где ионный пучок может смещаться со своего первоначального тракта, сканированием в горизонтальной плоскости пластинами 11, в вертикальной плоскости -пластинами 10 (для поштучного режима ионного легирования). Сканированный ионный пучок, минуя вакуумный затвор 13, попадает на полупроводниковую пластину 17, закрепленную в кассете 18. Контейнер 16 с установленными кассетами, закреплен на вертикальном валу и помещен в приемную камеру 15. Внутри контейнера имеются нагреватели, обеспечивающие нагрев пластин до t=400̊ С (при необходимости), и дозиметр 14, электроды которого расположены за соответствующими щелями кассет 18 и обеспечивают контроль над дозой легирования. При групповом режиме работы установки снимается напряжение сканирования с пластин 11, горизонтальное сканирование обеспечивается непрерывным вращением контейнера 16, приводимого в движение приводом 21 через соединительную штангу 22. Сигнал с дозиметра 14 подается на блок измерения дозы БИД-3. По окончании набора заданной дозы автоматически подается команда на отключение напряжения смещения. Цилиндр Фарадея ЦФ-1, 25 расположен в системе отклоняющей 9 и предназначен для измерения тока луча и настройки. Цилиндр Фарадея ЦФ-2, 12 служит для его первоначального контроля и измерения тока ионного пучка и его тестирования, при снятии напряжений с пластин 10,11,26. Он представляет собой датчик, размещенный на качающемся сильфоном вводе. Датчик выполнен по принципу цилиндра Фарадея и имеет закрепленный экран с входным отверстием 75мм, сетку, на которую подается подавляющее напряжение -200В, и измерительный электрод. Привод цилиндра Фарадея - от электродвигателя РД-09. Откачная система установки включает в себя 2 механических вакуумных насоса НВР-5Д, располагаемых отдельно, 2 высоковакуумных паромасляных агрегата АВП-2, пост вакуумной откачки, устройство напуска УН-3, а также систему трубопроводов, соединяющих пост вакуумной откачки с агрегатом АВП-2 и высоковакуумными объемами установки.  1-ионный источник, 2-электромагнит, 3-масс-сепаратор, 4-корпус фокусирующей системы, 5-электрод, 6-система фокусирующая, 7-ускорительная труба, 8-кольцевые электроды, 9-система отклоняющая, 10-пластины (верт. плоскость), 11-пластины (гор. плоскость), 12-цилиндр Фарадея ЦФ-2, 13-вакуумный затвор, 14-дозиметр, 15-приемная камера, 16-контейнер, 17-полупроводниковая пластина, 18-кассета, 19-крышка, 20-нагреватели, 21-привод, 22-ввод вращения, 23-дозиметр, 24-охлаждаемый корпус, 25-цилиндр Фарадея ЦФ-1, 26-пластины смещения, 27-металлофарфоровый изолятор Рисунок 2 - Структурная схема установки ионного легирования Для ускорения откачки высоковакуумных объемов установки после их вскрытия в установке предусмотрена система напуска сухого азота вместо атмосферного воздуха. Азот может подаваться от централизованной подачи сухого азота или от устройства питательного ОТ2.959.016Сп через прижимы ОТМ4.430.006 в систему азотных трубопроводов. В качестве уплотнителей применены уплотнители из эластомерных материалов (резина и фторопласт). Управление вакуумной системой осуществляются в двух режимах: автоматическом и ручном. Охлаждение установки осуществляется водой и высоковольтным маслом. Маслом охлаждаются элементы пульта высоковольтного, находящегося под потенциалом до +150кВ. Одна ветвь системы охлаждения обеспечивает охлаждение электромагнита 2, другая - источника ионов 1. Водой охлаждаются все элементы установки, находящиеся под потенциалом земли. Вода к охлаждаемым деталям установки подается через устройство УГ-32 ОТМ3.385.004, вмонтированное в раме устройства приемного и представляет собой входной трубопровод, с закрепленными на нем гидрореле. Поскольку в установке возможно возникновение рентгеновского излучения, как следствие торможения электронов, часть вакуумного тракта установки защищена свинцом. 1.2.1 Источник ионов аргона Ионный источник установки «Везувий-5» представляет собой дуговой источник с прямонакальным катодом и поперечным магнитным полем. Ионный источник состоит (рисунок 3) из охлаждаемого фланца на котором в металлокерамических изоляторах смонтированы вольфрамовые катоды 13 с отражающими пластинами 8, прогреваемой разрядной камеры 7 со сменной молибденовой диафрагмой, тигля с рабочим (твердым) веществом 11, охлаждаемого корпуса 6, опорного фланца 1, соединенного с корпусом 6 через изолятор 4, вытягивающего электрода 2, закрепленного на изоляторе 3. Для ионного источника, работающего с газообразным веществом, фланец 14 видоизменен, имеется трубопровод подвода газа. Поперечное магнитное поле источника создается постоянным С-образным магнитом 9, набранным из отдельных прямоугольных брусков из сплава ЮНДК-2ББА и намагниченных в собранном виде. Ионизация паров рабочих веществ и первичное формирование пучка в устройстве ионном осуществляется следующим образом: Между одним из катодов (второй является резервным), который за счет протекания тока накала разогрет до температуры 2500…3000С, и вторым катодом (анодом) при подаче на них «напряжения дуги» загорается дуговой разряд. Эмитированные горячим катодом электроны движутся к аноду по траекториям, определяемым направлением силовых линий магнитного поля, и, встречаясь на своем пути с молекулами или атомами паров рабочего вещества, ионизируют их. Образующееся облако плазмы, форма поверхностей которой также определяется силовыми линиями магнитного поля, располагается в районе щели диафрагмы разрядной камеры 7. Из плазменного облака ионы отбираются (вытягиваются) электрическим полем, создаваемым в зазоре между разрядной камерой, имеющей плюсовой потенциал относительно корпуса 1, и вытягивающим электродом, имеющим минусовой потенциал относительно корпуса 1 ( Uвыт.=10 кV). Электрод 2 жестко закреплен на корпусе 1 и выполняет роль формирующего электрода. Электропитание элементов устройства ионного осуществляется от блока питания источника ионов БПИИ-1, БПИИ-5. В ионном источнике используется нержавеющая сталь 12Х18Н10Т, уплотнители выполнены из меди, фторопласта и резины. Все неметаллические уплотнители охлаждаются маслом высоковольтным трансформаторным, подаваемым системой охлаждения. Электромагнит масс-сепаратора служит для магнитной сепарации ионов по массе, состоит из вакуумной камеры и магнитной системы. Вакуумная камера ОТМ3.805.010 имеет входное и выходное отверстия прямоугольной формы для подсоединения устройства ионного с одной стороны и системы фокусирующей с другой. Камера выполнена из нержавеющей стали 12Х18Н10Т, боковые стенки которой закрыты свинцовым экраном для защиты персонала от рентгеновского излучения.  1-корпус, 2-фокусирующий электрод, 3-изолятор (1), 4-изолятор (2), 5-вытягивающий электрод, 6-охлаждаемый корпус, 7-разрядная камера, 8-пластины, 9-система отклоняющая магнитная, 10-цилиндр Фарадея ЦФ-1, 11-тигель с рабочим веществом, 12- цилиндр Фарадея ЦФ-2, 13-вольфрамовые катоды, 14-фланец. Рисунок 3 - Ионный источник 1.2.2 Масс-сепаратор Масс-сепаратор (рисунок 4) установки ионного легирования «Везувий-5» состоит из источника ионов 1, анализатора энергий 2, масс-анализатора 3, диафрагмы формирования микропучка 4 и электромагнита 5. Вытягивающийся из источника ионный пучок, попадает в электромагнит масс-сепаратора, где происходит разделение ионов по массам, в зависимости от напряженности магнитного поля, создаваемого электромагнитом 5. Электромагнит масс-сепаратора служит для магнитной сепарации ионов по массе, состоит из вакуумной камеры и магнитной системы. 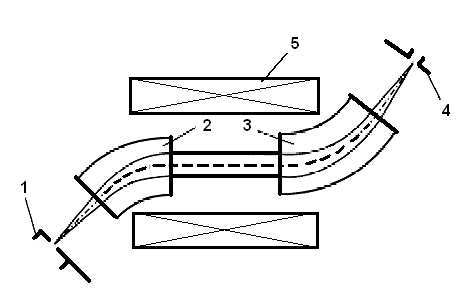 1-источник ионов, 2-анализатор энергий, 3-масс-анализатор, 4-диафрагма, 5-электромагнит Рисунок 4 - Масс-сепаратор 1.2.3 Блок ускорения и фокусировки Блок фокусировки (рисунок 5) представляет собой корпус, в котором размещены 2 конденсаторные линзы, каждая из которых состоит из двух пар электродов 5, 6. Конденсаторные линзы смонтированы на боковом монтажном люке корпуса системы фокусирующей. Блок фокусировки предназначен для фокусировки ионного луча, выходящего из масс-сепаратора. Электропитание системы осуществляется от высоковольтного источника ИВ-3ПМ-2 регулируемым, напряжением от 0-3 кВ. Трубка 7 предназначена для ускорения ионного пучка до необходимой энергии легирования. Она представляет собой вакуум-плотный металлофарфоровый многосекционный изолятор 27 с проходными кольцевыми электродами 8, напряжения на которые подаются через внешний делитель напряжений. Полное ускоряющее напряжение +150 кВ подается от источника И13150П-5 на делитель. Для защиты от рентгеновского излучения трубку закрывают кожухом левым ОТМ4.127.168-01 и кожухом правым ОТМ4.127.169-01. Система отклоняющая 9 (рисунок 2) представляет собой прямоугольную камеру с боковым люком, предназначенным для монтажа элементов системы. На основании камеры установлены пластины смещения 26, пластины горизонтального сканирования 11, пластины вертикального сканирования 10, цилиндра Фарадея ЦФ1-25, ЦФ2-12. Пластины смещения 26 предназначены для отклонения ионного пучка на заданный угол смещения; на них подается постоянное регулируемое напряжение на одну пластину от 0 до +15 кВ, на другую от 0 до -15 кэВ. Питание пластин осуществляется от блока питания отклоняющих пластин БПОП-3. На пластины 11, предназначенные для сканирования ионного пучка по горизонтали, подается регулируемое пилообразное треугольное напряжение симметричной формы от 0 до 5 кВ от блока БГС-5-50-0. Из пластин 10, предназначенных для сканирования ионного пучка по вертикали подается регулируемое пилообразное треугольное напряжение симметричной формы от 0 до 10 кВ от генератора сканирования БГС-3. 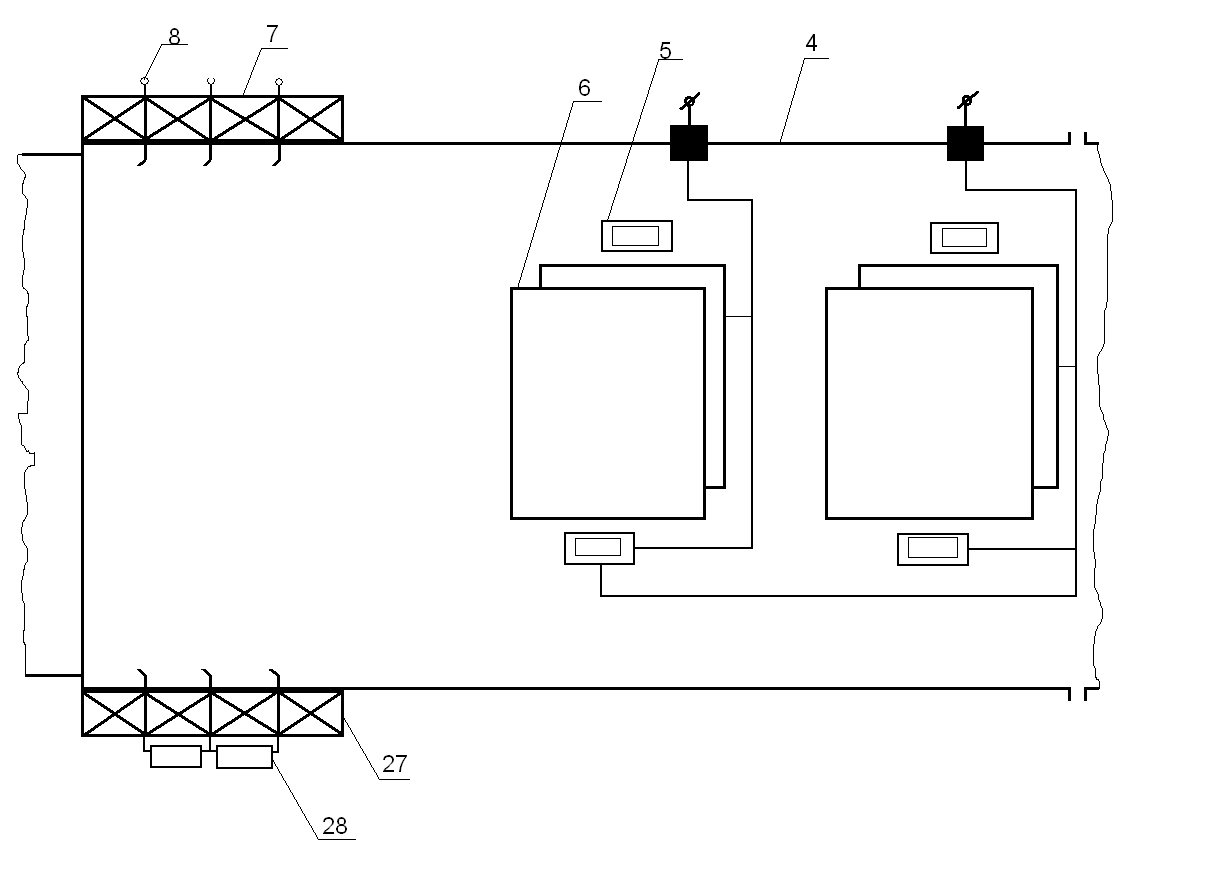 |
